
一种提升Nor Flash多晶硅刻蚀及介质层填充工艺窗口的方法.pdf

宜然****找我







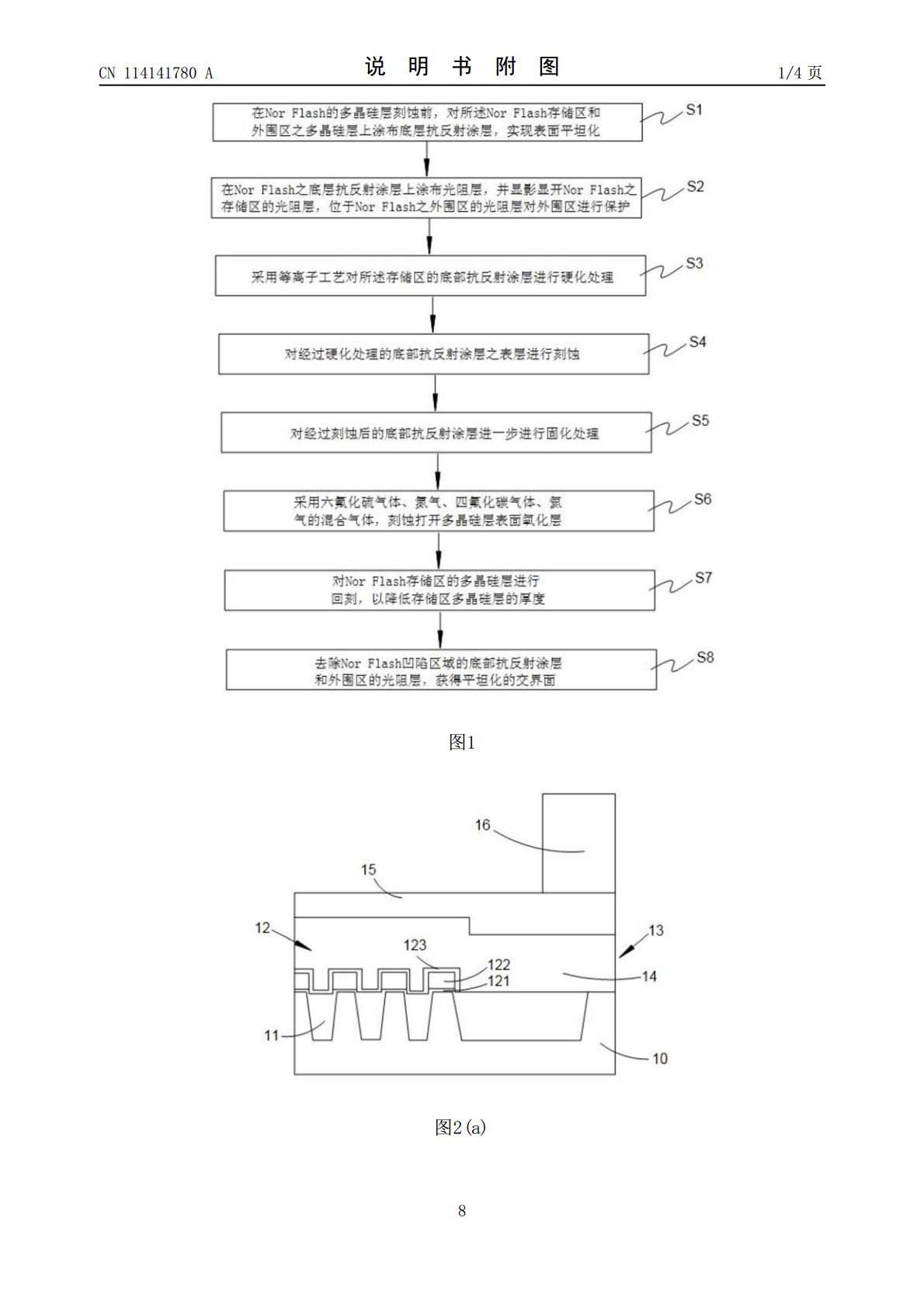
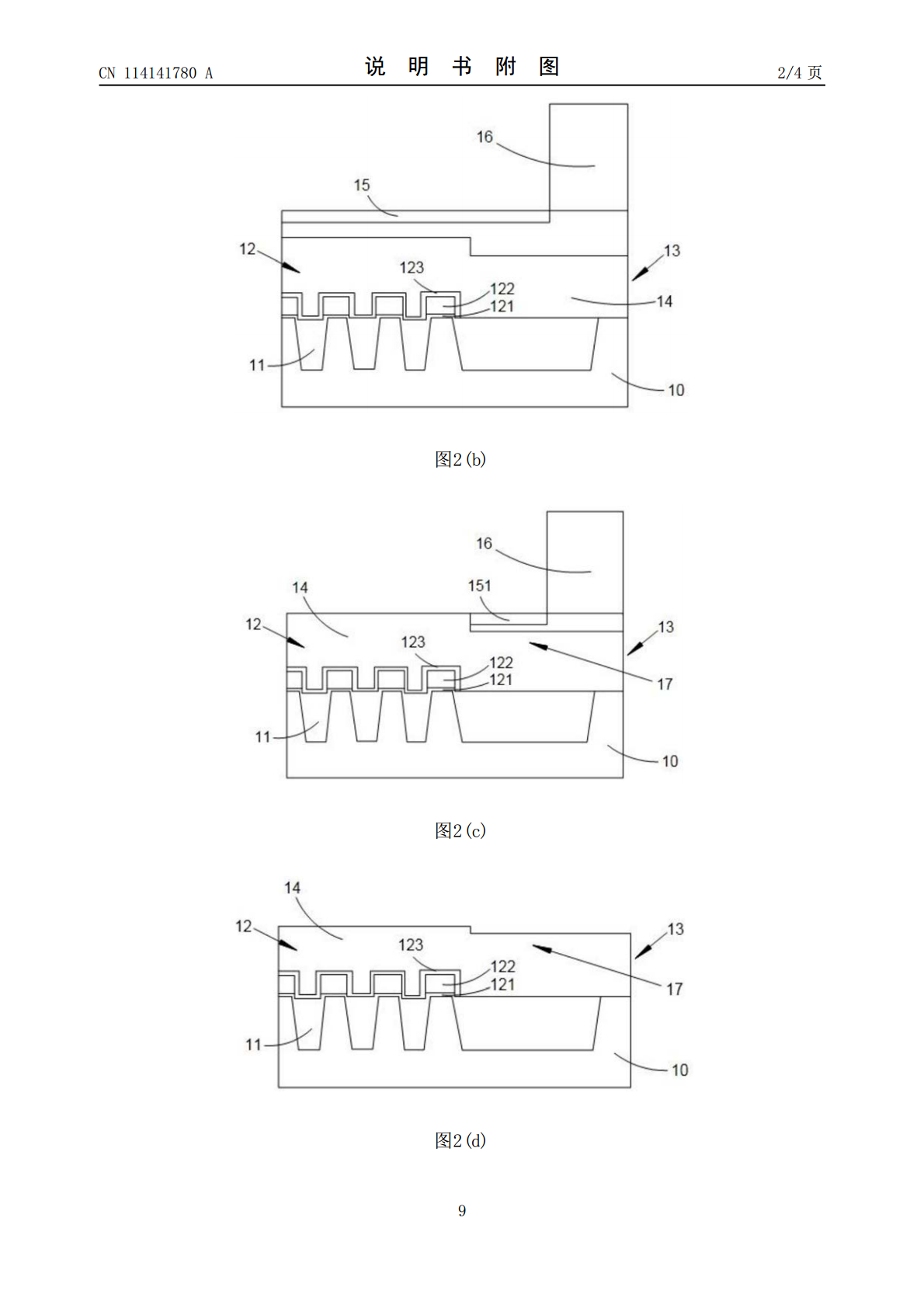
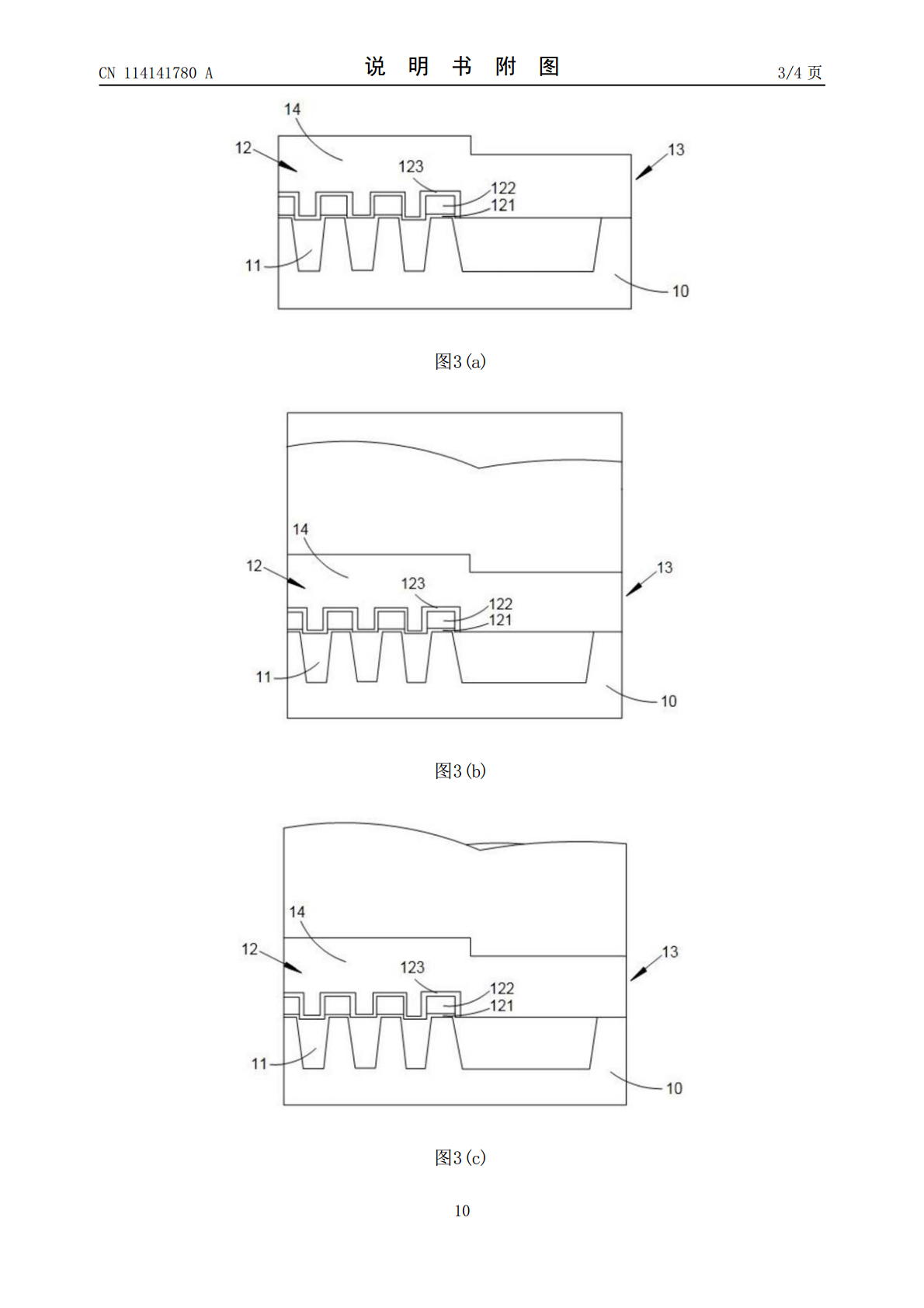
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种提升Nor Flash多晶硅刻蚀及介质层填充工艺窗口的方法.pdf
一种提升NorFlash多晶硅刻蚀及介质层填充工艺窗口的方法,所述提升NorFlash多晶硅刻蚀及介质层填充工艺窗口的方法通过在多晶硅层刻蚀前涂布底层抗反射涂层,并采用回刻工艺降低NorFlash存储区的多晶硅层,同时缩小所述NorFlash存储区和外围区交界处的高度差。本发明通过在多晶硅层刻蚀前涂布底层抗反射涂层,并采用回刻工艺降低所述NorFlash存储区的多晶硅层,同时缩小所述NorFlash存储区和外围区交界处的高度差,不仅可以避免多晶硅层刻蚀时因高度差过大而导致多晶硅刻蚀残留,扩大刻

一种NOR Flash栅极多晶硅工艺方法.pdf
本发明提供一种NORFlash栅极多晶硅工艺方法,提供同一工艺中的Flash存储区及外围逻辑区;在flash存储区中的栅极多晶硅以及外围逻辑区的逻辑区多晶硅上形成多晶硅硬掩膜;刻蚀去除flash存储区中栅极多晶硅上的多晶硅硬掩膜,保留外围逻辑区中逻辑区多晶硅上的多晶硅硬掩膜;刻蚀去除flash存储区中的栅极多晶硅;刻蚀去除flash存储区中的栅极氧化层和氮化硅层;刻蚀去除flash存储区中的字线端头处多晶硅,以及定义外围逻辑区中的逻辑区多晶硅。本发明不增加光罩,使用已有的存储单元光罩对flash区预先处

一种Nor Flash浅槽隔离填充方法.pdf
本申请公开了一种NorFlash浅槽隔离填充方法,属于半导体器件及制造领域。该方法中,在介质填充工艺中插入SiCoNi蚀刻工艺,实现将浅沟槽隔离结构淀积过程中存在的孔洞消除,再进行全填充至需求厚度;且SiCoNi蚀刻工艺类似各向同性刻蚀,因此SiCoNi蚀刻工艺之后沟槽轮廓仍然是“V”型,适应了该工序效果。

层间介质层的刻蚀方法.pdf
本发明公开了一种层间介质层的刻蚀方法,包括:在半导体衬底上依次形成有浮栅介质层、浮栅多晶硅层和层间介质层;在层间介质层上形成图案化的光刻胶层,以光刻胶层为掩模,对层间介质层进行第一次刻蚀,在层间介质层内形成具有第一深度的第一沟槽,所述第一沟槽沿其深度方向的截面从远离浮栅多晶硅层处到所述浮栅多晶硅层处收缩;以图案化的光刻胶层为掩模,对层间介质层进行第二次刻蚀,使第一沟槽形成具有第二深度的第二沟槽,第二沟槽沿其深度方向的截面从远离浮栅多晶硅层处到靠近浮栅多晶硅层处收缩;此时,第二沟槽内部沉积有聚合物,第二沟槽

阻挡介质层的刻蚀方法.pdf
本发明提供一种阻挡介质层的刻蚀方法,包括:提供半导体衬底,所述半导体衬底上依次形成有金属层、阻挡介质层、氧化介质层和光刻胶层,所述光刻胶层内形成有光刻胶开口;对所述光刻胶开口的形貌进行调整,形成具有倾斜角度的光刻胶开口;沿所述具有倾斜角度的光刻胶开口对下方的氧化介质层进行刻蚀工艺,在氧化介质层内形成氧化介质层开口;去除氧化介质层上方残留的光刻胶层;以所述氧化介质层为掩膜,沿所述氧化介质层开口对阻挡介质层进行刻蚀工艺,在阻挡介质层内形成阻挡介质层开口,露出下方的金属层,所述阻挡介质层开口具有倾斜角度。本发明
