
工艺腔的清洁方法.pdf

努力****梓颖








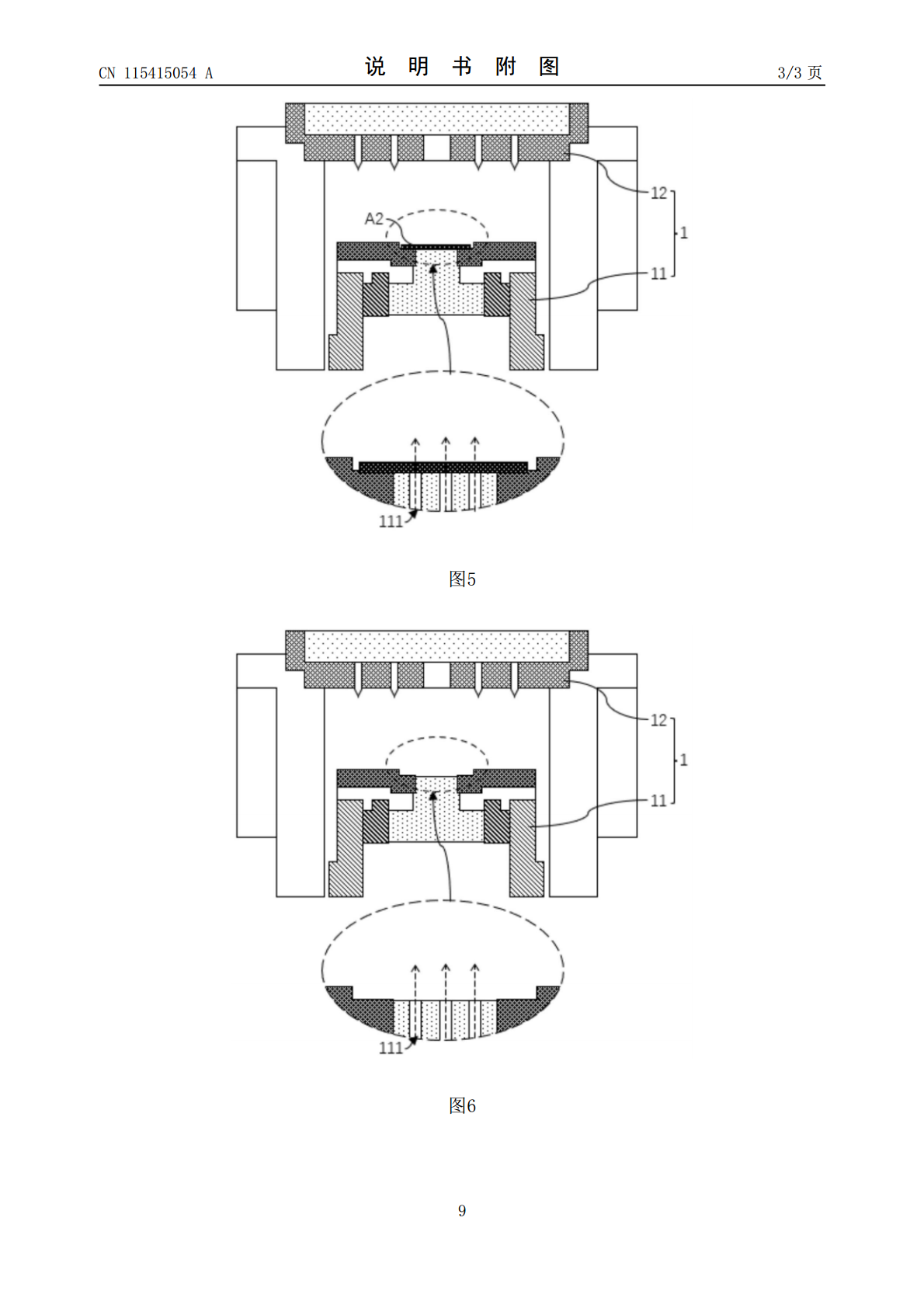
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

工艺腔的清洁方法.pdf
本发明提供了一种工艺腔的清洁方法,对晶圆进行刻蚀工艺后,贯穿静电吸盘的顶针将放置于静电吸盘上的晶圆向上顶起,以将晶圆与静电吸盘分离;在所述顶针向上顶起晶圆的过程中,通过贯穿所述静电吸盘的背氦出气孔向静电吸盘的表面通入清洁气体,以吹走静电吸盘上附着的部分刻蚀生成物。本发明通过向静电吸盘上的背氦出气孔通入清洁气体,减少静电吸盘上的刻蚀生成物堆积,避免静电吸盘上的背氦出气孔堵塞,从而避免静电吸盘在刻蚀工艺中温度不均,进而提高产品良率。本发明还在将晶圆移出工艺腔之后对工艺腔依次进行了第一清洁工艺和第二清洁工艺,大

基板清洁腔室以及清洁与调节方法.pdf
基板清洁室包括具有拱形表面的轮廓顶电极,所述拱形表面面对基板支撑件且具有可变的横截面厚度,以改变拱形表面与基板支撑件之间的间隙大小好提供横跨基板支撑件的可变的等离子体密度。清洁室的介电环包括底部、脊部以及覆盖基板支撑件的外围唇部的径向向内架部。底部挡板包括具有至少一外围壁的圆形盘。同时描述了清洁室的清洁与调节处理。

基板处理方法和腔室清洁方法.pdf
本发明构思提供了一种基板处理方法。所述基板处理方法包括:通过将过程等离子体传送到腔室的处理空间来处理基板;以及通过将清洁介质供应到定位在所述处理空间下方的所述腔室的排气空间来清洁排气空间。

处理腔室部件的清洁方法.pdf
提供了一种清洁半导体处理腔室的部件的方法。所述方法包含将部件中的残留物暴露于含有含氮气体和含氧气体的工艺等离子体。部件中的残留物经历化学反应,从而清洁部件。清洁了部件,将部件恢复到运行工艺化学反应之前的条件。

薄膜沉积腔室的清洁方法.pdf
公开了一种薄膜沉积腔室的清洁方法,可以包括:i)在薄膜沉积腔室中同时提供氧等离子体和氟等离子体,以至少部分地去除薄膜沉积腔室中的包括碳(C)的第一残留物和包括硅(Si)的第二残留物,以及ii)在薄膜沉积腔室中提供氟等离子体而不提供氧等离子体,以去除在薄膜沉积腔室中剩余的第二残留物。
