
沟槽栅半导体器件及其制造方法.pdf

书生****66








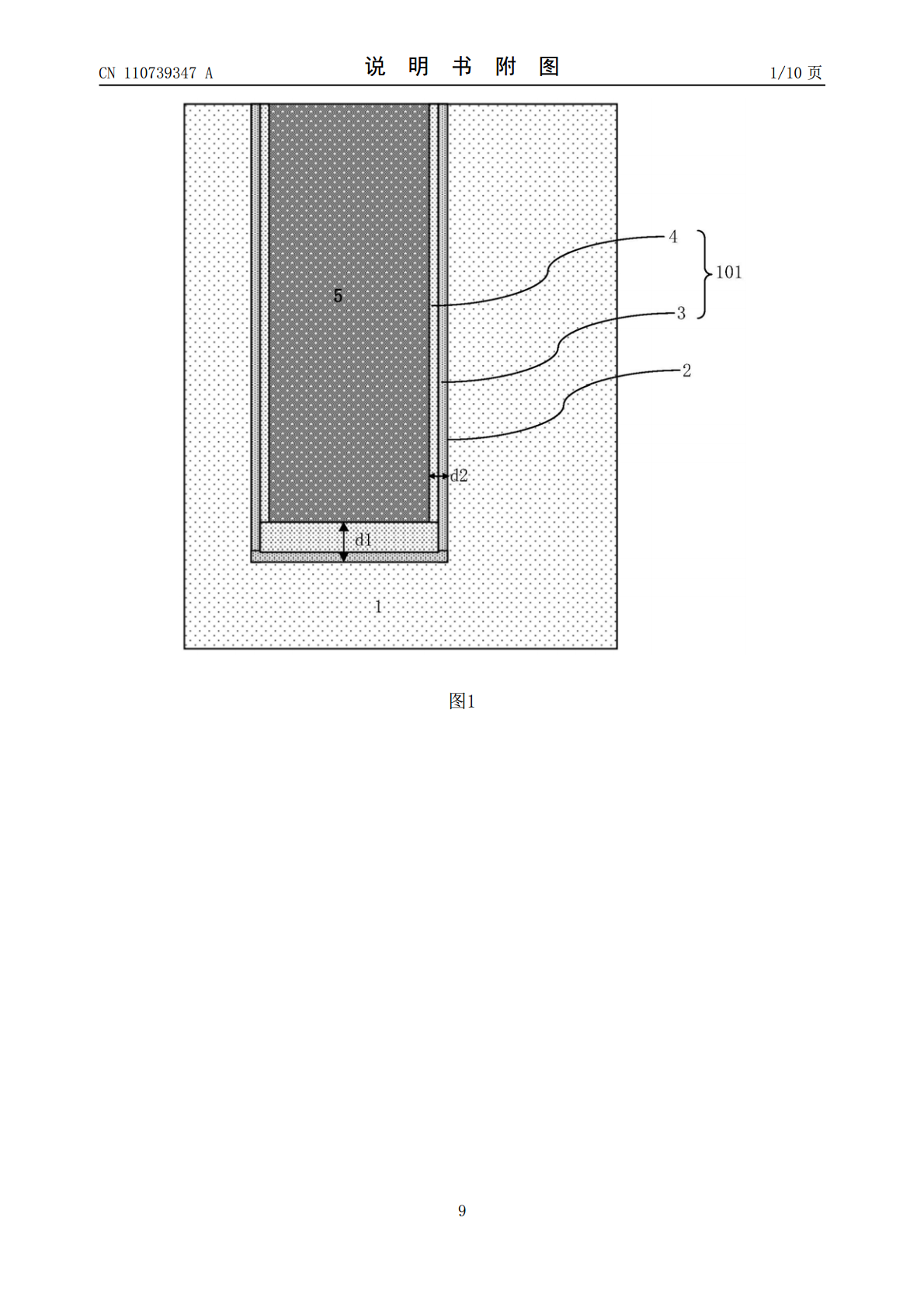
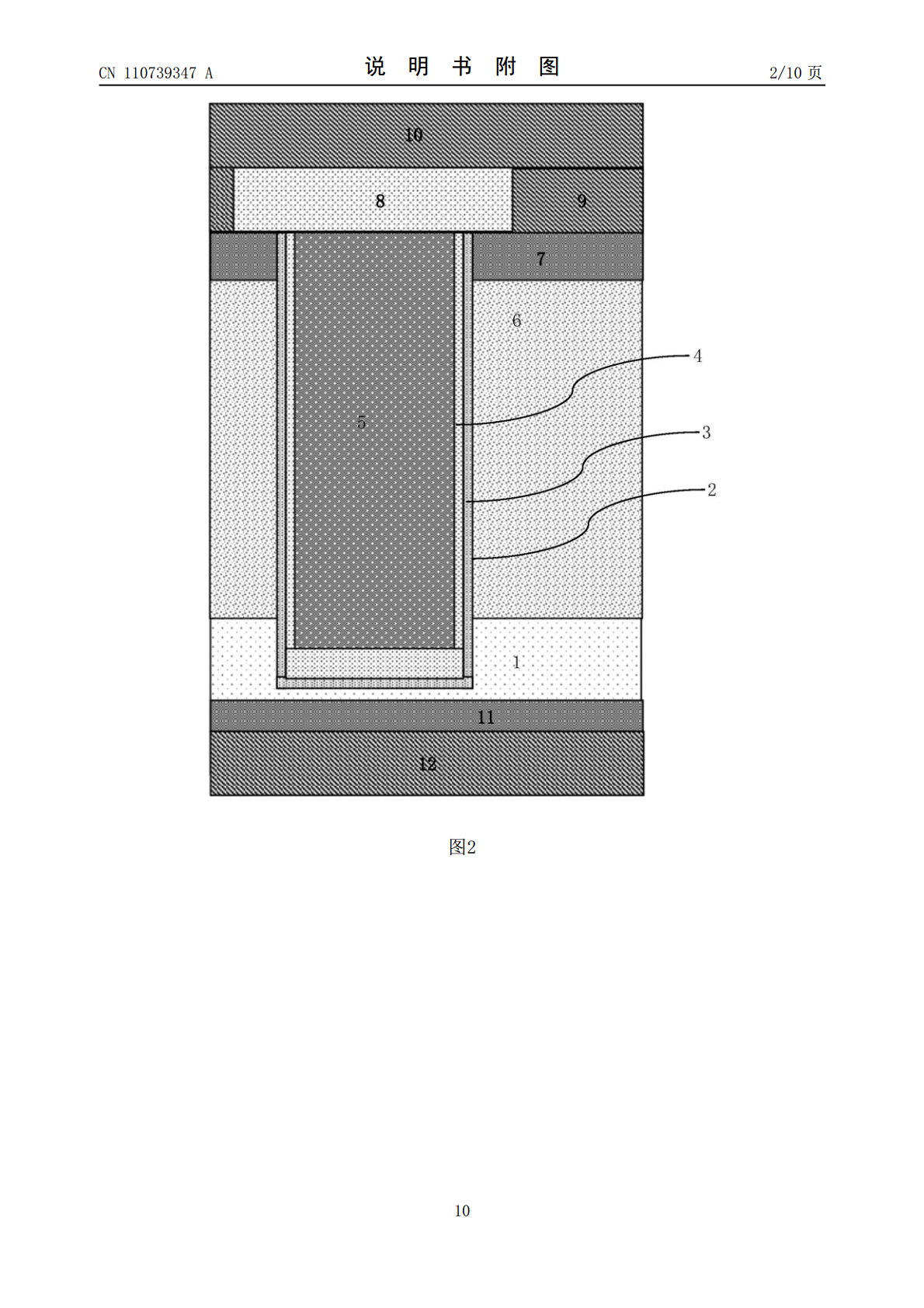
亲,该文档总共18页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

沟槽栅半导体器件及其制造方法.pdf
本发明公开了一种沟槽栅半导体器件,沟槽栅包括形成于半导体衬底中沟槽、形成于所述沟槽的底部表面和侧面的栅氧化层;栅氧化层由第一氧化层和第二氧化层叠加而成;第一氧化层为炉管热氧化层;第二氧化层为PECVD氧化层;栅氧化层具有通过RTA处理的热致密结构;利用沟槽中形成的PECVD氧化层具有底部表面的厚度大于侧面厚度的特性,使栅氧化层具有位于沟槽的底部表面的厚度大于位于沟槽的侧面的厚度的结构。本发明还公开了一种沟槽栅半导体器件的制造方法。本发明能提高器件的BVGSS,同时不影响器件的阈值电压,工艺简单且成本低。

沟槽栅半导体器件及其制造方法.pdf
本发明公开了一种沟槽栅半导体器件,包括:第一外延层组成的漂移区和形成于漂移区顶部的体区;多个包括栅极沟槽、栅介质层和栅极导电材料层的沟槽栅,原胞区包括多个并联的原胞,各原胞包括一个沟槽栅;在各沟槽栅的两侧分别形成有一个包括屏蔽沟槽、屏蔽介质层和屏蔽导电材料层的屏蔽电极结构,屏蔽沟槽的深度大于栅极沟槽的深度,屏蔽导电材料层填充在屏蔽沟槽中,屏蔽导电材料层用于对沟槽栅底部的漂移区产生横向耗尽,从而降低器件的密勒电容和导通电阻;在体区表面形成有源区;屏蔽导电材料层和源区都通过接触孔连接到由正面金属层组成的源极。

具有屏蔽栅沟槽结构的半导体器件及其制造方法.pdf
本发明提供了一种具有屏蔽栅沟槽的半导体器件及其制造方法,在回刻蚀场氧化层以形成核心区的屏蔽氧化层之后,且在通过热氧化工艺一步形成核心区屏蔽栅上方的栅间氧化层和栅氧化层之前,先通过平坦化工艺或者回刻蚀工艺来降低终端区的沟槽中的缝隙深度,由此在后续形成核心区的多晶硅栅的工艺中能避免在终端区的沟槽中产生的多晶硅残留,有效解决终端区器件的CP参数失效问题,保证半导体器件的性能。

一种沟槽栅半导体器件及其制造方法.pdf
本申请实施例提供一种沟槽栅半导体器件及其制造方法,沟槽栅半导体器件包括:第一衬底层、第一掺杂区、第二掺杂区、第一导电构件、第二导电构件、源极电极;还包括两个第三掺杂区,形成在所述第一衬底层上且对应位于第二导电构件的下方,所述第三掺杂区的掺杂类型均为第二掺杂类型,并且两个所述第三掺杂区内的电荷量之和与位于两者之间的第一衬底层内的电荷量的比值范围为0.9‑1.1。本公开提供的半导体器件改善了电场分布,提升了器件的耐压值。

具有屏蔽栅沟槽的半导体器件的制造方法.pdf
本发明提供了一种具有屏蔽栅沟槽的半导体器件的制造方法,在形成沟槽之后,在沟槽的内表面上形成刻蚀速率不同的第一氧化层和第二氧化层,并先将第二氧化层回刻蚀至要求高度,形成侧壁上保留有部分厚度的第一氧化层的回刻蚀槽,再进一步利用回刻蚀槽侧壁上的第一氧化层保护回刻蚀槽侧壁的衬底,并回刻蚀第一多晶硅层至第二氧化层的顶部以下,形成屏蔽栅,进而在去除回刻蚀槽侧壁上的第一氧化层之后,通过热氧化工艺一步形成栅间氧化层和栅氧化层,由此能够使得形成的栅间氧化层的顶面形貌相对平坦,且使得形成的栅氧化层相对较薄,避免了现有技术中一
