
SiC化学气相沉积装置和SiC外延晶片的制造方法.pdf

一只****iu









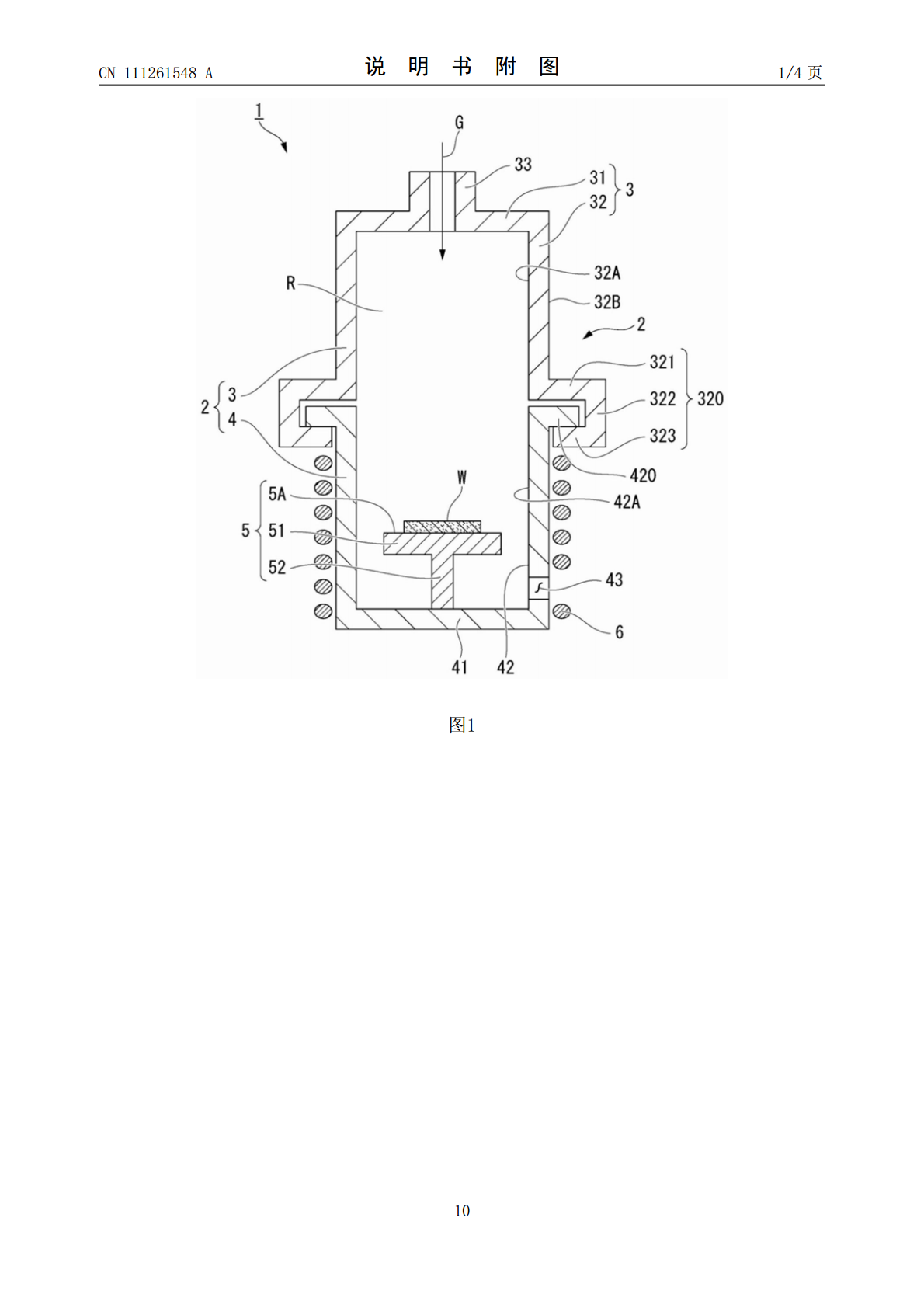
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

SiC化学气相沉积装置和SiC外延晶片的制造方法.pdf
本发明涉及SiC化学气相沉积装置和SiC外延晶片的制造方法。该SiC化学气相沉积装置具有在内部构成沉积空间的炉体和位于上述沉积空间的下部且在载置面上载置SiC晶片的载置台,上述炉体在与上述载置台大致正交的上下方向上被分离为多个部件,上述多个部件具有第一部分和第二部分,上述第一部分具有向外周方向突出的突出部,上述第二部分具有供上述突出部钩挂的钩部,上述第一部分与上述第二部分通过上述钩部钩挂于上述突出部而连结。

SiC外延晶片和SiC外延晶片的制造方法.pdf
本发明的目的在于得到能够测定外延层总厚度和漂移层厚度的SiC外延晶片及其制造方法。该SiC外延晶片具备SiC基板和层叠于所述SiC基板上的外延层,所述外延层从所述SiC基板侧依次具有第1层、第2层和第3层,所述SiC基板的氮浓度为6.0×10<base:Sup>18</base:Sup>cm<base:Sup>?3</base:Sup>以上且1.5×10<base:Sup>19</base:Sup>cm<base:Sup>?3</base:Sup>以下,所述第1层的氮浓度为1.0×10<base:Sup>

SiC化学气相沉积装置.pdf
本发明提供一种SiC化学气相沉积装置,上述SiC化学气相沉积装置具有:炉体,其在内部构成沉积空间;和载置台,其位于上述沉积空间内,且在载置面载置SiC晶片,上述炉体具有:第1孔,其位于与上述载置面对置的上部,向上述沉积空间内导入原料气体;第2孔,其位于上述炉体的侧壁,供吹扫气体流入上述沉积空间内;以及第3孔,其位于上述炉体的侧壁的比上述第2孔靠下方的位置,将上述沉积空间内的气体排出,在上述第2孔的下端具备突出部,该突出部朝向上述沉积空间突出,调整上述原料气体的流动。

气体配管系统、化学气相生长装置、成膜方法和SiC外延晶片的制造方法.pdf
该气体配管系统是向在内部进行气相生长的反应炉供给多种气体的运行放气方式的气体配管系统,其具备:将上述多种气体分别送入的多条供给管线,从上述反应炉的排气口向排气泵连接的排气管线,具备从上述多条供给管线分别分支、并向上述反应炉供给上述多种气体的1个或多个配管的运行管线,从上述多条供给管线分别分支、并与上述排气管线连接的多条放气管线,以及分别设置在上述多条供给管线的分支点、并将向运行管线侧流通气体或向放气管线侧流通气体进行切换的多个阀;上述多条放气管线被分离直到达到上述排气管线,上述排气管线的内径大于上述多条放

SiC单晶的制造方法、SiC单晶的制造装置以及SiC单晶晶片.pdf
本发明要解决的问题是提供一种在抑制了SiC升华的同时减少了内部应力的新型的SiC单晶主体。为了解决上述问题,本发明提供一种SiC单晶的制造方法,其包括将SiC单晶主体在含有Si元素和C元素的气氛下在1800℃以上进行加热并减少所述SiC单晶主体的内部应力的应力减少步骤。此外,本发明是一种SiC单晶的制造装置,包括:主体容器,由SiC材料制成且能够收纳SiC单晶主体;和加热炉,能够将所述主体容器在1800℃以上进行加热。
