
一种器件封装方法以及应用该封装方法封装的封装结构.pdf

葫芦****io








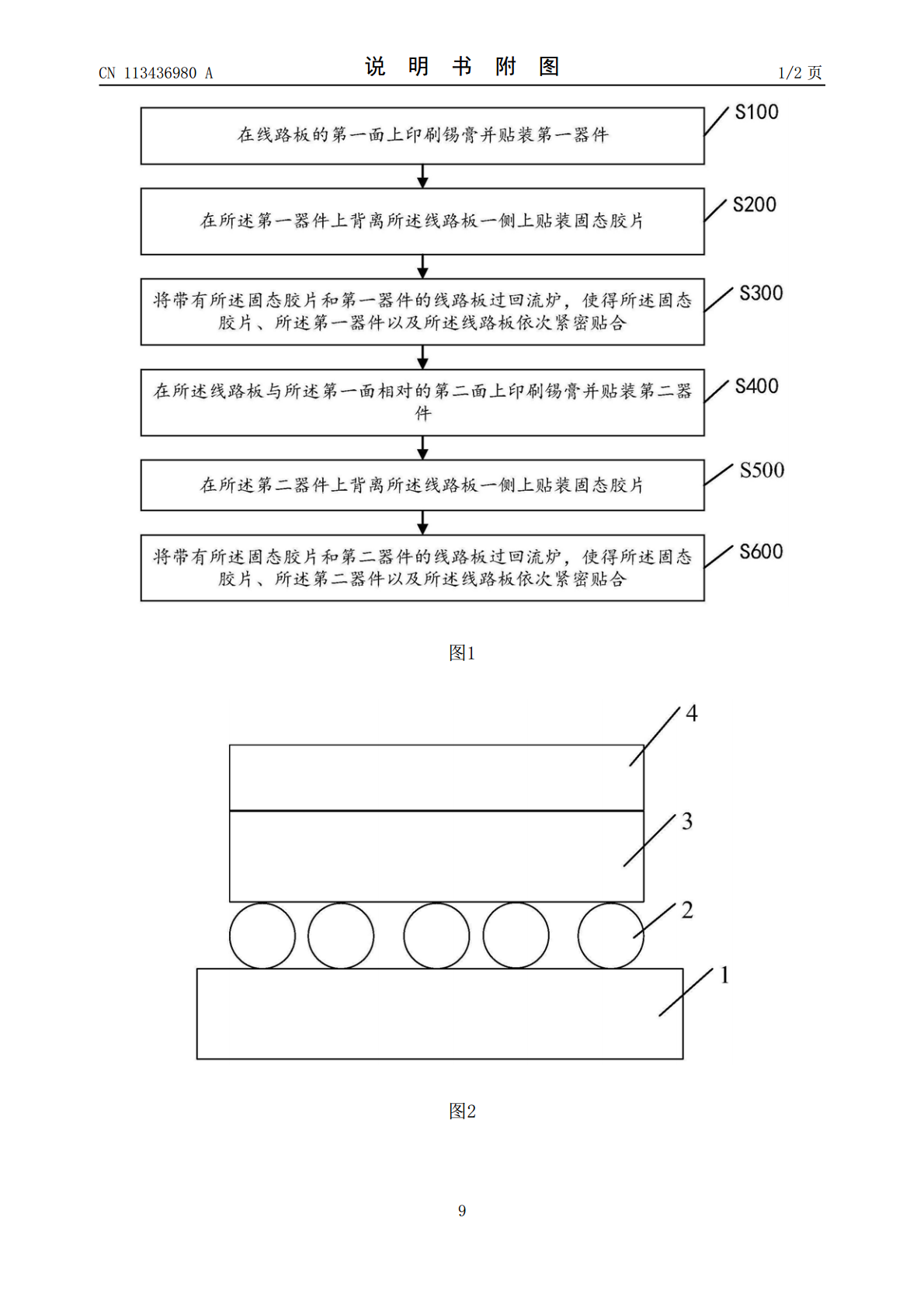
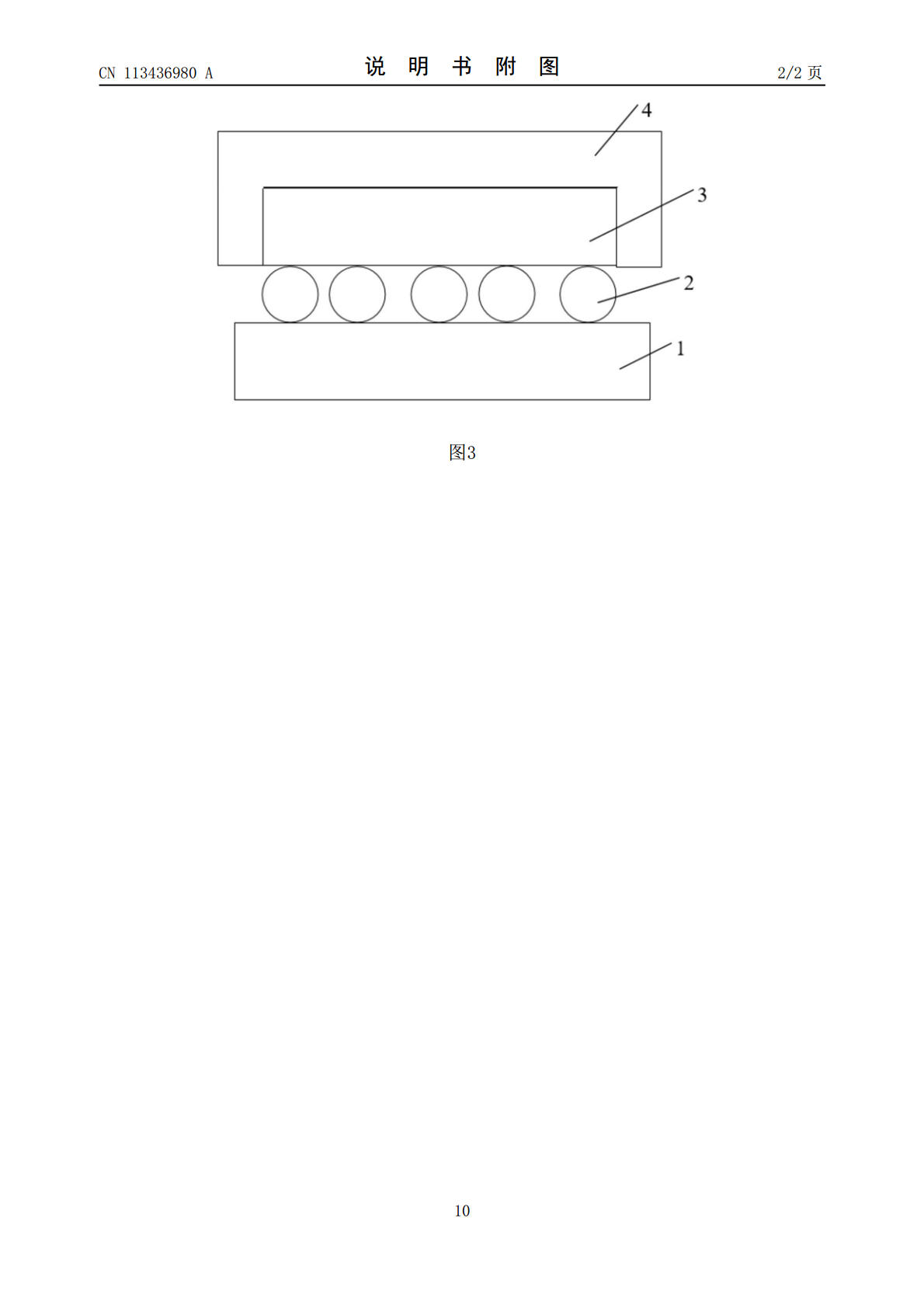
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种器件封装方法以及应用该封装方法封装的封装结构.pdf
本发明提供了一种器件封装方法以及应用该封装方法封装的封装结构,涉及器件保护领域,包括以下:在线路板的第一面上印刷锡膏并贴装第一器件;在所述第一器件上背离所述线路板一侧上贴装固态胶片;将带有所述固态胶片和第一器件的线路板过回流炉,使得所述固态胶片、所述第一器件以及所述线路板依次紧密贴合;在所述线路板与所述第一面相对的第二面上印刷锡膏并贴装第二器件;在所述第二器件上背离所述线路板一侧上贴装固态胶片;将带有所述固态胶片和第二器件的线路板过回流炉,使得所述固态胶片、所述第二器件以及所述线路板依次紧密贴合,用于解决

一种封装结构以及封装方法.pdf
本申请实施例涉及半导体封装领域,提供一种封装结构以及封装方法,一种封装结构包括:第一金属层以及第二金属层,第一金属层位于电路区的第一面,第二金属层位于支撑区的第一面;第三金属层以及第四金属层,第三金属层位于电路区的第二面且与导电结构电连接,第四金属层位于支撑区的第二面;其中,至少两个堆叠设置的半导体结构中的一个半导体结构的第一面与其相邻的另一半导体结构的第二面正对,且半导体结构的第一金属层与处于相邻层的半导体结构的第三金属层接触键合,半导体结构的第二金属层与处于相邻层的半导体结构的第四金属层接触键合,可以

一种封装面板、器件封装结构及其制备方法.pdf
本发明提供了一种封装面板、器件封装结构及其制备方法。本发明提供的封装面板包括贴合基板和通过构图工艺在贴合基板上形成的隔垫物,其中贴合基板上预留有封框胶封装位置。使用该封装面板封装器件时,由于隔垫物支撑在贴合基板和器件基板之间,因此封装面板易于从器件基板上分离,同时封装面板对器件基板以及形成在器件基板上的元器件的损伤较小或没有损伤,有效保护了器件基板以及器件基板上元器件的性能。

封装结构、封装方法以及滤波器.pdf
一种封装结构、封装方法以及滤波器,封装方法的形成通孔的步骤中,通孔侧壁的底部形成横向侧掏区域位于横向边缘区域,且通孔侧壁上形成有凹陷导致通孔侧壁的粗糙度较高,在形成保护层的步骤中,保护层会填充横向侧掏区域以及通孔侧壁上的凹陷,在去除通孔横向中心区域的保护层,至少保留横向边缘区域底部的保护层的步骤中,横向侧掏区域的保护层被保留,通孔侧壁的凹陷被保护层填充,从而形成种子层的步骤中,种子层避免了填充横向侧掏区域和凹陷,形成的种子层不易出现不连续的情况,使得再布线结构或者凸块下金属层不易短路或开路,有利于提高封装

发光器件的封装方法、封装结构及电子设备.pdf
本申请涉及电子技术领域,提供了发光器件的封装方法、封装结构及电子设备。发光器件的封装方法包括:提供一基底(20);在基底(20)内制作沉孔;将发光器件(10)埋入沉孔内;在基底(20)上制作扇出式封装的焊盘引出结构(30),将发光器件(10)的焊盘牵引至基底(20)外轮廓面,并露出发光器件(10)的发光区域。采用本申请的实施例,能够降低发光器件(10)封装结构的重量、缩小发光器件(10)封装结构的体积,并能够降低功耗、提高散热效率。
