
晶舟底盘、晶舟和扩散炉.pdf

Ch****49







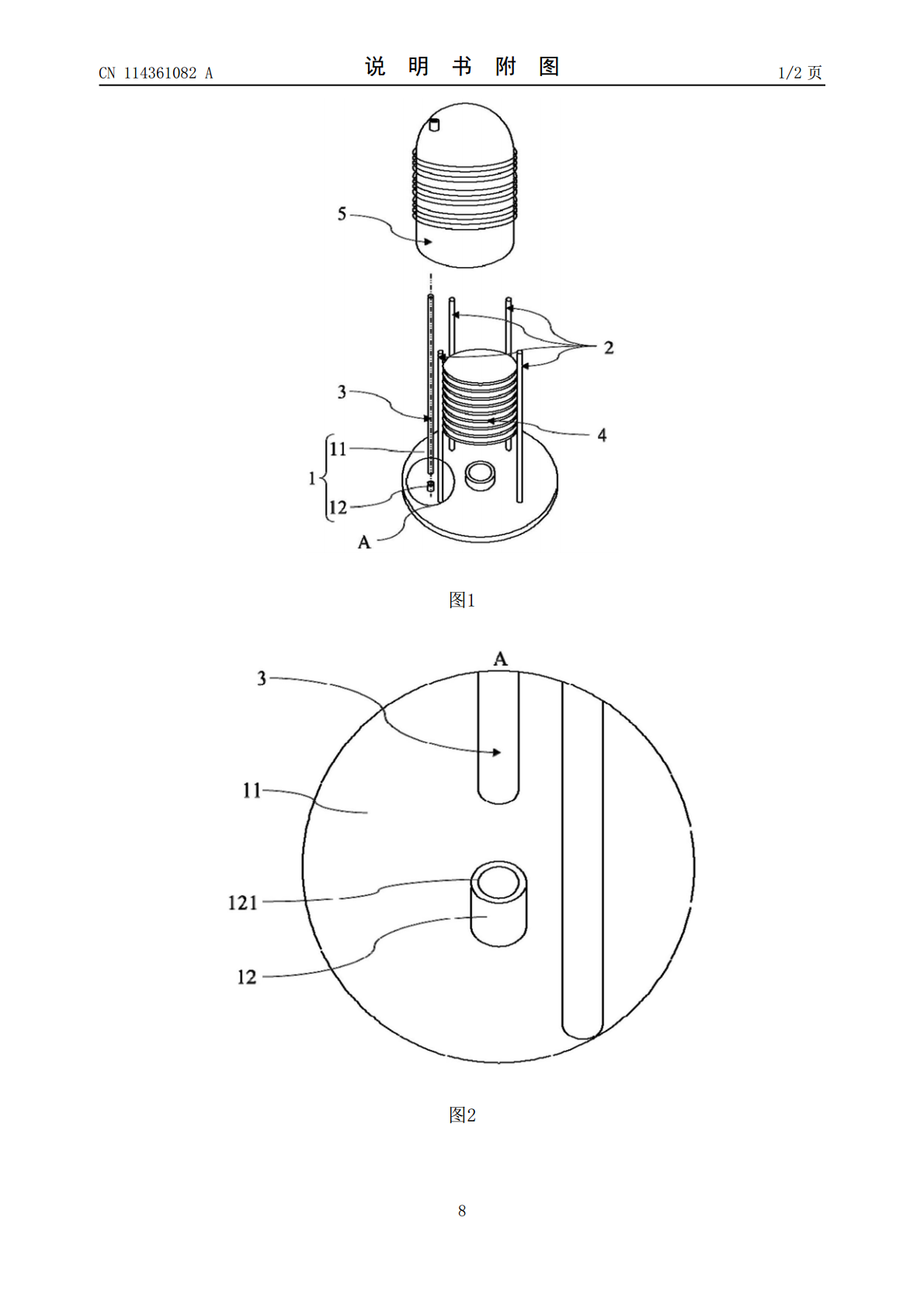
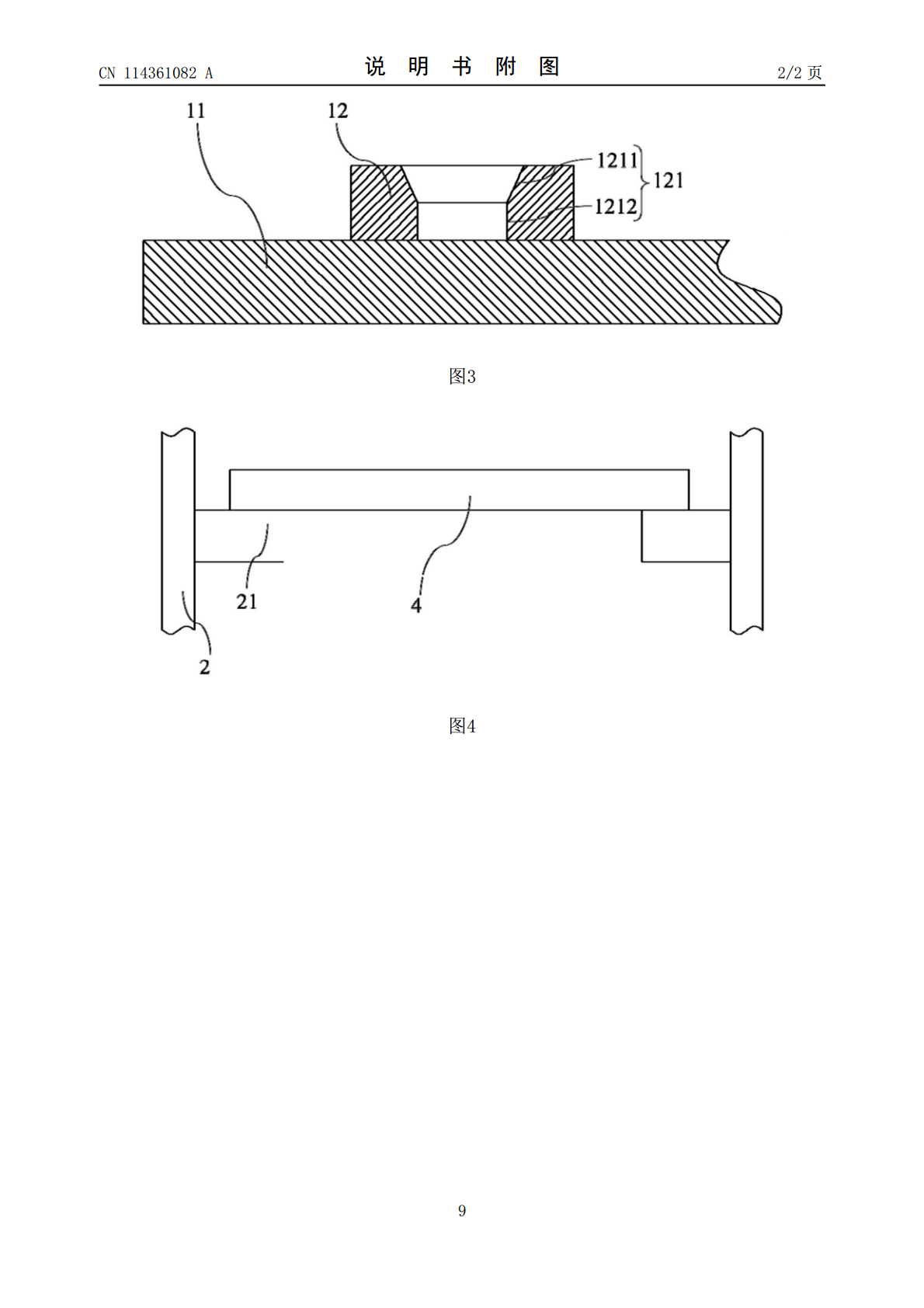
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

晶舟底盘、晶舟和扩散炉.pdf
本申请属于半导体技术领域,具体涉及一种晶舟底盘、晶舟和扩散炉,该晶舟底盘包括本体和固定件,固定件连接在本体朝向晶圆的一侧上,且固定件与本体为一体结构,固定件设置成用于固定热电偶。根据本申请实施例的晶舟底盘,固定件和本体为一体结构,即使热电偶发生倾斜时,固定件相对本体也不会发生相对移动,解决了本体磨损产生粉末的问题,避免粉末对加工工艺的影响,提高了晶圆的加工效果。将固定件设置在本体朝向晶圆的一侧,在进行工艺前的准备工作时,只需要使固定件与热电偶配合即可,加工结束后,将热电偶取走,无需对固定件进行拆装,简化了

晶舟结构和具有其的晶舟组件和扩散炉.pdf
该发明公开了一种晶舟结构和具有其的晶舟组件和扩散炉,晶舟结构包括支撑架,支撑架包括上支撑件和下支撑件,上支撑件与下支撑件之间设有多个支撑杆,支撑杆的两端分别与上支撑件和下支撑件相连,多个支撑杆沿上支撑件的周向间隔开设置且在其中两个相邻支撑杆之间形成有适于晶圆通过的开口;晶圆支撑部,晶圆支撑部设在支撑杆上以承载晶圆,晶圆支撑部包括支撑板和至少一个晶圆插板,支撑板和至少一个晶圆插板承载同一晶圆,支撑板与支撑杆相连且与上支撑件和下支撑件的中心位置处相对应,晶圆插板设在支撑杆的内侧以支撑晶圆的边缘。根据本发明实施

晶圆舟操作装置、立式分批炉和方法.pdf
晶圆舟操作装置,配置成定位在立式分批炉的处理室下方,且包括可旋转台,该可旋转台包括第一和第二晶圆舟支承表面。每个晶圆舟支承表面配置成支承晶圆舟。可旋转台可通过致动器旋转以将第一和第二晶圆支承表面两者旋转至:装载/接收位置,其中,晶圆舟操作装置配置成将晶圆舟从可旋转台竖直地装载到处理室中并且将晶圆舟从处理室接收到可旋转台上;冷却位置,其中,晶圆舟操作装置配置成冷却晶圆舟;以及转移位置,用于将晶圆移至和/或移离晶圆舟。

晶圆舟操作装置、立式分批炉和方法.pdf
晶圆舟操作装置,其配置成定位在立式分批炉的处理室下方。晶圆舟操作装置包括:主壳体,其具有限定并界定晶圆舟操作空间的壁;以及舟运输器,其包括用于支承晶圆舟并配置成将晶圆舟运输至晶圆舟操作空间内的冷却位置的晶圆舟支承件。壁邻近冷却位置的一部分是具有至少0.60的热辐射表面吸收率的壁部分,以便借助热辐射吸收从冷却位置中的晶圆舟吸取热量。

晶圆扩散用的碳化硅陶瓷晶舟开齿设备.pdf
本发明提供一种晶圆扩散用的碳化硅陶瓷晶舟开齿设备,包括:两个互相连接的主板;对称设置的两个限位组件;每个限位组件包括:固定板,固定设置在主板的外侧;横向推板组件驱动推板横向移动;升降组件,架设在主板的内侧;升降组件驱动一个移动块上下移动;两个滑套,分别套设在固定板和推板上;两个滑套的一端通过伸缩杆连接;固定板上的滑套的一侧面与移动块转动连接;调节齿轮,与固定板上的滑套固定连接;固定齿条,竖向固定架设在升降组件下端的一侧;金刚石切割移动台,架设在两个固定板的滑套之间,在碳化硅陶瓷晶舟的切割空间移动。该装置能
