
一种半导体封装用银合金线及其制造方法.pdf

邻家****ng







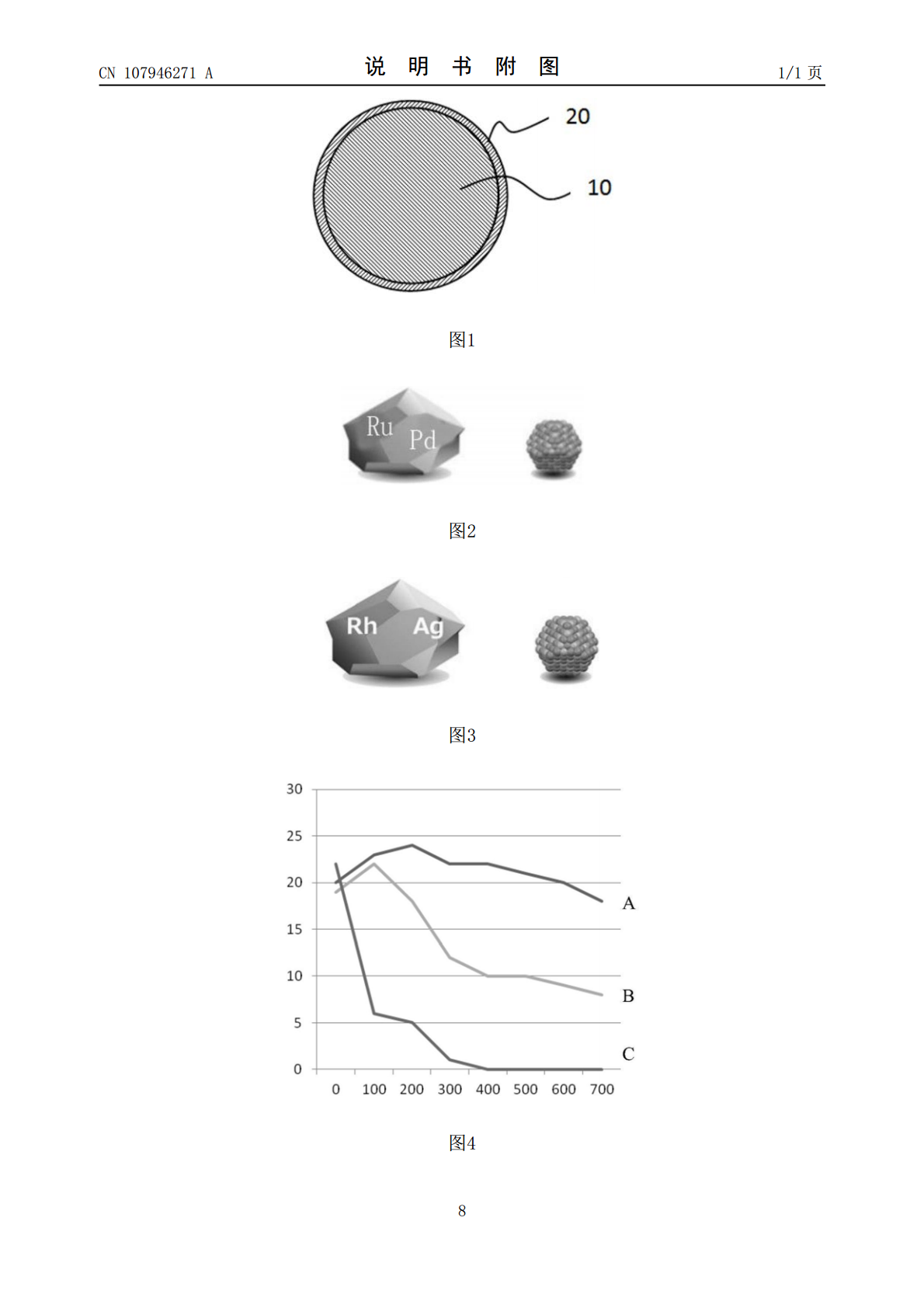
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种半导体封装用银合金线及其制造方法.pdf
本发明提供一种半导体封装用银合金线及其制造方法,银合金线包括:含0‑1%钯的银合金线主体;以及在银合金线主体上涂敷的一层包含纳米钯钌银合金和稳定剂的复合膜。稳定剂优选采用高分子聚乙烯吡咯烷酮,复合膜的厚度在11‑18纳米之间。纳米钯钌银合金中纳米颗粒中的钌、钯、银的原子比为1:1:2,纳米钯钌银合金中钯、钌、银可以采用液体还原法还原钯盐、钌盐和银盐获得,其中含有钯、钌、银的纳米颗粒的大小在2‑15nm之间。本发明提供了一种低电阻率、低硬度、高可靠性的银合金线,能够在高端封装领域取代金线,并降低封装成本。

一种LED封装用银合金线及其制作方法.pdf
本发明公开了一种LED封装用银合金线及其制作方法,LED封装用银合金线包括银合金键合丝、包覆在银合金键合丝外的第一混合层以及包覆在所述第一混合层外的第二混合层,所述第一混合层按重量计钯含量大于50%,其余为高熔点金属;所述第二混合层按重量计高熔点金属含量大于50%,其余为钯。本发明的银合金线由于高熔点金属在钯中有一定的溶解性,而正是这种溶解使得钯在烧球过程中向银球内扩散的过程受到了制约,从而促使钯和高熔点金属都均匀地分布于自由空气球的表面。另一方面,由于钯和高熔点金属的密度都高于银,所以使得钯和高熔点金属

一种LED封装用银合金键合丝及其制造方法.pdf
一种LED封装用银合金键合丝,其特征在于按重量计含有2-3.5%的第一添加成分,10-30ppm的第二添加成分,余量为银;第一添加成分为钯,第二添加成分为金、铂、钙、镁和铁中的一种或其中多种的组合。本发明还提供上述LED封装用银合金键合丝的制造方法,包括下述步骤:(1)熔铸获得线材;(2)拉丝:对线材进行拉丝,获得直径为18-50um的银合金键合丝;在拉丝过程中,在拉丝至直径为0.9100-0.0384mm时进行对线材进行中间退火;(3)最后退火:拉丝完成后,对银合金键合丝进行最后退火,冷却后得到LED封

半导体装置封装及其制造方法.pdf
一种半导体装置封装包含再分布层RDL、半导体装置、收发器,以及电容器。所述RDL具有第一表面和与所述第一表面相对的第二表面。所述半导体装置安置在所述RDL的所述第一表面上。所述收发器安置在所述RDL的所述第二表面上。所述电容器安置在所述RDL的所述第二表面上。所述半导体装置具有第一投影面积并且所述电容具有第二投影面积。所述第一投影面积与所述第二投影面积重叠。

半导体封装结构及其制造方法.pdf
本发明涉及半导体封装技术领域,提供了一种半导体封装结构及其制造方法,该封装结构包括:载体和多个引脚;半导体芯片,半导体芯片的背面通过粘接剂固定贴装在载体的上表面,半导体芯片的正面设置有多个焊垫;键合引线,用于电性连接多个焊垫和多个引脚;封装胶体,用于包覆载体、多个引脚、半导体芯片和键合引线,其中,半导体芯片的背面设置有厚度均匀的支撑结构,支撑结构的底面与载体的上表面接触,使得所述半导体芯片的背面在通过粘接剂固定贴装在载体的上表面时,半导体芯片的背面与载体的上表面平行。通过调整支撑结构的厚度可以保证芯片与载
