
半导体封装结构及其制造方法.pdf

骊英****bb








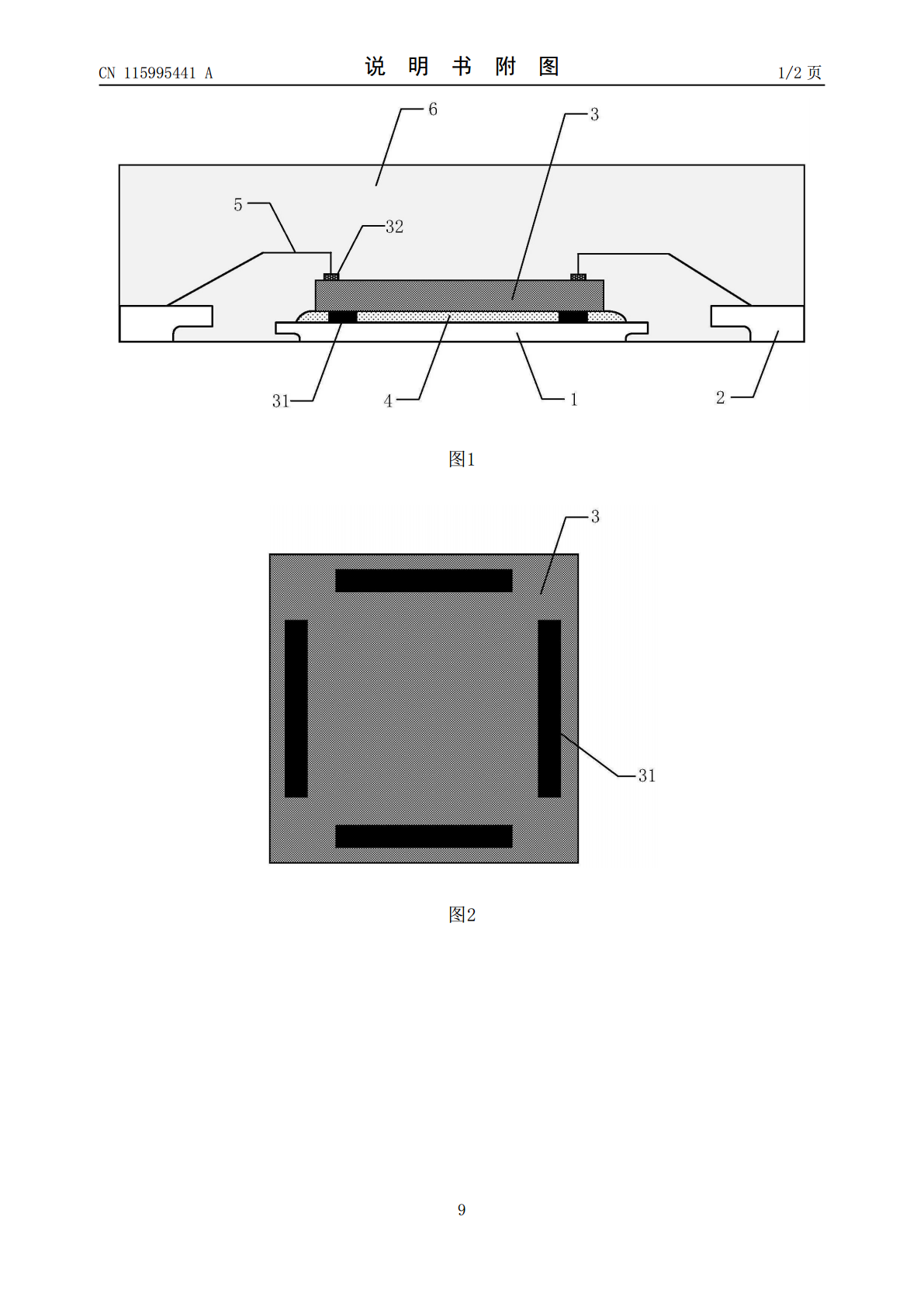
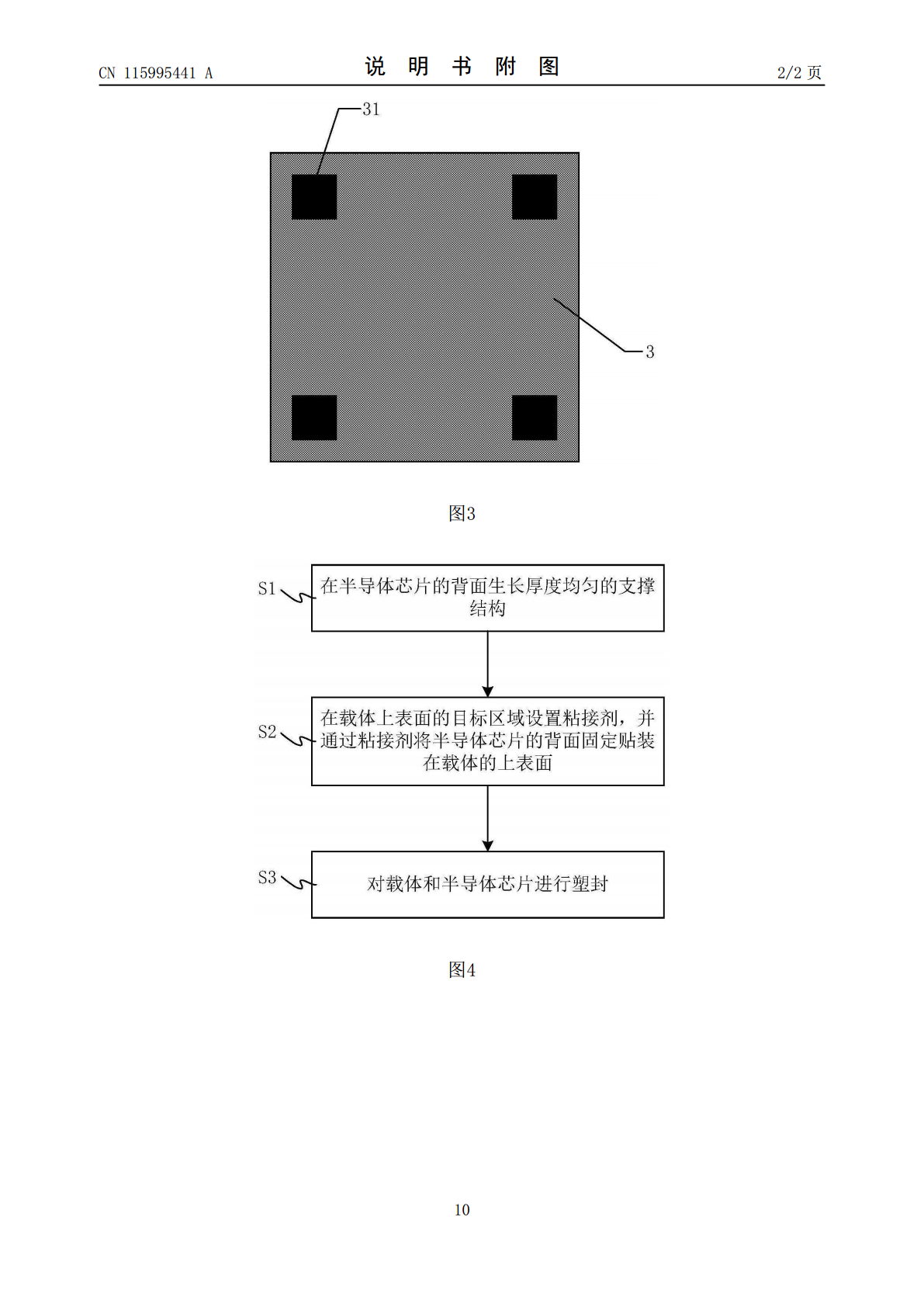
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

半导体封装结构及其制造方法.pdf
本发明涉及半导体封装技术领域,提供了一种半导体封装结构及其制造方法,该制造方法包括:提供基板;将半导体芯片设置于基板上并与基板电性连接;将散热翅片固定在半导体芯片背离基板的背面上;基板、半导体芯片和散热翅片进行塑封,形成半导体封装结构。本发明能够提高散热翅片与半导体芯片以及与塑封料之间的固定效果,使得散热翅片更加不易脱落,在能够提高封装结构的散热性能的情况下,通用性和可靠性更强。

半导体封装结构及其制造方法.pdf
本发明涉及半导体封装技术领域,提供了一种半导体封装结构及其制造方法,该半导体封装结构包括:框架,具有基岛及多个引脚;多个半导体芯片,上表面设有多个焊盘;多个引线,电性连接多个焊盘与多个引脚;封装胶体,包覆框架、多个半导体芯片和多个引线,其中,基岛上设置有多个具有不同高度的承载平台,多个半导体芯片分别设置在多个承载平台上,且至少部分半导体芯片的上表面之间具有大于等于预定高度的高度差。本发明能够在进行引线键合时错开打线并降低线弧高度,减小了不同引线之间以及引线与焊垫之间的短路风险和线弧过高、不稳定导致的引线脱

半导体封装结构及其制造方法.pdf
本公开提供的半导体封装结构及其制造方法,利用柔性线路板(FlexiblePrintedCircuit,FPC)可绕折的特点,将低介电常数/介电损耗(lowdk/df)的载体作为支撑件,使FPC的接地反射导体绕折至FPC的辐射导体的相对面,支撑件的厚度即为共振腔高度,由此天线导体之间的共振距离可以不受制程能力的限制。同时由于AiP/AiM整体结构为FPC‑支撑件‑FPC,所以整体的热膨胀系数(CoefficientofThermalExpansion,CTE)较为平衡。

半导体封装结构及其制造方法.pdf
本发明涉及半导体封装技术领域,提供了一种半导体封装结构及其制造方法,该封装结构包括:载体和多个引脚;半导体芯片,半导体芯片的背面通过粘接剂固定贴装在载体的上表面,半导体芯片的正面设置有多个焊垫;键合引线,用于电性连接多个焊垫和多个引脚;封装胶体,用于包覆载体、多个引脚、半导体芯片和键合引线,其中,半导体芯片的背面设置有厚度均匀的支撑结构,支撑结构的底面与载体的上表面接触,使得所述半导体芯片的背面在通过粘接剂固定贴装在载体的上表面时,半导体芯片的背面与载体的上表面平行。通过调整支撑结构的厚度可以保证芯片与载

封装框架、半导体封装结构及其制造方法.pdf
本发明涉及芯片封装技术领域,提供了一种封装框架、半导体封装结构及其制造方法,该封装框架包括:多个管脚,每个管脚的第一表面上设置有至少一个焊接点;至少一个贯穿槽,设置于所述多个管脚中的目标管脚的第一表面,并贯穿所述目标管脚的第一表面,所述目标管脚对应所述多个管脚中长度大于预设值的管脚。本发明能够有效的缓解封装框架与半导体芯片之间的焊锡在温度循环的过程中受到的局部热应力,有利于提高封装结构的可靠性。
