
一种半导体封装结构及封装方法.pdf

是笛****加盟







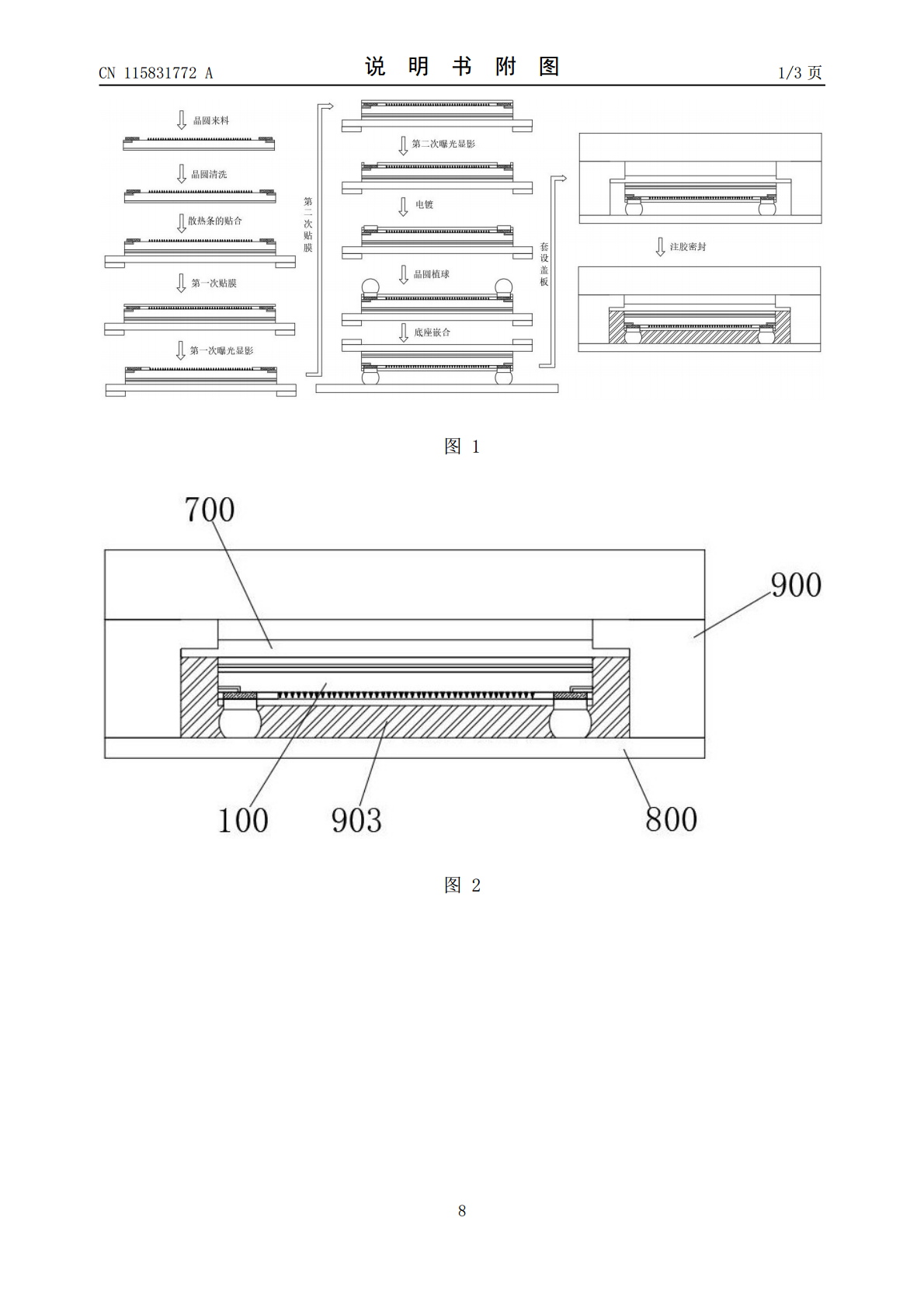
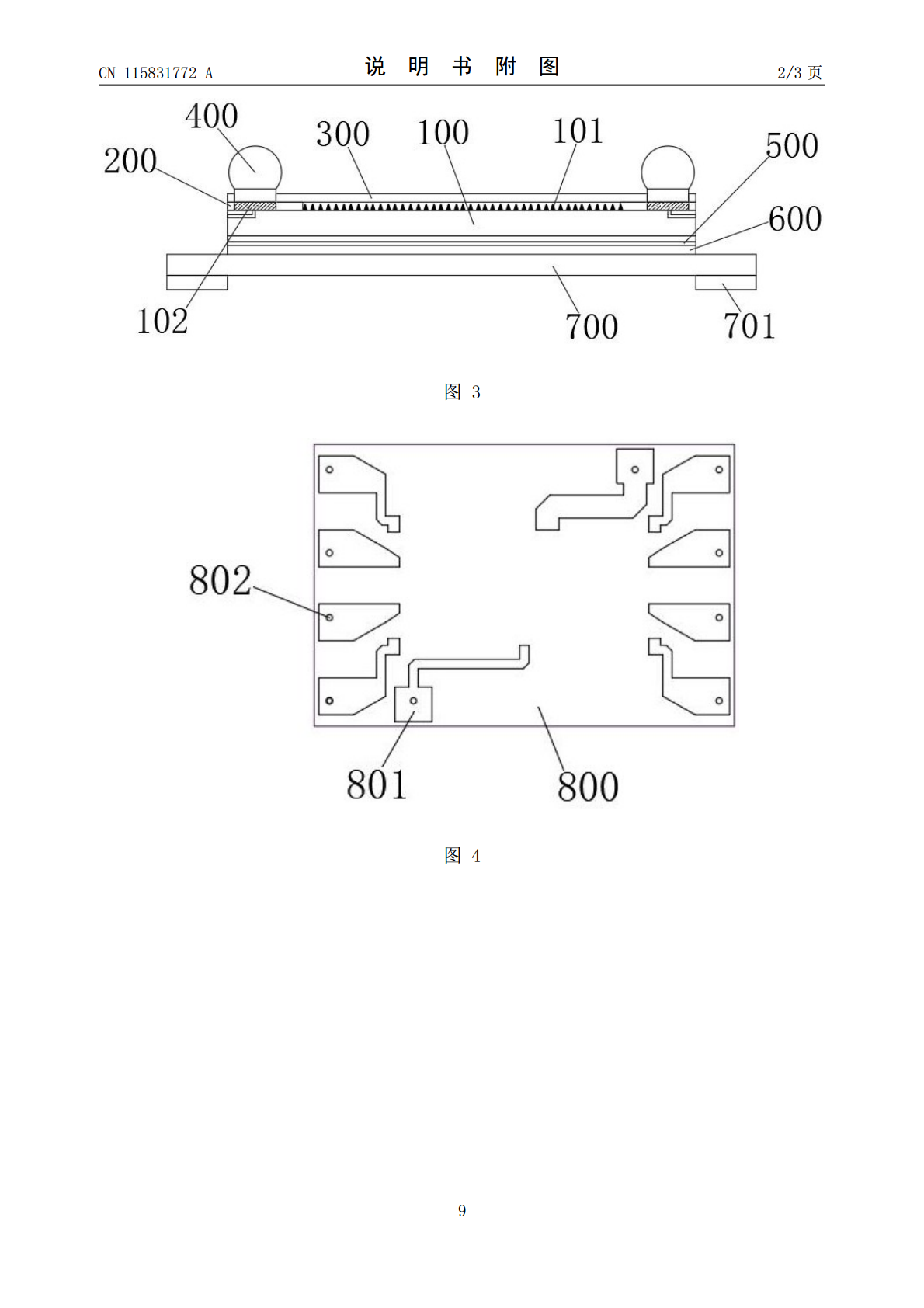
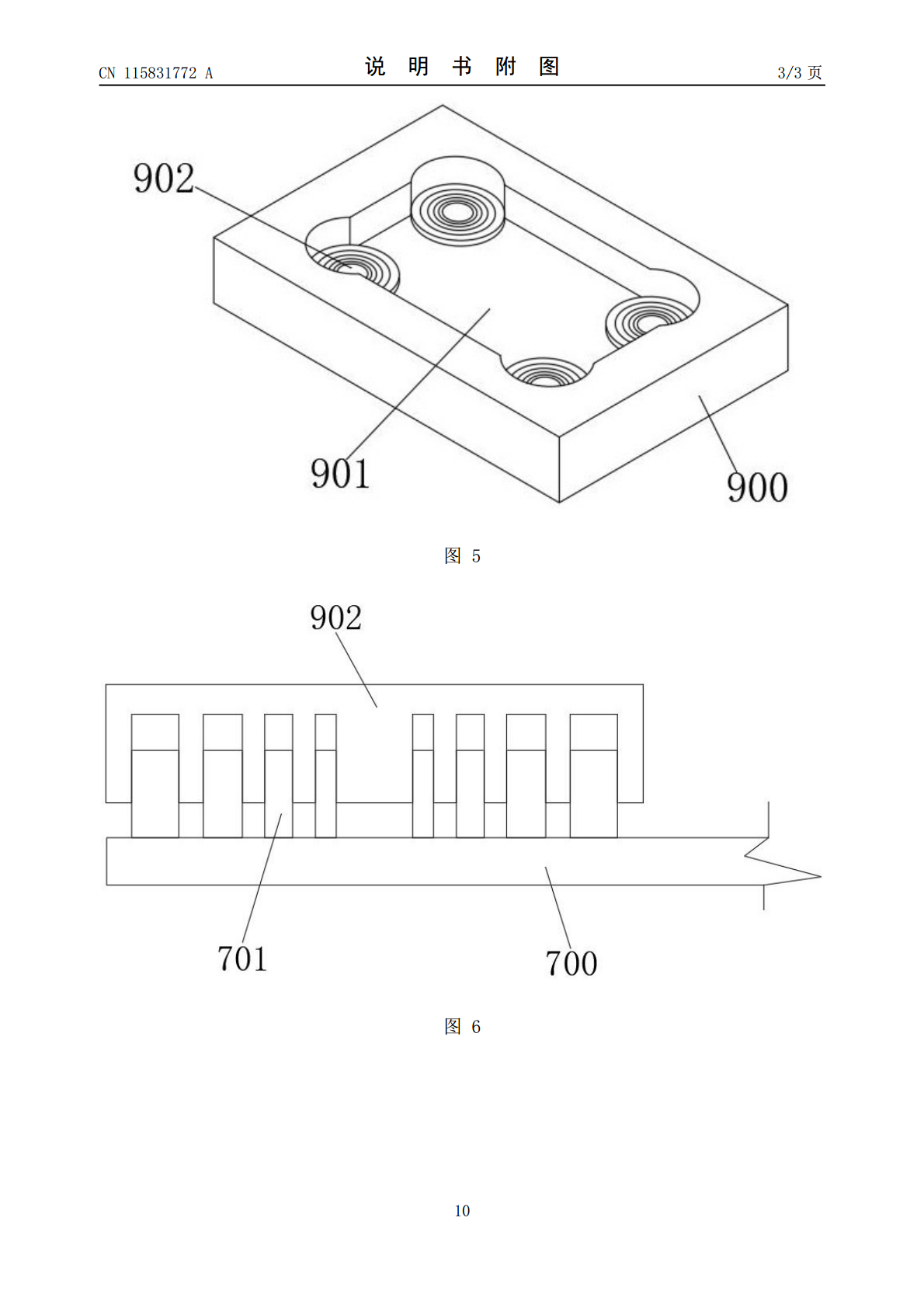
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

半导体封装结构及半导体封装结构的封装方法.pdf
本发明公开了一种半导体封装结构及半导体封装结构的封装方法,该封装结构包括导线架、单层基板、金属线路层以及半导体组件。所述导线架包括主体部、多个接垫以及未接触区域的补强区。所述单层基板位于所述导线架上且部分填入所述补强区内,所述单层基板设有第一通孔及第二通孔,所述第一通孔内形成第一导电柱且电连接所述主体部,所述第二通孔内形成第二导电柱且电连接所述接垫。所述金属线路层分布于所述单层基板表面上且与对应的所述第一及第二导电柱电连接。所述半导体组件设有焊接部,所述半导体组件由所述焊接部电连接于所述金属线路层上。

一种半导体的封装方法及封装结构.pdf
本发明属于半导体制造技术领域,具体公开了一种半导体的封装方法及封装结构。包括以下步骤:在基底上开设若干盲孔和若干通孔;在基底底面贴装若干无源器件和若干第二芯片;在基底顶面上贴装若干第一芯片、SAW滤波器和若干无源器件,在每个SAW滤波器下方都安装一个IDT功能区域;在顶面上方包裹一层光敏感材料膜,使每个SAW滤波器底部形成空腔结构;去除顶面通孔上的光敏感材料膜使通孔重新外露;采用塑封工艺处理基底,塑封完成后,去除固定盖,转序切割成单颗产品;在每个单颗产品的顶面进行金属镀膜形成金属镀层。本发明通过在基底顶面

一种半导体封装结构及封装方法.pdf
本发明公开了一种半导体封装结构及封装方法,涉及半导体封装技术领域,用于解决盖板与氮化铝陶瓷散热片闭合后填充的环氧树脂在潮湿环境下,吸收空气中的水汽,而器件受热后水汽的蒸发,造成芯片与基板局部产生裂纹或者分层问题,包括芯片本体、盖板和氮化铝陶瓷散热片;本发明中利于芯片本体上部分未能从氮化铝陶瓷散热片上排出的热量通过散热板排至盖板上,提高整个芯片的整体散热效果,同时散热板上的安装的散热环与盖板上的安装的散热层相互卡接,提高整个散热板的散热面积,同时留有一定缓冲空间,避免潮湿环境下环氧树脂吸收空气中的水汽受热蒸

半导体封装结构的制造方法及半导体封装结构.pdf
本发明涉及芯片封装技术领域,提供了一种半导体封装结构的制造方法及半导体封装结构,该方法包括:在晶圆的上表面形成钝化层,并在钝化层上进行开窗,以露出晶圆中每个晶片表面的多个电极;在钝化层的上表面形成交替堆叠的重新布线层和绝缘层,重新布线层位于晶圆的晶片区域内,并通过开窗与多个电极电连接;在顶层的绝缘层上形成开口,以露出重新布线层的部分表面;在开口内的重新布线层表面形成可焊层,以形成每个晶片的外漏引脚;对晶圆进行切割划片,获得多个封装结构芯片。通过使用绝缘层和重新布线层取代传统封装的塑封料和引线框架,可以有效

半导体封装结构形成方法及半导体封装结构.pdf
本申请涉及半导体器件制造技术领域,特别是涉及半导体封装结构形成方法及半导体封装结构,其中,该形成方法包括:连接层形成步骤,提供氧化物层,所述氧化物层上形成有连接层,所述氧化物层包括对准标记、测量标记及金属块;标记初对准步骤,图案化所述连接层,在所述连接层中形成所述第一初对准凹槽、第二初对准凹槽;连接凹槽形成步骤,利用所述对准标记、测量标记进行套准后,图案化所述连接层,在所述连接层中形成所述连接凹槽,露出所述金属块。通过本申请,实现了减小对准标记、测量标记上方连接层的厚度,提高对准标记、测量标记的对比度。
