 预览加载中,请您耐心等待几秒...
预览加载中,请您耐心等待几秒...

1/8

2/8

3/8

4/8

5/8

6/8
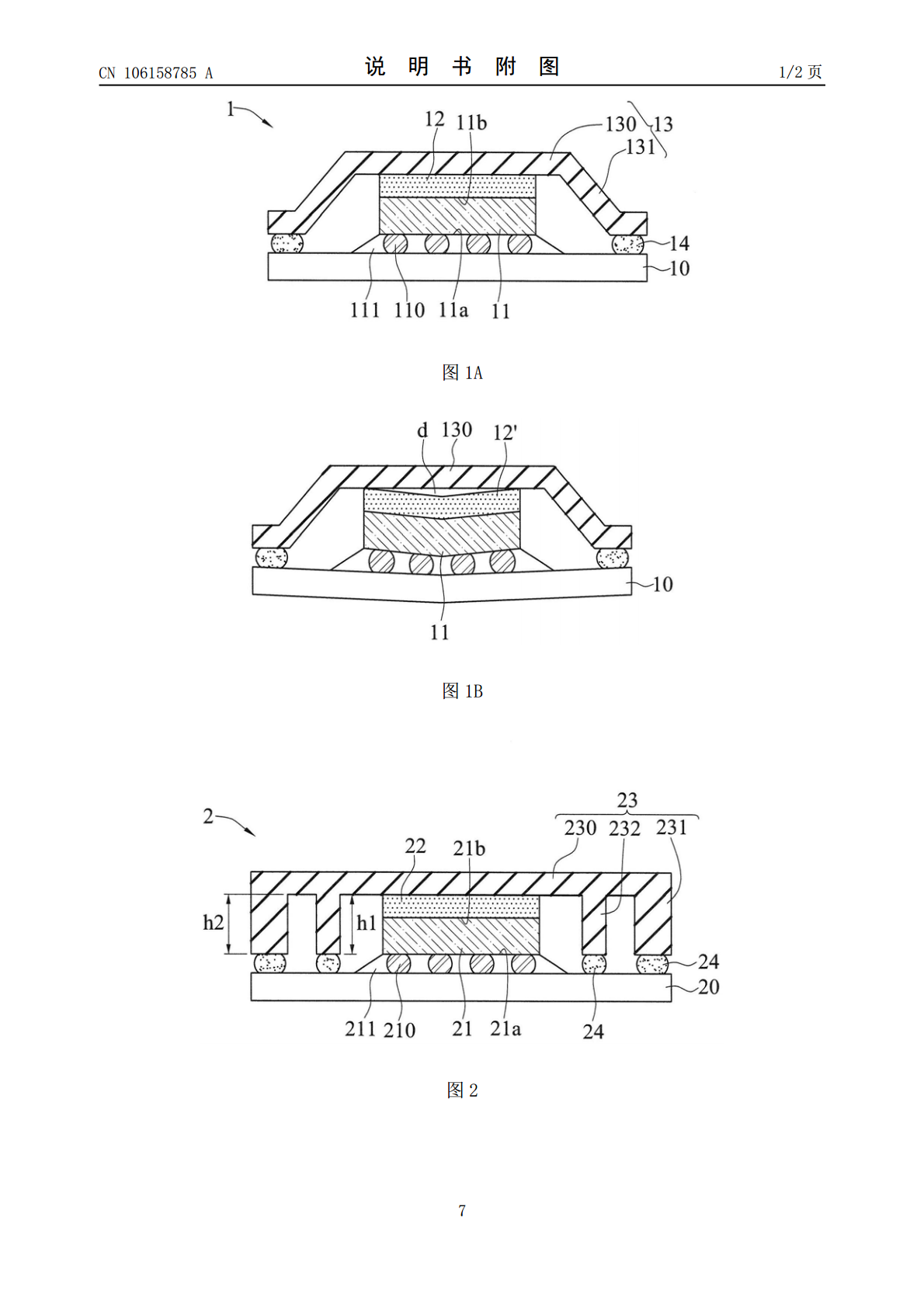
7/8
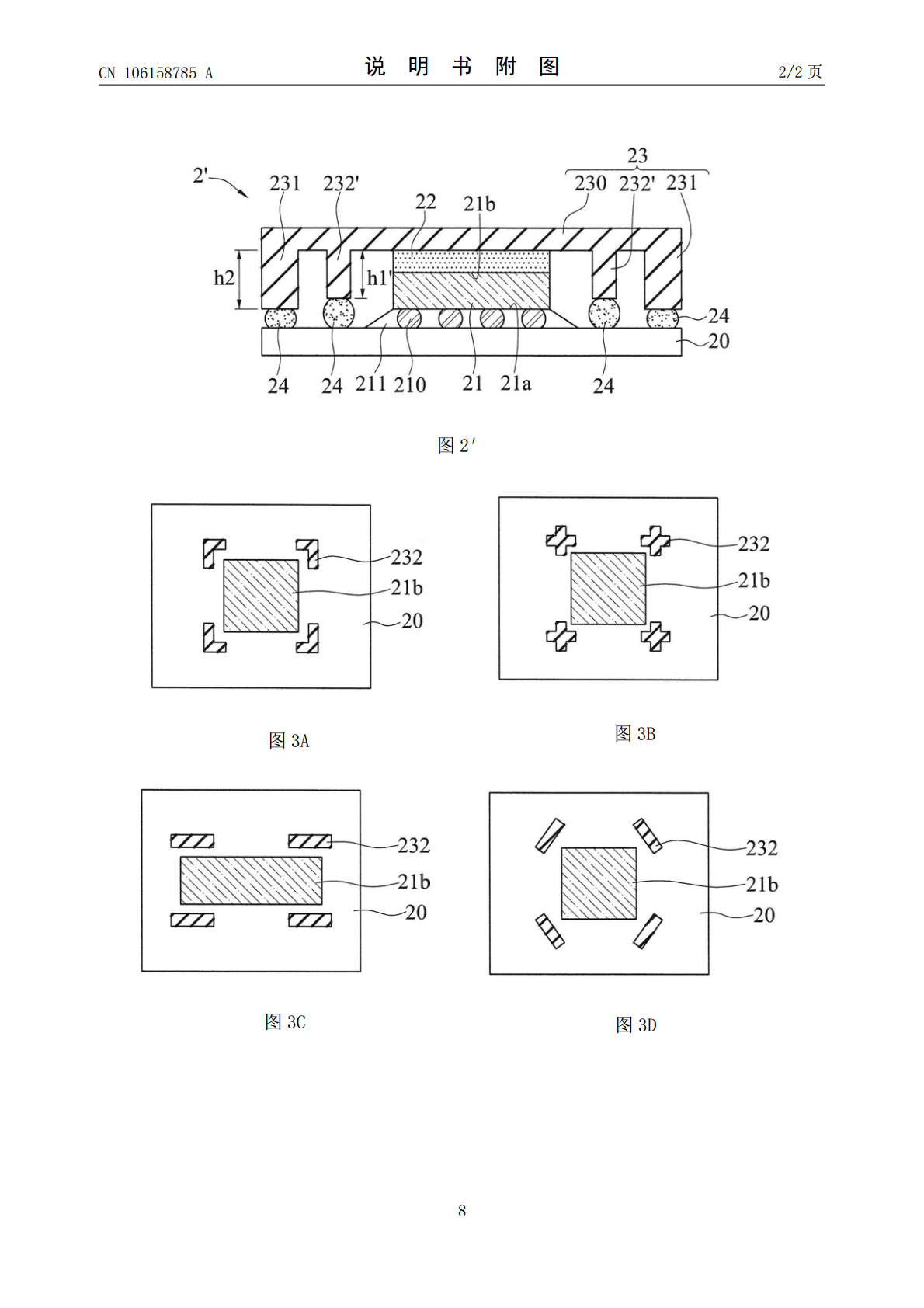
8/8
在线预览结束,喜欢就下载吧,查找使用更方便
如果您无法下载资料,请参考说明:
1、部分资料下载需要金币,请确保您的账户上有足够的金币
2、已购买过的文档,再次下载不重复扣费
3、资料包下载后请先用软件解压,在使用对应软件打开
(19)中华人民共和国国家知识产权局(12)发明专利申请(10)申请公布号CN106158785A(43)申请公布日2016.11.23(21)申请号201510156193.4(22)申请日2015.04.03(30)优先权数据1041089232015.03.20TW(71)申请人矽品精密工业股份有限公司地址中国台湾台中市(72)发明人姚进财杨志仁黄富堂(74)专利代理机构北京戈程知识产权代理有限公司11314代理人程伟王锦阳(51)Int.Cl.H01L23/367(2006.01)权利要求书1页说明书4页附图2页(54)发明名称散热型封装结构及其散热件(57)摘要一种散热型封装结构及其散热件,该散热型封装结构包括:承载件、设于该承载件上的电子元件、以结合层设于该电子元件上的散热件,该散热件具有支撑脚与支架,该支撑脚与该支架结合于该承载件上,且该支架位于该电子元件与该支撑脚之间,以提供支撑力而避免封装结构发生过大的翘曲。CN106158785ACN106158785A权利要求书1/1页1.一种散热型封装结构,其特征为,该封装结构包括:承载件;电子元件,其设于该承载件上;结合层,其设于该电子元件上;以及散热件,其设于该结合层上,且该散热件具有散热体、设于该散热体上的支撑脚与设于该散热体上的至少一支架,该散热体接触该结合层,且该支撑脚与该支架结合于该承载件上,又该支架位于该电子元件与该支撑脚之间。2.如权利要求1所述的散热型封装结构,其特征为,该承载件为封装基板或导线架。3.如权利要求1所述的散热型封装结构,其特征为,该电子元件为主动元件、被动元件、封装元件或其三者的组合。4.如权利要求1所述的散热型封装结构,其特征为,该结合层为导热介面材或导热胶。5.如权利要求1所述的散热型封装结构,其特征为,该散热体为散热片。6.如权利要求1所述的散热型封装结构,其特征为,该支架邻近于该电子元件的角落处。7.如权利要求1所述的散热型封装结构,其特征为,该支架的高度与该支撑脚的高度相同或不相同。8.如权利要求1所述的散热型封装结构,其特征为,该支架为一体成型于该散热体上。9.如权利要求1所述的散热型封装结构,其特征为,该支架粘贴于该散热体上。10.如权利要求1所述的散热型封装结构,其特征为,该支架的材质不同于该散热体的材质。11.如权利要求1所述的散热型封装结构,其特征为,该支架的材质为不导热材料。12.如权利要求1所述的散热型封装结构,其特征为,该支架为L形柱体。13.一种散热件,其特征为,该散热件包括:散热体;支撑脚,其设于该散热体上;以及至少一支架,其设于该散热体上,且该支架较该支撑脚邻近该散热体中央处。14.如权利要求13所述的散热件,其特征为,该散热体为散热片。15.如权利要求13所述的散热件,其特征为,该支架的高度与该支撑脚的高度相同或不相同。16.如权利要求13所述的散热件,其特征为,该支架为一体成型于该散热体上。17.如权利要求13所述的散热件,其特征为,该支架粘贴于该散热体上。18.如权利要求13所述的散热件,其特征为,该支架的材质不同于该散热体的材质。19.如权利要求13所述的散热件,其特征为,该支架的材质为不导热材料。20.如权利要求13所述的散热件,其特征为,该支架为L形柱体。2CN106158785A说明书1/4页散热型封装结构及其散热件技术领域[0001]本发明涉及一种封装结构,尤指一种散热型封装结构及其散热件。背景技术[0002]随着电子产品在功能及处理速度的需求的提升,作为电子产品的核心组件的半导体晶片需具有更高密度的电子元件(ElectronicComponents)及电子电路(ElectronicCircuits),故半导体晶片在运作时将随之产生更大量的热能,且包覆该半导体晶片的封装胶体为一种导热系数仅0.8Wm-1k-1的不良传热材质(即热量的逸散效率不佳),因而若不能有效逸散所产生的热量,则会造成半导体晶片的损害或造成产品信赖性问题。[0003]因此,为了迅速将热能散逸至大气中,通常在半导体封装结构中配置散热片(HeatSink或HeatSpreader),且传统散热片藉由散热胶结合至晶片背面,以藉散热胶与散热片逸散出半导体晶片所产生的热量,通常以散热片的顶面外露出封装胶体或直接外露于大气中为佳,以取得较佳的散热效果。[0004]然而,散热胶已不符合制程需求,故遂发展出导热介面材(ThermalInterfaceMaterial,简称TIM)制程。[0005]现有TIM层为低温熔融的热传导材料(如焊锡材料),其设于半导体晶片背面与散热片之间,而为了提升TIM层与晶片背面之间的接着强度,需于晶片背面上覆金(即所谓的CoatingGoldOnChipBack),且需使用助焊剂(flux),以利于该TIM