
一种散热型芯片级LED封装方法及其封装结构.pdf

青团****青吖






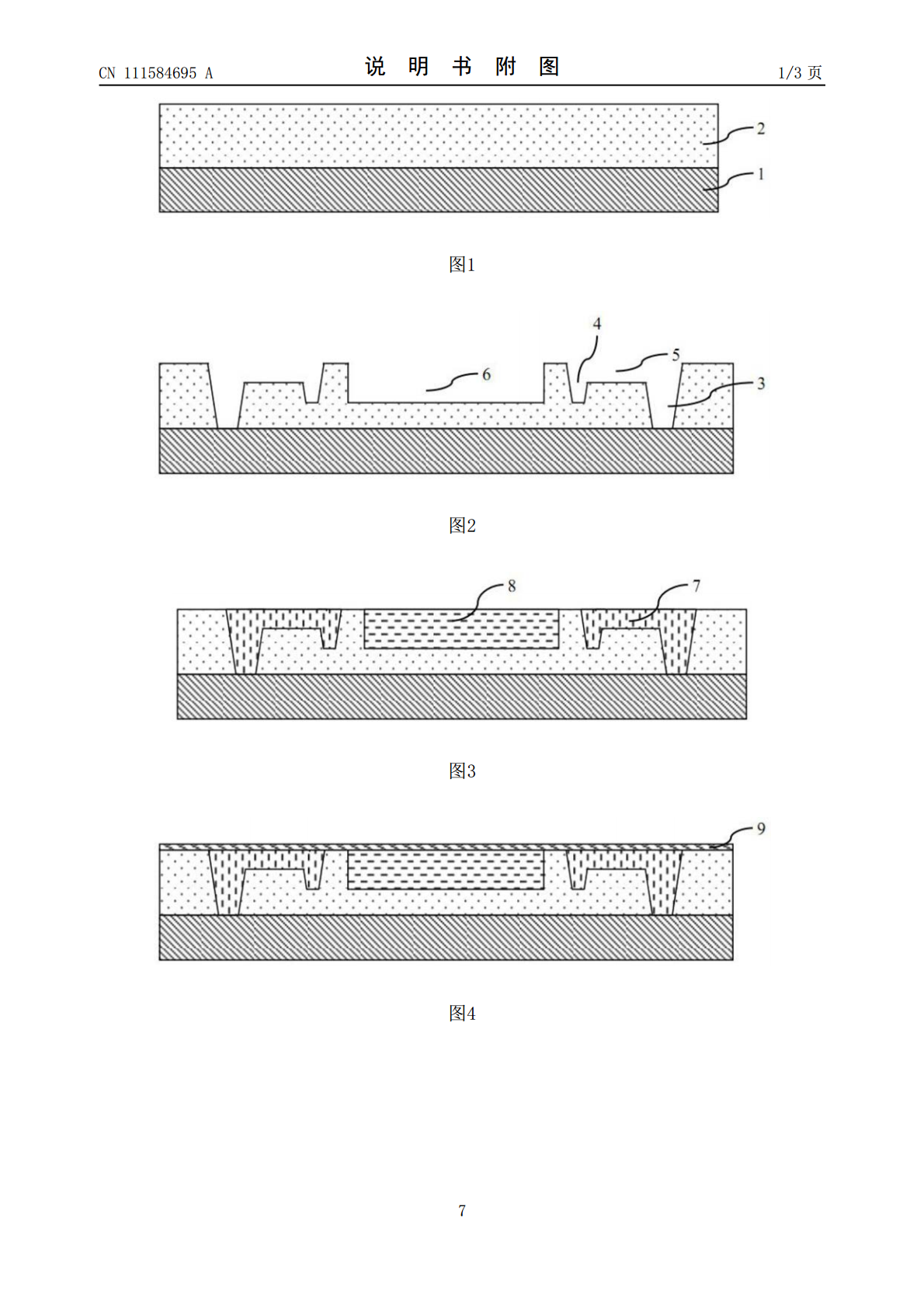


在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种散热型芯片级LED封装方法及其封装结构.pdf
本发明提供了一种散热型芯片级LED封装方法及其封装结构,其在所述聚合物层中设置通孔、盲孔、沟槽和凹陷,并填充导热和导电的软化材料形成布线层和散热结构;并利用LED芯片上的两个导电插针和多个导热插针对应插入所述盲孔和凹陷,实现电连接和热连接,能够有效的提高散热和防止电接触的不良现象。

一种散热型芯片级LED封装方法及其封装结构.pdf
本发明提供了一种散热型芯片级LED封装方法及其封装结构,其在所述聚合物层中设置通孔、盲孔、沟槽和凹陷,并填充导热和导电的软化材料形成布线层和散热结构;并利用LED芯片上的两个导电插针和多个导热插针对应插入所述盲孔和凹陷,实现电连接和热连接,能够有效的提高散热和防止电接触的不良现象。

LED封装结构及其封装方法.pdf
本发明涉及公开了一种LED封装结构及其封装方法,为解决现有LED封装中仅靠底面吃锡的问题,本发明中,在向通孔(1)内装填填充物(6)时,并不装填满通孔(1),而是在通孔(1)内自引脚(5)下表面起保留一段未装填填充物(6)的空孔结构;在切割形成单个LED灯珠之后,两侧镀铜层的下部是裸露状态,这部分镀铜层与下表面的引脚连通,可形成“L”型的LED引脚,从而在后续使用中焊接时可以靠底面和侧面共同吃锡,与现有技术中仅靠底面吃锡的结构相比,增加了侧面的吃锡面积,从而可降低虚焊率。

一种LED封装结构及其封装方法.pdf
本发明涉及一种LED封装结构及其封装方法;LED封装结构,包括上表面设有固焊功能区和LED芯片、下表面固设有引脚的PCB基板;固焊功能区与引脚电性连接;LED芯片与固焊功能区电性连接;PCB基板包括两层重叠固定联接在一起的板材;下板材上设有第一通孔,且厚度与预留的上锡高度相同;第一通孔的内表面设有金属层;引脚与该金属层电性连接;上板材上设有第二通孔;第二通孔内装填满导电金属;固焊功能区与第二通孔内的导电金属电性连接;第二通孔内的导电金属与第一通孔的内表面的金属层电性连接。本结构,增大了焊接时的吃锡面积,提

一种LED封装结构及其封装方法.pdf
本发明提供了一种LED封装结构及其封装方法,本发明的密封树脂直接从所述LED芯片的背光面进行密封所述LED芯片和焊球,使得LED芯片底部也被密封树脂完全填充,不会留有空隙,并且利用弹性围坝的弹性,使得焊球的高度变大,焊球的纵宽比变大。本发明的制造方法简单易行,成本也较低。
