
原子层沉积设备.pdf

小新****ou








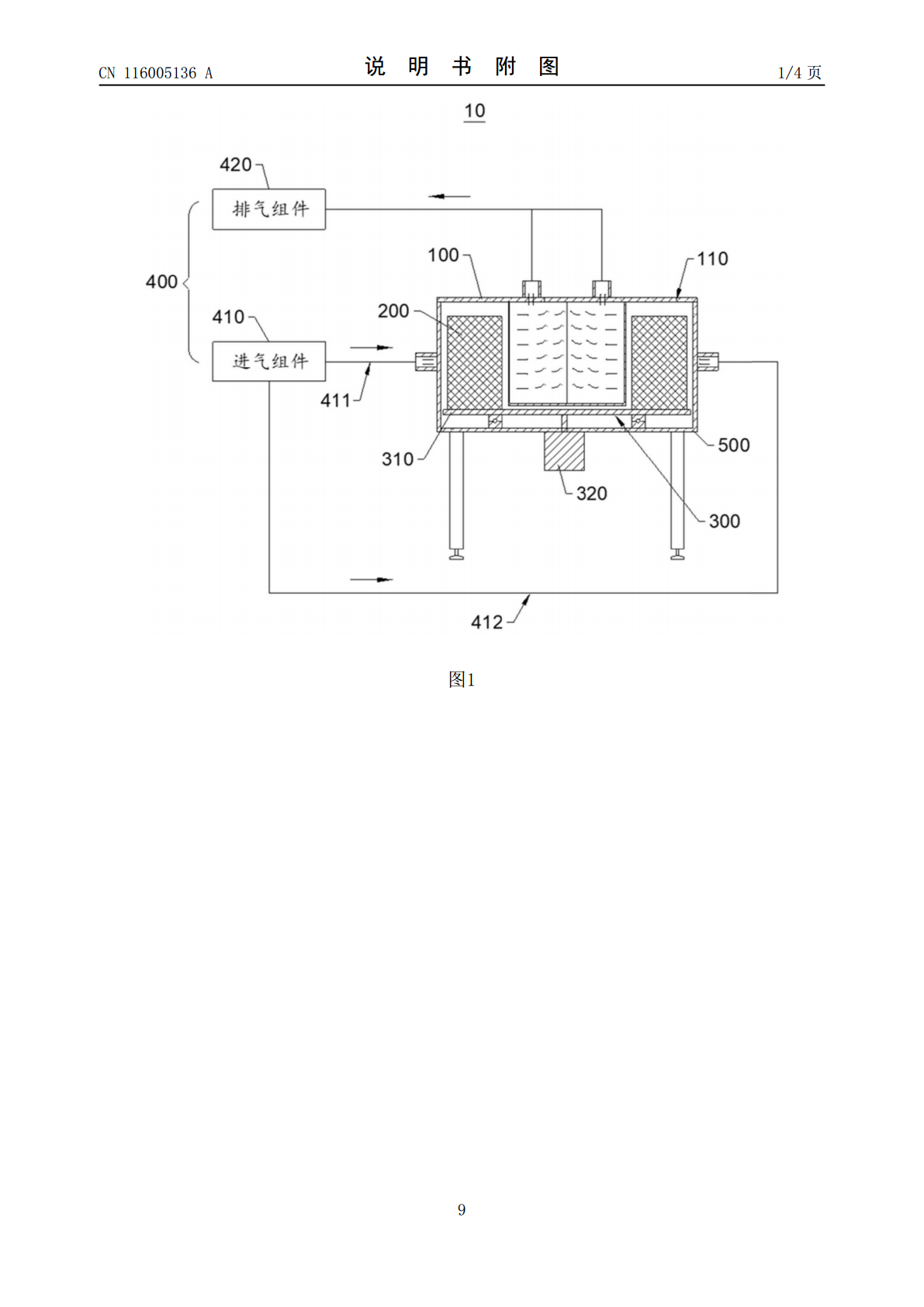

亲,该文档总共12页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

原子层沉积设备.pdf
本发明涉及原子层沉积设备技术领域,涉及一种原子层沉积设备,其包括反应室、基片架、承载装置和供气装置;承载装置包括承载件和旋转组件,承载件可转动地容置于反应腔内,基片架设于承载件上,旋转组件分别连接于反应室和承载件并用于驱动承载件旋转;供气装置包括进气组件和排气组件,进气组件和排气组件分别连通于反应腔,且进气组件用于朝向基片架输送反应气体,排气组件用于排出反应腔内的尾气。在本实施例的原子层沉积设备中,通过设置承载装置和供气装置配合,可以在一次加工过程中驱使基片架与多种不同的反应物接触反应,并且无需再经历冲洗

用于原子层沉积的设备.pdf
本发明的实施例提供了用于例如等离子体增强ALD(PE-ALD)的原子层沉积(ALD)的设备。在一个实施例中,提供了莲喷头组件,其包括莲喷头板,该莲喷头板具有上表面、下表面、从莲喷头板的中心向外边缘延伸的半径,与上表面和下表面流体相通的第一多个孔和与上表面和下表面流体相通的第二多个孔,第一多个孔位于第一区域内,第一区域从莲喷头板的中心延伸到莲喷头板的半径的约25%,并且每个孔具有小于0.1英寸的直径,第二多个孔位于第二区域内,第二区域从莲喷头板的半径的约25%延伸到大约莲喷头板的外边缘,并且每个孔具有大于0

用于原子层沉积的设备.pdf
本发明公开了用于将材料原子层沉积在移动基底上的设备,所述设备包括用于沿着预定的平面或弯曲行进路径移动基底的传输装置和具有至少一个前体递送通道的涂覆杆。所述前体递送通道将包含待沉积在基底上材料的流体朝向行进路径引导。在使用时,可沿着行进路径移动的基底限定所述前体递送通道的出口端与所述基底之间的间隙。所述间隙限定对于来自前体递送通道的流体流的阻抗Zg。在前体递送通道内部设置了限流器,其表现出对于通过穿过它的流的预定阻抗Zfc。所述限流器的尺寸被设置成使得所述阻抗Zfc为所述阻抗Zg的至少五(5)倍,并且更优选

一种原子层沉积设备和原子层沉积设备的定量输气装置.pdf
本实用新型提供了一种原子层沉积设备和原子层沉积设备的定量输气装置,涉及原子层沉积技术领域。其中,这种定量输气装置,包含用以连通原子层沉积设备的工艺腔室的出气管、分别出气管的至少两个定量进气组件,以及接合于出气管的不定量进气组件。定量进气组件包括定量腔室、用以连通源瓶的第一进气管、用以连通定量腔室和第一出气管的第一阀门,以及用以连通出气管和第一进气管的第二阀门。不定量进气组件包括用以连接气源的第二进气管,以及用以连通出气管和第二进气管的第三阀门。通过定量输气装置,能够有效的控制每次向反应腔室输送的气体的体积

原子层沉积方法及炉管设备.pdf
本发明提供一种原子层沉积方法及炉管设备,其中一种原子层沉积方法包括步骤S1至步骤S6共六个步骤,本发明一方面通过改进炉管设备中真空泵系统,另一方面通过原子层沉积方法的控制,使得原子层沉积的两种反应气体分别从不同的真空泵通过,致使真空泵内沉积薄膜大幅减少,降低了真空泵中的累积膜厚,提高真空泵的寿命,可以提高真空泵寿命达到两倍或两倍以上。
