
非晶硅的应用、晶圆上芯片的形成方法及晶圆上芯片.pdf

猫巷****盟主









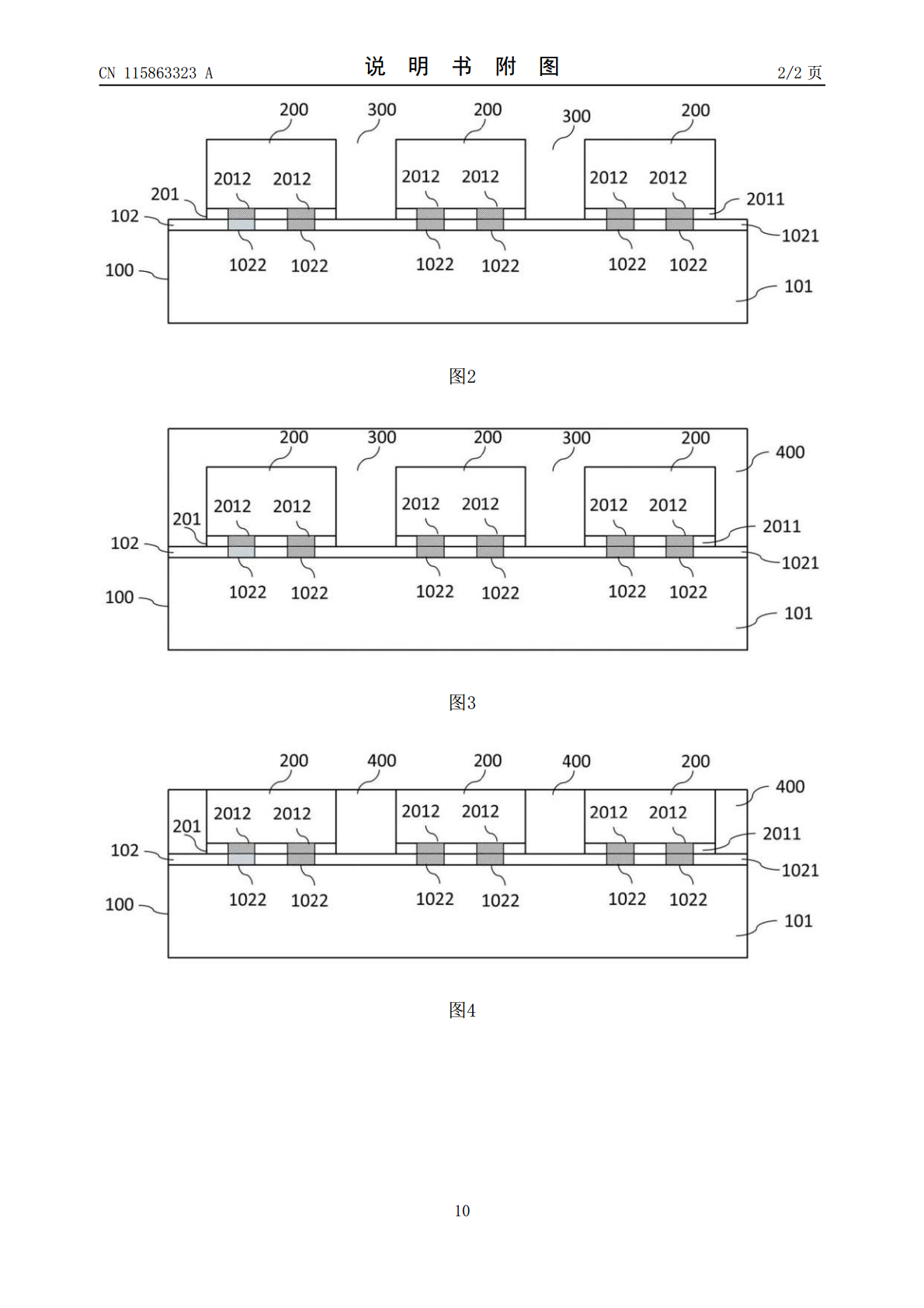
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

非晶硅的应用、晶圆上芯片的形成方法及晶圆上芯片.pdf
本发明涉及一种非晶硅在晶圆上芯片中作为芯片之间填充材料的应用、晶圆上芯片的形成方法及晶圆上芯片。其中,晶圆上芯片的形成方法,包括以下步骤:提供待接合的晶圆以及多个芯片;执行接合工艺,在所述晶圆之上接合所述多个芯片且在所述多个芯片之间形成间隙;执行间隙填充工艺,以非晶硅作为填充材料填充所述间隙并覆盖所述芯片的表面;执行化学机械研磨工艺,以露出所述芯片的表面。采用非晶硅作为填充材料填充至各芯片之间的间隙中,由于非晶硅与作为芯片基材的硅的材质相近,在后续利用化学机械研磨工艺进行减薄的过程中,可以降低化学机械研磨

制作板上芯片的晶圆样品的制备方法及板上芯片制作方法.pdf
本发明提供一种用于制作板上芯片的晶圆样品的制备方法和制作板上芯片的方法,其中用于制作板上芯片的晶圆样品的制备方法包括以下步骤:在多晶圆叠封样品中确定目标晶,目标晶圆为非最下方晶圆且通过金线直接连接到所述基板,金线在与基板的接触部分具有第一金球;去除基板至露出多个晶圆中最下方晶圆底部的阻焊层;测量将目标晶圆连接至基板的金线上的第一金球与目标晶圆的边缘在水平方向上的第一间距;根据该第一间距确定对目标晶圆下方的一个或多个晶圆进行去除时的研磨区域;基于确定的研磨区域将目标晶圆下方的一个或多个晶圆进行研磨去除,得到

晶圆级芯片封装方法、晶圆级芯片封装结构和电子设备.pdf
本申请提供了一种晶圆级芯片封装方法、晶圆级芯片封装结构和电子设备,涉及半导体领域。晶圆级芯片封装方法包括在基材正面铺设贴片膜,在贴片膜上贴装晶粒,利用塑封材料对晶粒进行晶圆级塑封,并制作电连接于晶粒的锡球,然后从基材的背面去除部分基材的材料,以减薄基材的厚度。在本申请实施例中,最终并不移出基材,而是保留部分基材。减薄后基材的厚度可以根据整体封装结构的尺寸来决定。由于保留了部分基材,基材具有一定结构强度,能够起到较佳的支撑作用,来抵抗塑封体中的应力,避免变形。这样制作出来的整个晶圆级芯片封装结构不容易存在翘

TOF芯片的晶圆测试系统、方法.pdf
本方案涉及一种TOF芯片的晶圆测试系统、方法。所述系统包括:探针卡、探针台、被测TOF芯片晶圆、中控单元、测试头;探针卡上设置有若干接点,每个接点分别与被测TOF芯片晶圆上的不同位置相连;测试头上每个卡槽分别插接有不同功能的板卡;测试头用于对每个接点对应的被测TOF芯片晶圆进行与板卡对应的功能测试,并得到测试数据;中控单元用于控制测试头工作,接收从测试头传输的测试数据,并对测试数据进行分析处理,得到测试结果,并将测试结果传输至上位机。测试头上每个卡槽分别插接有不同功能的板卡,可以根据测试需求插拔,通过同一

晶圆级芯片规模封装.pdf
一种制造一个或多个光电子器件的方法,每个光电子器件包括至少一个无源光学组件。该方法包括提供第一载体,将可溶性粘合剂沉积到第一载体的表面上,以及将多个集成电路器件放置到所述表面上并固化可溶性粘合剂以将集成电路器件固定到载体上。该方法还包括将成型材料沉积到第二载体的多个模具上以形成多个所述无源光学组件,对准所述第一载体和所述第二载体使得多个无源光学组件接触多个集成电路器件的相应区域,将聚合物化合物注入所述第一载体和所述第二载体之间的空间中并固化所述聚合物化合物,移除所述第二载体以留下通过所述聚合物化合物固定到
