
一种压焊块制作方法及压焊块.pdf

丹烟****魔王





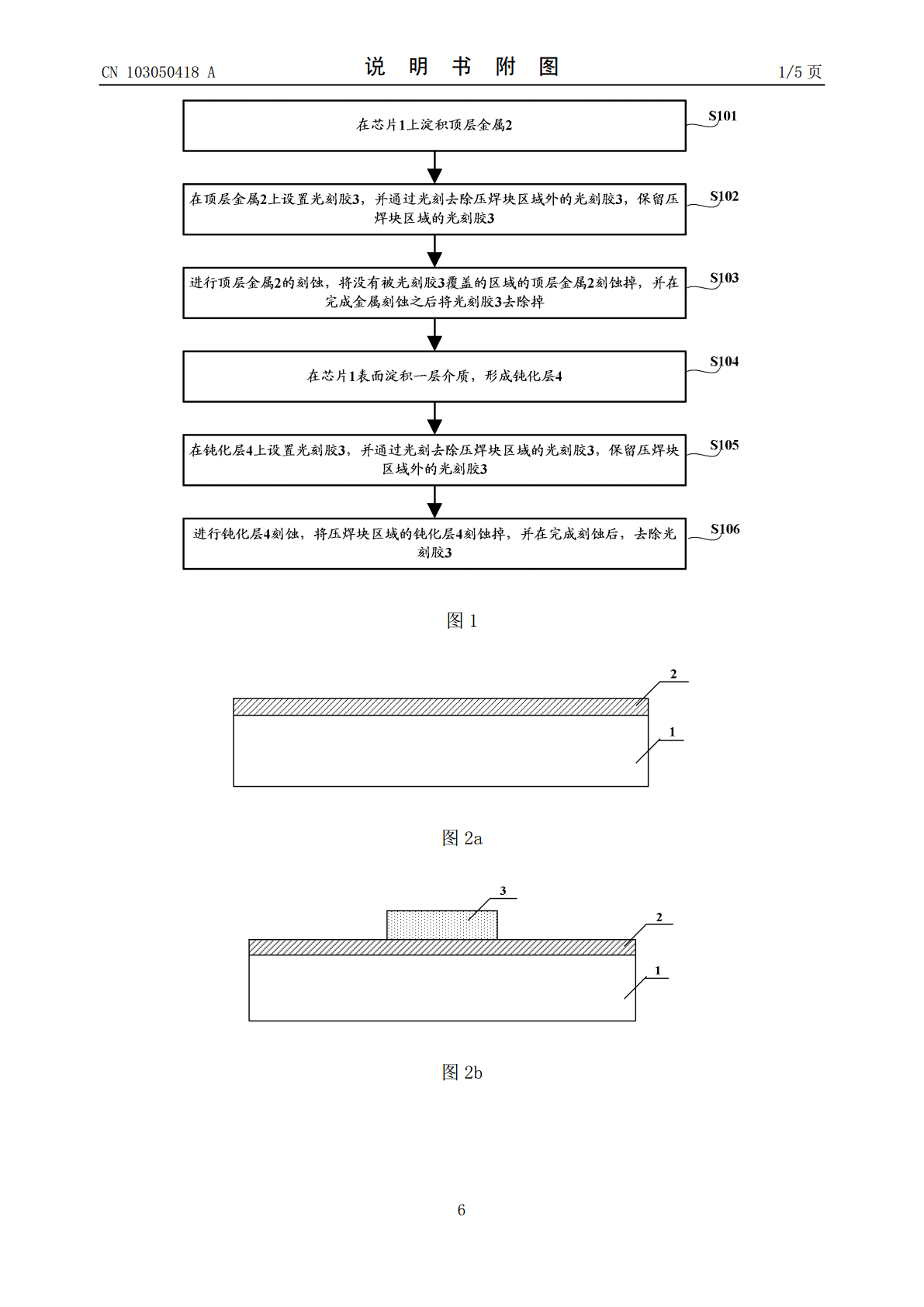
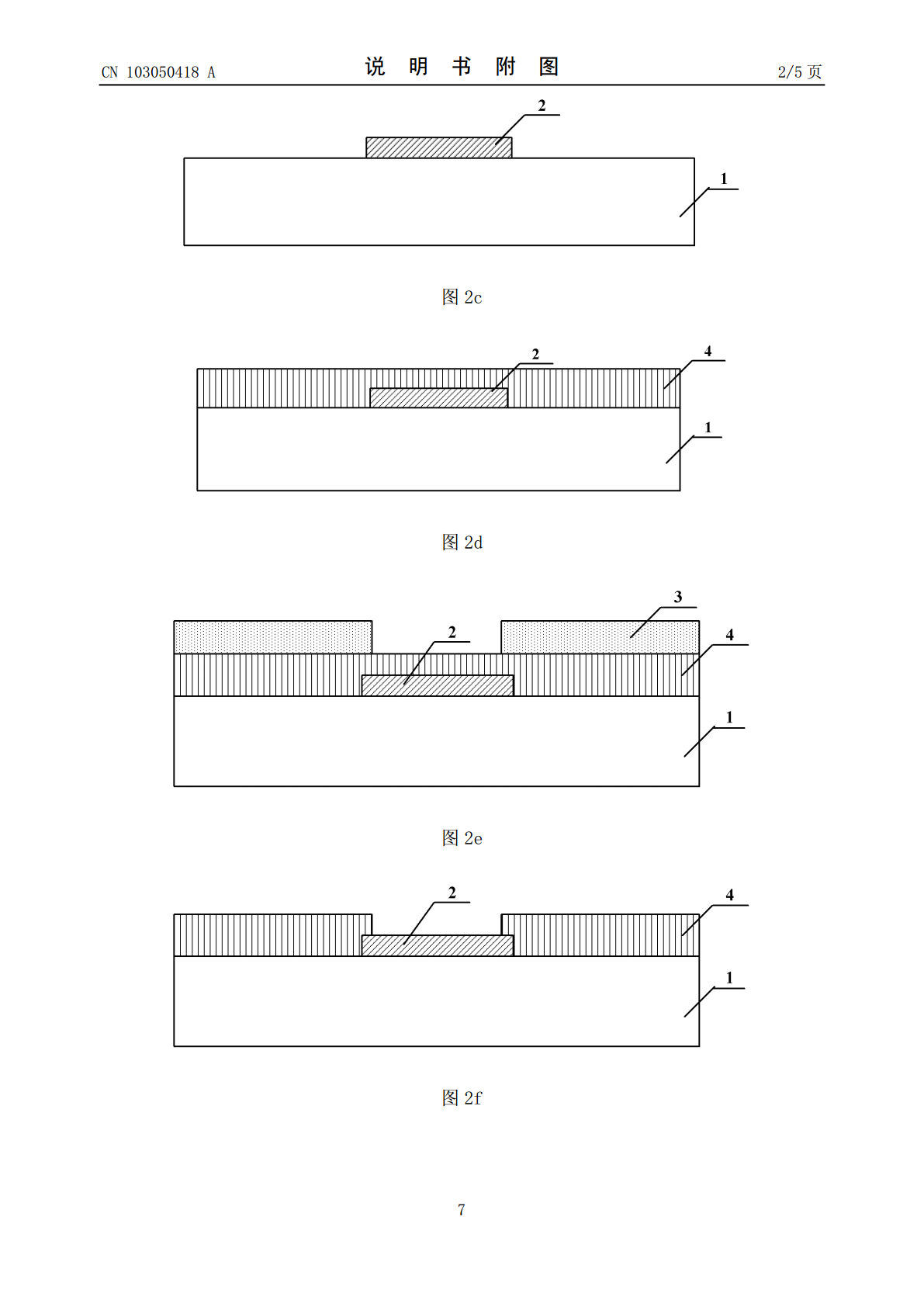

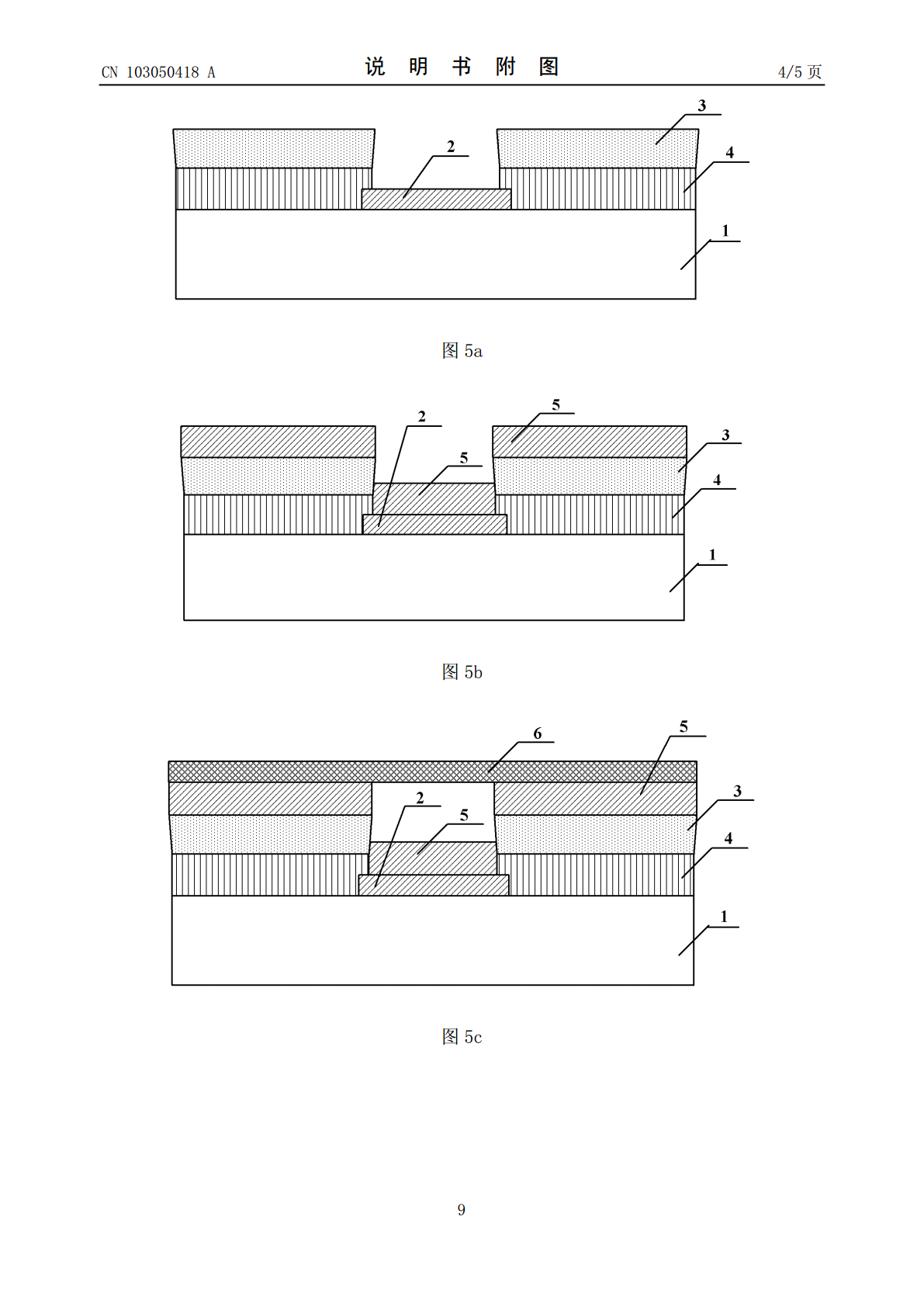

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种压焊块制作方法及压焊块.pdf
本发明公开了一种压焊块制作方法及压焊块,涉及半导体工艺技术,本发明实施例提供的压焊块制作方法中,在刻蚀掉芯片的压焊块区域的钝化层后,在芯片上淀积金属层,并通过粘性薄膜去除压焊块区域外的金属层,保留压焊块区域的金属层,从而增加了压焊块金属的厚度。

一种压焊块金属层加厚的芯片及其制造方法.pdf
本发明公开了一种压焊块金属层加厚的芯片及其制造方法,属于半导体芯片制造技术领域。本发明所述芯片,包括硅衬底、硅衬底上的金属层、金属层上的钝化层以及压焊块,其中,压焊块的金属层厚度大于金属走线的金属层厚度。其制造方法包括根据芯片的功能,在硅衬底表面上进行金属层的溅射、光刻和刻蚀,完成芯片内的金属走线,同时形成压焊块的步骤;钝化层生长、光刻和刻蚀,将压焊块区域刻蚀出来的步骤;以及在钝化层表面上再次进行金属层的溅射、光刻和刻蚀的步骤,保留压焊块区域的金属。本发明在芯片制造时实现了单独加厚芯片内部压焊块的效果,满

一种SQUID芯片压焊装置与压焊方法.pdf
提供一种SQUID芯片压焊装置与压焊方法,压焊装置包括PCB固定装置及其面接触式的压力传感器(7),与其位置对应,设置有由驱动装置(5)驱动可作直线滑动的推进杆(6),推进杆(6)包括位于其顶部的芯片推头(8),芯片推头(8)的顶端设置有芯片容纳槽(9);压焊方法包括将芯片(1)的电引出端与PCB板(2)的电接入端设置为数量相同的对应的焊接盘(3);选用各项异性的导电胶(18)加热至100至200度,将芯片(1)压焊至PCB板(2)的对应位置,使对应焊接盘(3)之间的导电胶(18)达到设定的压缩程度而电连

用于铜丝键合的金属压焊块厚铝工艺.pdf
本发明公开了用于铜丝键合的金属压焊块厚铝工艺,旨在解决铜丝键合,芯片焊块的制造方法存在明显缺点,1um的铝层厚度太薄,铜丝焊接容易把铝层打穿,造成弹坑,导致产品的电性能及可靠性问题失效的问题。其技术方案要点是:用于铜丝键合的金属压焊块厚铝工艺,工艺的具体制备流程如下所述:步骤一~九。本发明的用于铜丝键合的金属压焊块厚铝工艺,用于铜丝键合,以克服薄铝焊块在铜丝焊接时出现的弹坑问题,同时可以适用于不具备AL湿法腐蚀设备的工艺线及小尺寸集成电路的加工。

钎焊与压焊.ppt
压焊和钎焊一、电阻焊1.点焊SpotWelding点焊过程:点焊分流现象:焊接新焊点时,有一部分电流会流经已焊好焊点,使焊接电流发生变化,影响点焊质量。点距:两相邻焊点间的中心距。焊件厚度越大,导电性越强,点距要越大。焊点直径:要尽量大应用:薄板冲压件及钢筋焊接。点焊工件常用厚度范围是0.05~6mm。2.缝焊SeamWelding3.对焊ButtWelding(1)电阻对焊UpsetButtWelding(2)闪光对焊FlashButtWelding焊接过程如4-15(b)图所示加紧、对正→通电→移动、
