
一种去除SiC外延晶片金属污染或残留的清洗方法.pdf

书生****aa






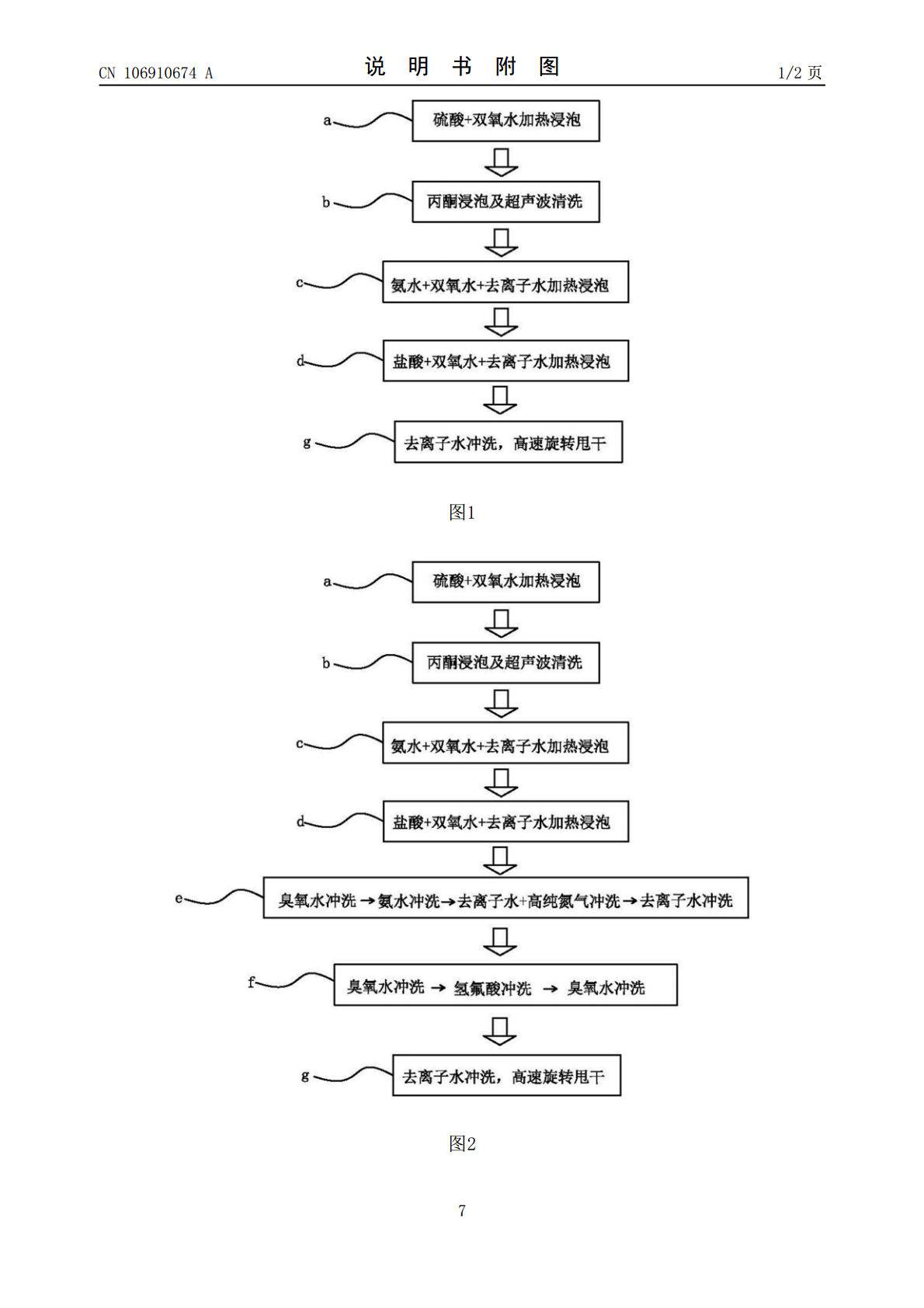
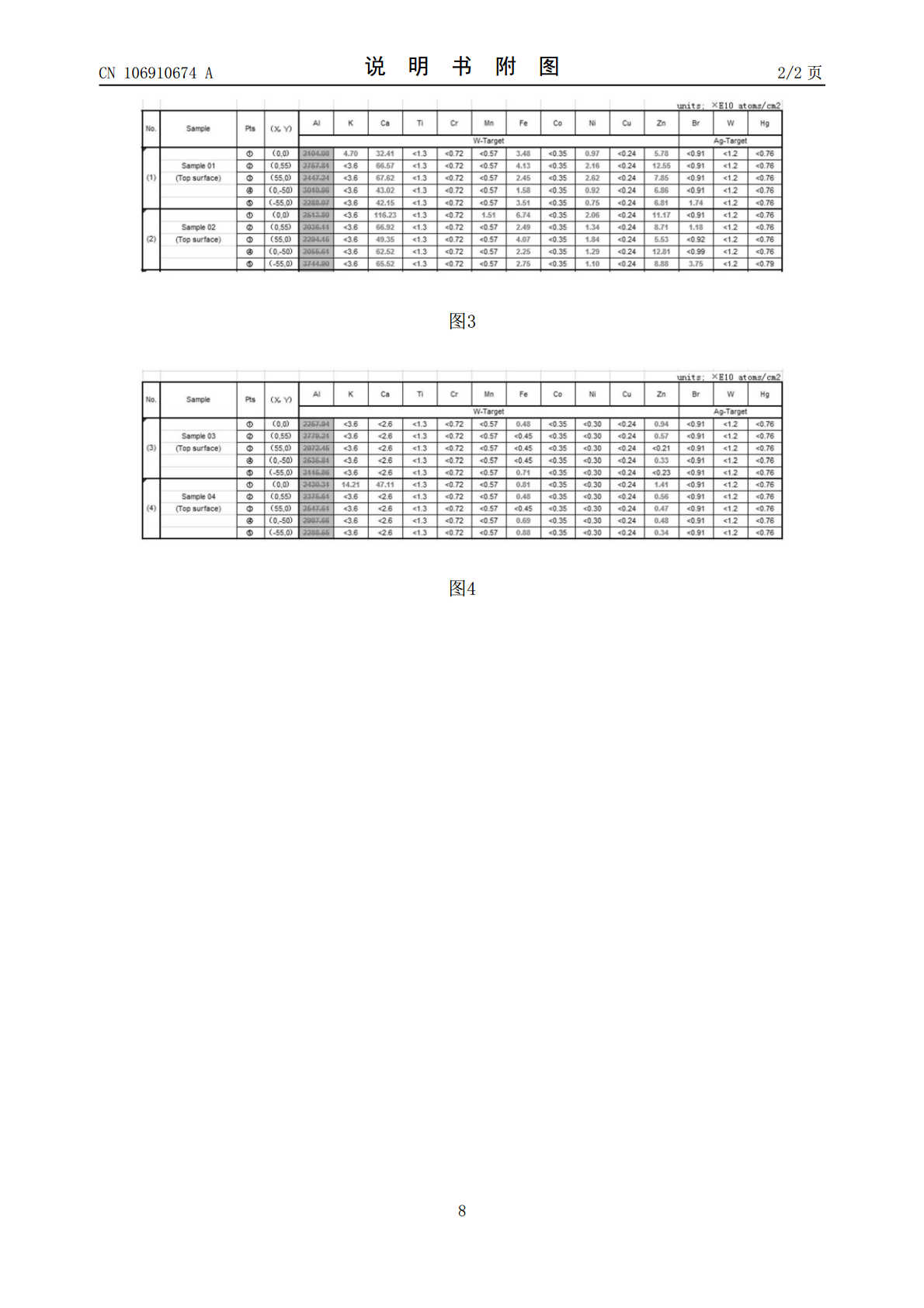
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种去除SiC外延晶片金属污染或残留的清洗方法.pdf
本发明公开一种去除SiC外延晶片金属污染或残留的清洗方法,其包括以下步骤:a、将SiC外延晶片置于加热的由硫酸与双氧水混合形成的混合洗液中浸泡;b、用去离子水冲洗SiC外延晶片表面,然后置于丙酮中超声波清洗;c、用去离子水冲洗SiC外延晶片表面,然后置于加热的由氨水、双氧水、去离子水混合形成的混合洗液中浸泡;d、用去离子水冲洗SiC外延晶片表面,然后置于加热的由盐酸、双氧水、去离子水混合形成的混合洗液中浸泡;e、依次用臭氧水、氨水、高纯氮加去离子水分别冲洗SiC外延晶片表面;f、依次用臭氧水、氢氟酸溶液、

SiC外延晶片和SiC外延晶片的制造方法.pdf
本发明的目的在于得到能够测定外延层总厚度和漂移层厚度的SiC外延晶片及其制造方法。该SiC外延晶片具备SiC基板和层叠于所述SiC基板上的外延层,所述外延层从所述SiC基板侧依次具有第1层、第2层和第3层,所述SiC基板的氮浓度为6.0×10<base:Sup>18</base:Sup>cm<base:Sup>?3</base:Sup>以上且1.5×10<base:Sup>19</base:Sup>cm<base:Sup>?3</base:Sup>以下,所述第1层的氮浓度为1.0×10<base:Sup>

一种SiC晶片的外延生产工艺.pdf
本发明涉及碳化硅外延技术领域,具体的是一种SiC晶片的外延生产工艺,本发明包括S1将碳化硅晶圆的背面通过碳沉积反应永久键合在石墨载盘上;S2将S1中的固定有碳化硅晶圆的石墨载盘固定于高温炉内的石墨转盘内;S3向高温炉内通入反应气体并抽真空,最终在碳化硅晶圆的表面生长出外延层;本发明通过先将碳化硅晶圆用碳沉积反应固定在石墨载盘上,在面对超薄碳化硅晶圆的外延生长时,可以减小碳化硅晶圆在高温炉内转动时受到的应力,防止碳化硅晶圆曲翘甚至破裂;通过在高温炉内设置有两个转盘,第二转盘位于第一转盘的表面,第一转盘转动形

SiC化学气相沉积装置和SiC外延晶片的制造方法.pdf
本发明涉及SiC化学气相沉积装置和SiC外延晶片的制造方法。该SiC化学气相沉积装置具有在内部构成沉积空间的炉体和位于上述沉积空间的下部且在载置面上载置SiC晶片的载置台,上述炉体在与上述载置台大致正交的上下方向上被分离为多个部件,上述多个部件具有第一部分和第二部分,上述第一部分具有向外周方向突出的突出部,上述第二部分具有供上述突出部钩挂的钩部,上述第一部分与上述第二部分通过上述钩部钩挂于上述突出部而连结。

一种晶片清洗槽及晶片清洗方法.pdf
本发明涉及半导体材料技术领域,具体是一种晶片清洗槽,包括清洗槽,所述清洗槽的上方设置有夹持臂,夹持臂镜像对称设置有2排,每排等距分布有若干个夹持臂,且每排中夹持臂相靠近的一侧分别设置有调距推拉座,并且每排所述夹持臂的中部和上端分别活动连接有限位支撑杆和夹持控制同步杆,所述夹持臂的下端上下间隔设置有主动支撑轮和被动支撑轮,本发明能通过2排若干个夹持臂批量的对晶片自动夹持,且夹持臂上的主动支撑轮和被动支撑轮能够让晶片的边沿与夹持臂之间滚动连接,使得晶片被夹起后还能够自转,而且通过取放架和喷洗组合管与夹持臂的配
