
一种提高器件均匀性的方法.pdf

元枫****文章





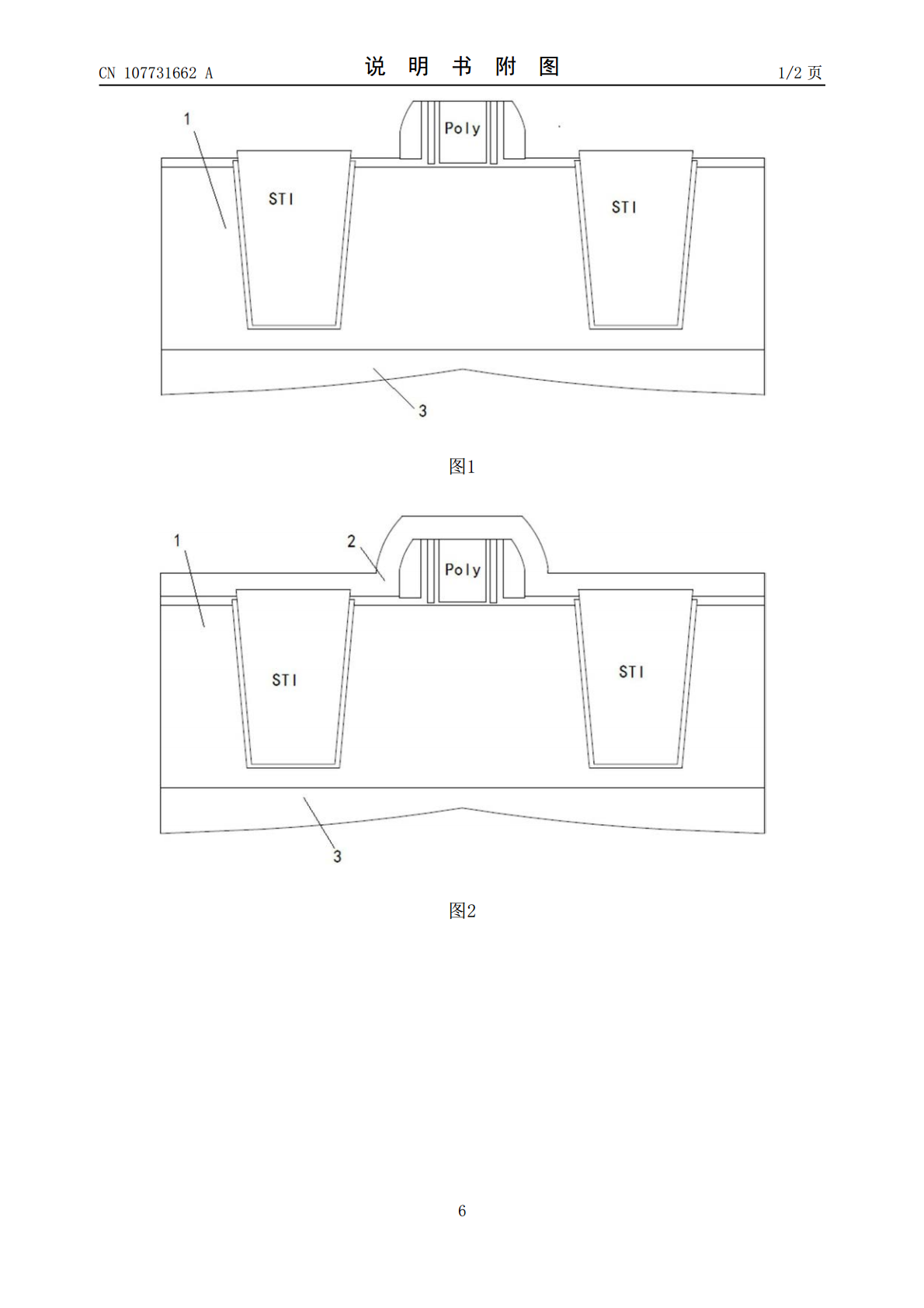

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种提高器件均匀性的方法.pdf
本发明公开了一种提高器件均匀性的方法,包括:步骤一、通过化学气相沉积工艺在晶圆正面生长一层氧化物遮挡层;步骤二、采用湿法刻蚀去除所述晶圆的背面残留的氮化物薄层;步骤三、采用湿法刻蚀去除所述晶圆的正面的所述氧化物遮挡层。本发明通过去除晶圆背面的残留氮化物,为后续尖峰退火工艺提供均匀的衬底,可以有效的减小因为晶圆背面氮化硅薄膜厚度对尖峰退火工艺温度的影响带来的晶圆之间器件特性的大幅波动。通过这种方法,可以明显提高大规模量产中产品器件均匀性和良率的稳定性。

一种提高薄膜均匀性的方法.pdf
本申请实施例提供一种提高薄膜均匀性的方法,包括:根据注入参数,确定向晶圆第一注入面注入的第一注入剂量,以及,向晶圆第二注入面注入的第二注入剂量,按照第一注入剂量向晶圆第一注入面注入;按照第二注入剂量向晶圆第二注入面注入;向晶圆第一注入面注入第三注入剂量,第三注入剂量不大于临界注入剂量;如果向晶圆第一注入面注入的离子总注入剂量达到目标注入剂量,则将第一注入面与衬底层键合,得到键合体;对键合体热处理,在衬底层上形成薄膜层。将目标注入剂量分步向第一注入面注入,同时配合向第二注入面注入,以抵消第一注入面注入产生的

一种提高硅片切割厚度均匀性的方法.pdf
本发明公开了一种提高硅片切割厚度均匀性的方法,包括:(1)导轮涂覆和开槽:导轮涂覆时,在导轮涂层反涂树脂胶中添加碳化硅粉,并开V型槽;(2)粘棒:用AB胶将晶托、树脂板和硅棒粘接在一起;(3)切割:将粘好的硅棒放到线切机中进行切割,切割前采用斜线网方式布网;切割过程中,将添加了硅粉分散剂的水溶液引流至切割面;(4)切割完成,脱胶清洗硅片。本发明简单有效,可以明显提高硅片切割厚度的均匀性。

一种提高VCSEL氧化孔径均匀性的方法.pdf
本发明涉及半导体技术领域,公开了一种提高VCSEL氧化孔径均匀性的方法,具体为:将VCSEL刻蚀的台面结构设计为花瓣型,且沟道宽度设计为10‑25um;再将VCSEL置于氧化炉内,然后对氧化炉快速升温至VCSEL的氧化温度以下,并恒温25‑35min,在升温和恒温时向氧化炉内通入氮气和水汽的混合气体;对氧化炉以10‑20℃/min的升温速率升温至氧化所需温度,直至氧化完毕;最后对氧化炉降温,使氧化炉快速降温至180‑220℃,然后自然冷却至室温。本发明能够提高VCSEL氧化孔径均匀性。

提高晶体掺杂均匀性的方法.docx
提高晶体掺杂均匀性的方法提高晶体掺杂均匀性的方法摘要:晶体掺杂是指将外源性杂质引入到晶体中,以改变它的电学、磁学、光学等性质。晶体掺杂均匀性的提高对于材料科学和电子器件的性能至关重要。本文综述了提高晶体掺杂均匀性的方法,包括选择适当的掺杂材料、优化掺杂过程和控制晶体生长条件等方面。通过采取这些方法,可以显著提高晶体的掺杂均匀性,从而实现更好的性能。关键词:晶体掺杂、均匀性、掺杂材料、掺杂过程、晶体生长1.引言晶体掺杂是指将外源性杂质引入到晶体中,以改变它的电学、磁学、光学等性质。掺杂可以使晶体具有特定的导
