
清洗基材表面的方法.pdf

邻家****66








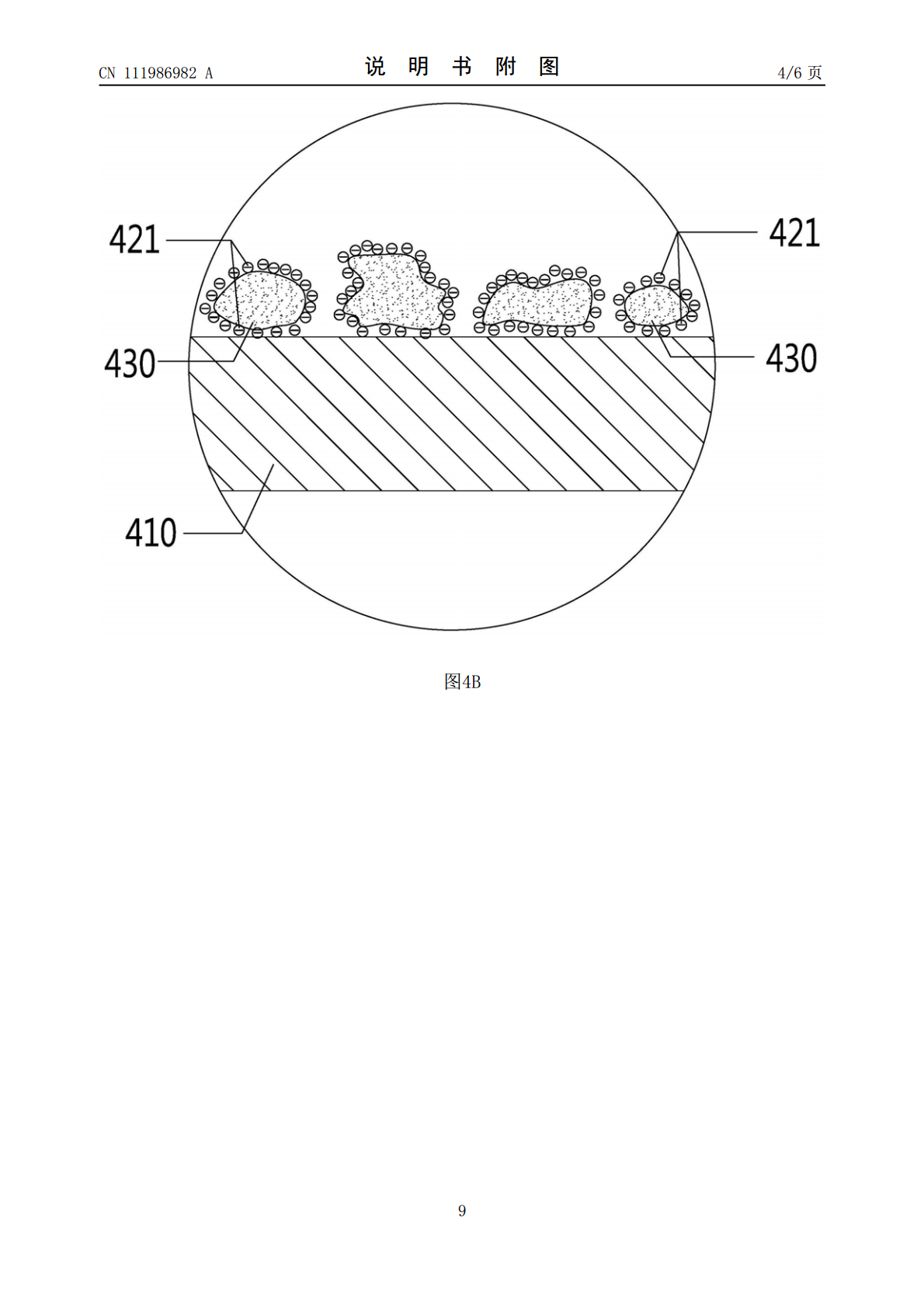

亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

清洗基材表面的方法.pdf
本发明中清洗基材表面的方法主要提供奈米水以及一外力于该基材表面,将位于该基板表面的复数残留粒子移除;最后进行一干燥步骤去除残留于该基材表面的该奈米水,本发明主要利用奈米水来移除清洗经研磨或抛光处理后的一半导体晶圆、一玻璃或一光学镜片等基材,具有较佳的清洗效率,可有效地移除基材表面的残留粒子,也不会让基材上的表面处理或电子线路遭受损害。

测量基材特性的方法及其系统及测量基材的表面的方法.pdf
本揭露的一实施例一般是关于一种测量基材特性的方法及其系统及测量基材的表面的方法。测量基材特性的方法包含以扫描式探针显微镜扫描基材,基材上具有鳍,扫描获取的第一图像显示鳍个别的鳍顶区域,在扫描的期间,通过振荡的扫描探针,扫描式探针显微镜与鳍的侧壁的个别的部分相互作用。选择第二图像,以获取鳍的线边缘轮廓,其中第二图像是由鳍顶区域的下方的预定深度所获取。通过处理器架构系统,使用功率频谱密度(powerspectraldensity,PSD)方法分析鳍的线边缘轮廓,以获取鳍的线边缘轮廓的空间频率数据。通过处理

芯片表面的清洗方法.pdf
本发明的芯片表面的清洗方法,依次包括:芯片置于碱性溶液中利用超声波进行清洗;该芯片置于异丙醇和水的混合液中利用超声波进行清洗;该芯片置于柠檬酸溶液中利用超声波进行清洗;以及用去离子水漂洗该芯片。该方法能高效去除芯片表面上的残留物,防止对芯片造成腐蚀,从而提高芯片的使用寿命。

一种构筑基材界面的预连接方法.pdf
本发明涉及一种构筑基材界面的预连接方法,依次包括有以下步骤:1)将两个构筑样品的表面加工平整;2)将两个构筑样品对接并堆叠放入炉体腔室内的样品台上;3)通过加压系统,对两个构筑样品施加从上向下的应力P

形成于基材表面的抗菌及骨整合涂层及在基材表面制备抗菌及骨整合涂层的方法.pdf
本发明公开了一种形成于基材表面的抗菌及骨整合涂层及在基材表面制备抗菌及骨整合涂层的方法,该方法包括:(1)将基材浸泡于粘附剂中;(2)将步骤(1)获得的基材浸泡于阳离子材料溶液中;(3)将步骤(2)获得的基材浸泡于硫化铜纳米颗粒溶液中;(4)重复步骤(2)和(3)至少两次。该涂层不仅与基材牢固结合、时效持久,而且硫化铜纳米颗粒在近红外光照射下能够被激活而杀灭细菌,达到治疗种植体周围炎的效果,且杀菌效果智能可控、即时性强;硫化铜纳米颗粒能够释放二价铜离子,活化血管内皮生长因子(VEGF),进而促进种植体周围
