
一种半导体结构及其制造方法.pdf

盼易****君a








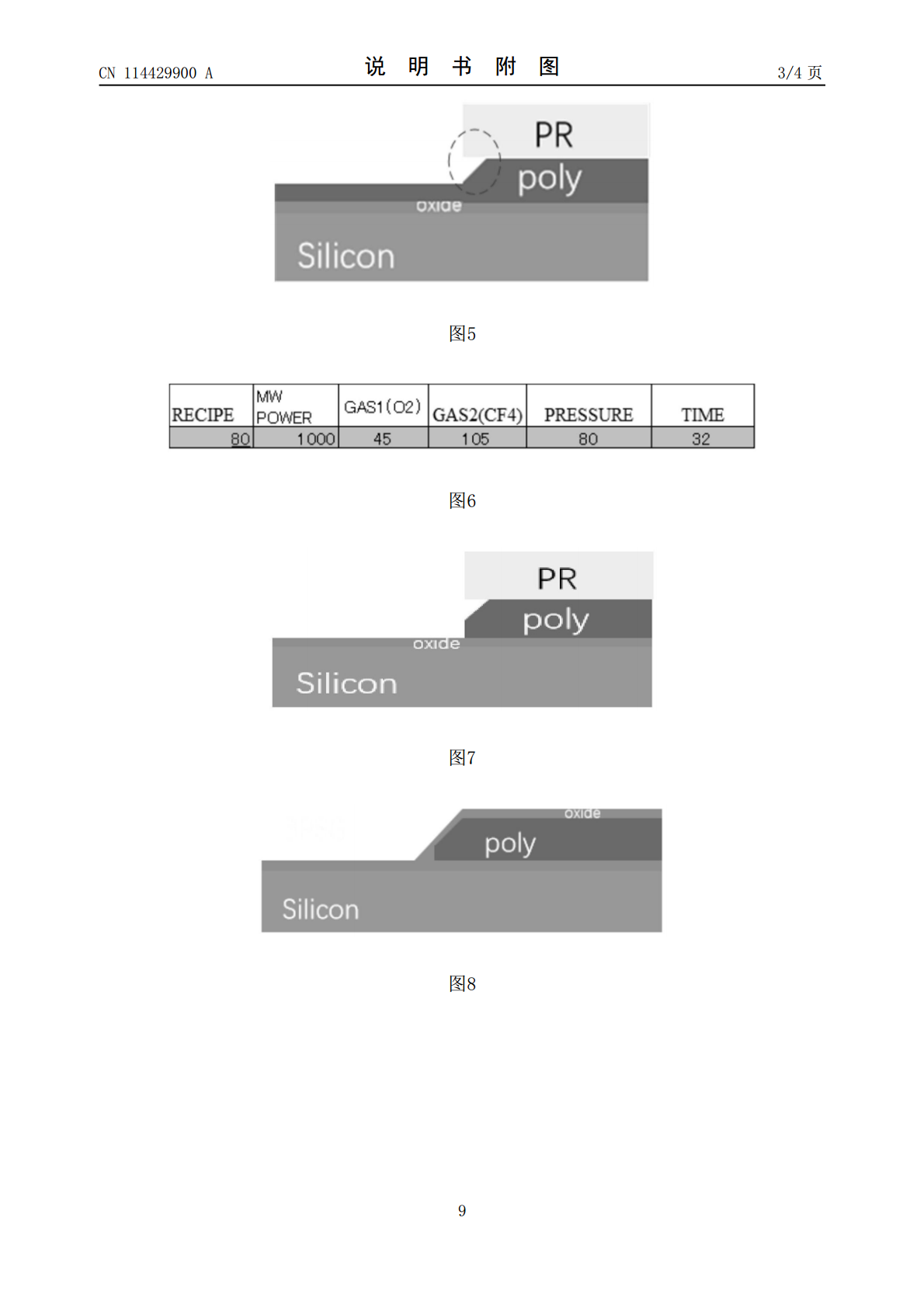

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种半导体结构及其制造方法.pdf
本发明提供一种半导体结构及其制造方法,提供衬底,在衬底上生长一栅氧层,在栅氧层上形成多晶硅层;在多晶硅层上方形成具有栅极形成区域图案的光刻胶层;以光刻胶层为掩膜,利用各向同性刻蚀工艺去除部分多晶硅层,在光刻胶层与多晶硅层之间形成底切;以光刻胶层为掩膜,利用各向异性刻蚀工艺去除剩余的多晶硅层,在栅氧层上方形成左上角呈斜坡状的多晶硅栅极;形成覆盖多晶硅栅极顶部和侧面的氧化层,氧化层和裸露的栅氧层表面共同呈斜坡台阶状;在氧化层和栅氧层表面形成一介质层。本发明解决了由于多晶硅刻蚀边缘为直角导致钨刻蚀难以刻蚀干净产

一种半导体结构及其制造方法.pdf
本发明公开了一种半导体结构及其制造方法,属于半导体技术领域。所述半导体结构至少包括:在衬底上依次设置的连接层、接触孔蚀刻停止层、层间介质层和多层掺杂层;第一凹部,设置在所述掺杂层中,且由所述第一凹部开口一侧至底壁一侧,所述第一凹部的径向长度逐渐减小;第二凹部,延伸入部分所述层间介质层中,所述第二凹部的侧壁垂直设置;第三凹部,设置在所述第二凹部底部,且所述第三凹部延伸入部分所述连接层,由所述第三凹部的开口一侧至底壁一侧,所述第三凹部的径向长度逐渐减小;以及导电结构,设置在所述第一凹部、所述第二凹部和所述第三

一种半导体结构及其制造方法.pdf
公开了一种半导体结构及其制造方法,方法包括:提供包括衬底、有源区多条位线结构和多条隔离栅栏的初始结构,位线结构和隔离栅栏相互交叉限定出多个暴露有源区的开口,位线结构包括位线层以及覆盖位线层侧壁的牺牲层、至少覆盖牺牲层的第一介质层;在开口内形成存储节点接触插塞;去除牺牲层形成间隙;采用选择性快速等离子体氮处理工艺形成至少覆盖间隙的内壁并封闭间隙的顶部开口的第二介质层,间隙未被第二介质层填充的区域定义为气隙;在存储节点接触插塞上形成覆盖部分第二介质层的接触焊盘。

一种半导体结构及其制造方法.pdf
本公开实施例公开了一种半导体结构及其制造方法,所述半导体结构包括:衬底以及位于衬底内的导电通孔、第一导电类型晶体管及第二导电类型晶体管;其中,第一导电类型晶体管沿第一方向设置于导电通孔的两侧;第二导电类型晶体管沿第二方向设置于导电通孔的另外两侧;第一方向与第二方向垂直;第一金属层,位于衬底上,第一金属层包括至少一条沿第一方向延伸的第一金属线,第一金属线与第一导电类型晶体管的栅极电连接;第二金属层,位于第一金属层上,第二金属层包括至少一条沿第二方向延伸的第二金属线,第二金属线与第二导电类型晶体管的栅极电连接

一种半导体结构及其制造方法.pdf
本公开提供一种半导体结构及其制造方法,所述半导体结构包括:衬底;第一介质层,覆盖所述衬底的上表面;第一导电层,至少包括第一子层,所述第一子层覆盖所述第一介质层的部分上表面;第二导电层,覆盖所述第一导电层;其中,所述第一导电层在固体中的扩散系数小于所述第二导电层在固体中的扩散系数;导电通孔,所述导电通孔从与所述衬底相对的下表面延伸至所述第一子层并暴露所述第一子层。
