
FDSOI混合区域的外延生长方法.pdf

书生****aa







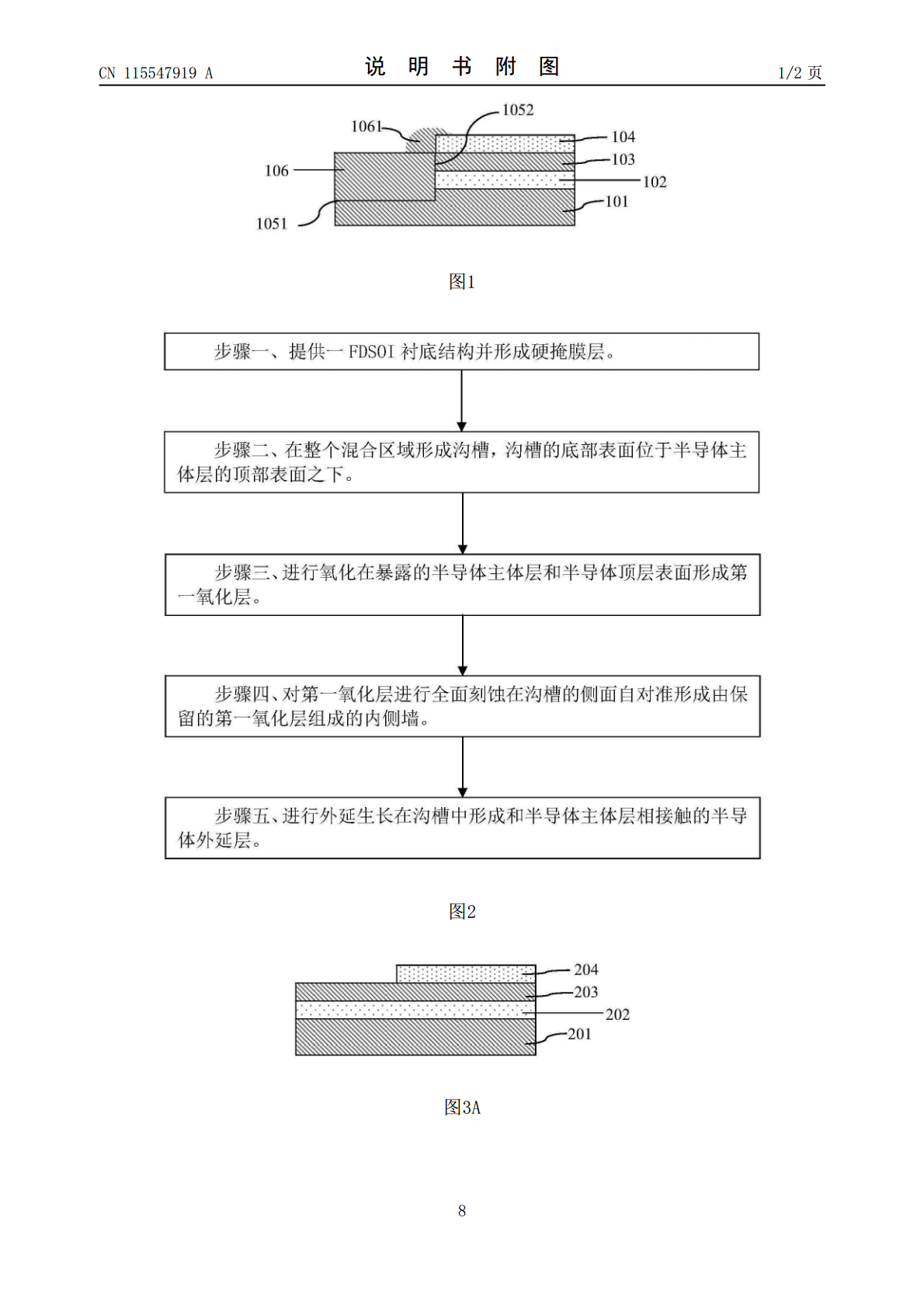
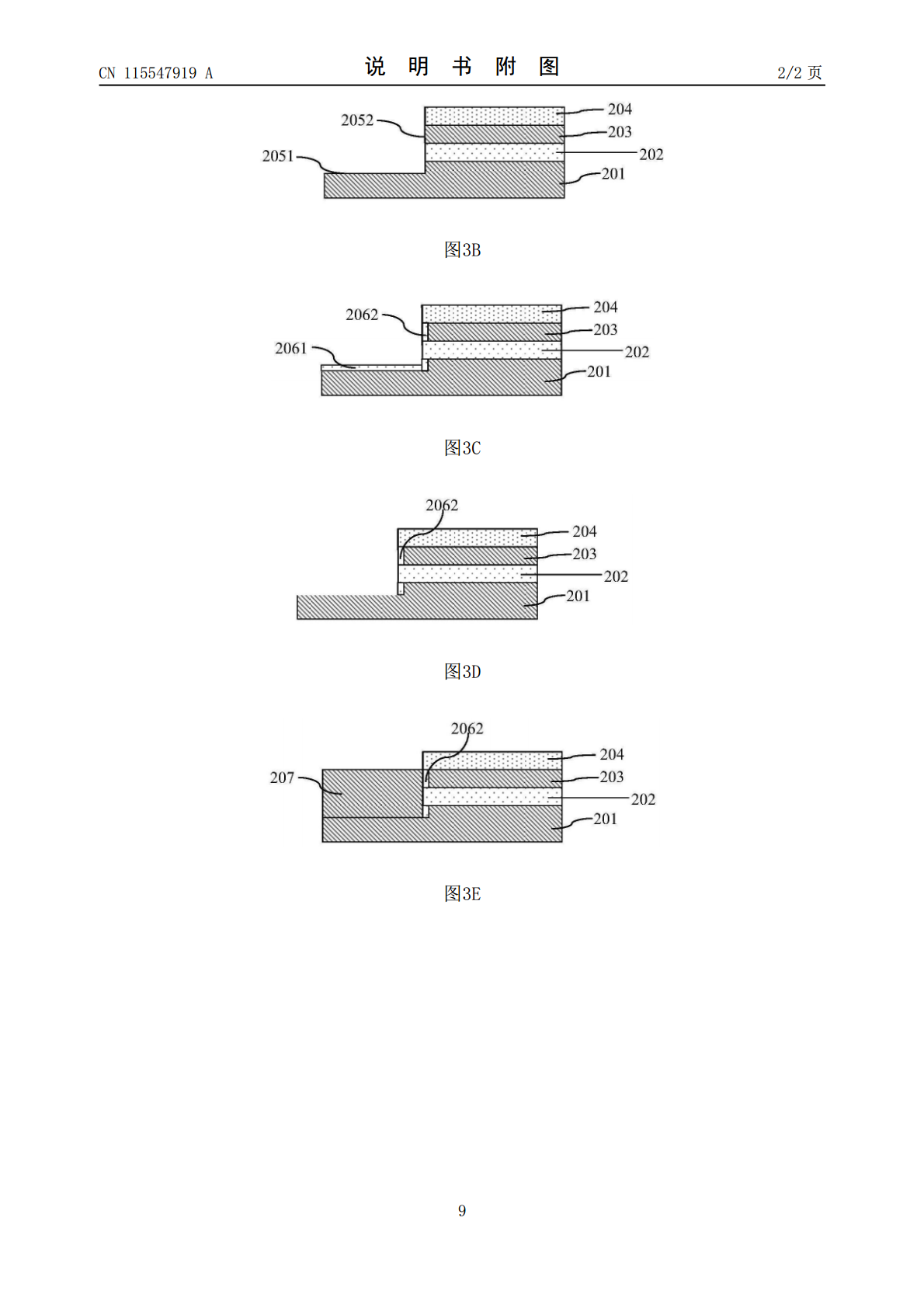
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

FDSOI混合区域的外延生长方法.pdf
本发明公开了一种FDSOI混合区域的外延生长方法,包括:步骤一、提供一FDSOI衬底结构并形成硬掩膜层;步骤二、在整个混合区域形成沟槽,沟槽的底部表面位于半导体主体层的顶部表面之下;步骤三、进行氧化在暴露的半导体主体层和半导体顶层表面形成第一氧化层;步骤四、对第一氧化层进行全面刻蚀在沟槽的侧面自对准形成由保留的第一氧化层组成的内侧墙;步骤五、进行外延生长在沟槽中形成和半导体主体层相接触的半导体外延层。本发明能消除在混合区域边界处产生半导体外延层的凸起缺陷,提高半导体外延层表面的平坦性,还能使工艺得到整体改

一种改善FDSOI外延生长的薄膜工艺优化方法.pdf
本发明公开了一种改善FDSOI外延生长的薄膜工艺优化方法,其可减少栅极区与顶层硅相连接拐角处的残留薄膜,晶体管包括衬底,衬底上分布有主动区域、沟槽隔离区、栅极区,衬底包括N型硅衬底、P型硅衬底,主动区域上表面沉积第一层顶层硅,薄膜加工包括:在N型硅衬底、P型硅衬底上表面均沉积第一层薄膜,在P型硅衬底的第一层薄膜的上方设置掩膜版,对N型硅衬底上方的第一层薄膜进行刻蚀,在第一层顶层硅的表面沉积第二层顶层硅,在第二层顶层硅表面沉积第二层薄膜,刻蚀N型硅衬底上方的第二层薄膜,对第二层薄膜刻蚀后,在第二层顶层硅的外

优化薄膜外延生长均匀性的装置、方法及外延生长设备.pdf
本发明公开了一种优化薄膜外延生长均匀性的装置、方法及外延生长设备。所述方法包括:使承载衬底的托盘同时绕第一轴线和第二轴线做圆周运动,以使所述衬底上任一点沿一非圆形轨迹做摆线运动,从而使沉积到衬底表面不同位置的原料的量相同,其中,所述第一轴线为托盘自身轴线,所述第二轴线与第一轴线相互平行且不重合。本发明通过使衬底表面点做摆线运动,使衬底表面点可经过更多的路径以覆盖到更大的源炉束流的入射区域,源炉到衬底表面不同位置的入射距离多次取均值后基本保持恒定,从而使衬底表面不同位置的入射通量基本相同,进而提高了薄膜生长

水平液相外延石墨舟、生长系统、外延方法和生长方法.pdf
本发明公开了一种水平液相外延石墨舟,包括至少一个刮除装置,拉动滑条至第一预设位置时,刮除装置能够刮除滑条上滞留的母液;以及至少一个吸收装置,拉动滑条至第二预设位置时,吸收装置能够吸收滑条上滞留的母液;并且拉动滑条时,滑条先滑动至衬底槽与母液滞留槽对中的位置,再滑动至第一预设位置,最后滑动至第二预设位置。碲镉汞母液在衬底上生长出碲镉汞薄膜;拉动滑条至第一预设位置,刮除装置将滞留在滑条上的碲镉汞母液刮除;再拉动滑条至第二预设位置,吸收装置将碲镉汞母液吸收;在刮除装置和吸收装置的双重作用下,减少残留的碲镉汞母液

水平液相外延石墨舟、生长系统、外延方法和生长方法.pdf
本发明公开了一种水平液相外延石墨舟。该水平液相外延石墨舟包括至少两个具有母液滞留槽的槽体组,相邻的槽体组之间相互连通;具有至少两个衬底槽的滑条;设置于滑条下方的底托;设置于槽体组上方的盖板,滑条能够在底托与母液槽之间滑动,并且滑条拉动至预设位置时,每个衬底槽均能够与一个母液滞留槽对中。由于该水平液相外延石墨舟具有至少两个槽体组,滑条具有至少两个衬底槽,因此每次至少能够生长两片碲镉汞薄膜,并且相邻的槽体组之间连通,相邻的槽体组之间的汞蒸气能够流通,每片碲镉汞薄膜处于相同的工艺条件,实现了碲镉汞薄膜的批量化生
