
改善侧墙刻蚀中刻蚀停止层凹陷的方法.pdf

曾琪****是我







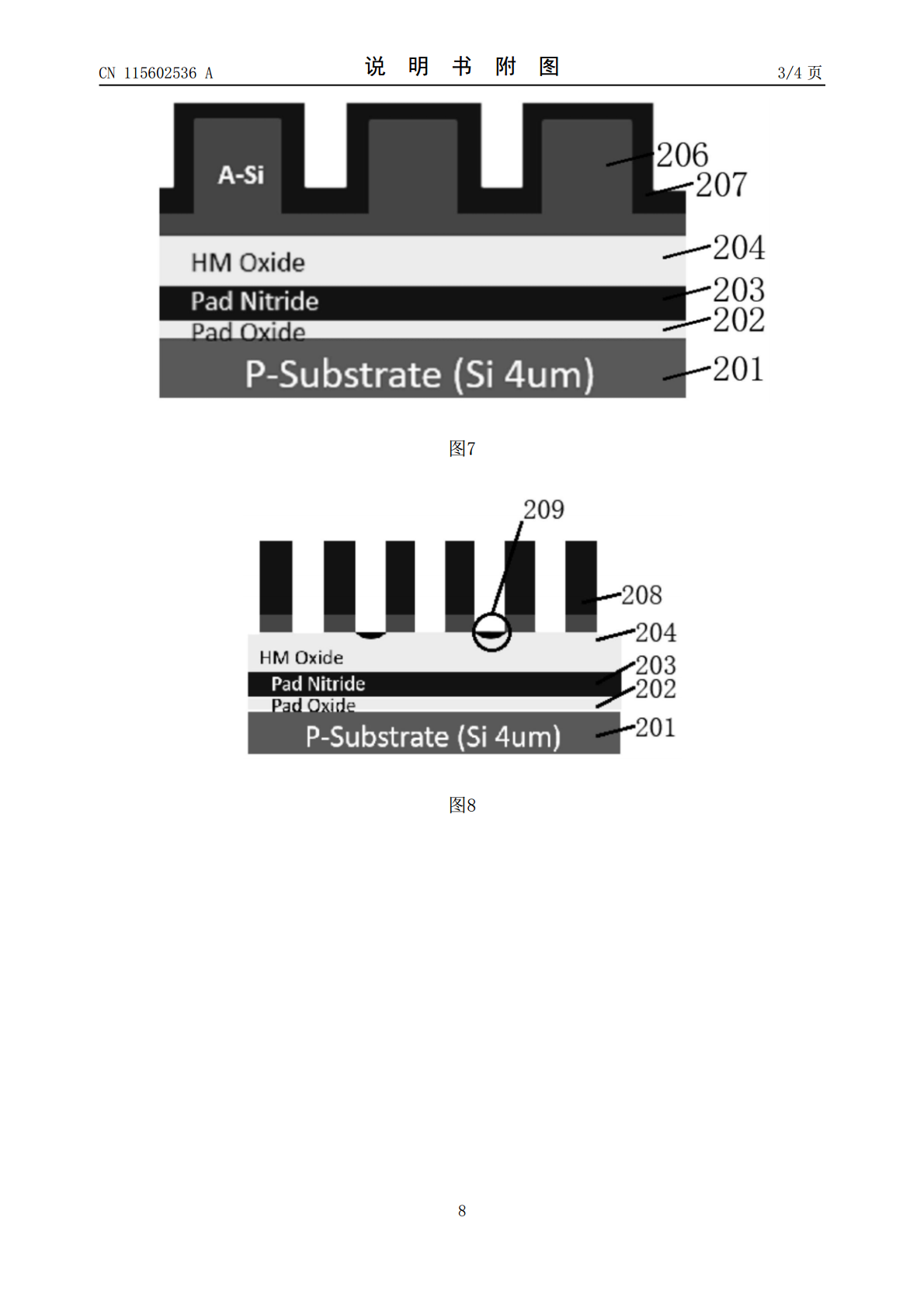

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

改善侧墙刻蚀中刻蚀停止层凹陷的方法.pdf
本发明提供一种改善侧墙刻蚀中刻蚀停止层凹陷的方法,提供衬底,衬底上形成有叠层,叠层上形成有牺牲层;在牺牲层上形成光刻胶层,光刻打开光刻胶层使得其下方的牺牲层裸露,刻蚀部分裸露的牺牲层形成凹槽,使得凹槽的底部与叠层间保留部分牺牲层,用以形成芯模图形;在芯模图形上形成掩膜层;刻蚀硬掩膜层及其下方的牺牲层至叠层的上方形成侧墙,使得除侧墙下方以外的牺牲层裸露;刻蚀去除裸露的牺牲层。本发明在芯模图形刻蚀时,通过调节刻蚀的时间,使得非芯模图形区域剩余一层无定形硅,在侧墙刻蚀时,非芯模图形区域剩余一层无定形硅将作为刻蚀

改善刻蚀缺陷的方法.pdf
本发明提供一种改善刻蚀缺陷的方法,提供衬底,衬底上形成有第一金属层以及形成于第一金属层上的第二金属层;在第二金属层上形成光刻胶层,光刻打开部分光刻胶层使得其下方的第二金属层裸露,调节光刻胶去除机台的温度,使得第一、二金属层的接触面处形成为金属间化合物;利用湿法刻蚀去除裸露的第二金属层,之后干燥处理衬底,使得第一、二金属层上的溶液去除;利用灰化工艺去除光刻胶层,使得第一、二金属层上残留的溶液去除;清洗衬底,之后干燥处理衬底。本发明在金属层刻蚀前进行烘烤热处理,释放热应力;并在刻蚀后加强干燥处理,清除因金属层

一种监控侧墙刻蚀后残留的方法.pdf
一种监控侧墙刻蚀残留的方法,其以在线光学线宽量测为手段,通过在传统的侧墙刻蚀工艺中增加一步在线光学线宽量测步骤,对图形密集区域的残留介质膜进行量测,通过光学线宽测量的多样本点残留介质膜厚度来监控刻蚀完成后是否有微小异常残留的现象发生,从而作为生产过程后缺陷检测的一种补充手段。因此,通过本发明提供的方法,可以大大提高产品缺陷的检测准确率,缩短检测周期并确保了产品良率的稳定性。

层间介质层的刻蚀方法.pdf
本发明公开了一种层间介质层的刻蚀方法,包括:在半导体衬底上依次形成有浮栅介质层、浮栅多晶硅层和层间介质层;在层间介质层上形成图案化的光刻胶层,以光刻胶层为掩模,对层间介质层进行第一次刻蚀,在层间介质层内形成具有第一深度的第一沟槽,所述第一沟槽沿其深度方向的截面从远离浮栅多晶硅层处到所述浮栅多晶硅层处收缩;以图案化的光刻胶层为掩模,对层间介质层进行第二次刻蚀,使第一沟槽形成具有第二深度的第二沟槽,第二沟槽沿其深度方向的截面从远离浮栅多晶硅层处到靠近浮栅多晶硅层处收缩;此时,第二沟槽内部沉积有聚合物,第二沟槽

阻挡介质层的刻蚀方法.pdf
本发明提供一种阻挡介质层的刻蚀方法,包括:提供半导体衬底,所述半导体衬底上依次形成有金属层、阻挡介质层、氧化介质层和光刻胶层,所述光刻胶层内形成有光刻胶开口;对所述光刻胶开口的形貌进行调整,形成具有倾斜角度的光刻胶开口;沿所述具有倾斜角度的光刻胶开口对下方的氧化介质层进行刻蚀工艺,在氧化介质层内形成氧化介质层开口;去除氧化介质层上方残留的光刻胶层;以所述氧化介质层为掩膜,沿所述氧化介质层开口对阻挡介质层进行刻蚀工艺,在阻挡介质层内形成阻挡介质层开口,露出下方的金属层,所述阻挡介质层开口具有倾斜角度。本发明
