
一种晶圆方向识别系统及晶圆传送盒.pdf

玄静****写意






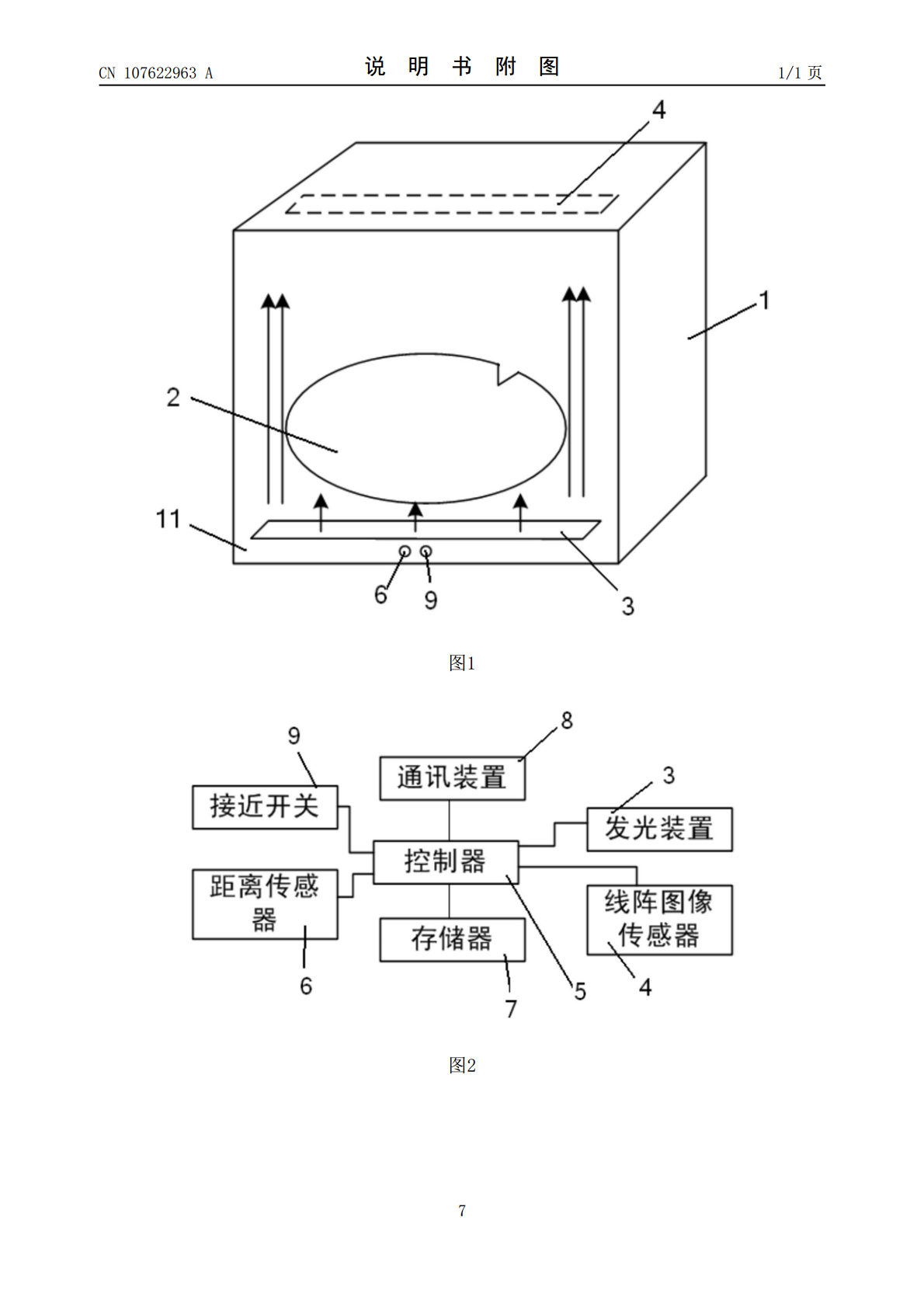
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种晶圆方向识别系统及晶圆传送盒.pdf
本发明公开了一种晶圆方向识别系统及晶圆传送盒,属于半导体制造技术领域,晶圆方向识别系统包括分别于晶圆传送盒的开口处设置于晶圆传送盒顶部和底部的发光装置、线阵图像传感器,发光装置于晶圆进入晶圆传送盒时发射线结构光,线阵图像传感器,扫描获取多个灰度值变化序列,灰度值变化序列的灰度值变化表示晶圆的边缘,再通过控制器处理多个灰度值变化序列得到晶圆轮廓图,进而获得晶圆的定位缺口的方向。上述技术方案的有益效果是:通过在晶圆传送盒设置晶圆方向识别系统,通过获取晶圆轮廓图的方式识别每一道工艺后晶圆的方向,方便工作人员在发

晶圆盒、晶圆传送系统及晶圆传送方法.pdf
本申请涉及半导体制备技术领域,特别是涉及一种晶圆盒、晶圆传送系统及晶圆传送方法,该晶圆盒包括:盒体、晶圆扫描装置、盒盖。盒体上设有与盒体内部相连通的开口。晶圆扫描装置包括第一晶圆扫描装置,晶圆扫描装置设置于盒体的内壁上,用于扫描盒体内晶圆的存放情况。盒盖扣设于开口处。晶圆盒的盒体的内壁上设有晶圆扫描装置,晶圆扫描装置实时扫描确认晶圆盒内的晶圆的存放情况。取代了晶圆盒每次上机台时,都需要机台的机械手臂对晶圆盒中的晶圆进行扫描,确认晶圆盒内的晶圆的存放情况。如此,可以节约大量时间,进而提高产能。并且,无需购买

一种晶圆传送装置和晶圆传送方法.pdf
本申请公开了一种晶圆传送装置和晶圆传送方法,涉及半导体设备制造领域。其中,晶圆传送装置包括处理腔室、导气管道和加热组件,本申请实施例通过在处理腔室的腔室内壁与外壳之间设置导气管道并在导气管道与腔室内壁间设置加热组件,使传送装置启动后通过加热组件对处理腔室和导气管道同时进行加热以起到气体烘干的效果,减少晶圆上的残留腐蚀气体在传送过程中冷凝生成聚合物。由此降低对晶圆传送装置造成污染和腐蚀,在保护晶圆传送装置的同时提高产品良率、降低运营成本。

一种晶圆传送盒搬运车.pdf
本实用新型公开一种晶圆传送盒搬运车,涉及晶圆传送盒搬运设备技术领域,以解决晶圆传送盒搬运效率低的问题。所述晶圆传送盒搬运车包括主体结构,主体结构上设置有用于承载晶圆传送盒的承载结构、用于实现晶圆传送盒移送/释放动作的执行机构以及用于实现主体结构移动的行走机构,执行机构包括叉架和驱动叉架运动的驱动装置,晶圆传送盒具有与叉架配合的叉口;晶圆传送盒搬运时,驱动装置驱动叉架伸入至叉口内实现晶圆传送盒的移送动作,或者驱动装置驱动叉架远离叉口实现晶圆传送盒的释放动作,所述晶圆传送盒搬运车用于搬运晶圆传送盒。

晶圆盒.pdf
一种晶圆盒,包括:盒体、门体和气体保压装置,其中所述盒体的一侧具有开口,所述盒体内具有容纳空腔,所述容纳空腔中用于放置晶圆并容纳保护气体;所述门体用于封闭所述盒体的开口;所述气体保压装置位于所述盒体的外侧表面,用于在所述门体将所述盒体密封后,向所述盒体的容纳空腔中释放保护气体。通过在晶圆盒的盒体上设置气体保压装置,使得晶圆盒内的保护气体的存留的时间大幅的延长,从而极大的延长了Q‑Time的时间,使得站点与站点之间的停留时间延长。
