
以低轮廓封装体封装键合线的方法.pdf

小琛****82








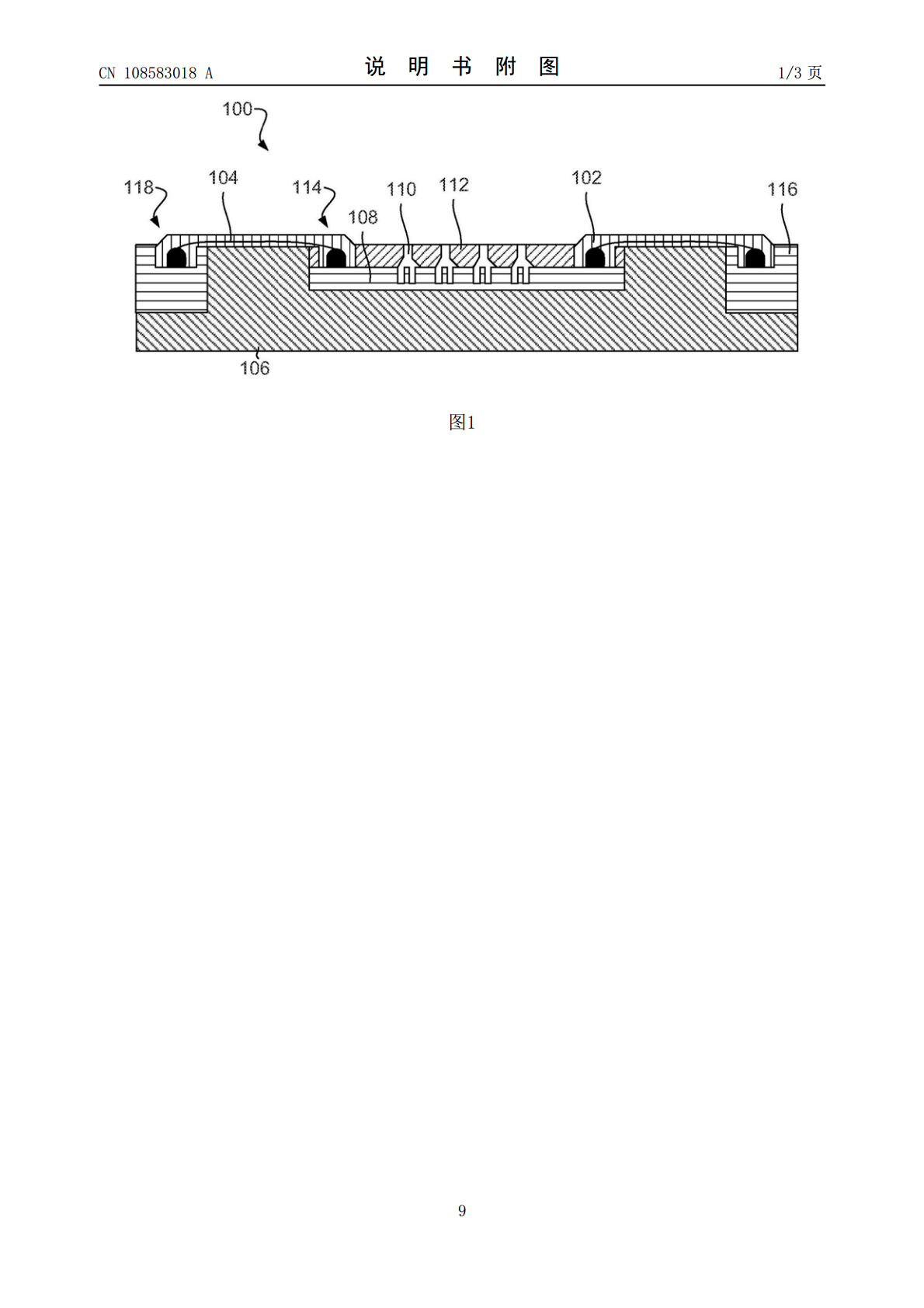
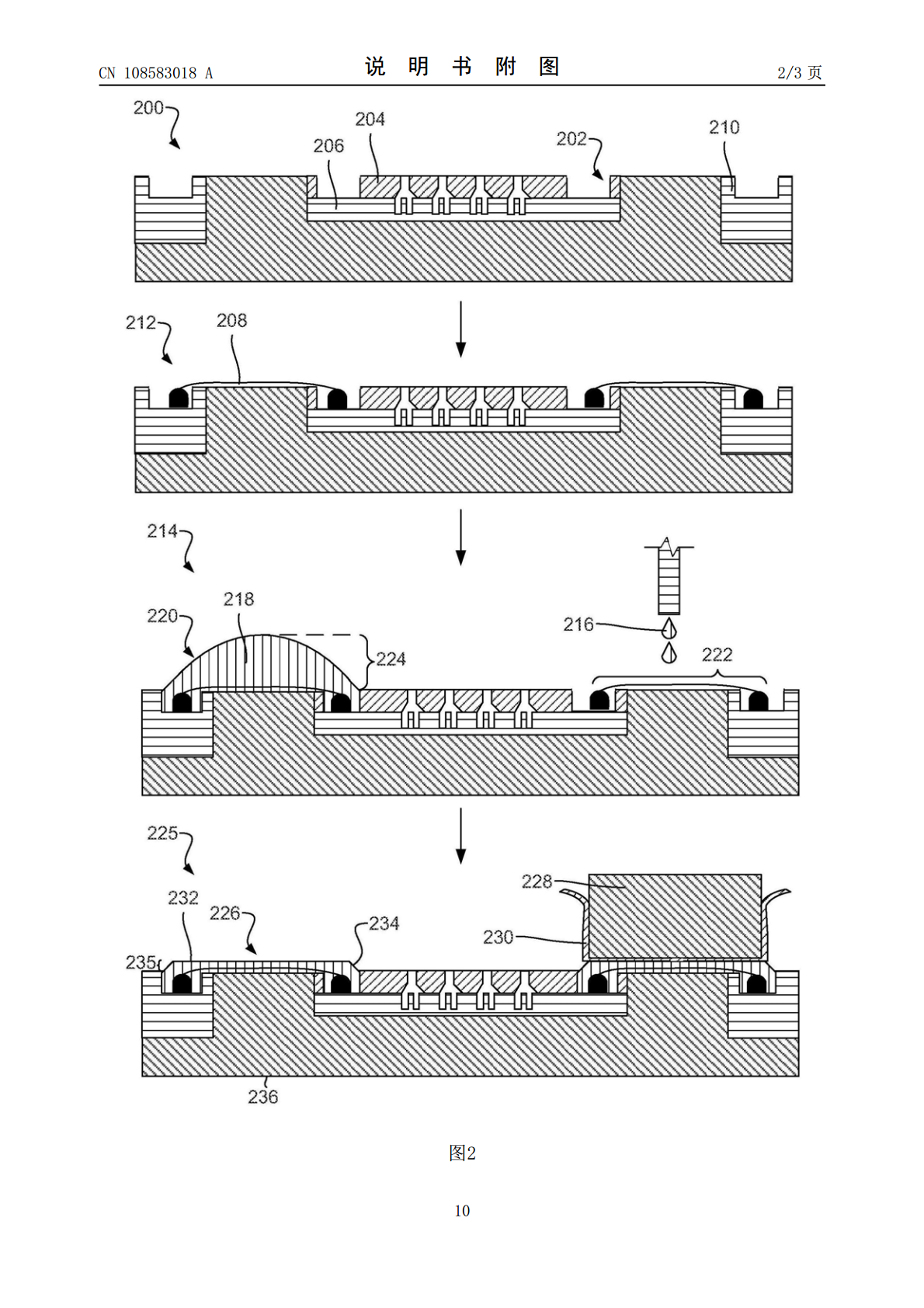
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

以低轮廓封装体封装键合线的方法.pdf
以低轮廓封装体封装键合线的方法包括:将封装体施加在键合线之上,该键合线在第一端连接至晶片并且在第二端连接至电路元件;和将所述封装体的形状截头,以形成截头形体。

以低轮廓封装体封装键合线的方法.pdf
以低轮廓封装体封装键合线的方法包括:将封装体施加在键合线之上,该键合线在第一端连接至晶片并且在第二端连接至电路元件;和将所述封装体的形状截头,以形成截头形体。

低轮廓微电子封装及其制造方法以及包含该低轮廓微电子封装的电子组件.pdf
一种低轮廓微电子封装包括管芯(110)(具有第一表面(111)和第二表面(112))及封装衬底(120)。衬底包括电绝缘层(121),其形成所述衬底的第一侧面(126);导电层(122),连接到管芯;以及导电层上的保护层(123),其形成衬底的第二侧面(127)。管芯的第一表面位于衬底的第一侧面。绝缘层具有形成于其中的多个焊盘。封装部件进一步包括互连结构(140)的阵列,位于衬底的第一侧面。所述互连结构的阵列中的每一互连结构都具有第一端部(141)和第二端部(142),第一端部连接到一个焊盘。

低轮廓传感器封装.pdf
本公开的实施例涉及低轮廓传感器封装。本公开针对光学传感器封装的实施例。例如,光学传感器封装的至少一个实施例包括第一树脂内的发光管芯、光接收管芯和互连衬底。第一透明部分定位在发光管芯和互连衬底上,并且第二透明部分定位在光接收管芯和互连衬底上。第二树脂分别在第一树脂、互连衬底与第一透明部分和第二透明部分上。第二树脂分别部分地覆盖第一透明部分和第二透明部分的相应表面,使得相应表面从第二树脂中暴露。

封装键合铂金丝及其制备方法.pdf
本发明涉及芯片封装技术领域,且公开了封装键合铂金丝及其制备方法,包括以下步骤:S1、将铂金属与铍、钙、铈、镧等微量元素投入真空熔铸炉,经过高温熔铸,得到特定直径的铂金属棒;S2、铂金属棒再经过多组模具进行拉伸,此拉伸过程中在某一线径进行中间退火;S3、中间退火的线材再次拉伸至半成品线材;通过铂金属代替传统的键合丝中的金和银金属,从而大大降低了键合丝的生产制造成本,从而间接的减低了芯片生产制造的成本,铂金属棒在通过模具拉绳的过程中,在某一线径的时候进行中间退火,然后再次被拉伸成半成品线材,半成品线材经过退火
