
去除伪栅多晶硅表面硬质掩膜层的方法.pdf

茂学****23






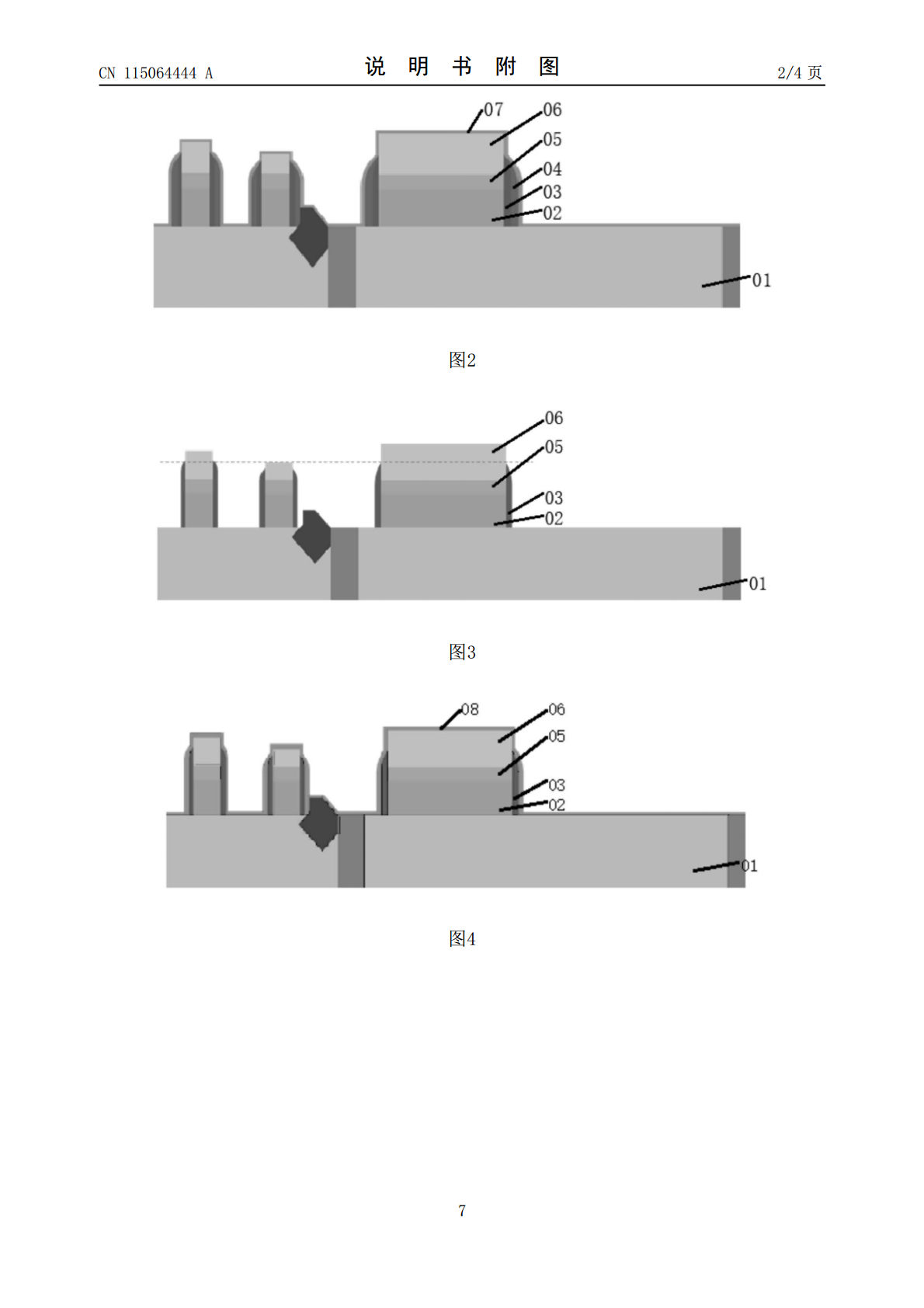
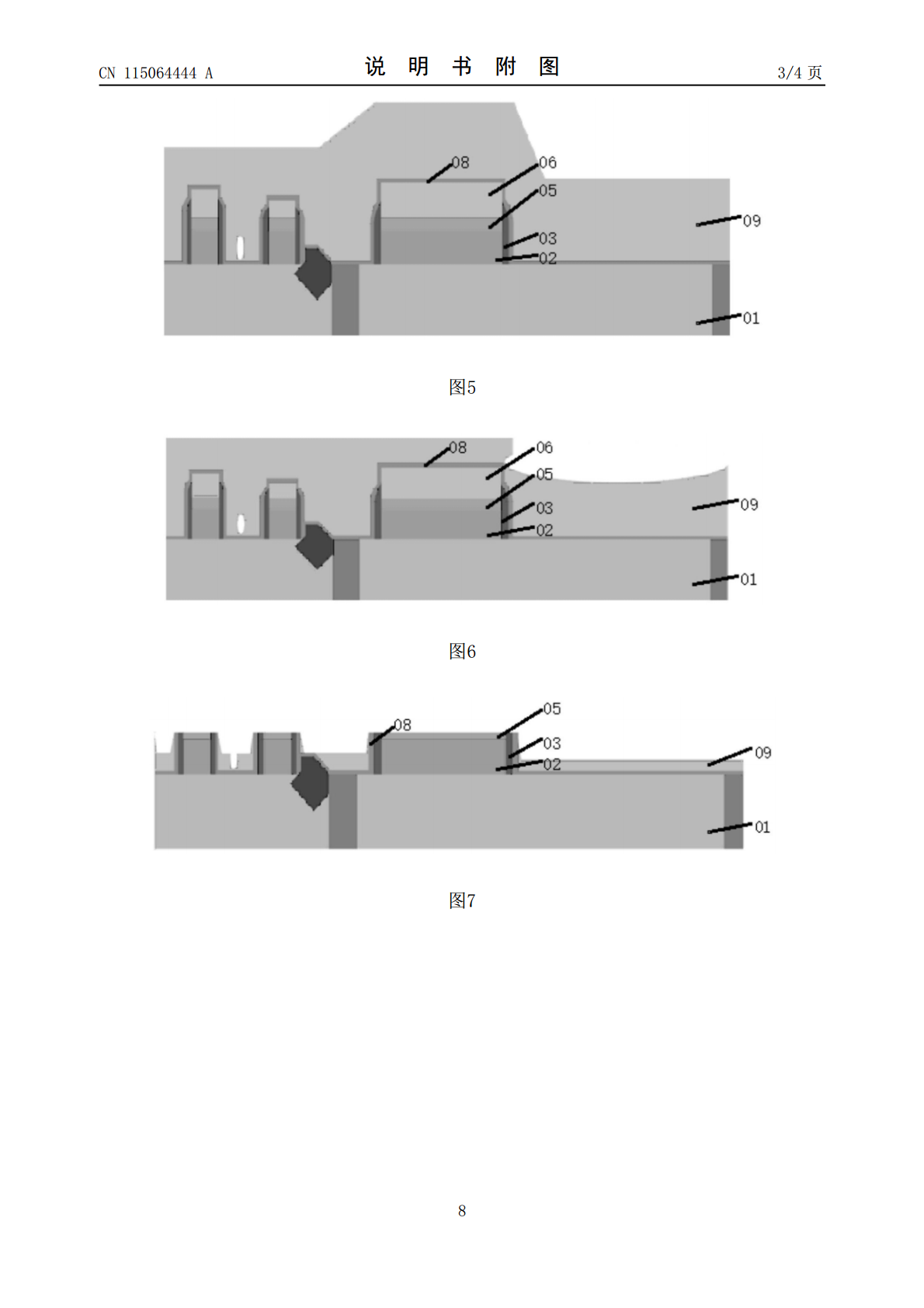
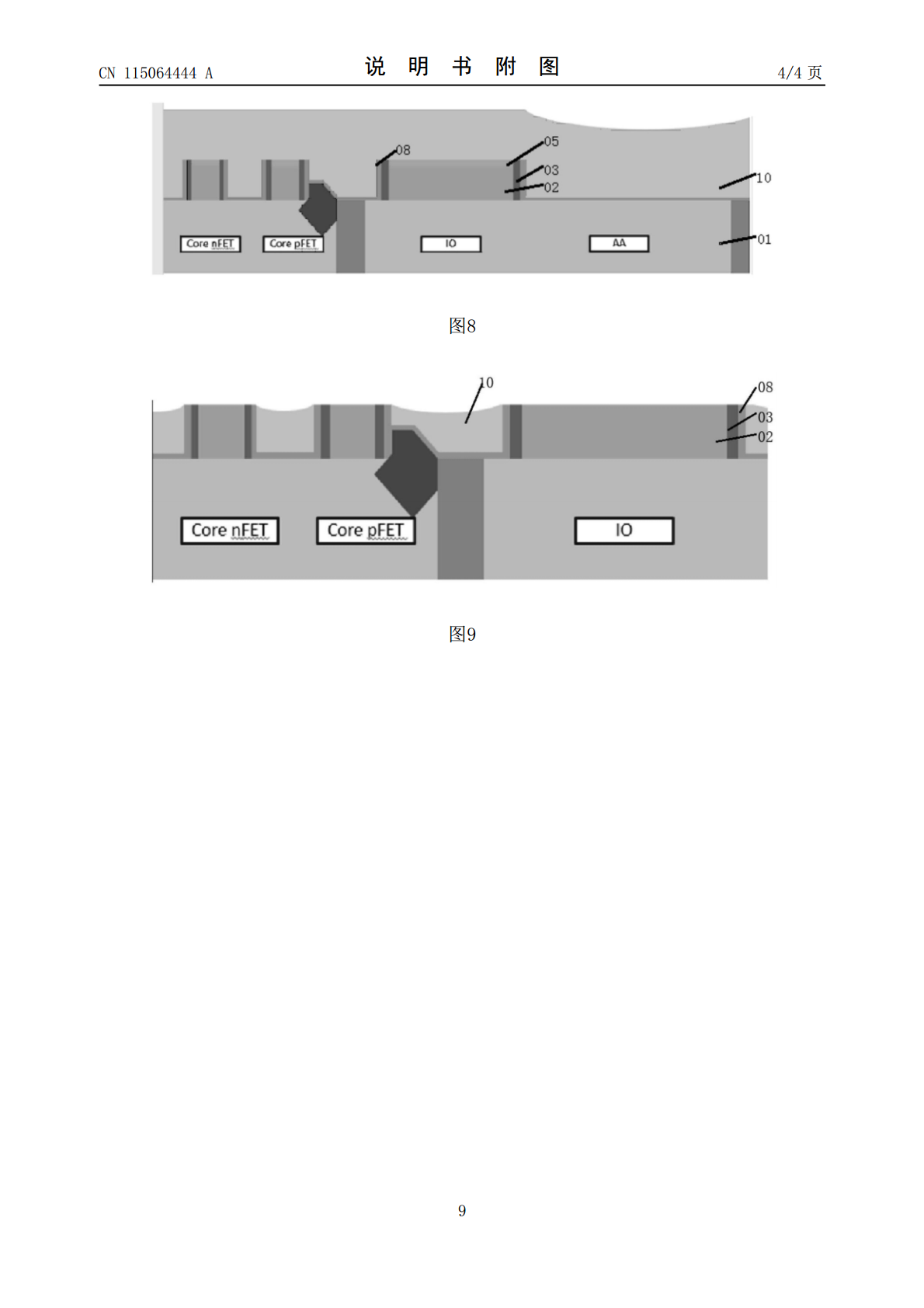
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

去除伪栅多晶硅表面硬质掩膜层的方法.pdf
本发明提供一种去除伪栅多晶硅表面硬质掩膜层的方法,提供衬底,衬底上形成有伪栅,伪栅包括由自下而上的伪栅多晶硅层、氮化层和氧化层以及依次形成于伪栅侧壁上的第一、二侧墙,伪栅的表面形成有第一刻蚀停止层;刻蚀去除第一刻蚀停止层和第二侧墙;在衬底上形成覆盖刻蚀后伪栅的第二刻蚀停止层;形成覆盖第二刻蚀停止层的第一层间介质层,之后研磨第一层间介质层至第二刻蚀停止层的上方;回刻第一层间介质层,使得氧化层去除;形成覆盖剩余的第一层间介质层、氮化层、第二刻蚀停止层、第一侧墙的第二层间介质层;研磨第二层间介质层至伪栅多晶硅层

锗硅生长后氮化掩膜层的去除方法.pdf
本发明提供一种锗硅生长后氮化掩膜层的去除方法,在氧化膜侧壁上形成氮化膜侧墙;将光刻胶覆盖氮化膜掩膜层和氧化膜上表面;利用N型、P型多晶硅栅极的高度差,使N型多晶硅栅极上的氧化膜掩膜层和氮化膜掩膜层露出,而P型多晶硅栅极上氧化膜表面仍被光刻胶覆盖;将N型多晶硅栅极上的氧化膜以及氧化膜掩膜层去除至露出氮化膜掩膜层;P型多晶硅栅极上的氧化膜仍被光刻胶覆盖;光刻胶剥离后去除氮化掩膜层和氮化膜侧墙。由于N型多晶硅栅极氧化掩膜层已经被单独刻蚀,所以DHF刻蚀时间可以大大缩短,P型多晶硅氧化膜不会过度消耗,有利于保护P

增大多晶硅栅极硬掩膜去除工艺窗口的方法.pdf
本申请公开了一种增大多晶硅栅极硬掩膜去除工艺窗口的方法,包括:提供一半导体衬底,通过预定工艺形成MOSFET器件结构;进行PMOS侧墙形成、P型注入和热退火工艺;沉积锗硅硬掩膜层;利用锗硅光罩通过光刻曝光,打开生长锗硅硬掩膜层的PMOS区域和多晶硅栅极顶部区域;蚀刻锗硅硬掩膜层,在PMOS源漏区域形成U型沟槽,同时刻蚀掉多晶硅栅极顶部的部分锗硅硬掩膜层;将U型沟槽蚀刻成Sigma型沟槽;沉积锗硅;去除多晶硅栅极顶部和侧壁的栅极硬掩膜层;重新生长NMOS侧墙,进行N型注入。通过打开多晶硅顶部,增大锗硅工艺中

掩膜版组件及掩膜版保护组件去除方法.pdf
本发明提供一种掩膜版组件及掩膜版保护组件的去除方法,掩膜版组件包括,光掩模版;掩膜版保护组件,掩膜版保护组件通过粘结物粘接在光掩模版上;以及冷却装置,冷却装置至少将粘结物冷却,从而使得粘结物脱离所述光掩模版。通过上述技术方案,本发明的掩膜版组件及掩膜版保护组件去除方法,通过冷却的方式使得光掩模版和保护框之间的粘结物脱离光掩模版,可以是使二者之间的粘结物硬化,从而使得粘结物脱离光掩模版,可以使得粘结物与保护框一同被移除,上述方式使得粘结物不会残留在光掩模版上,从而可以有效防止光掩模版的污染,防止光掩模版报废

去除栅介质层的方法.pdf
本发明提出一种去除栅介质层的方法,在形成层间介质层之后,刻蚀去除虚拟栅极之前,先对所述层间介质层以及侧墙进行第一次预处理,使层间介质层和侧墙的表面更加致密,降低后续刻蚀对层间介质层和侧墙的损伤;在进行刻蚀去除栅介质层时,同时对层间介质层以及侧墙进行第二次预处理,能够进一步的减少刻蚀时对所述层间介质层和侧墙的损伤,使层间介质层和侧墙的表面更平坦,能更好的控制形成金属栅的高度以及避免金属栅材料在层间介质层发生残留,从而可以提高形成的半导体器件的良率。
