
栅极侧墙的制造方法.pdf

努力****妙风









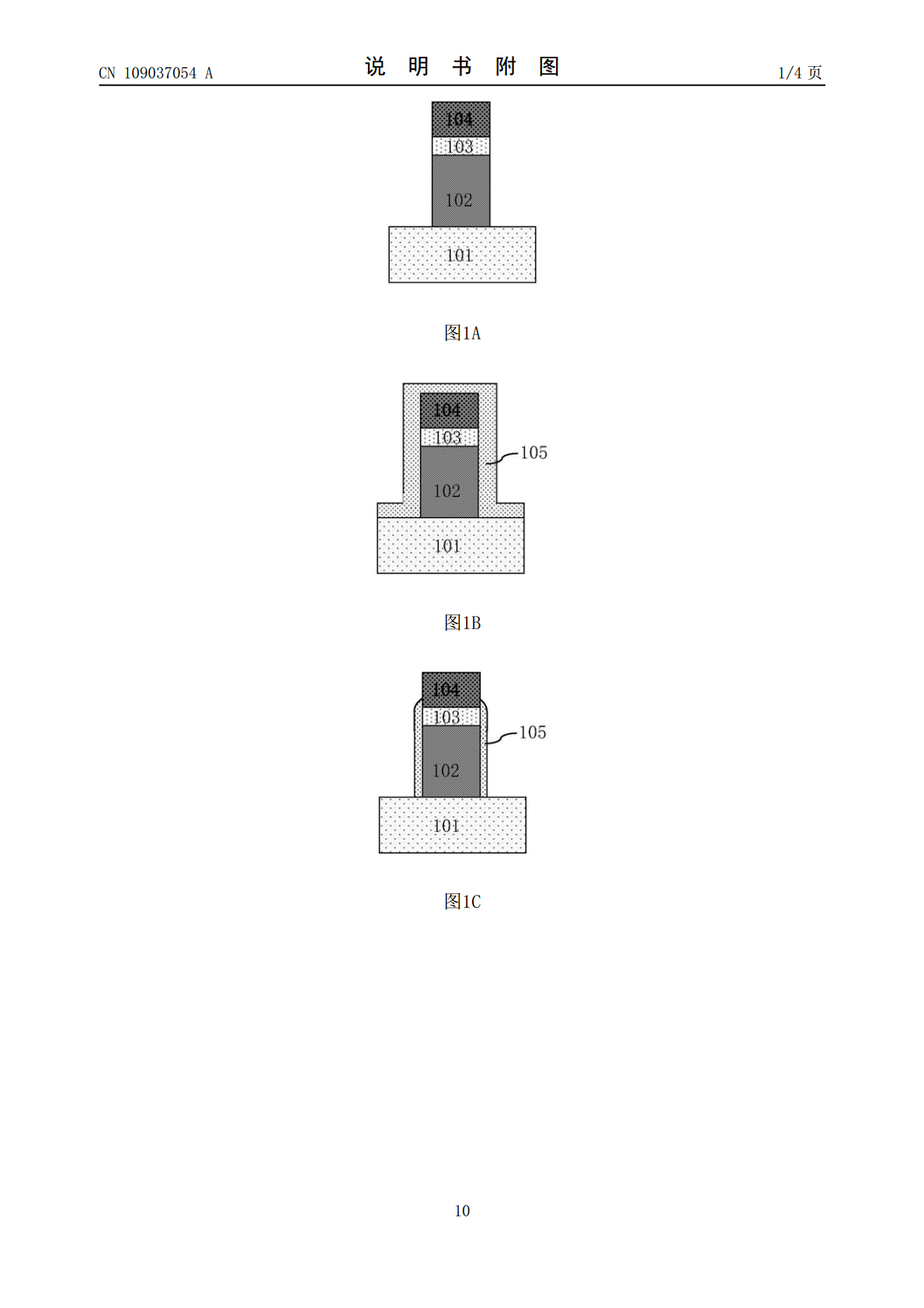
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

栅极侧墙的制造方法.pdf
本发明公开了一种栅极侧墙的制造方法,包括步骤:步骤一、在半导体衬底表面形成由栅介质层、多晶硅栅和硬质掩膜层叠加而成的栅极结构;步骤二、形成侧墙介质层;步骤三、在侧墙介质层的表面形成侧墙保护介质层;步骤四、对侧墙保护介质层进行第一次全面刻蚀并使侧墙保护介质层仅位于栅极结构侧面;步骤五、对侧墙介质层进行第二次全面刻蚀形成侧墙,所保留的侧墙保护介质层对侧墙的侧面进行保护,侧墙保护介质层和硬质掩膜层自对准暴露出侧墙的顶部表面从而能调节侧墙的高度;步骤六、去除所保留的侧墙保护介质层。本发明能防止侧墙的厚度减薄,使侧

改善栅极侧墙形貌的方法及半导体器件制造方法.pdf
本发明提供一种改善栅极侧墙形貌的方法以及半导体器件制造方法,在形成的侧墙层表面上覆盖一层保护层,该保护层包裹住侧墙层,这样使半导体衬底表面趋于平坦;然后,采用侧墙层和保护层具有高刻蚀选择比的穿通刻蚀工艺垂直刻蚀保护层,以去除保护层位于栅极结构顶部等平面上的部分,而保留位于所述栅极结构的侧壁及斜肩上的部分;之后在部分刻蚀侧墙层形成侧墙的过程中,斜肩上的保护层可以对其下的侧墙层进行保护,降低斜肩处侧墙材料的刻蚀损耗,从而可以最终获得宽度均匀性的侧墙,该侧墙可以增大后续在源/漏区上形成的接触孔与栅极结构之间的有

侧墙的制造方法.pdf
本发明公开了一种侧墙的制造方法,包括步骤:步骤一、形成栅介质层和多晶硅栅,在多晶硅栅的顶部表面形成有氮化硅组成的硬质掩模层;步骤二、采用原子层沉积工艺形成第二氮化硅层;步骤三、采用离子注入工艺进行氮化硅的修饰处理,多晶硅栅的侧面的第二氮化硅层保持为未被修饰处理;步骤四、采用DHF去除被修饰处理的氮化硅,未被修饰处理的氮化硅保留在多晶硅栅的侧面形成第一层侧墙。本发明能对多晶硅栅侧面外的采用ALD沉积的氮化硅进行很好的去除,避免在多晶硅栅顶部形成氮化硅侧墙围栏。

侧墙的制造方法.pdf
本发明公开了一种侧墙的制造方法,包括:步骤一、在半导体衬底上形成需要形成侧墙的第一图形结构;步骤二、沉积第一介质层;步骤三、进行第一次横向刻蚀,第一次横向刻蚀对第一介质层的横向刻蚀速率大于纵向刻蚀速率,第一次横向刻蚀使第一图形结构侧面的第一介质层的宽度做第一次减薄;步骤四、进行第二次刻蚀,第二次刻蚀对第一介质层的纵向刻蚀速率大于横向刻蚀速率,第二次刻蚀将第一图形结构顶部表面以及第一图形结构外第一介质层都去除,第二次刻蚀还对第一图形结构侧面的第一介质层的宽度做第二次减薄并由保留在第一图形结侧面的第一介质层作

一种功率器件栅极侧墙制备方法.pdf
本发明公开了一种功率器件栅极侧墙制备方法,包括:步骤1,在完成功率器件主体的多晶硅栅极刻蚀后,在所述功率器件主体的表面以及多晶硅栅极侧壁设置预定厚度的绝缘层;步骤2,在所述绝缘层上沉积绝缘保护层;步骤3,整面干法刻蚀所述绝缘保护层,将所述多晶硅栅极上方以及所述多晶硅栅极之间的所述绝缘保护层刻蚀干净;步骤4,整面干法刻蚀所述多晶硅栅极之间的所述绝缘层。通过在功率器件主体的栅极绝缘侧墙外侧沉积一层绝缘保护层,在干法刻蚀过程中,保护功率器件主体的多晶硅栅极的绝缘侧墙免受损失,使其保留较厚的厚度,从而改善器件的漏
