
改善栅极侧墙形貌的方法及半导体器件制造方法.pdf

岚风****55







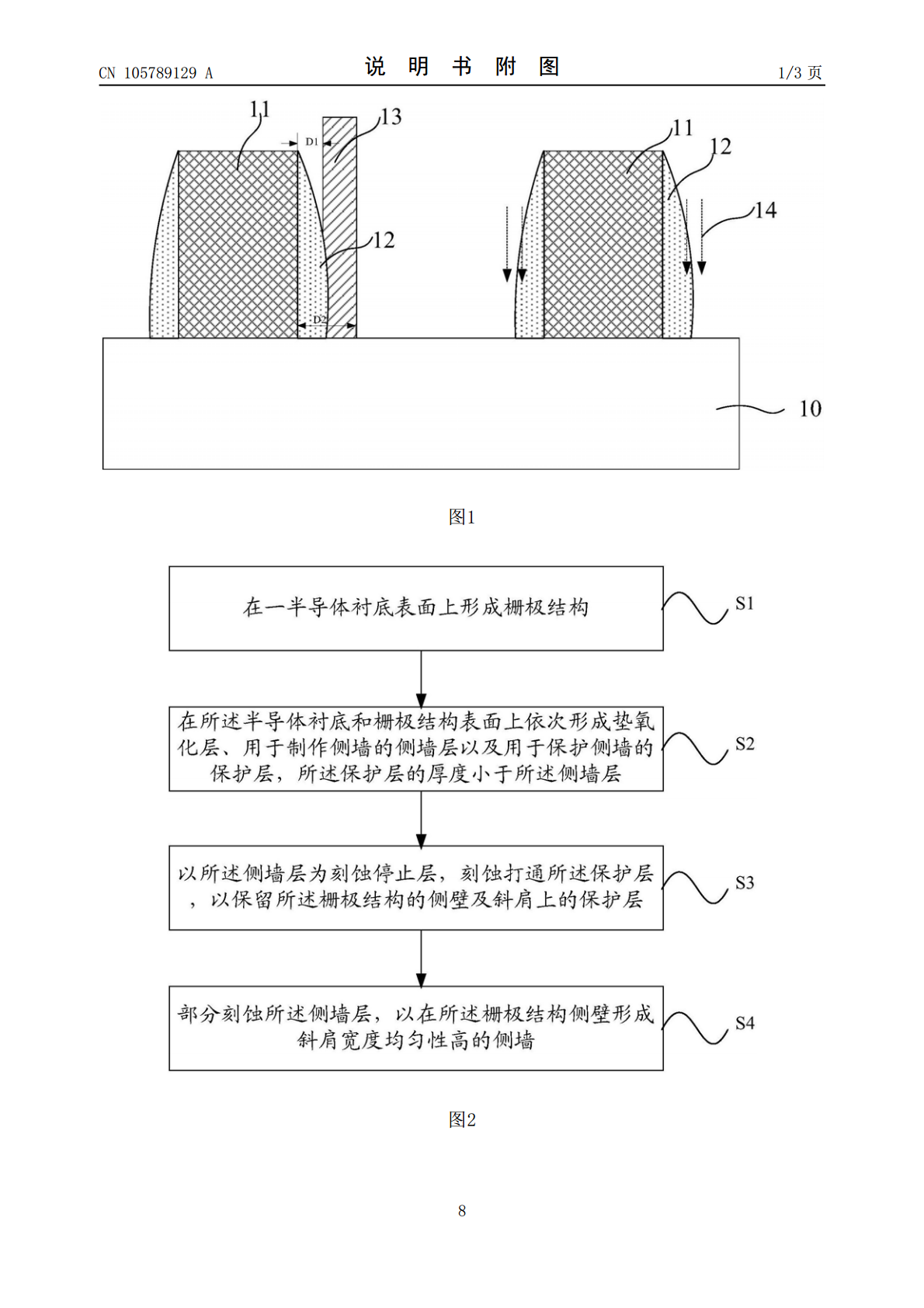
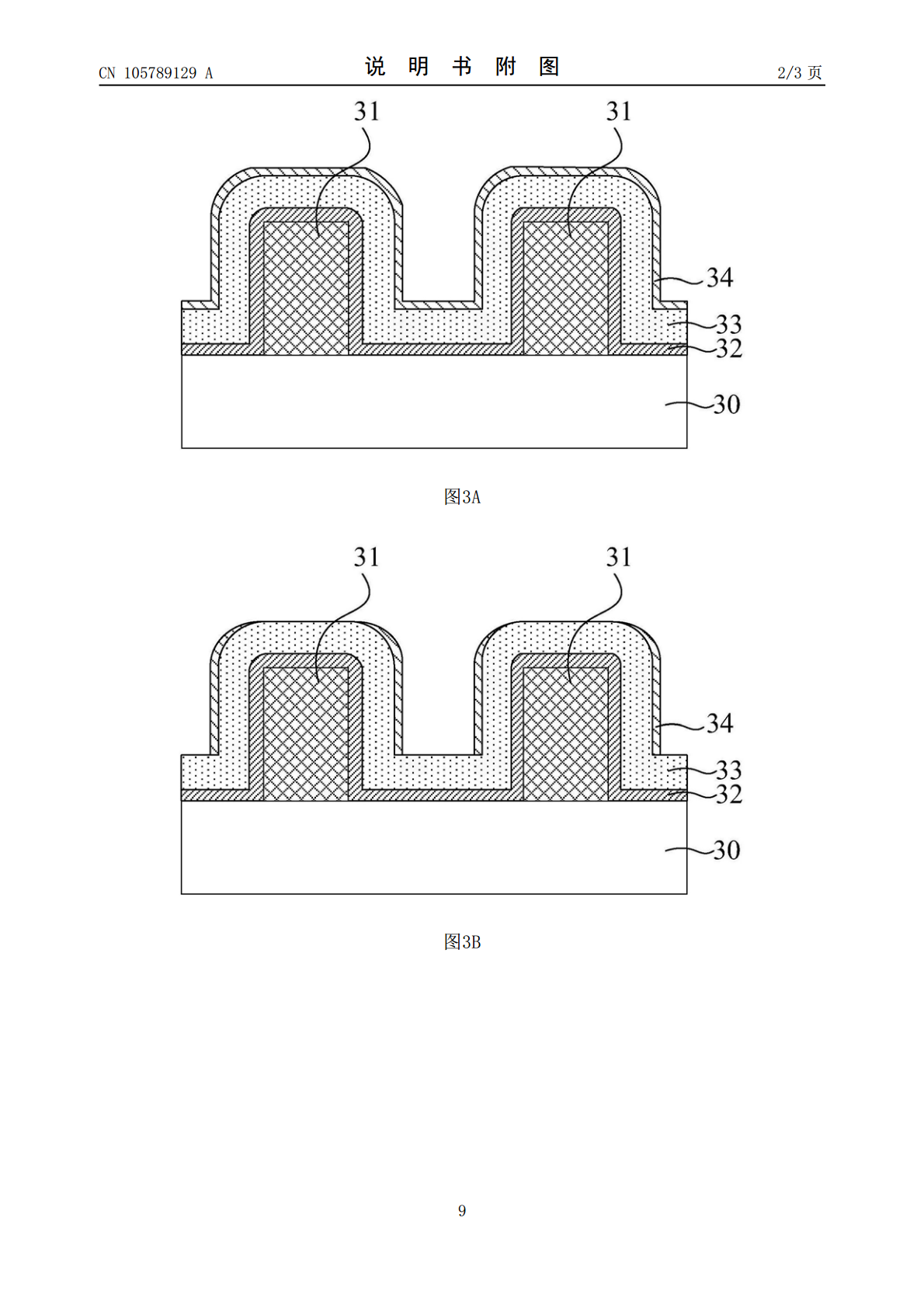

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

改善栅极侧墙形貌的方法及半导体器件制造方法.pdf
本发明提供一种改善栅极侧墙形貌的方法以及半导体器件制造方法,在形成的侧墙层表面上覆盖一层保护层,该保护层包裹住侧墙层,这样使半导体衬底表面趋于平坦;然后,采用侧墙层和保护层具有高刻蚀选择比的穿通刻蚀工艺垂直刻蚀保护层,以去除保护层位于栅极结构顶部等平面上的部分,而保留位于所述栅极结构的侧壁及斜肩上的部分;之后在部分刻蚀侧墙层形成侧墙的过程中,斜肩上的保护层可以对其下的侧墙层进行保护,降低斜肩处侧墙材料的刻蚀损耗,从而可以最终获得宽度均匀性的侧墙,该侧墙可以增大后续在源/漏区上形成的接触孔与栅极结构之间的有

改善栅极氧化层的方法及半导体器件的制造方法.pdf
本发明提供了一种改善栅极氧化层的方法及半导体器件的制造方法,所述改善栅极氧化层的方法包括:在栅极氧化层形成工艺之前对衬底进行高温热处理工艺,所述高温热处理工艺的温度不低于500℃。通过优先对衬底进行高温热处理,之后再形成栅氧化层的方法,一方面,可以将衬底中残留的一些Si‑H的键合形态去除,减少Si‑SiO

栅极侧墙的制造方法.pdf
本发明公开了一种栅极侧墙的制造方法,包括步骤:步骤一、在半导体衬底表面形成由栅介质层、多晶硅栅和硬质掩膜层叠加而成的栅极结构;步骤二、形成侧墙介质层;步骤三、在侧墙介质层的表面形成侧墙保护介质层;步骤四、对侧墙保护介质层进行第一次全面刻蚀并使侧墙保护介质层仅位于栅极结构侧面;步骤五、对侧墙介质层进行第二次全面刻蚀形成侧墙,所保留的侧墙保护介质层对侧墙的侧面进行保护,侧墙保护介质层和硬质掩膜层自对准暴露出侧墙的顶部表面从而能调节侧墙的高度;步骤六、去除所保留的侧墙保护介质层。本发明能防止侧墙的厚度减薄,使侧

用于半导体器件的栅极堆叠的制造方法.pdf
提供了一种用于半导体器件的栅极堆叠的制造方法。此方法包括:沉积多个栅极堆叠形成层于半导体表面上;依照预期的栅极堆叠的尺寸图案化附加栅极层,露出金属层的上表面;将功函数调控杂质从金属层露出的上表面掺入该金属层中且掺入该图案化的附加栅极层中;在掺入功函数调控杂质之后,以图案化的附加栅极层作为硬掩模,图案化金属层及该栅极绝缘层以形成栅极堆叠;移除该附加栅极层;以及在移除该附加栅极层之后,降低该源极区及该漏极区中所述功函数调控杂质的浓度。采用本申请的方案,通过在金属层中掺入具有在器件的源极区及漏极区之间变化的浓度

栅极堆叠的制造方法和半导体器件.pdf
本发明提出了一种具有牺牲金属去氧侧墙的栅极堆叠的制造方法,包括:在半导体衬底上形成由界面氧化物层、高K介电层和金属栅电极上构成的栅极堆叠结构;保形地沉积覆盖所述半导体衬底和所述栅极堆叠结构的金属层;以及对所述金属层选择性刻蚀处理,去除覆盖所述栅极堆叠结构顶部和所述半导体衬底的所述金属层,仅保留在所述栅极堆叠结构的外周围绕所述栅极堆叠结构的牺牲金属去氧侧墙。本发明还提出了一种通过上述工艺制造的半导体器件。
