
GaN器件SiC衬底刻蚀方法.pdf

雅云****彩妍








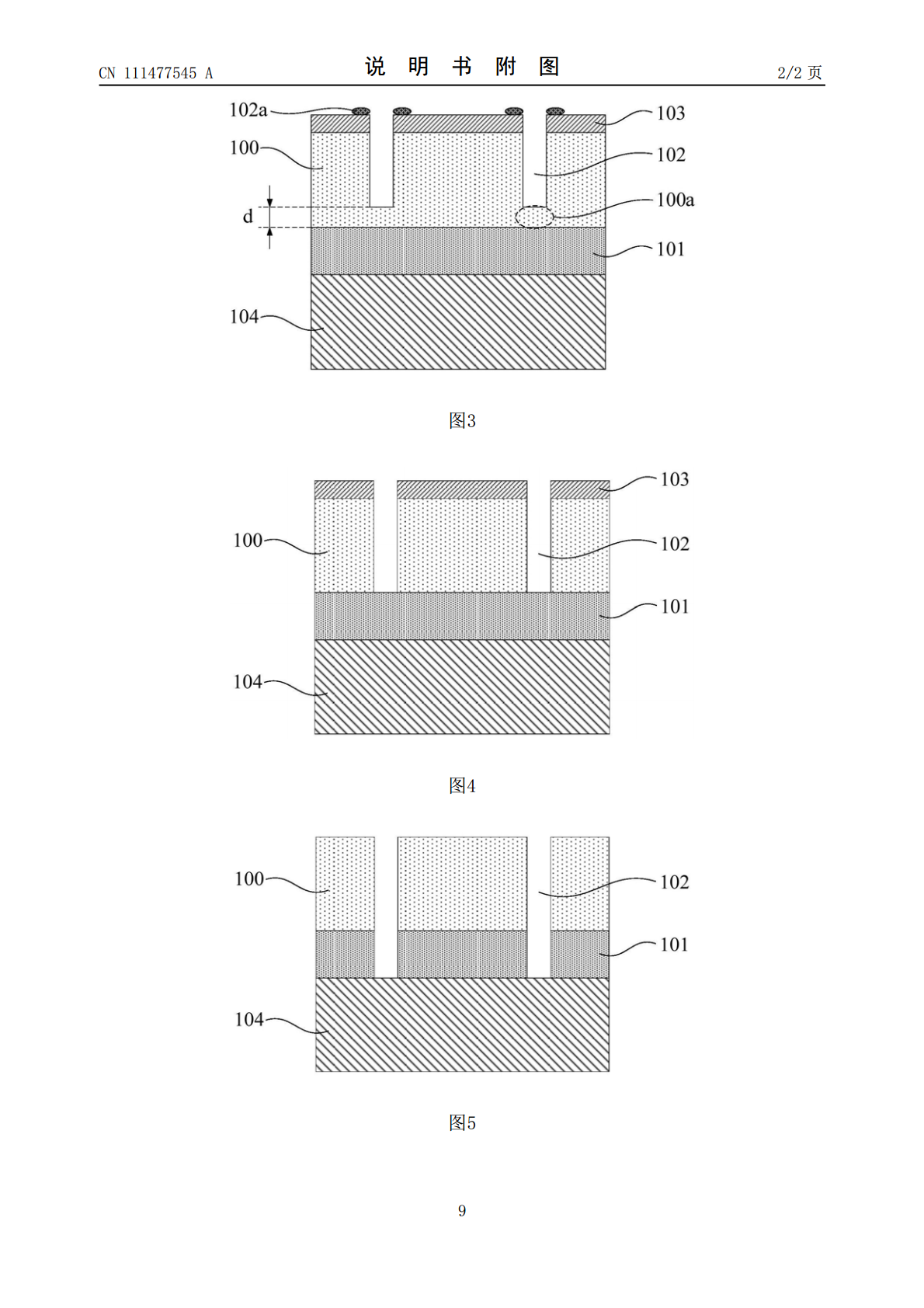
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

GaN器件SiC衬底刻蚀方法.pdf
本发明提供了一种GaN器件SiC衬底刻蚀方法,包括如下步骤:提供一衬底,所述衬底具有相对设置的第一表面和第二表面,在所述衬底的第一表面上形成有半导体器件层;通过激光刻蚀对所述衬底的第二表面进行刻蚀,并在所述衬底的第二表面形成盲孔;通过干法刻蚀对所述盲孔进行刻蚀,使所述盲孔贯通至所述半导体器件层远离所述衬底的表面。本发明通过采用激光刻蚀对SiC等衬底进行刻蚀,刻蚀过程稳定性好,可重复性高,避免了采用Ni等金属掩膜进行干法刻蚀所产生的沉积物;省去了制作光刻版的成本,简化了工艺复杂度和工艺时间;激光刻蚀过程不会

基于SiC衬底的准垂直GaN PIN与SBD集成式器件.pdf
本发明公开了一种基于SiC衬底的准垂直GaNPIN与SBD集成式器件,主要解决现有技术分立式PIN二极管用于多级限幅电路时功率容量受限,响应速度慢,集成度低的缺点。本发明碳化硅衬底(1)的上方淀积n+层(2),n+层(2)的上方并列淀积n?层(31)、公共阴极(5)、n?层(32),n?层(31)的上方依次淀积p+层(4)、PIN结阳极(6),n?层(32)的上方淀积肖特基结阳极(7)。本发明将GaNPIN与SBD通过共阴极的方式集成在同一碳化硅衬底上,同时PIN管与SBD管均设置为准垂直结构。本发明器件

一种基于n型导电SiC衬底的GaN完全垂直型电子器件及其制备方法.pdf
本发明涉及一种基于n型导电SiC衬底的GaN完全垂直型电子器件及其制备方法,从下至上依次包括漏极或阴极、n型导电SiC衬底、导电缓冲层、厚GaN外延层、源极或阳极;厚GaN外延层的厚度为1~100μm;本发明通过在n型导电SiC衬底上开发了导电缓冲层,在导电缓冲层通过外延生长,获得了无裂纹的厚GaN外延层,进而得到完全垂直型的GaN电子器件,改善了准垂直型器件的电流和电场拥挤的问题,静态电学性能优异,拥有良好的正反向电学特性;同时由于GaN比SiC材料的优势,本发明的完全垂直型的GaN电子器件性能更优,同

一种复合结构SiC衬底器件的切割方法.pdf
本发明是一种复合结构SiC芯片的切割方法,采用砂轮切割在划片槽区域把复合结构SiC芯片进行切割分离。通过先形成复合结构SiC芯片完成圆片;再测量其厚度;把SiC芯片完成圆片贴在切割片架上的蓝膜或UV膜上;测量其总厚度;应用第一切割条件切割开多层介质到SiC外延层,再针对SiC衬底应用第二切割条件切割到SiC衬底中,应用第三切割条件切割到SiC衬底与背面金属界面处,最后应用第四切割条件切割到背面多层金属厚度的1/2处,最终裂片分离SiC芯片。优点:可以很安全地实现复合结构SiC芯片的切割分离,有效减小复合结

衬底沟槽刻蚀方法.pdf
本发明公开了一种衬底沟槽刻蚀方法,包括:在衬底表面形成侧壁倾斜的凹槽;在凹槽的内表面形成保护层;去除凹槽中央区域的保护层,并保留凹槽边缘倾斜侧壁上的保护层;刻蚀衬底,在衬底中形成设定深度的沟槽,同时去除凹槽边缘倾斜侧壁上的保护层并在沟槽顶部边缘形成圆化顶角形貌。本发明能够获得理想的圆化硅顶角形貌,减轻后续介质填充后由于尖锐顶角造成的漏电风险。
