
超薄芯片的封装结构、柔性集成封装方法.pdf

Ch****75








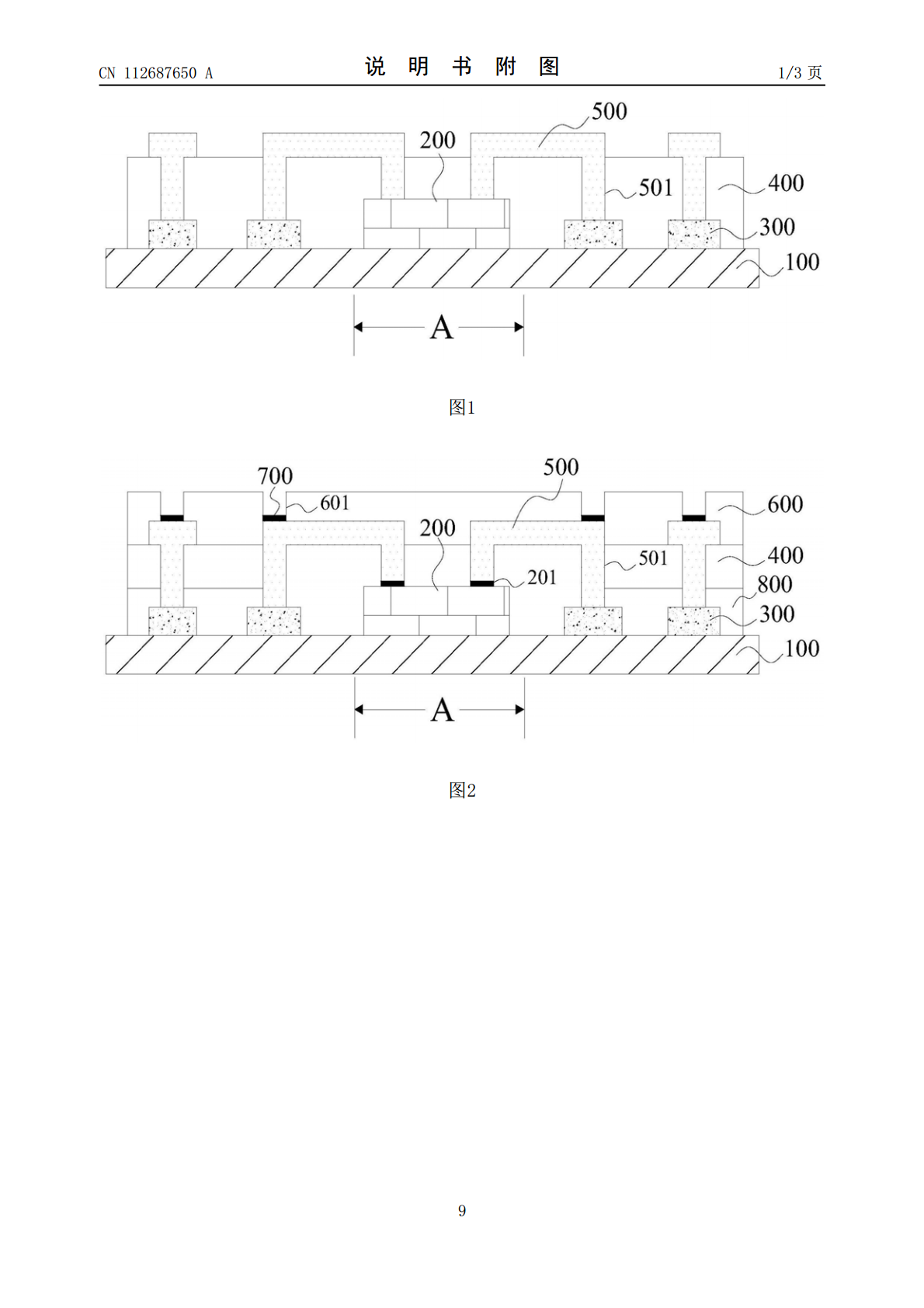

亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

超薄芯片的封装结构、柔性集成封装方法.pdf
本发明涉及超薄芯片的封装结构、柔性集成封装方法。该超薄芯片的封装结构包括:布线层;柔性线路板介质层,设置在布线层的表面且设置有开槽;至少一个超薄芯片,设置在开槽内;感光显影型覆盖膜,覆盖超薄芯片和柔性线路板介质层;盲孔,贯穿感光显影型覆盖膜和柔性线路板介质层;连接电极,通过盲孔将超薄芯片与布线层电连接。本发明所提出的封装结构,采用柔性的感光显影型覆盖膜代替保护膜,并通过贯穿感光显影型覆盖膜和柔性线路板介质层的盲孔,将超薄芯片与柔性线路板介质层背面的布线层互连,如此优化布线可以实现单颗或多颗超薄芯片的嵌入式

超薄芯片的封装结构、柔性集成封装方法.pdf
本发明涉及超薄芯片的封装结构、柔性集成封装方法。该封装结构包括:柔性线路板,其一侧表面上设置有贴合区;至少一个超薄芯片,设置在贴合区内;布线层,设置在贴合区以外;感光显影型覆盖膜,设置在超薄芯片和布线层远离柔性线路板的表面;连接电极,通过感光显影型覆盖膜上的盲孔将超薄芯片与布线层电连接。本发明所提出的超薄芯片的封装结构,采用柔性线路板作为封装基板,并通过感光显影型覆盖膜,且采用多层次布线,如此,封装结构的厚度在100微米以下,表现形态上具有可柔、可弯折的特点,从而实现超薄芯片的柔性集成封装,及封装结构的整

芯片封装方法及芯片封装结构.pdf
本发明提供一种芯片的封装方法,其包括以下步骤:依次叠合一第一胶片、多个芯片及一第二胶片,压合使所述第一胶片与所述第二胶片固化,形成一封装体,使所述多个芯片埋入所述封装体中,其中,每个所述芯片上具有多个引脚,所述多个引脚远离所述第一胶片;自第二胶片远离第一胶片的表面向第二胶片内部形成与每个引脚一一对应的盲孔,每个引脚均从对应的盲孔露出;在所述盲孔的内壁形成与对应的引脚电导通的导电层;在每个盲孔上形成与对应盲孔的导电层电导通的金属块,形成封装基板;切割所述封装基板,形成多个包括有一个芯片的封装结构。本发明还涉

芯片封装方法及芯片封装结构.pdf
本发明涉及一种芯片封装方法及芯片封装结构,所述芯片封装方法通过在载板的第一表面设置第一线路及第二表面设置第二线路;将芯片设置于所述载板,该芯片与第一线路和/或第二线路连接;设置第三线路;在对载板的第三表面和/或第四表面金属化形成金属部;对芯片进行包封,形成芯片封装结构;使得芯片封装结构内的所述芯片与第一线路电性连接;所述金属部与第一线路、第二线路及第三线路中的至少一个线路电性连接。通过所述金属部、第三线路及第一定位孔使得芯片与载板上的第一线路、第二线路连通,避免的现有技术中的通过引线将芯片与载板的线路导通

芯片封装方法及芯片封装结构.pdf
本发明提供一种芯片封装方法及芯片封装结构,在元件晶圆上形成有暴露用于晶片堆叠的预留位置表面的具有较低热膨胀系数的热膨胀系数过渡层,可以避免包封层对元件晶圆上的晶片和热膨胀系数过渡层包封后引起较大的热膨胀系数不匹配的问题,由此能够改善晶圆翘曲和应力引起的分层的问题,避免堆叠的晶片和包封层从元件晶圆上剥离,提高封装结构的性能;进一步的,所述热膨胀系数过渡层采用印刷电路板用阻焊剂材料形成,易于实现,不会产生副作用,并可以增强与后续包封层之间的粘附性,避免包封层从元件晶圆表面剥离。
