
日盲紫外光电探测器及其制备方法.pdf

小代****回来









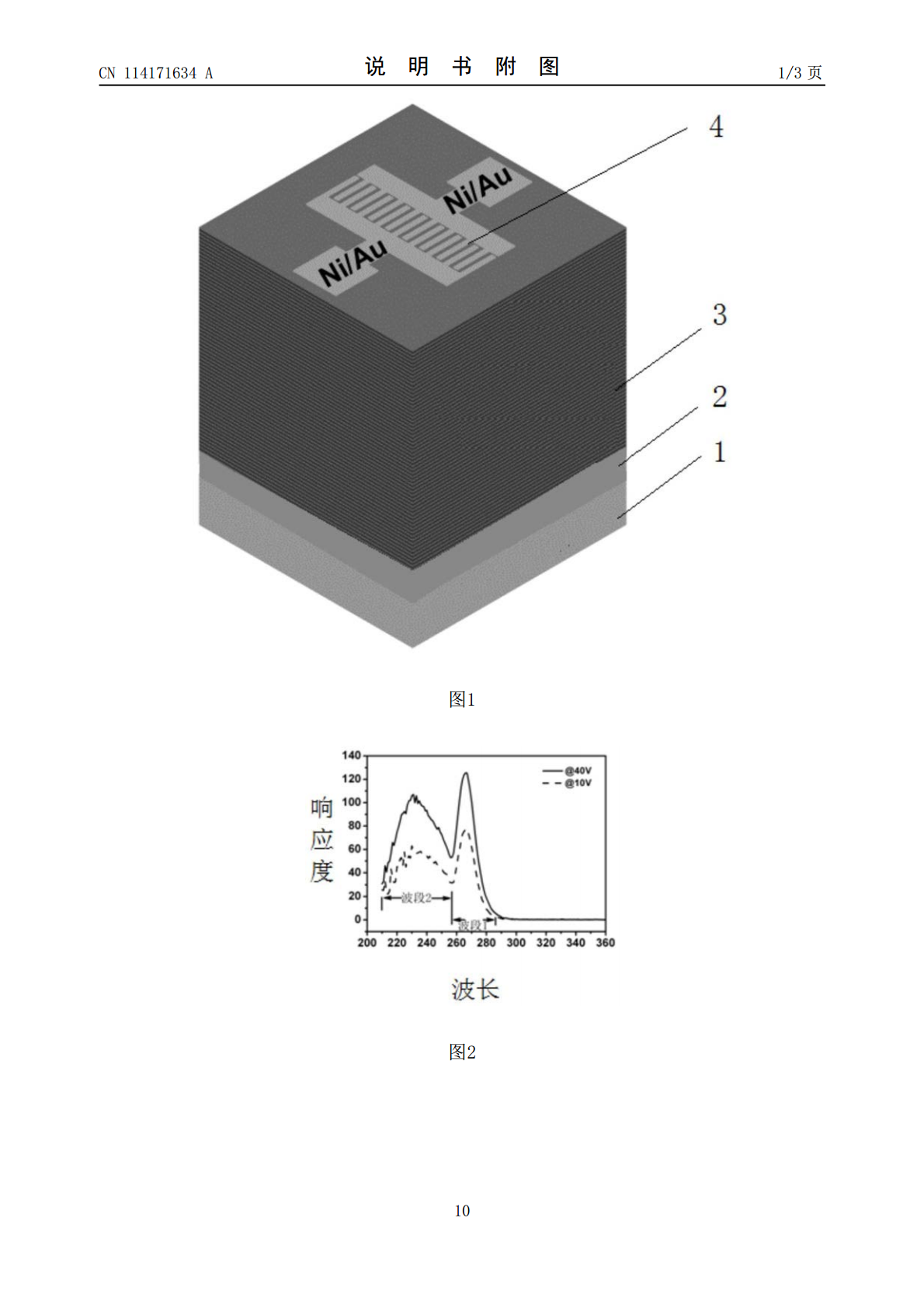
亲,该文档总共12页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

日盲紫外光电探测器及其制备方法.pdf
本发明提供一种日盲紫外光电探测器及其制备方法,日盲紫外光电探测器包括从下至上依次设置的基底、缓冲层、多周期薄膜层、金属叉指电极;多周期薄膜层至少为双层结构,多周期薄膜层的各层由GaN、Al

日盲紫外探测器及其制备方法、以及日盲紫外探测方法.pdf
本申请提供一种日盲紫外探测器及其制备方法、以及日盲紫外探测方法,属于日盲紫外探测技术领域。探测器包括:高阻非晶氧化镓层,氧空位浓度和致密度可在1~2sccm的氧流量条件下磁控溅射沉积,厚度15~30nm,有相对的第一和第二表面;低阻非晶氧化镓层,氧空位浓度和致密度可在不高于0.2sccm的氧流量条件下磁控溅射沉积,连接于第一表面;收集电极,有分别与第二表面连接的第一和第二电极。探测方法采用探测器,包括:在20~100V的工作电压下进行探测;或每次探测后转换电压正负性。探测器作为两端结构可兼具高的响应度和低

日盲紫外探测器及其制备方法、以及日盲紫外探测方法.pdf
本申请提供一种日盲紫外探测器及其制备方法、以及日盲紫外探测方法,属于日盲紫外探测技术领域。探测器包括:高阻非晶氧化镓层,其氧空位浓度和致密度可在1~2sccm的氧流量条件下磁控溅射沉积得到,厚度为15~30nm,具有相对的第一表面和第二表面;低阻非晶氧化镓层,其氧空位浓度和致密度可在不高于0.2sccm的氧流量条件下磁控溅射沉积得到,连接于第一表面;收集电极,具有分别与第二表面连接的第一电极和第二电极。探测方法包括:在20~100V的工作电压下,采用探测器对日盲紫外光进行探测。探测器作为两端结构可兼具高的

一种日盲紫外雪崩光电探测器及其制备方法.pdf
本发明公开了一种日盲紫外雪崩光电探测器及其制备方法,其中光电探测器的结构从下至上依次为AlN模板层、AlN缓冲层、n型Al

增强日盲光电响应的紫外探测器的制备方法.pdf
本发明揭示了一种增强日盲光电响应的紫外探测器的制备方法,其包括如下步骤:1)采用GaN外延片作为衬底材料;2)在所述GaN外延片上沉积一层掺镓氧化锌(GZO)薄膜;3)将所述一层掺镓氧化锌(GZO)薄膜与GaN外延片的表面之间形成肖特基接触;以及4)在所述一层掺镓氧化锌(GZO)薄膜的表面上沉积Ti/Au,作为加厚电极。本发明的制备工艺简单,器件成本低,同时还提高了器件的紫外探测灵敏度,适于日盲紫外探测器的工业化推广。
