
一种肖特基器件用硅外延片的制备方法.pdf

鸿朗****ka








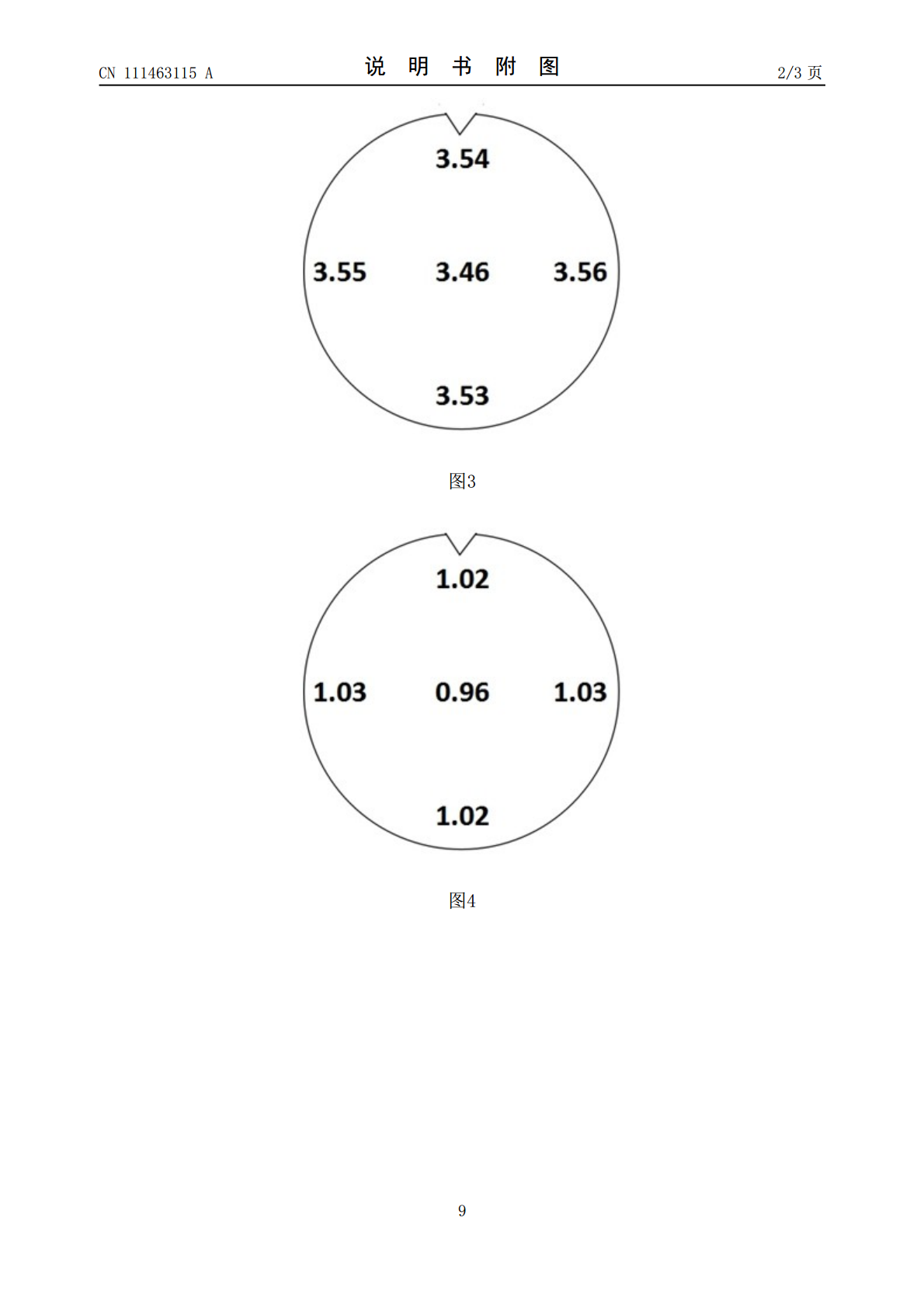

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种肖特基器件用硅外延片的制备方法.pdf
本发明涉及一种肖特基器件用硅外延片的制备方法,向硅外延炉反应腔体内通入氯化氢气体,对基座上残余沉积物质进行刻蚀;将主工艺氢气携带气态三氯氢硅进入硅外延炉反应腔体,基座表面沉积一层无掺杂的致密多晶硅;将基座温度降低,向基座上装入硅衬底片;基座升温,对硅衬底片的表面进行高温烘焙;通入主工艺氢气对硅外延炉反应腔体进行吹扫;主工艺氢气携带气态三氯氢硅进入硅外延炉反应腔体,基座下部流入与主工艺氢气流动方向相反的辅助氢气,三氯氢硅在管路中排空;通入主工艺氢气对硅外延炉反应腔体进行吹扫;进行硅外延层生长;硅外延层生长完

一种高频器件用硅外延片的制备方法.pdf
本发明涉及一种高频器件用硅外延片的制备方法,硅外延炉反应腔体的基座升温,通入氯化氢气体对硅外延炉反应腔体的基座进行一次刻蚀,随后将基座温度降温;硅衬底片装在硅外延炉反应腔体的基座上,对硅衬底片表面进行气相抛光;使用氢气对反应腔体进行吹扫;三氯氢硅原料位于鼓泡器内,以氢气鼓泡的方式进入反应腔体,作为硅外延层的生长原料;硅外延片的硅外延层生长完成后,待温度降低后从基座上取出;硅衬底片导电类型为N型,电阻率低于0.005Ω·cm;硅外延片的硅外延层导电类型为N型,厚度为0.3~0.7μm,表层电阻率高于0.3Ω

一种肖特基器件用重掺薄磷衬底上硅外延层的制备方法.pdf
本发明涉及一种肖特基器件用重掺薄磷衬底上硅外延层的制备方法,采用常压平板式外延炉,步骤包括,(1)利用纯度≥99.99%的氯化氢在高温下对外延炉基座进行抛光;(2)向外延炉内装掺磷硅衬底片,依次用纯度均≥99.999%的氮气和氢气吹扫外延炉腔体;(3)利用氯化氢气体对硅衬底片表面进行抛光;(4)采用大流量氢气对硅衬底片表面进行吹扫;(5)进行本征外延层的生长;(6)对外延炉反应腔室进行变流量吹扫;(7)进行掺杂外延层的生长。有益效果是外延层为厚度不均匀性

HEMT外延片及其制备方法、HEMT器件.pdf
本公开提供了一种HEMT外延片及其制备方法、HEMT器件,属于半导体器件技术领域。所述HEMT外延片包括:Si衬底、依次层叠在所述Si衬底上的复合过渡层、AlGaN缓冲层、AlGaN高阻层、GaN沟道层、AlGaN势垒层与GaN盖帽层,所述复合过渡层包括依次层叠在所述Si衬底上的低温BP成核层、高温BP成核层和预铺Al层,所述低温BP成核层的生长温度低于所述高温BP成核层的生长温度。

一种肖特基器件的制备方法及结构.pdf
本发明提供一种肖特基器件的制备方法及结构,该方法包括:在衬底上形成沟槽;用高密度等离子体气相沉积法在沟槽底部填充底部氧化层;在沟槽内填满光阻后去除沟槽外的氧化层;在沟槽侧壁上生长栅氧层并于沟槽内填充导电材料;去除沟槽上部的部分导电材料及栅氧层,在沟槽中部保留栅氧层及导电材料;在衬底表面、沟槽上部沉积肖特基金属层;在肖特金属层上形成电极层和金属引线层;电极层下凹填满沟槽的上部空间。本发明有利于在保持器件低漏电、耐压的基础上增加器件的抗反向浪涌能力,有效的降低相同器件面积下的沟槽型肖特基器件的正向导通电压,可
