
一种原子层沉积制备薄膜材料的装置和方法.pdf

春景****23







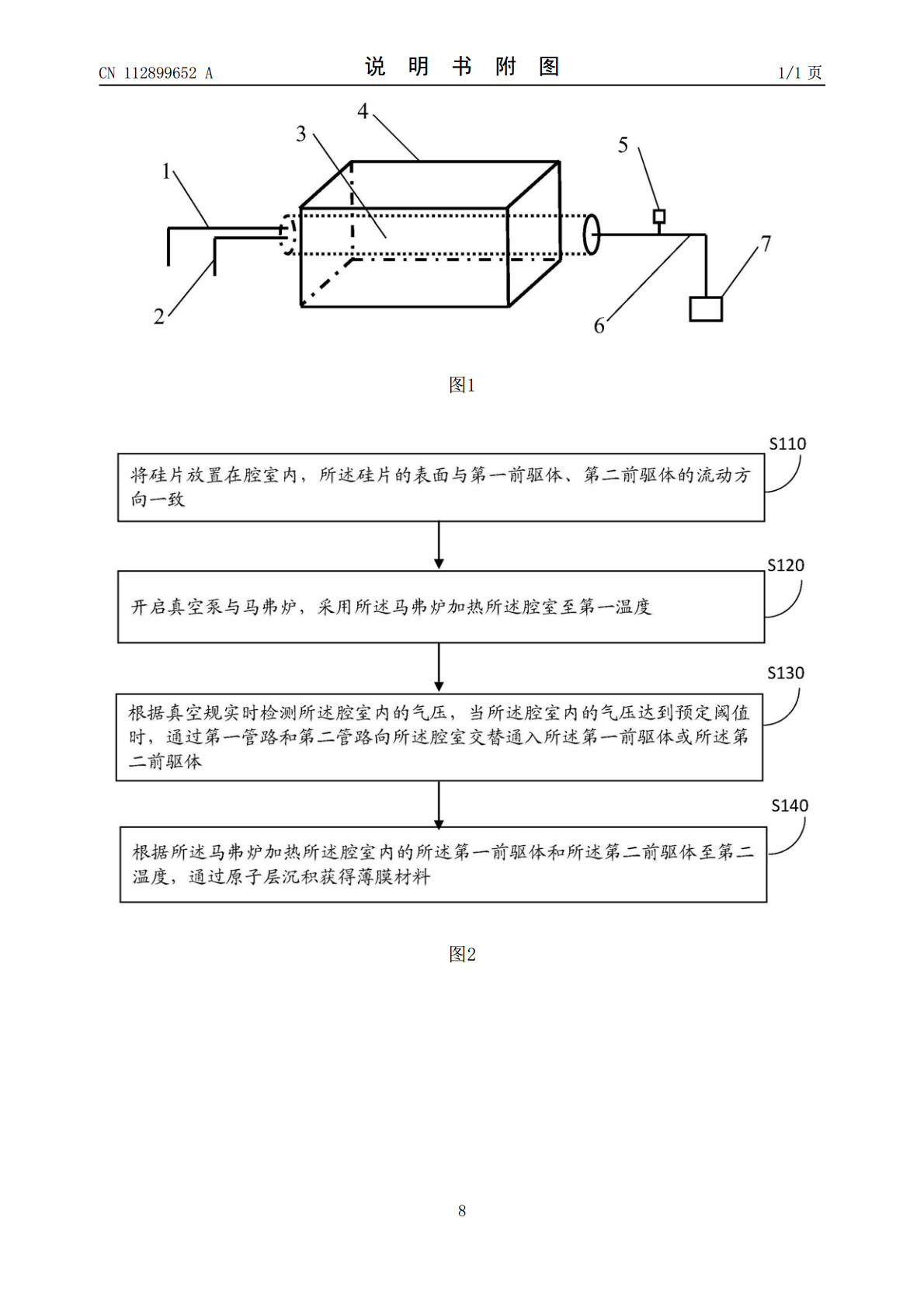
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种原子层沉积制备薄膜材料的装置和方法.pdf
本发明公开了一种原子层沉积制备薄膜材料的装置和方法,通过腔室;第一管路,所述第一管路与所述腔室的一端连通,且所述第一管路通入第一前驱体进入所述腔室;第二管路,所述第二管路与所述腔室的一端连通,且所述第二管路通入第二前驱体进入所述腔室;马弗炉,所述马弗炉设置在所述腔室的外侧,且所述马弗炉采用分段加热所述腔室,其中,所述马弗炉第一段加热衬底至第一温度,在所述第一温度下向所述腔室通入所述第一前驱体与所述第二前驱体,所述马弗炉第二段加热至第二温度;抽真空管路,所述抽真空管路的一端与所述腔室的另一端连通。达到提高前

一种原子层沉积技术制备银薄膜的方法.pdf
本发明涉及一种原子层沉积技术制备银薄膜的方法,包括银前躯体、肼类还原剂、待镀基料、银源罐、还原剂钢瓶、反应室、运输管道、ALD脉冲阀门,所述银前驱提选用液态银源,作为金属有机化合物前驱体与所述待镀基料表面发生化学自饱和吸附并发生交换反应,在所述待镀基料表面生成银置换前驱体,所述银置换前驱体再与肼类还原剂发生还原反应,生成银薄膜。本发明选用液态银源为银前驱体,可以避免银源在使用过程中冷凝从而堵塞阀门,并且可以良好的控制沉积工艺,降低生产成本;选用肼类还原剂为还原性前驱体,可以直接利用热型原子层沉积技术即可沉

一种原子层沉积技术制备单质钯薄膜的方法.pdf
本发明涉及单质钯薄膜制作方法技术领域,且公开了一种原子层沉积技术制备单质钯薄膜的方法,所述方法包括钯前驱体和肼类还原性前驱体,钯前驱体可采用六氟乙酰丙酮钯Pd(hfac)2,肼类还原性前驱体可采用无水肼、甲基肼、乙基肼、丙基肼、叔丁基肼等等C1‑C5的烃链还原性前驱体,肼类还原剂结构式为R1R2N‑NR3R4,其中R1、R2、R3、R4包括氢原子、C1‑C5的烃链,R1、R2、R3、R4可以相同也可以不同。本发明选用肼类还原剂为还原性前驱体,可以直接利用热型原子层沉积技术即可沉积单质钯薄膜,优于现有技术中

一种用于制备铱薄膜的原子层沉积技术及方法.pdf
本发明公开了一种用于制备铱薄膜的原子层沉积技术及方法,包括液态铱源和肼类还原剂,所述液态铱源作为前驱体,肼类还原剂作为还原性前驱体,所述液态铱源可采用1‑乙基环戊二烯基‑1、3‑环己二烯基铱(Ι)等原材料。本发明选用液态铱源Ir为铱前驱体,可以避免铱源在使用过程中冷凝从而堵塞阀门,并且可以良好的控制沉积工艺,降低生产成本,选用肼类还原剂为还原性前驱体,可以直接利用热型原子层沉积技术即可沉积单质铱薄膜,优于现有技术中所使用的等离子NH3、氢气等气体,在使用过程中,更方便、更安全、更容易操作,既可以避免等离子

一种高温原子层沉积装置和方法.pdf
本发明公开了一种高温原子层沉积装置和方法,通过腔室,所述腔室为柱状管式腔体结构;第一管路,所述第一管路与所述腔室的一端连通,且所述第一管路通入第一前驱体进入所述腔室;第二管路,所述第二管路与所述腔室的一端连通,且所述第二管路通入第二前驱体进入所述腔室;马弗炉,所述马弗炉设置在所述腔室的外侧;抽真空管路,所述抽真空管路的一端与所述腔室的另一端连通。解决现有技术中原子层沉积设备腔室为金属且腔体较大,对于腔室的升温和降温速度缓慢,不适宜活性较低的原子层沉积前驱体的技术问题,达到了前驱体气流的单向流动,缩短工艺吹
