
一种高温原子层沉积装置和方法.pdf

一条****淑淑







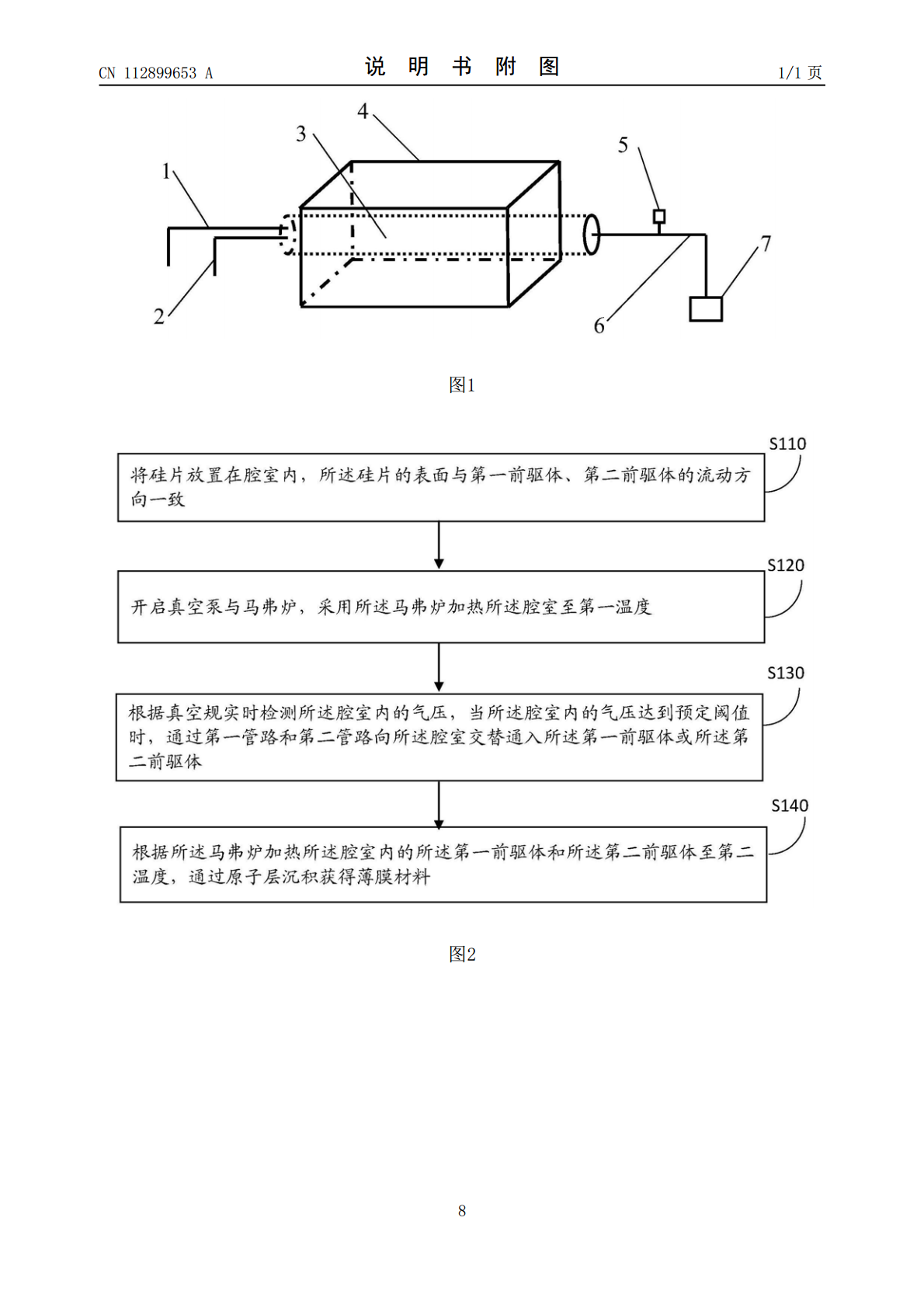
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种高温原子层沉积装置和方法.pdf
本发明公开了一种高温原子层沉积装置和方法,通过腔室,所述腔室为柱状管式腔体结构;第一管路,所述第一管路与所述腔室的一端连通,且所述第一管路通入第一前驱体进入所述腔室;第二管路,所述第二管路与所述腔室的一端连通,且所述第二管路通入第二前驱体进入所述腔室;马弗炉,所述马弗炉设置在所述腔室的外侧;抽真空管路,所述抽真空管路的一端与所述腔室的另一端连通。解决现有技术中原子层沉积设备腔室为金属且腔体较大,对于腔室的升温和降温速度缓慢,不适宜活性较低的原子层沉积前驱体的技术问题,达到了前驱体气流的单向流动,缩短工艺吹

一种原子层沉积设备和原子层沉积设备的定量输气装置.pdf
本实用新型提供了一种原子层沉积设备和原子层沉积设备的定量输气装置,涉及原子层沉积技术领域。其中,这种定量输气装置,包含用以连通原子层沉积设备的工艺腔室的出气管、分别出气管的至少两个定量进气组件,以及接合于出气管的不定量进气组件。定量进气组件包括定量腔室、用以连通源瓶的第一进气管、用以连通定量腔室和第一出气管的第一阀门,以及用以连通出气管和第一进气管的第二阀门。不定量进气组件包括用以连接气源的第二进气管,以及用以连通出气管和第二进气管的第三阀门。通过定量输气装置,能够有效的控制每次向反应腔室输送的气体的体积

原子层沉积装置及方法.pdf
本申请公开了一种原子层沉积装置及方法,原子层沉积装置采用了额外添加吹扫管路的设计,通过将吹扫管路并联在原有的前驱体传输管路中,从而将吹扫气体的流量从前驱体的设定流量中解放出来,可以显著加大吹扫气体的流量,由于吹扫气流的增强,其吹扫工序所消耗的时间可以进一步减小,从而间接提高了整个装置的生产效率,同时还可以更彻底的对反应腔室中喷淋头及喷淋头边缘焊接处进行吹扫,避免了前驱体的残留,提高了生产薄膜的均匀性及薄膜质量。

一种原子层沉积制备薄膜材料的装置和方法.pdf
本发明公开了一种原子层沉积制备薄膜材料的装置和方法,通过腔室;第一管路,所述第一管路与所述腔室的一端连通,且所述第一管路通入第一前驱体进入所述腔室;第二管路,所述第二管路与所述腔室的一端连通,且所述第二管路通入第二前驱体进入所述腔室;马弗炉,所述马弗炉设置在所述腔室的外侧,且所述马弗炉采用分段加热所述腔室,其中,所述马弗炉第一段加热衬底至第一温度,在所述第一温度下向所述腔室通入所述第一前驱体与所述第二前驱体,所述马弗炉第二段加热至第二温度;抽真空管路,所述抽真空管路的一端与所述腔室的另一端连通。达到提高前

用于在基板上沉积原子层的方法和装置.pdf
一种在基板上沉积原子层的方法,包括从包含于鼓轮中的前体气体供应器供应前体气体;鼓轮相对于从气体源接收气体的密封件旋转。鼓轮或密封件中的一个包括一个或多个气体气体进料通道,该气体进料通道与前体气体供应器流体连通,以及鼓轮或密封件中的另一个在其表面包括一个或多个环周沟槽,该表面由该鼓轮或密封件中的一个密封,从而防止沿径向方向的流体流动路径,且留下沿环周方向的流体流动路径。至少一个密封沟槽设置有一个或多个分隔件来分离在密封沟槽中的制程气体进料的邻近区域,从而使得区域提供互不相同的制程气体组成,以使前体气体在基板
