
半导体器件制备方法.pdf

论文****酱吖









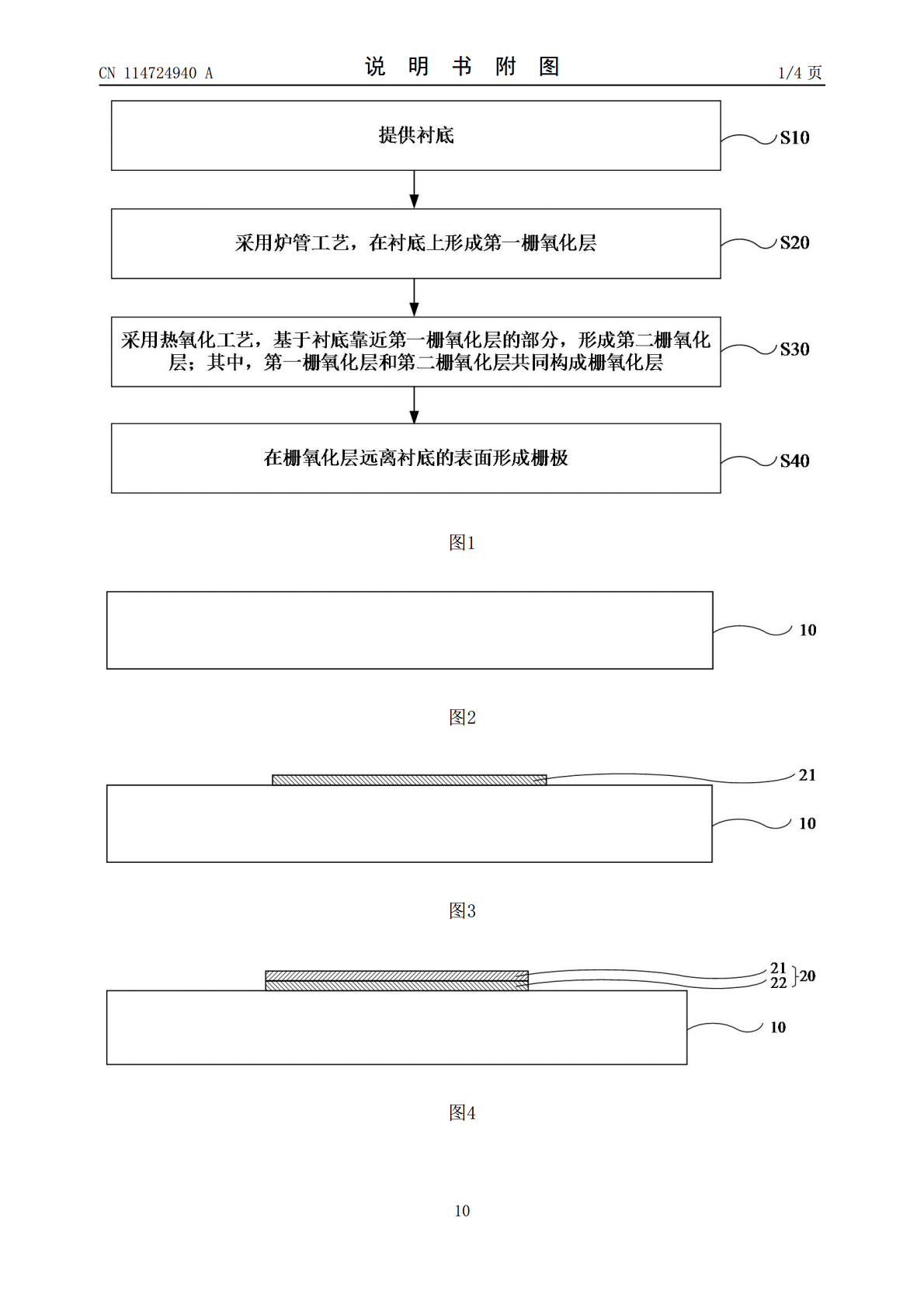
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体器件的制备方法及半导体器件.pdf
本申请涉及一种半导体器件的制备方法及半导体器件。该半导体器件的制备方法包括:在衬底表面形成外延层,在外延层背离衬底的一侧形成第一氧化层;在外延层内形成掺杂区;在高温炉内进行预扩散,预扩散温度为950℃‑1050℃;通过漂酸的方式对部分第一氧化层以及第一氧化层表面残留的有机物进行去除;在高温炉内进行再扩散,再扩散温度为800℃‑900℃,在第一氧化层背离衬底的一侧形成牺牲层;通过漂酸的方式对牺牲层、部分第一氧化层以及第一氧化层表面残留的有机物进行去除。本申请通过在低温条件下生长出比较疏松的牺牲层并去除牺牲层

半导体器件的制备方法和半导体器件.pdf
本申请公开了一种半导体器件的制备方法和半导体器件,包括:提供一衬底,衬底上形成有外延层,外延层上形成有ESD结构和第一氧化层,外延层中形成有DTI结构;在ESD结构、第一氧化层和DTI结构的表面形成第二氧化层;去除ESD结构、第一氧化层和DTI结构上方的第二氧化层,剩余的第二氧化层在ESD结构的周侧形成侧壁;在ESD结构和第一氧化层的上方依次形成第一层间介质和第二层间介质;在第一层间介质、第二层间介质和DTI结构中形成接触通孔,在接触通孔上形成金属引线,接触通孔的底端与DTI结构连接。本申请通过在ESD结

半导体器件和制备半导体器件的方法.pdf
本发明公开了一种半导体器件和制备半导体器件的方法。该半导体器件包括:第一硅层(110;210);第一介质层(120;220),位于该第一硅层(110;210)上面,该第一介质层(120;220)包含窗口(121;221),该第一介质层(120;220)的窗口(121;221)底部的横向尺寸不超过20nm;III-V族半导体层(130;230),位于该第一介质层(120;220)上面以及该第一介质层(120;220)的窗口(121;221)内,并在该第一介质层(120;220)的窗口(121;221)内与该

半导体器件的制备方法和半导体器件.pdf
本发明实施例公开了一种半导体器件的制备方法和半导体器件。方法包括:提供具有多个有源区的衬底,有源区包括源漏极区,位线接触区,字线段和字线绝缘结构;在源漏极区上形成保护层,且保护层覆盖字线绝缘结构并具有在位线接触区上形成的接触通道,接触通道连通到位线接触区;形成缓冲材料层,覆盖保护层以及接触通道的侧壁;刻蚀缓冲材料层,保留缓冲材料层位于接触通道的侧壁的部分,以形成缓冲层,缓冲层再定义接触通道的宽度;在保护层上及接触通道内形成位线材料层,位线材料层还覆盖缓冲层;图案化位线材料层,以在所述接触通道之上形成高于保

半导体器件制备方法.pdf
本公开涉及一种半导体器件制备方法。所述半导体器件制备方法,包括以下步骤:提供衬底;采用炉管工艺,在衬底上形成第一栅氧化层;采用热氧化工艺,基于衬底靠近第一栅氧化层的部分,形成第二栅氧化层;其中,第一栅氧化层和第二栅氧化层共同构成栅氧化层。在栅氧化层远离衬底的表面形成栅极。上述半导体器件制备方法中,既保证了可以制备所需的栅氧化层厚度,又保证了衬底表面的栅氧化层具有相当高的质量,进而减小了半导体器件的热载流子效应,使得半导体器件的性能达到最佳化。此外,由于衬底表面的栅氧化层是热氧化工艺制备的,故栅氧化层的均匀
