
腔室屏蔽装置和半导体处理腔室.pdf

是浩****32






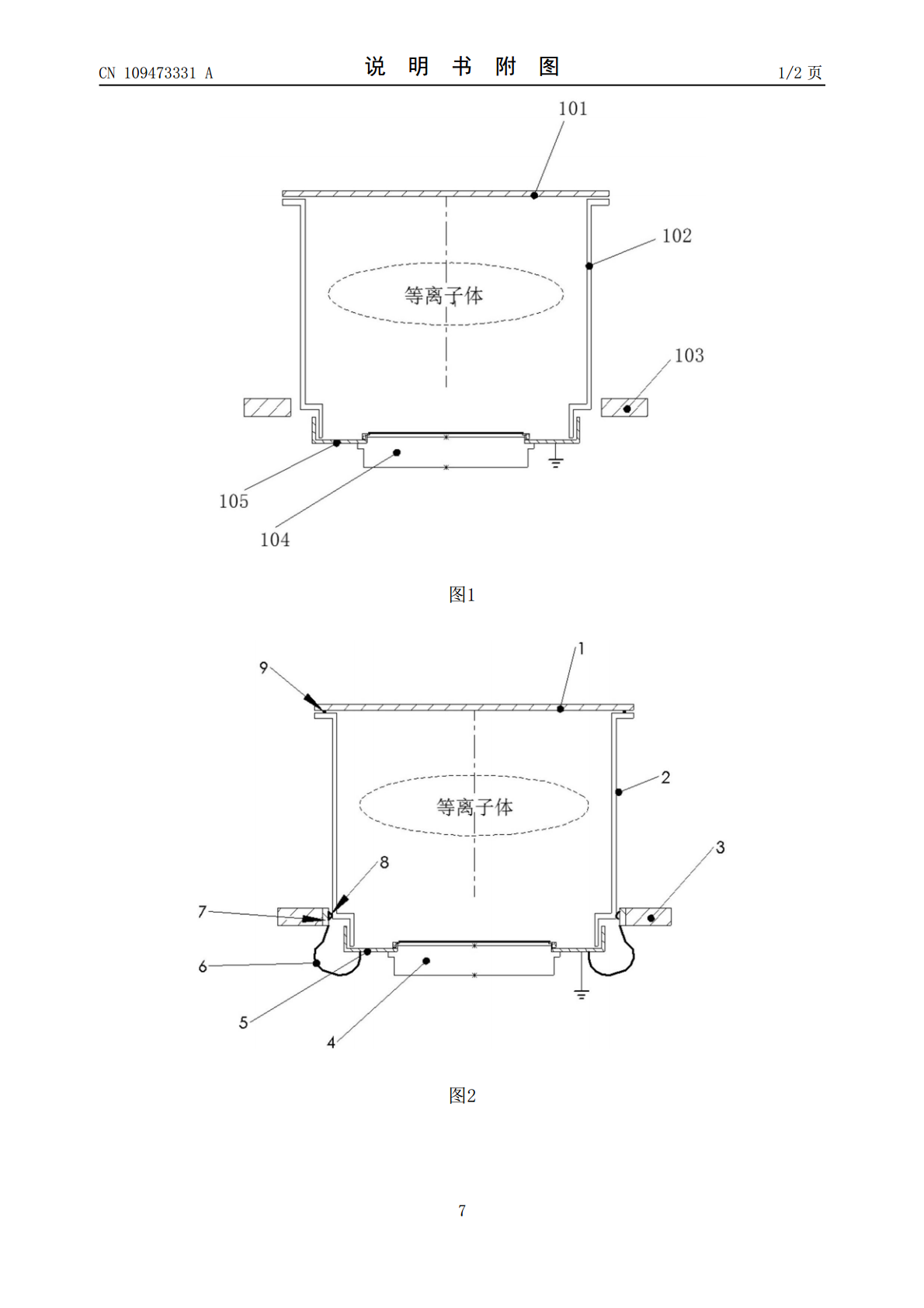

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

腔室屏蔽装置和半导体处理腔室.pdf
本发明公开一种腔室屏蔽装置和半导体处理腔室,腔室屏蔽装置包括依次拼接的上屏蔽板、侧屏蔽板和下屏蔽板,上屏蔽板与侧屏蔽板通过第一导体电连接,侧屏蔽板和下屏蔽板通过导电组件电连接。该腔室屏蔽装置的上屏蔽板、侧屏蔽板和下屏蔽板的电位相等,能够防止屏蔽板发生表面放电现象,避免屏蔽板表面留下打火痕迹,避免腔室内颗粒度超标。

腔室内衬、工艺腔室和半导体处理设备.pdf
本发明公开了一种腔室内衬、工艺腔室和半导体处理设备。腔室内衬用于在工艺腔室内形成限制等离子体分布的工艺空间,包括:第一围挡部;自第一围挡部向工艺空间内侧弯折延伸形成的过渡连接部;自过渡连接部向背离第一围挡部的方向弯折延伸形成的第二围挡部;第一围挡部、过渡连接部和第二围挡部共同形成工艺空间;过渡连接部上设置有第一收容结构,用于收容工艺腔室内产生的颗粒杂质。通过所设置的第一收容结构,能够有效收集工艺腔室内产生的颗粒杂质,从而能够避免该些颗粒杂质落到工艺腔室中的硅片表面,进而能够提高硅片的工艺良率,降低制作成本

承载装置及半导体工艺腔室.pdf
本发明提供一种承载装置及半导体工艺腔室,其中,承载装置用于半导体工艺腔室支撑待加工件,承载装置包括多个相互间隔并连接的承载柱,各承载柱上均间隔设置有多个承载槽,且各承载柱上的承载槽一一对应设置,对应设置的所有承载槽用于共同承载待加工件,各承载柱上均设有通孔,通孔和承载槽一一对应设置,通孔和承载槽相连通,用于部分工艺气体通过通孔导流至承载槽内的待加工件的待加工面上。本发明提供的承载装置及半导体工艺腔室,能够降低承载柱对工艺气体的阻挡,提高工艺气体在待加工件的待加工面上的分布均匀性,从而提高工艺均匀性,提高工

半导体工艺腔室.pdf
本申请公开一种半导体工艺腔室,其包括腔体,所述腔体设有内腔,所述内腔设有顶部开口和侧部开口;内衬体,所述内衬体设置于所述内腔中,所述内衬的顶端与所述顶部开口连接,所述内衬体设有传片口,所述传片口与所述侧部开口相对设置;内门,所述内门包括门体和驱动组件,所述驱动组件用于驱动所述门体沿所述腔体的轴向运动,并选择性地控制所述门体嵌入所述传片口内或者避让所述传片口。上述技术方案能够解决目前工艺腔室内容易产生横向气流,对气体的流动均匀性产生不利影响,进而造成晶圆的刻蚀均匀性受到影响的问题。

反应腔室及半导体热处理设备.pdf
本发明提供一种反应腔室及半导体热处理设备,包括内炉管,套置在内炉管外周的外炉管和进气管,进气管包括依次串接且连通的第一管部、第二管部和第三管部;第一管部的出气端伸入设置在内炉管上的第一通孔中,且第一管部通过第一通孔与内炉管的内部连通;第二管部设置在内炉管和外炉管之间,第三管部的进气端通过设置在外炉管上的第二通孔延伸至外炉管的外部;第一管部与第一通孔相配合,且第三管部固定在第二通孔处,以能够使进气管整体固定不动。其可以提高进气管的固定稳定性,并能够防止进气管与基片发生碰撞,减少损失,且工艺气体不会受到进气管
