
晶圆缺陷检测设备以及晶圆缺陷检测方法.pdf

Ch****91








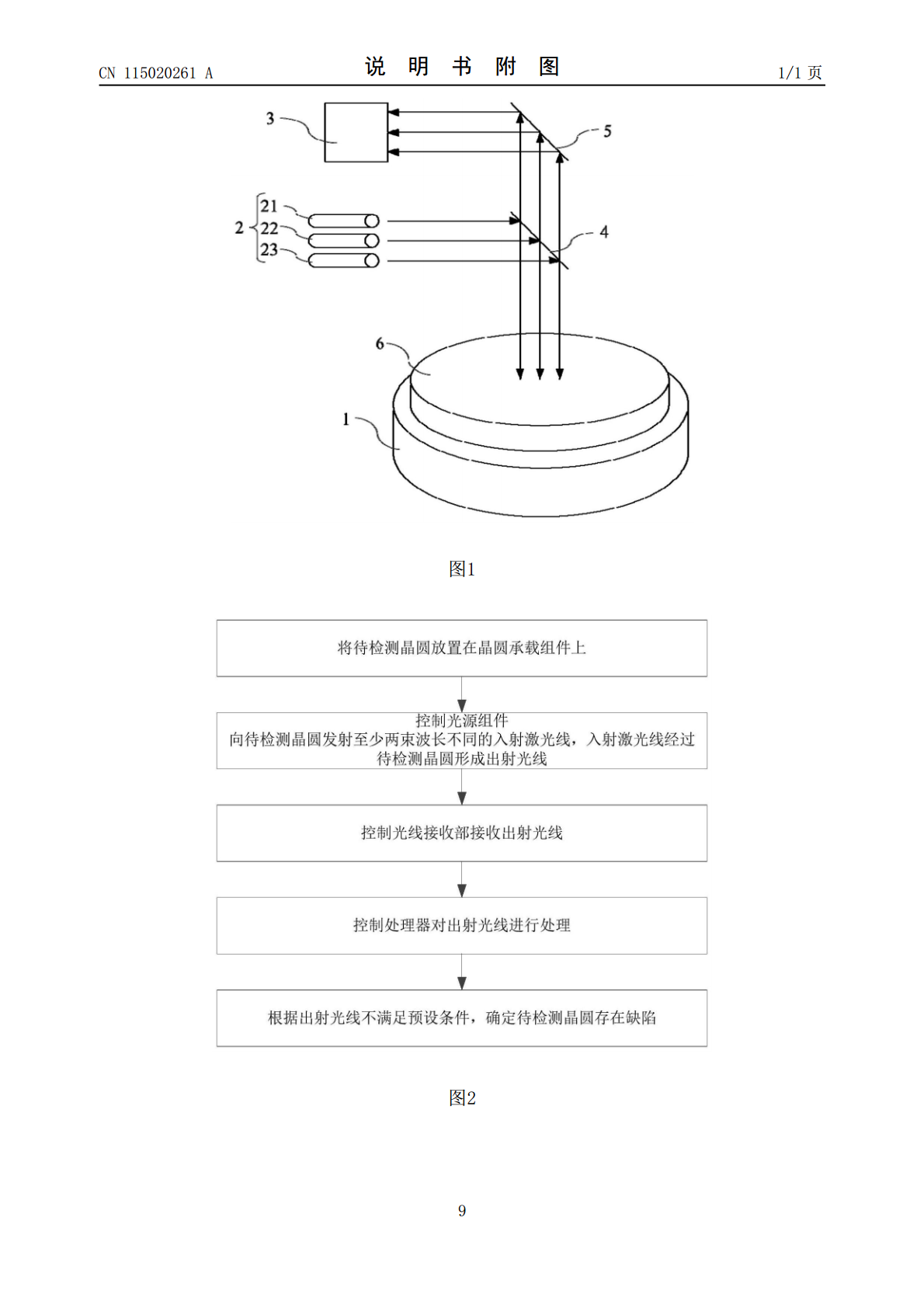
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

晶圆缺陷检测设备以及晶圆缺陷检测方法.pdf
本申请属于半导体技术领域,具体涉及一种晶圆缺陷检测设备以及晶圆缺陷检测方法,该晶圆缺陷检测设备包括晶圆承载组件、光源组件、光线接收部和处理器,晶圆承载组件设置成用于承载待检测晶圆,光源组件包括至少两个激光光源,且至少两个激光光源的波长不同,光源组件设置成向待检测晶圆发射入射光线,入射光线经待检测晶圆形成出射光线,光线接收部设置成接收出射光线,处理器与光线接收部电连接,处理器设置成对出射光线进行处理以确定待检测晶圆是否存在缺陷。根据发明实施例的晶圆缺陷检测设备,综合了灯源和激光的优势的晶圆缺陷检测设备,既保

晶圆缺陷的检测方法.pdf
本发明提供一种晶圆缺陷的检测方法,包括:获取晶圆表面的图像,并将所述晶圆表面的图像划分为多个检测区域;在每个所述检测区域内选取多个第一测定区域,并将每个所述检测区域内的第一测定区域进行差异化比对,根据差异化比对的结果获得每个所述检测区域用于表征缺陷的阈值;将每个所述检测区域划分为多个第二测定区域,并将每个所述检测区域内的第二测定区域进行差异化比对后,将差异化比对的结果与对应的检测区域的阈值进行比较,若比较的结果满足预设条件,即获得对应的检测区域上所存在的缺陷。本发明通过给不同检测区域设定不同的阈值,得到与

晶圆缺陷的检测方法及装置.pdf
本申请是关于一种晶圆缺陷的检测方法及装置。该方法包括:通过模板匹配算法识别出待测晶圆上不同缺陷形态所对应的图像区域,从而根据不同图像区域的检测图像进行特征参数的提取,提取出的特征参数可以可靠表征待测晶圆,对提取出的特征参数进行阈值判断,根据判断结果得到待测晶圆的缺陷检测结果。本申请提供的方案,能够识别出缺陷类型,并根据映射关系推算出晶圆生产制程中的站点异常,从而为晶圆制程提供指导性的改善建议。

晶圆缺陷的检测方法及装置.pdf
本申请是关于一种晶圆缺陷的检测方法及装置。该方法包括:通过模板匹配算法识别出待测晶圆上不同缺陷形态所对应的图像区域,从而根据不同图像区域的检测图像进行特征参数的提取,提取出的特征参数可以可靠表征待测晶圆,对提取出的特征参数进行阈值判断,根据判断结果得到待测晶圆的缺陷检测结果。本申请提供的方案,能够识别出缺陷类型,并根据映射关系推算出晶圆生产制程中的站点异常,从而为晶圆制程提供指导性的改善建议。

晶圆低纹理缺陷的检测方法.pdf
本发明公开了一种晶圆低纹理缺陷的检测方法,首先根据获取的彩色晶圆图像得到晶圆二值图像;然后利用一阶导数获得晶圆的最外侧轮廓曲线,锁定晶圆位置;对整副图像进行旋转处理,使得晶圆上下边水平、左右边垂直,根据旋转后的原始彩色图像最小矩形区域的四个顶点锁定矩形晶粒区的四个顶点,得到晶粒区;对彩色晶粒区图像等面积裁剪成若干份,统计每份所有像素点R、G、B通道灰度值所在的特定灰度级数量;最后与标准晶圆图像进行对比,根据每个灰度级中灰度值的数量计算相似度;若所有子区域检测结果均大于阈值,则判定没有缺陷,否则含有缺陷;本
