
一种晶圆的研磨方法.pdf

曦晨****22







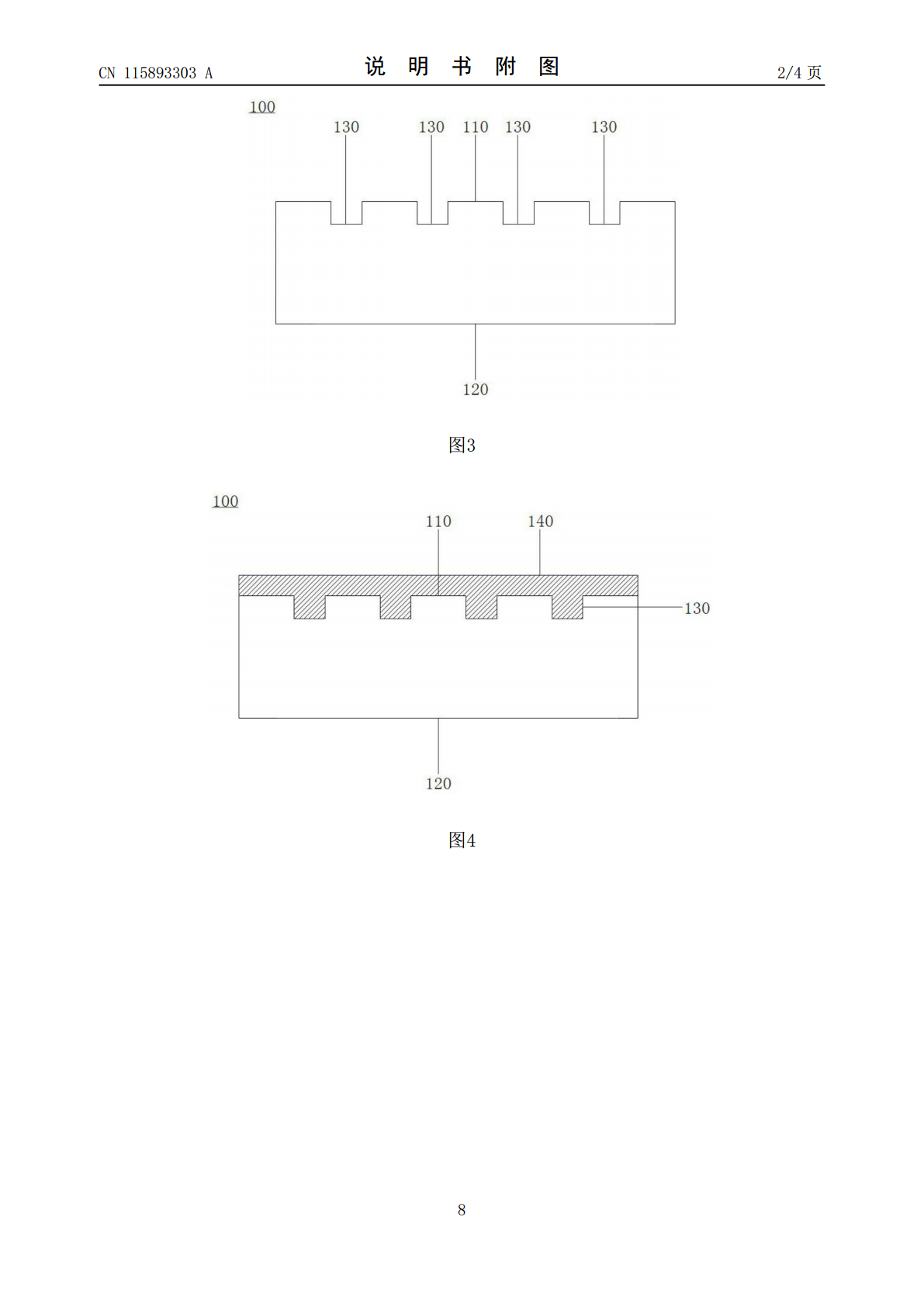
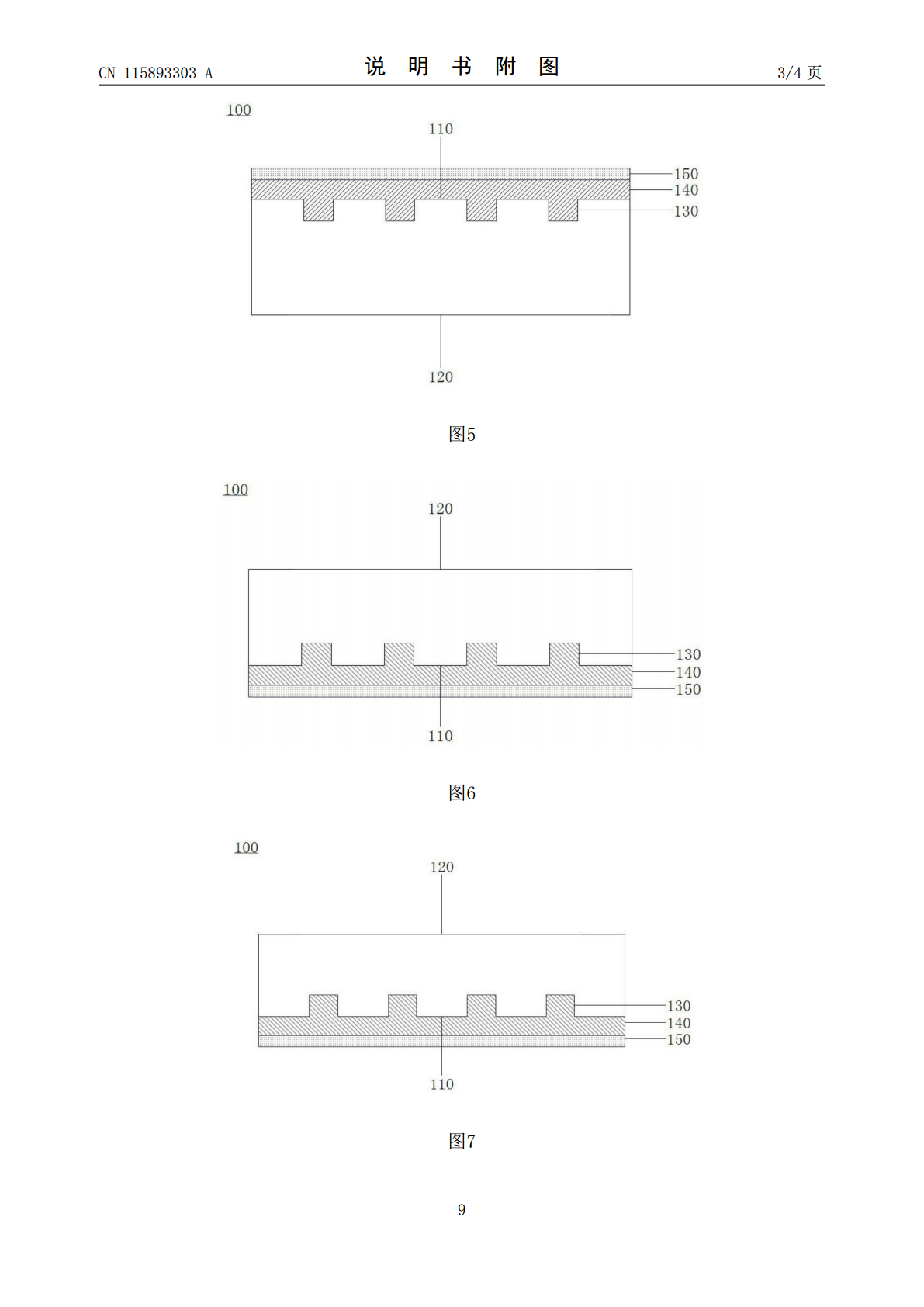

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

晶圆研磨装置与晶圆研磨方法.pdf
一种晶圆研磨装置与晶圆研磨方法。晶圆研磨装置包括一支撑板、一修整垫以及一研磨轮。支撑板用以放置一晶圆于其上。修整垫设置邻近于支撑板。研磨轮能够在支撑板与修整垫之间移动,以研磨放置在支撑板上的晶圆或经由修整垫修整研磨轮的一研磨面。

一种晶圆的研磨方法.pdf
本发明属于研磨技术领域,尤其是涉及一种晶圆的研磨方法,包括如下步骤:S1.提供晶圆,所述晶圆包括正面以及与正面相对的反面;S2.将晶圆的正面向上放置在研磨装置中,并用研磨液和第一研磨粉对所述晶圆的正面进行研磨;S3.取出晶圆,并在晶圆的正面蚀刻形成沟坑,且沟坑的深度小于晶圆的厚度;S4.对晶圆进行洁净处理;S5.在晶圆的正面上形成保护层;S6.在保护层上覆盖保护胶带。本发明不但可以避免在对晶圆进行研磨时晶圆因强度变弱而产生破裂,而且可以避免在进行BG工艺时保护胶带由于粘性过大将晶圆的正面结构粘连着一起被去

一种晶圆研磨方法.pdf
本发明提供一种晶圆研磨方法,包括以下步骤:晶圆背面清洗步骤:提供一晶圆,清洗所述晶圆背面;晶圆载入步骤:将晶圆载入研磨腔室,并采用真空吸附部件吸附晶圆的背面;晶圆研磨步骤:停止真空吸附部件对晶圆背面的吸附,并采用研磨部件对晶圆的双面进行研磨;晶圆载出步骤:将晶圆载出研磨腔室。本发明在晶圆研磨工艺之前增加晶圆背面清洗步骤,通过施加清洗液、毛刷摩擦的物理清洗方式,使得前序工艺残留的切割液和颗粒物更多的从晶圆背面去除,从而有效保持晶圆背面的清洁,避免后续晶圆因真空吸附部件与晶圆背面之间存在残留颗粒物而造成晶圆背

一种晶圆研磨抛光方法.pdf
本发明公开一种晶圆研磨抛光方法,用于在钨化学金属研磨工艺中实现钨触点突出晶圆表面,其包含以下步骤:1、研磨液管路和研磨台表面进行冲洗;2、研磨垫进行研磨修整以保证研磨垫的稳定性能,并喷射氮气保证研磨垫表面干净;3、研磨液由去离子水切换为研磨液;4、研磨液预流出,使得在进行主要的抛光工艺前研磨液已经布满研磨垫;5、持续供应研磨液,研磨头压在研磨垫上并加背压的方式进行氧化物抛光工艺;6、研磨头保持不动,晶圆受力由背压的状态转为真空,提供的研磨液切换为去离子水;7、采用去离子水研磨,对晶圆进行研磨抛光同时去除晶

晶圆研磨装置和晶圆的制造方法.pdf
本发明提供一种不对输送中的晶圆的整周拍摄图像就能够进行该晶圆的破裂检测的晶圆研磨装置和晶圆的制造方法。本发明的晶圆研磨装置(1)包括平板(12、14)和设有能够保持晶圆(2)的通孔(21)的载置构件(20),使保持在载置构件(20)的通孔(21)中的晶圆(2)与平板(12、14)相对移动来研磨该晶圆(2),其中,具有用于检测在通孔(21)内残留的晶圆碎片的有无的、图像处理部件(6)和非接触检测部件(7)的至少一方。
