
一种高线性HEMT器件及其制备方法.pdf

傲丝****账号






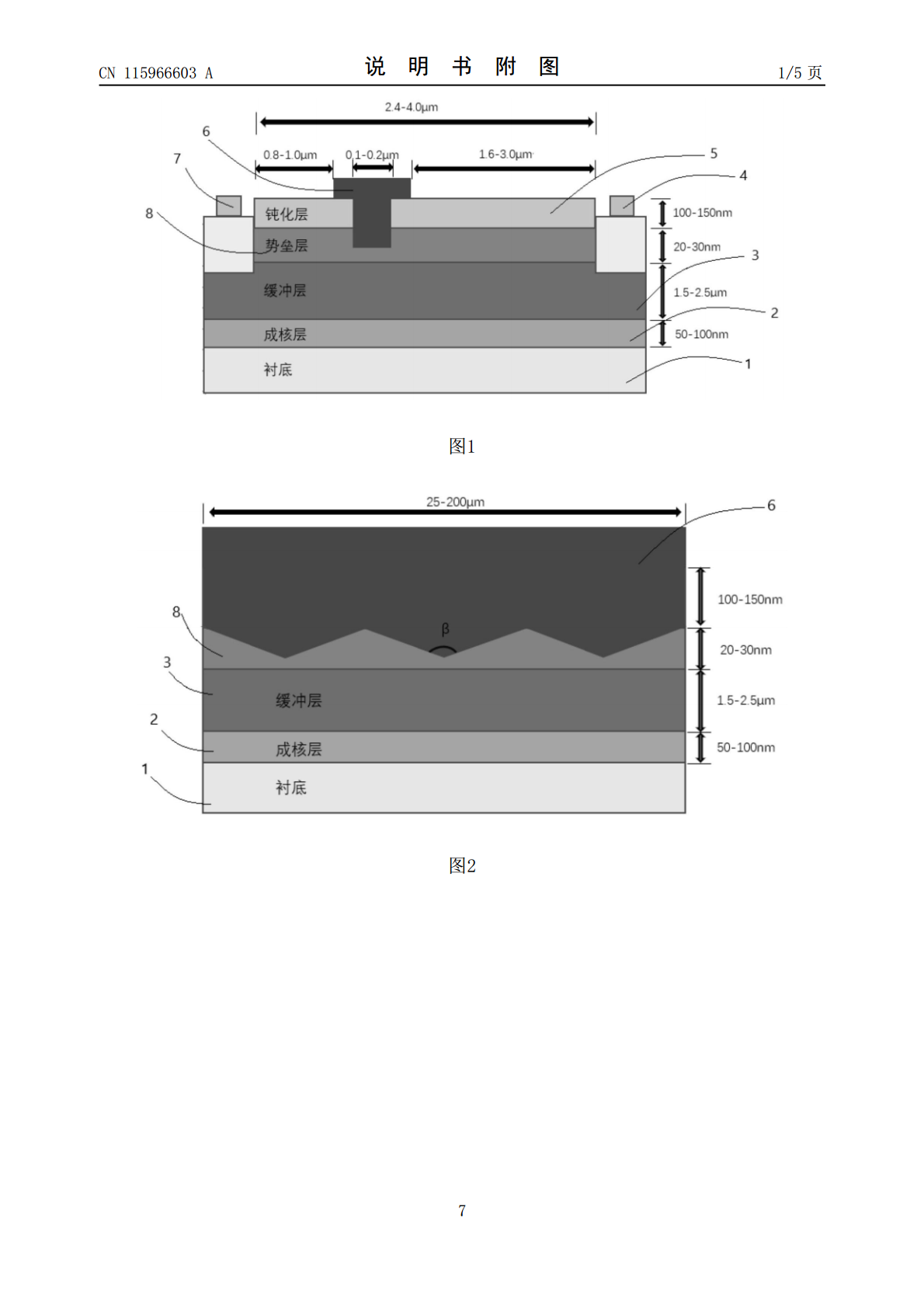
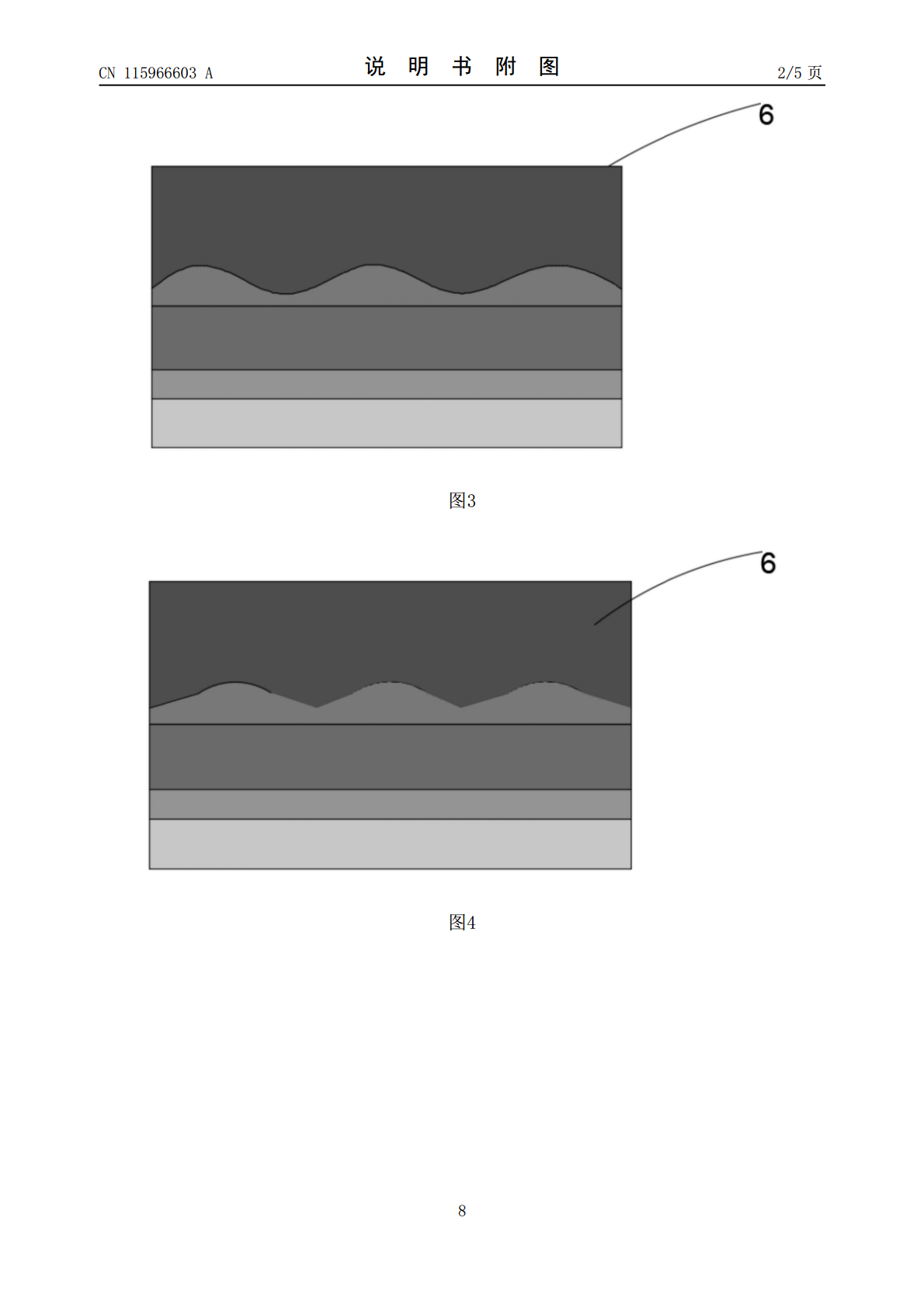
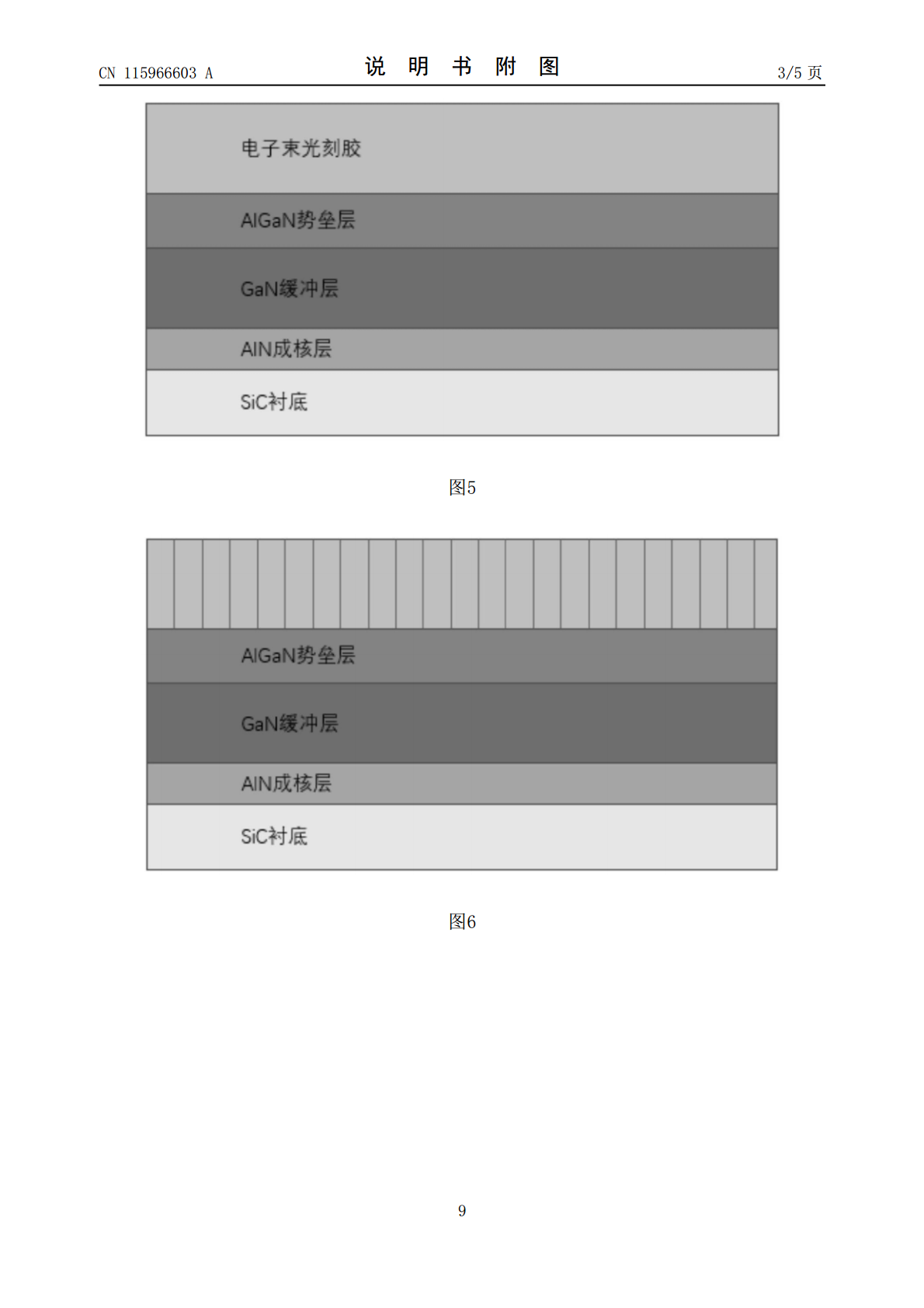
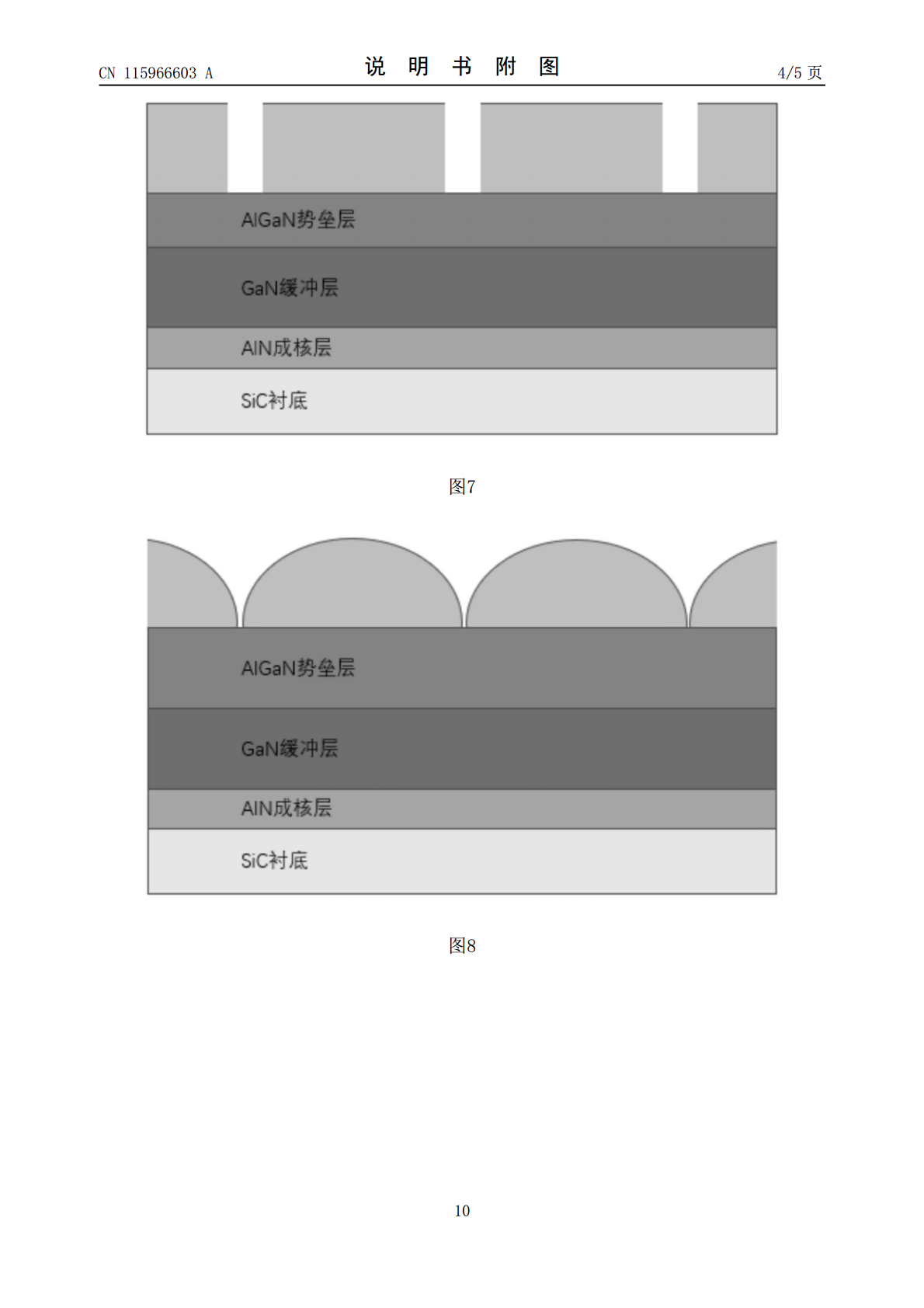
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种高线性HEMT器件及其制备方法.pdf
本发明涉及一种高线性HEMT器件及其制备方法,旨在提高HEMT器件的线性度,从结构优化的途径来尽量避免因器件非线性因素所带来的跨导滚降,以及跨导导数变化过大造成跨导尖峰现象等非线性问题。本发明的第一方面提供一种高线性HEMT器件,包括:衬底,以及在所述衬底上由下至上依次堆叠的成核层、缓冲层、势垒层和钝化层;其中,所述钝化层设有栅槽,所述栅槽底部位于所述势垒层中,所述栅槽内设置有栅极;所述栅极的两侧分别设有源极和漏极,源极和漏极均与所述缓冲层欧姆接触;所述栅槽的底部具有以下形状:沿所述栅极的宽度方向,栅槽的

HEMT外延片及其制备方法、HEMT器件.pdf
本公开提供了一种HEMT外延片及其制备方法、HEMT器件,属于半导体器件技术领域。所述HEMT外延片包括:Si衬底、依次层叠在所述Si衬底上的复合过渡层、AlGaN缓冲层、AlGaN高阻层、GaN沟道层、AlGaN势垒层与GaN盖帽层,所述复合过渡层包括依次层叠在所述Si衬底上的低温BP成核层、高温BP成核层和预铺Al层,所述低温BP成核层的生长温度低于所述高温BP成核层的生长温度。

一种高栅耐压p-GaN HEMT器件及其制备方法.pdf
本发明属于微电子器件技术领域,具体涉及一种高栅耐压p‑GaNHEMT器件,包括衬底层以及自下而上生长在衬底层上的GaN沟道层和AlGaN势垒层,所述AlGaN势垒层的上表面设置有漏极、p‑GaN层以及源极,且漏极和源极分别设置在p‑GaN层的两侧,所述p‑GaN层的上表面生长有超晶格帽层,且超晶格帽层上设置有栅极;所述超晶格帽层包括2组及以上GaN层和AlGaN层,所述GaN层和AlGaN层依次叠加,且AlGaN层位于GaN层的上方。克服了现有技术的不足,通过自身的极化电场对栅区域的电场分布进行调制,有效

一种具有高阻缓冲层的GaN HEMT器件及其制备方法.pdf
本发明公开一种具有高阻缓冲层的GaNHEMT器件及其制备方法,所述器件包括自下而上依次设置的衬底、AlN成核层、应力调控层、高阻缓冲层、GaN沟道层、AlN插入层、AlGaN势垒层和GaN帽层,其中,高阻缓冲层自下而上依次包括掺Fe的GaN缓冲层、六方BN缓冲层和掺C的GaN缓冲层;GaN帽层的上表面设置有相互间隔的源电极、漏电极和栅电极,源电极和漏电极与AlGaN势垒层形成欧姆接触;栅电极与AlGaN势垒层形成肖特基接触。本发明利用高阻缓冲层不仅可以实现缓冲层的高阻特性,还可以防止Fe进入GaN沟道层

一种高阈值GaN增强型HEMT器件及其制备方法.pdf
本发明公开了一种高阈值GaN增强型HEMT器件及其制备方法,其结构自下而上依次包括:衬底层,成核层,GaN缓冲层,AlGaN势垒层,其中,AlGaN势垒层上设置有源极,漏极,以及源极和漏极之间且与源极和漏极有间隔的插入层;插入层的材料为AlN或Al<base:Sub>x</base:Sub>Ga<base:Sub>1?x</base:Sub>N,其中,0.5≤x<1;AlN插入层或AlGaN插入层中的Al组分含量大于AlGaN势垒层中的Al组分含量;插入层上设置有p型GaN层;p型GaN层上设置有栅极。本
