
一种晶圆的膜层膜厚量测方法.pdf

一只****ua







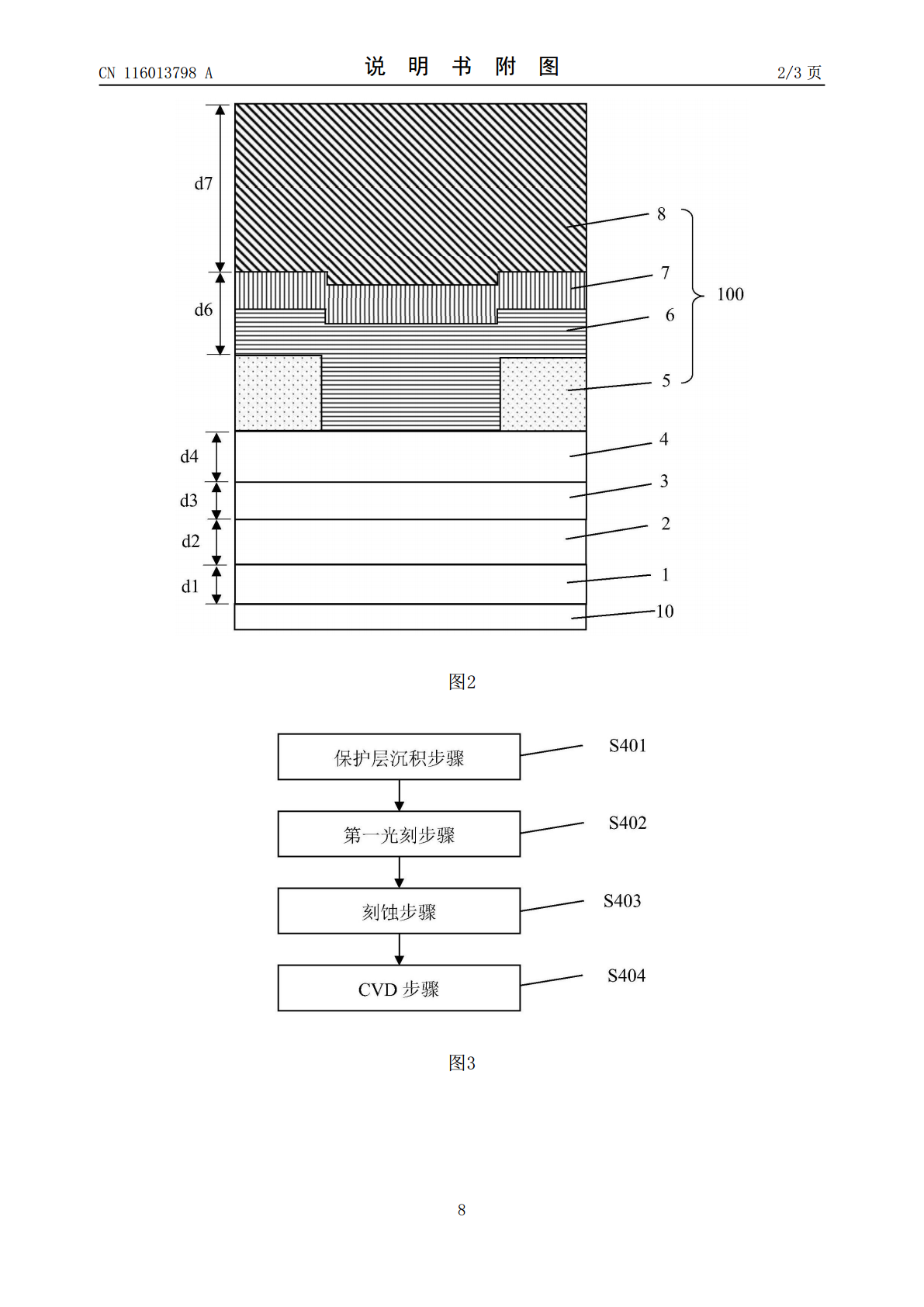
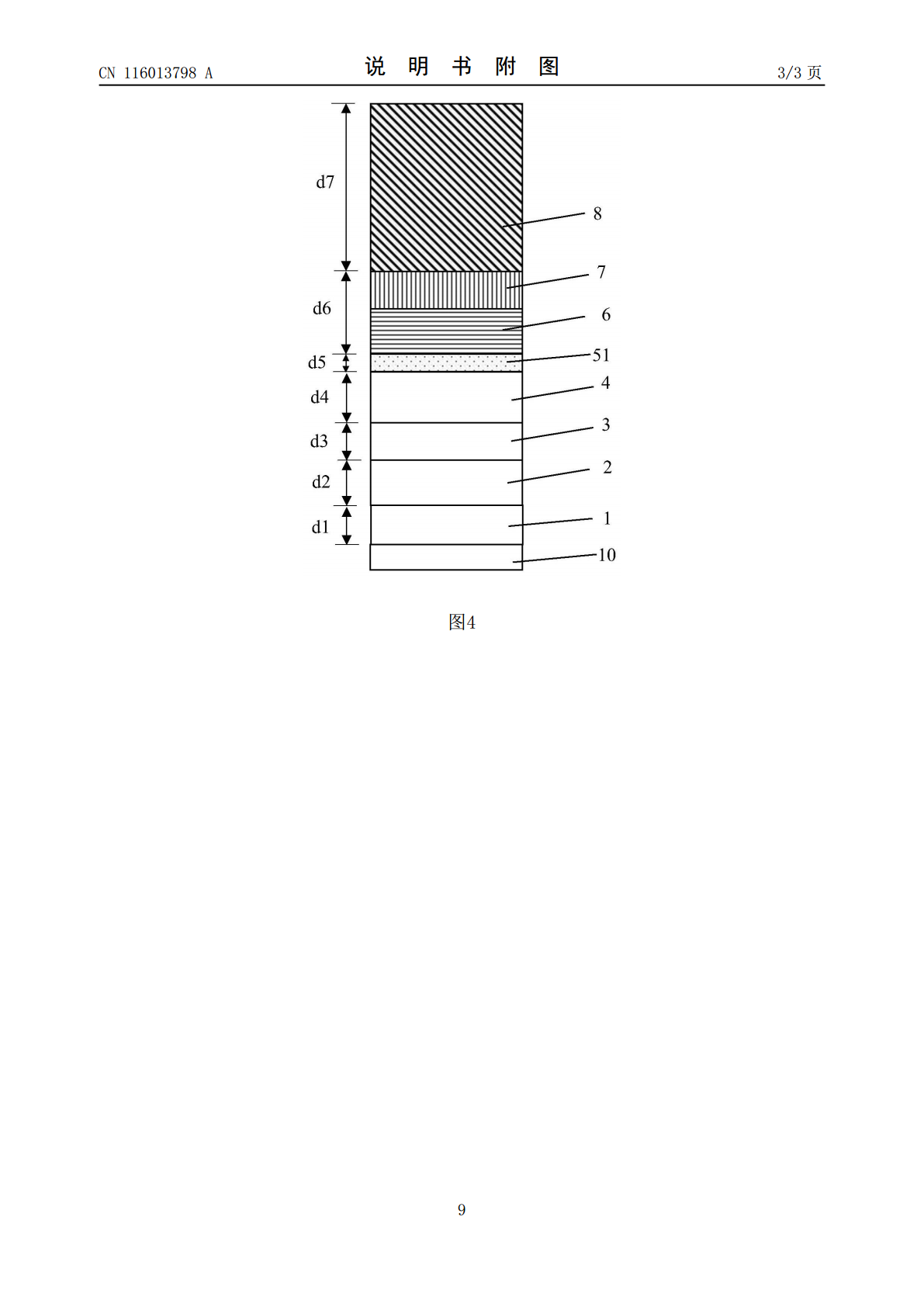
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种晶圆的膜层膜厚量测方法.pdf
本发明提供一种晶圆的膜层膜厚量测方法,属于半导体集成电路制造领域。该方法使用的设备包括:PVD机台、CVD机台、CMP机台、光刻机台、刻蚀机台、检测机台和量测机台,所述量测方法包括:相变材料沉积步骤;光刻对准步骤;对准标记刻蚀步骤;半导体组件形成步骤;第一量测步骤;第二光刻步骤;检测步骤;量测重工步骤:如果存在异常,则量测晶圆与正常的膜层结构的优拟合度;重工判定步骤:如果优拟合度过低,则判定发生异常的原因;第二重工量测步骤:更改膜层结构,然后量测晶圆与更改后的膜层结构的优拟合度。通过本发明的量测方法,可以

膜层厚度的量测方法.pdf
一种膜层厚度的量测方法,包括:提供基底;在所述基底上形成参照层;在所述参照层上形成待量测层,所述待量测层与所述参照层的材料不同,所述待量测层具有相对的第一面和第二面,第二面与参照层接触;采用干蚀刻机台对所述待量测层进行蚀刻处理,并获取所述干蚀刻机台对待量测层的蚀刻时间;获取所述干蚀刻机台对所述待量测层的蚀刻速率;根据所述蚀刻时间和所述蚀刻速率,获取所述待量测层的膜层厚度。通过获取所述干蚀刻机台对所述待量测层的蚀刻速率和蚀刻时间,即可获取所述待量测层的膜层厚度,对所述待量测层的膜层厚度没有限制,因此能够有效

晶圆贴膜方法及晶圆贴膜装置.pdf
本发明公开了一种晶圆贴膜方法,其特征在于,向晶圆与台盘之间吹入气体,利用吹入的气体支撑晶圆,然后在晶圆表面贴膜。使用本发明中的晶圆贴膜方法及贴膜装置,实现了非接触贴膜,减小了损坏晶圆正面的风险。由于在滚轮按压时,可以利用气体支撑晶圆,以此可以抵消滚轮的压力,滚轮不会轻易将晶圆压破或压碎;因此,使用本发明中的方法及装置进行非接触贴膜,可以贴膜的晶圆最小厚度为50μm,远低于使用现有技术贴膜的最小厚度200μm。

改善原子层沉积膜厚均匀度的方法和用于承载晶圆的晶舟.pdf
本发明提供一种改善原子层沉积膜厚均匀度的方法、电容器的制造方法、用于承载晶圆的晶舟及原子层沉积炉管,其中改善原子层沉积膜厚均匀度的方法,包括:提供用于承载晶圆的晶舟,包括将顶部稳流件可抽取式地插入第一凹槽,以在顶盖与晶圆之间形成阻挡;将底部稳流件可抽取式插入第二凹槽,以在底座和晶圆之间形成阻挡;装载多个晶圆在装载架中,包括将多个晶圆中的每一个可抽取式插入第三凹槽;进行原子层沉积工艺,包括由原子层沉积炉管的气体注射器排入制程气体,经由所述晶舟沉积于多个晶圆以形成薄膜,顶部稳流件和底部稳流件改善制程气体在晶舟

一种半导体晶圆贴膜设备及贴膜方法.pdf
本发明涉及一种半导体晶圆贴膜设备及贴膜方法,属于半导体生产领域,该设备包括机体,机体内设置有真空承片台和膜贴附机构,机体底部设置有腔室真空管道;真空承片台包括内部空间互通的台面和支腿,台面和支腿互通的内部空间形成腔室B,支腿处连接有承片台真空管道,用于对腔室B抽真空,台面上设置有一个或多个承片区域,承片区域上设置有均匀分布的圆孔;膜贴附机构设置在升降装置上,初始时,膜贴附机构的高度高于真空承片台,通过升降装置的下降将蓝膜覆盖到真空承片台的台面上;贴膜时腔室A和腔室B存在气压差,腔室B的压力值小于腔室A的压
