
半导体封装方法及其结构.pdf

慧颖****23






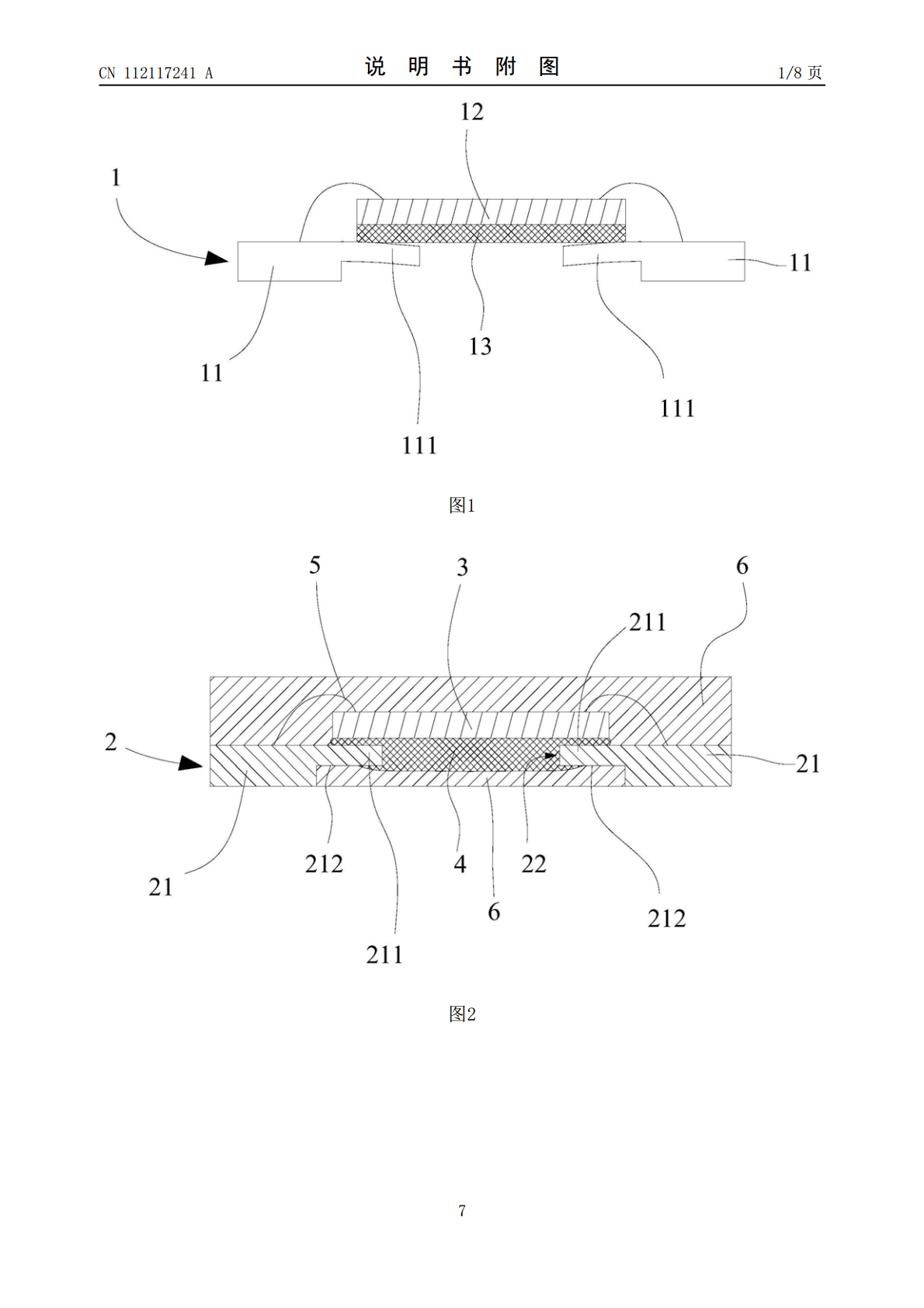
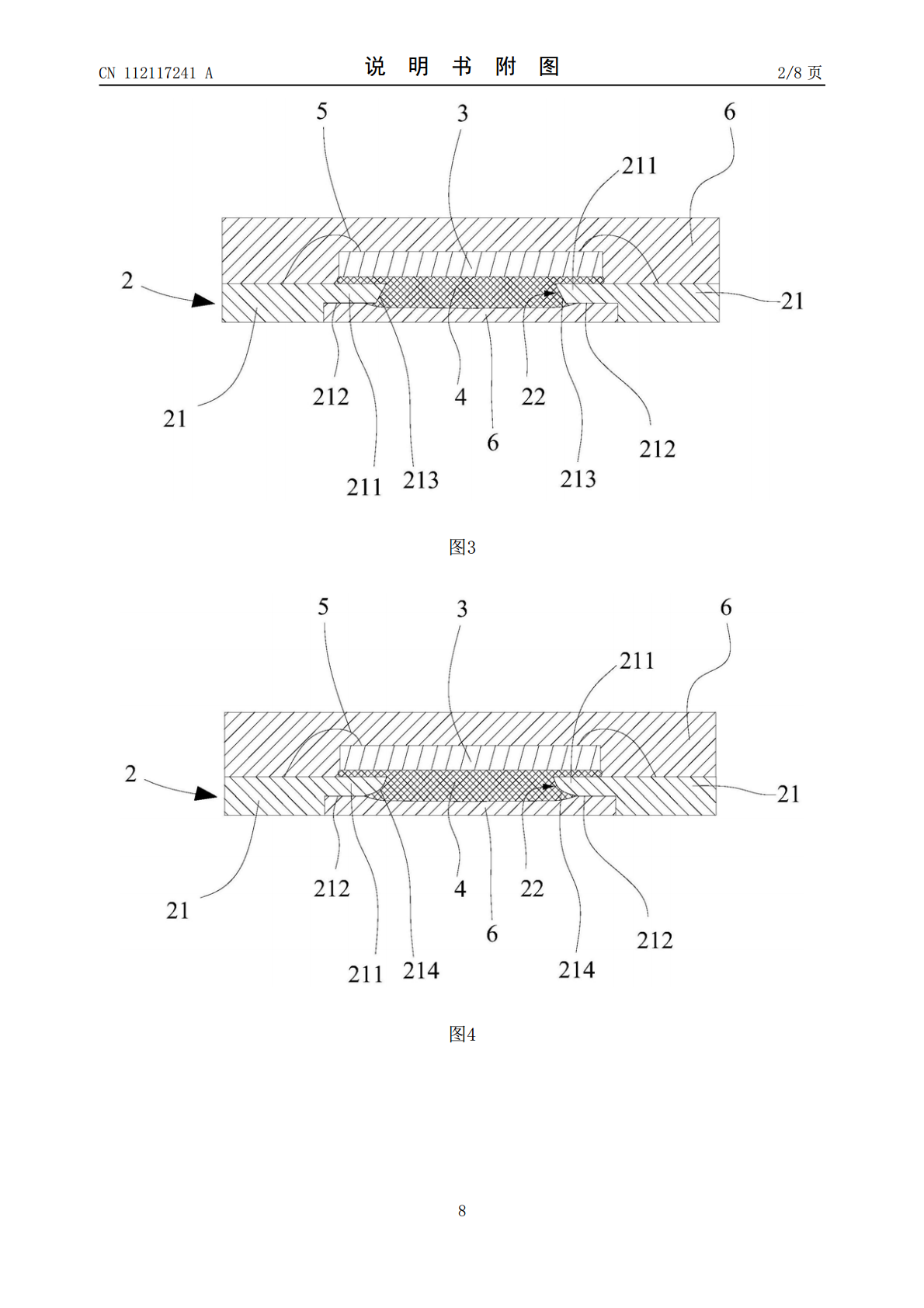
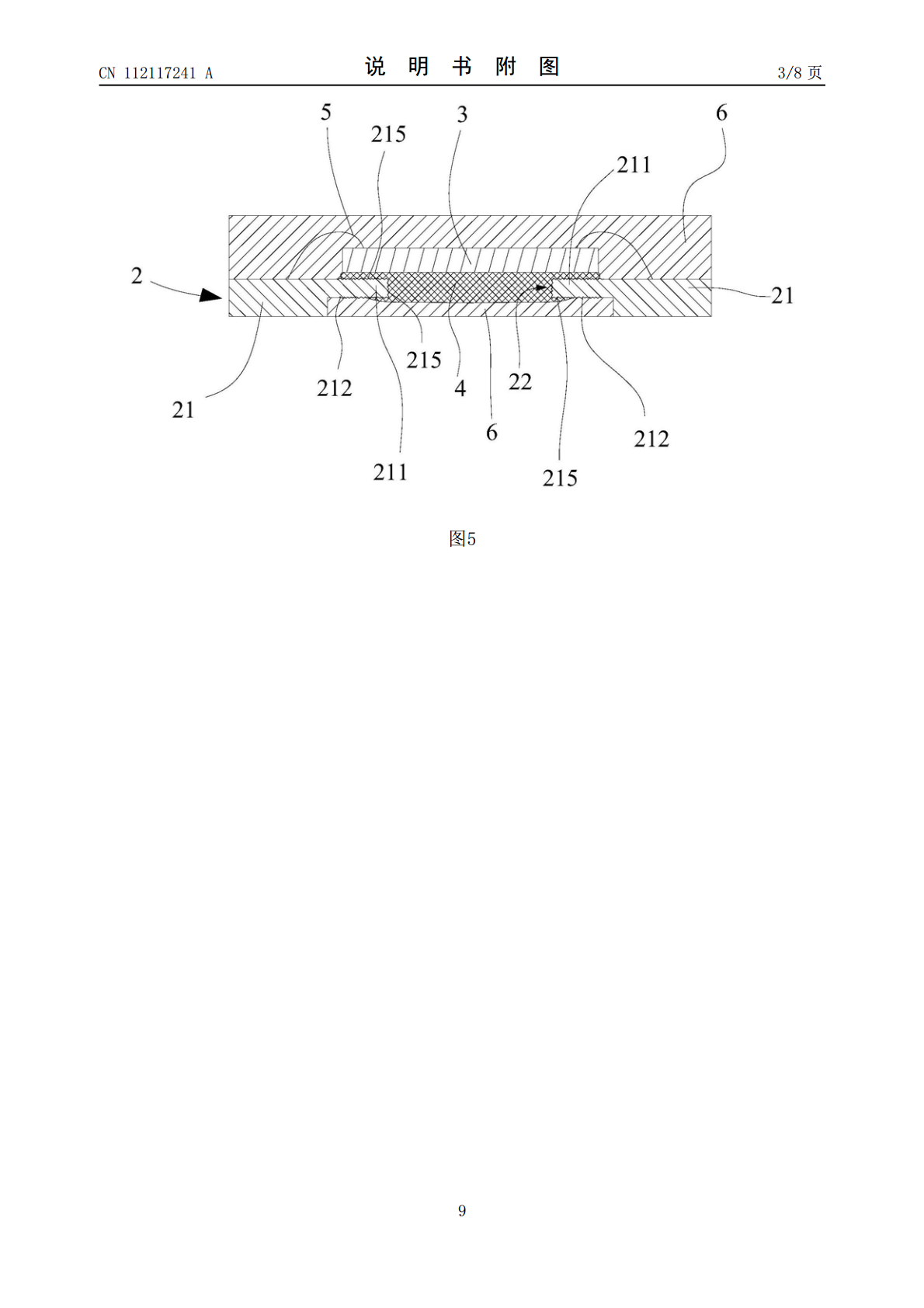

亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体封装方法及其结构.pdf
本发明公开了一种半导体封装方法及其结构。所述半导体封装结构包括导线架,具有多个引脚,引脚具有承放导线,其相邻对称设置的承放导线之间形成一间隔区,承放导线底部形成内凹部;芯片,放置于承放导线上且遮蔽间隔区;引线,电性连接芯片与引脚;封胶体,包覆芯片、承放导线、引线且让引脚部份露出。本发明是于芯片与承放导线接触区域设有黏胶体,黏胶体固化后会分布于间隔区及内凹部内,藉此提升承放导线的支撑力,防止承放导线在打线作业时下陷变形。

半导体结构及其制备方法、封装结构.pdf
本公开涉及一种半导体结构及其制备方法、封装结构,半导体结构的制备方法包括:提供衬底;于衬底上形成目标电容结构,目标电容结构包括依次形成的第一电极及第二电极;目标电容结构包括沟槽电容结构及平面电容结构;至少于第二电极内形成间隔分布的第一导电插塞及第二导电插塞;第一导电插塞在衬底的第二表面的正投影位于沟槽电容结构的第二电极在衬底的第二表面的正投影内,第二导电插塞电连接平面电容结构的第一电极。上述制备方法能够简化工艺步骤并节省工艺材料,以及改善过刻蚀的问题,避免短路,还能够减小电阻以提升半导体导电性能。

半导体封装结构及其加工方法.pdf
本申请公开了一种半导体封装结构及其加工方法,属于半导体工艺技术领域。一种半导体封装结构的加工方法,包括:提供晶圆,晶圆包括相对设置的第一表面和第二表面,晶圆的第一表面暴露出焊垫;在第一表面上依次形成图案化的第一钝化层和布线层,布线层电连接焊垫;在第二表面上形成有钝化层图案化的第二钝化层;以第二钝化层为掩膜,在预设工艺条件下刻蚀晶圆形成贯穿晶圆的锥形孔,从第二表面至第一表面的方向,锥形孔的宽度逐渐减小,且暴露出第一钝化层;其中,预设工艺条件包括:采用的下电极功率小于或等于50W。采用上述技术方案可以解决目前

半导体封装结构及其制造方法.pdf
本发明涉及半导体封装技术领域,提供了一种半导体封装结构及其制造方法,该封装结构包括:载体和多个引脚;半导体芯片,半导体芯片的背面通过粘接剂固定贴装在载体的上表面,半导体芯片的正面设置有多个焊垫;键合引线,用于电性连接多个焊垫和多个引脚;封装胶体,用于包覆载体、多个引脚、半导体芯片和键合引线,其中,半导体芯片的背面设置有厚度均匀的支撑结构,支撑结构的底面与载体的上表面接触,使得所述半导体芯片的背面在通过粘接剂固定贴装在载体的上表面时,半导体芯片的背面与载体的上表面平行。通过调整支撑结构的厚度可以保证芯片与载

半导体封装结构及其制造方法.pdf
本发明涉及半导体封装技术领域,提供了一种半导体封装结构及其制造方法,该半导体封装结构包括:框架,具有基岛及多个引脚;多个半导体芯片,上表面设有多个焊盘;多个引线,电性连接多个焊盘与多个引脚;封装胶体,包覆框架、多个半导体芯片和多个引线,其中,基岛上设置有多个具有不同高度的承载平台,多个半导体芯片分别设置在多个承载平台上,且至少部分半导体芯片的上表面之间具有大于等于预定高度的高度差。本发明能够在进行引线键合时错开打线并降低线弧高度,减小了不同引线之间以及引线与焊垫之间的短路风险和线弧过高、不稳定导致的引线脱
