
金属互连结构的制备方法及半导体器件的制备方法.pdf

俊凤****bb









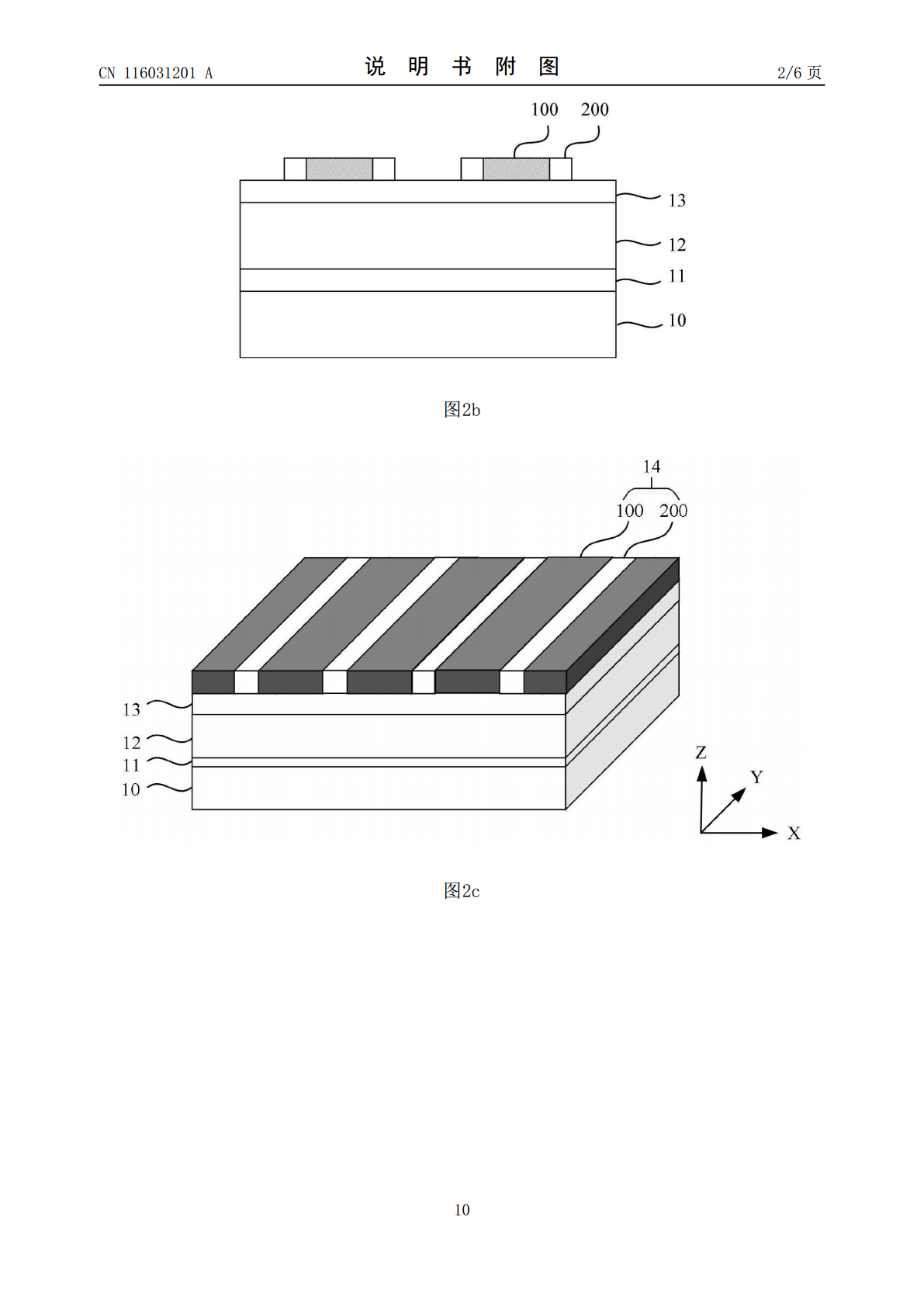
亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

金属互连结构的制备方法及半导体器件的制备方法.pdf
本发明提供一种金属互连结构的制备方法及半导体器件的制备方法,首先在半导体衬底上形成第一材料层和第二材料层,第一材料层包括在第一方向上间隔设置的掩膜材料层及介质材料层,第二材料层包括在与第一方向垂直的第二方向上间隔设置的掩膜材料层及介质材料层,接着依次进行湿法刻蚀和干法刻蚀,由于掩膜材料层与介质材料层的刻蚀速率有较大的差异,因此能够在刻蚀掩膜材料层/介质材料层的同时保护剩余部分不受损耗,从而形成金属互连沟槽,在所述沟槽中填充金属材料形成金属互连结构。本发明提供的金属互连结构的制备方法无需多次曝光、刻蚀即可获

半导体器件结构及制备方法.pdf
本发明公开了一种半导体器件结构及制备方法,半导体器件结构的制备方法包括:提供衬底,所述衬底包括第一区域及与所述第一区域相邻接的第二区域;于所述衬底内形成字线沟槽,所述字线沟槽贯穿所述第一区域及所述第二区域;于所述字线沟槽内形成埋入式栅极字线,所述栅极字线包括字线导电层,所述字线导电层贯穿所述第一区域及所述第二区域,且位于所述第二区域的所述字线导电层的厚度大于位于第一区域的所述字线导电层的厚度,以形成台阶状的字线导电层,在完成制备埋入式栅极字线后可以确保形成在第二区域的第一互连孔能够暴露出字线导电层,从而确

半导体器件结构及制备方法.pdf
本发明提供一种半导体器件结构及制备方法,制备方法包括提供一半导体基底,形成第一金属层;于第一金属层内形成第一沟槽,于第一沟槽内及周围沉积第一层间介质层;形成第一氢遮挡层;于第一氢遮挡层及第一层间介质层内形第一插塞;形成由下电极层、阻变氧化层及上电极层构成的且与第一插塞相连接的叠层结构;于叠层结构上形成连续的第二氢遮挡层,形成第二层间介质层。本发明通过第一氢遮挡层及第二氢遮挡层的设计,保护了下电极层、阻变氧化层及上电极层,防止阻变氧化层受环境及制程的影响,阻止了对器件的金属层及确保晶体管特性的退火工艺对阻变

外延结构及其制备方法、半导体器件及其制备方法.pdf
本发明实施例公开了一种外延结构及其制备方法、半导体器件及其制备方法,该外延结构包括:衬底;半导体层,位于衬底一侧,半导体层远离衬底一侧的表面为金属极性面;氮极性面帽层,位于半导体层远离衬底的一侧。具有金属极性面的半导体层和氮极性面帽层形成复合极性外延结构,形成半导体器件时,具有强负电性的氮极性面帽层,在常温下即可与源极和漏极形成良好的欧姆接触,无需高温处理,能够降低工艺难度,半导体层可作为氮极性面帽层的湿法腐蚀自停止层,稳定阈值电压同时可提高跨导,从而提高器件性能。

外延结构、半导体器件及制备方法.pdf
本申请实施例涉及一种外延结构的制备方法、外延结构、半导体器件的制备方法以及半导体器件,通过在衬底上外延生长缓冲层;在缓冲层上外延生长第一高阻半导体层;去除部分第一高阻半导体层,形成至少两个从第一高阻半导体层的上表面延伸至第一高阻半导体层内部的凹槽,至少两个凹槽包括第一凹槽和第二凹槽,其中,第一高阻半导体层位于第一凹槽和第二凹槽之间的部分未被去除而形成隔离侧墙;在第一高阻半导体层上外延生长低阻半导体层;在低阻半导体层的位于第一凹槽内的部分之上外延生长第一器件材料层,第一器件材料层与低阻半导体层采用不同的半导
