
半导体器件半导体工艺掺杂.pptx

胜利****实阿









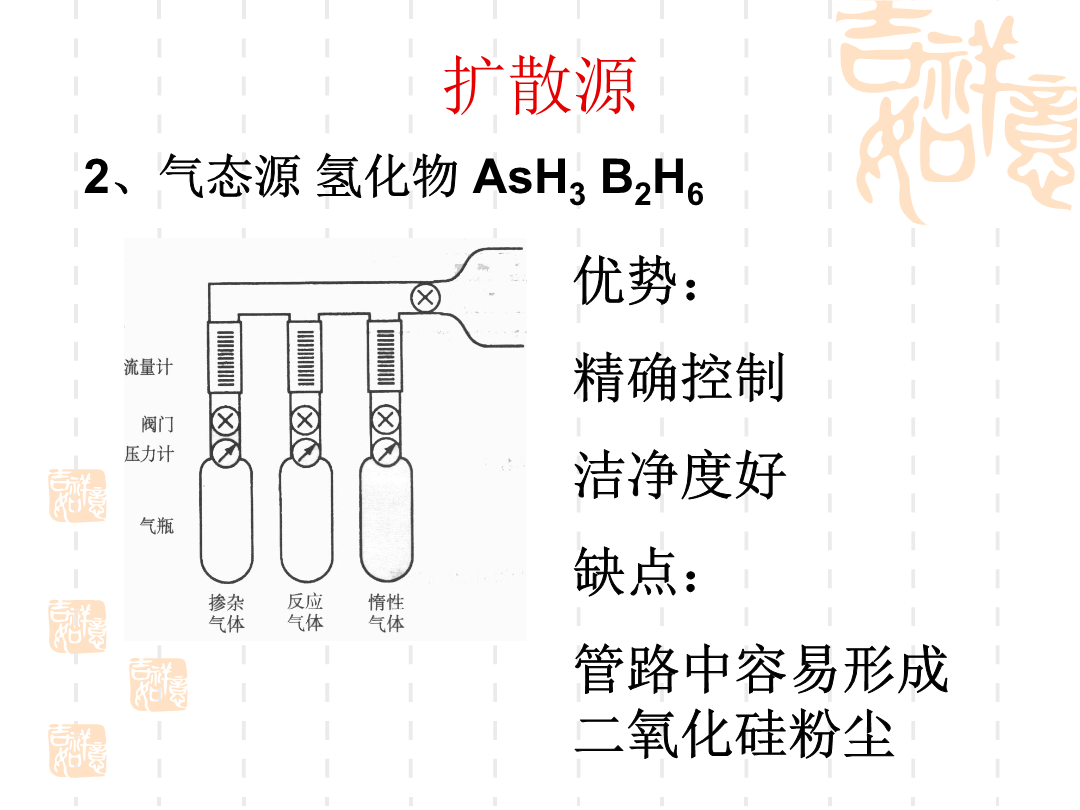
亲,该文档总共24页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体器件半导体工艺掺杂.pptx
掺杂工艺目的扩散扩散形成的掺杂区和结扩散工艺步骤扩散方式淀积工艺受控制或约束的因素淀积工艺受控制或约束的因素扩散源扩散源扩散源2、推进氧化drive-in-oxidation氧化的影响离子注入离子注入概念离子注入系统离子注入系统离子注入系统束流聚焦:离开加速管后,束流由于相同电荷的排斥作用而发散。发散导致离子密度不均匀和晶体掺杂不均一。成功的离子注入,束流必须聚焦。静电或磁透镜用于将离子束聚焦为小尺寸束流或平行束流。束流中和:尽管真空去除了系统中大部分空气,但是束流附近还是有些残存的气体分子。离子和这些气

半导体器件与工艺综合.pdf
2222第23卷第7期半导体学报Vol.23No.72002年7

半导体器件与工艺(11).ppt
第十一章金属化芯片金属化是应用化学或物理处理方法在芯片上淀积导电金属薄膜的过程。这一过程与介质的淀积紧密相连,金属线在IC电路中传导信号,介质层则保证信号不受邻近金属线的影响。金属和介质都是薄膜处理工艺,在某些情况下金属和介质是由同种设备淀积的。金属化对不同金属连接有专门的术语。互连意指由导电材料,如铝、多晶硅或铜制成的连线将电信号传输到芯片的不同部分。互连也被用做芯片上器件和整个封装之间普通的金属连接。接触是指硅芯片内的器件与第一金属层之间在硅表面的连接。通孔是穿过各种介质层从某一金属层到毗邻的另一金属

半导体器件与工艺(12).ppt
第十二章测试、装配与封装在制造厂工艺完成时,通过电测试的硅片准备进行单个芯片的装配和封装。这些被称为集成电路制造过程的后道工序。最终装配和封装在集成电路后道工序是两个截然不同过程。每个有它特殊的工艺和工具。在传统工艺中,集成电路最终装配从硅片上分离出每个好的芯片并将芯片粘贴在金属引线框架或管壳上。对于引线框架装配,用细线将芯片表面的金属压点和提供芯片电通路的引线框架内端互连起来。最终装配后,集成电路封装是将芯片封在一个保护管壳内。现在最常用的封装是用塑料包封芯片。这种塑料包封提供环境保护并形成更高级装配连

半导体器件与工艺综合.pdf
第23卷第7期半导体学报Vol.23,No.72002年7月CHINESEJOURNALOFSEMICONDUCTORSJuly,2002半导体器件与工艺综合鲁勇谢晓锋张文俊杨之廉(清华大学微电子学研究所,北京100084)摘要:利用器件与工艺综合的思想,开发出自顶向下的新的器件和工艺设计方法,实现了该设计方法的MOSPAD软件,并利用MOSPAD系统做出了一定的综合结果.做出了关于器件与工艺综合的两个实例,即对FIB器件的器件综合和对阱形成工艺模块进行的工艺综合,并证明了自顶向下的器件与工艺综合思想的可
