
扇出型芯片封装方法及扇出型芯片封装体.pdf

Jo****31









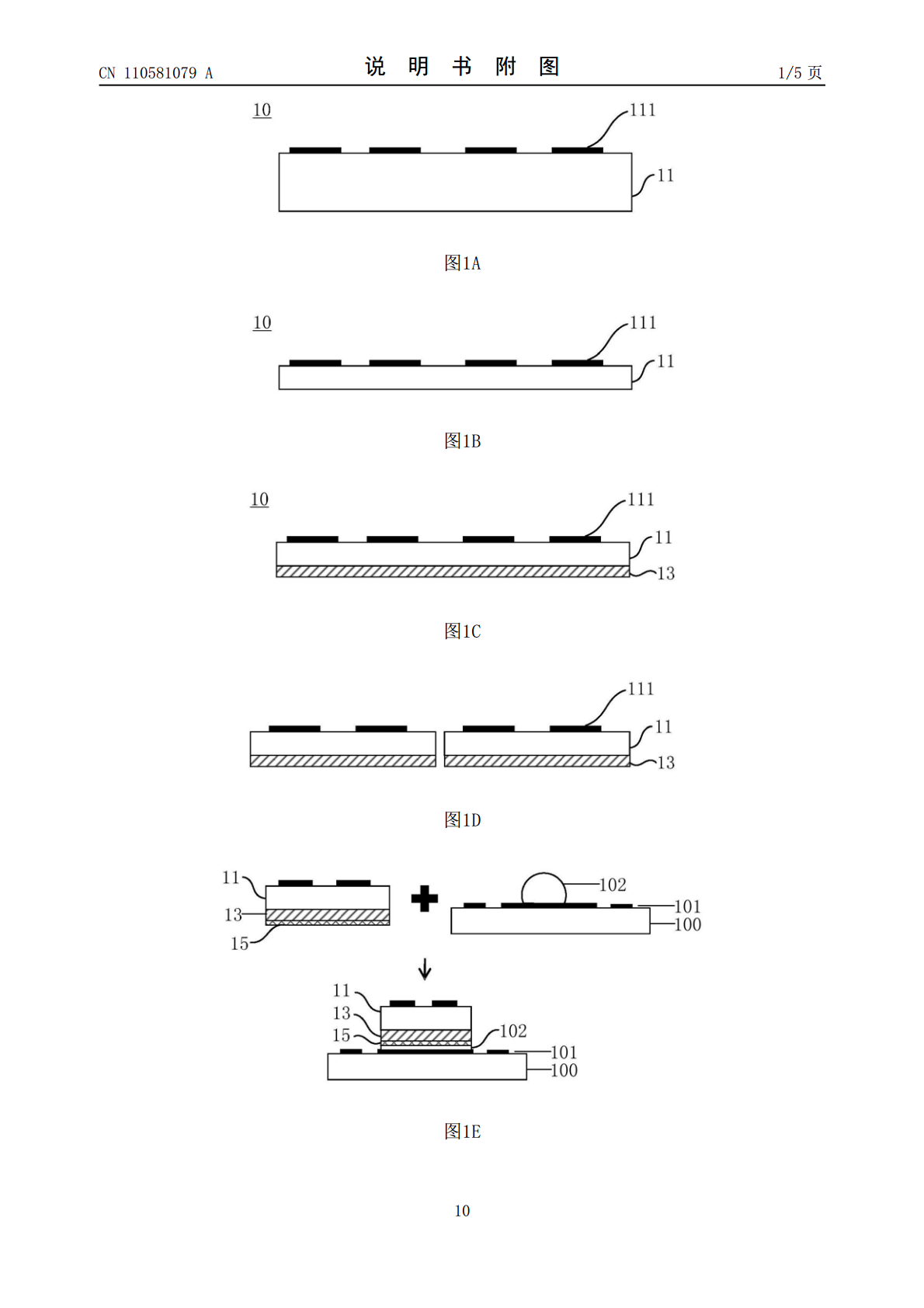
亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

扇出型芯片封装方法及扇出型芯片封装体.pdf
本发明提供一种扇出型芯片封装方法及扇出型芯片封装体,利用多次包封、开槽、沉积导电金属层、引脚电镀、图形化连接等工艺,制备的扇出型芯片封装体,芯片厚度可以减薄至小于或等于50um,极大地降低了芯片的体电阻,提高了元器件的性能;芯片背面无需再采用背银工艺利用银胶制作背银层,也无需通过导电胶粘结基板,省去了基板、银胶两种主要物料,有效节省芯片制造成本。

扇出型芯片封装方法和扇出型芯片封装结构.pdf
本发明的实施例提供了一种扇出型芯片封装方法和扇出型芯片封装结构,涉及半导体封装技术领域。通过在载具的表面贴装形成第一胶膜凸起,然后塑封后形成包覆在第一胶膜凸起外的塑封体,然后去除载具和第一胶膜凸起,保留了具有第一凹槽的塑封体,然后在第一凹槽内贴装第一芯片,并在塑封体的表面形成钝化层,最后形成布线组合层并完成植球。相较于现有技术,本发明能够避免使用硅衬底刻蚀凹槽的方式来防止芯片,从而避免了刻蚀带来的一系列问题。并且采用胶膜凸起倒模的方式,降低了工艺难度,并且对于第一凹槽的尺寸管控更为精确,有利于芯片的安装。

扇出型芯片封装方法.pdf
本公开实施例提供一种扇出型芯片封装方法,包括:分别提供载板、多个硅片和多个芯片;分别在多个硅片上形成导电连接结构,以形成多个硅中介板;至少一个硅中介板上的导电连接结构与其它硅中介板上的导电连接结构不同;将每个硅中介板进行切割,获得多个子硅中介板;根据预设的封装要求,从多个子硅中介板中选取多个目标子硅中介板,并将多个目标子硅中介板固定于载板;在多个目标子硅中介板背离载板的一侧形成第一塑封层;将多个芯片互连至多个目标子硅中介板上。该方法可以避免多个芯片互连至多个目标子硅中介板上时,目标子硅中介板产生翘曲或者破

扇出型芯片封装方法.pdf
本公开实施例提供一种扇出型芯片封装方法,包括:提供载板、多个硅片和多个芯片;分别在多个硅片上形成互连导电结构以形成多个硅中介板;至少一个硅中介板上的互连导电结构与其它不同;将每个硅中介板切割获得多个子硅中介板;从多个子硅中介板中选取多个目标子硅中介板,并将至少一个目标子硅中介板的第一表面固定于载板,将其余目标子硅中介板的第二表面固定于载板;多个目标子硅中介板的高度相同;在多个目标子硅中介板背离载板的一侧形成第一塑封体;将多个芯片键合至多个目标子硅中介板。该方法可避免多个芯片键合至目标子硅中介板时,目标子硅

扇出型芯片封装方法.pdf
本公开实施例提供一种扇出型芯片封装方法,包括:提供载板、多个硅片和多个芯片;分别在多个硅片上形成互连导电结构,以形成多个连接板;至少一个连接板上的互连导电结构与其它连接板上的互连导电结构不同;将每个连接板进行切割获得多个子连接板;从多个子连接板中选取多个目标子连接板并将多个目标子连接板的背面固定于载板;至少一个目标子连接板的高度与其他目标子连接板不同;在多个目标子连接板的正面形成第一塑封层;将多个芯片互连至多个目标子连接板上。该方法可避免多个芯片互连至多个目标子连接板上时,目标子连接板产生翘曲或者破裂;多
