
浅沟隔离槽.pdf

安双****文章





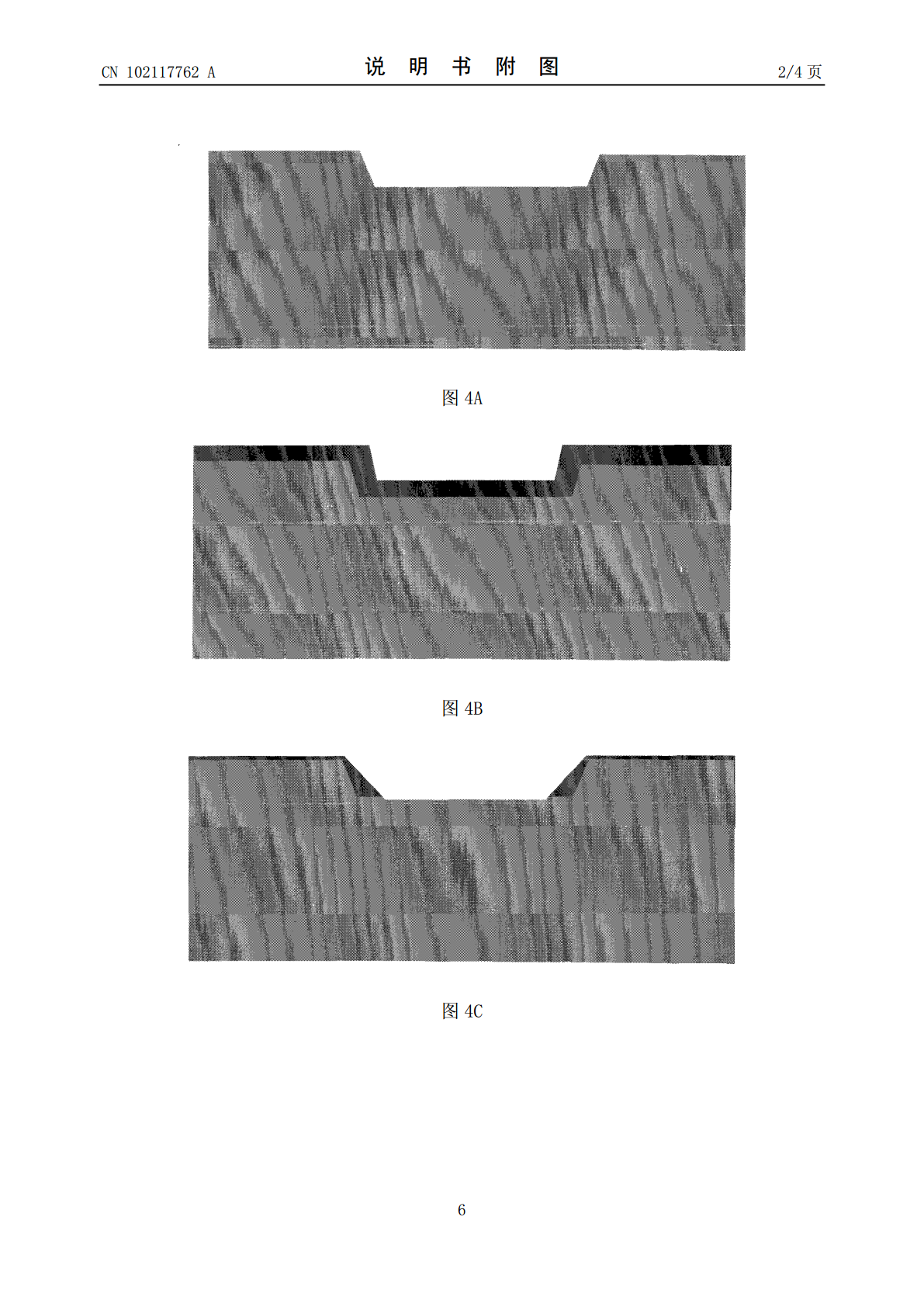


在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

浅沟隔离槽.pdf
本发明公开了一种浅沟隔离槽,由纵向相接的上下两部分组成,下部分宽度大于上部分宽度,形成步骤为:做上部分宽度隔离槽的光刻、刻蚀,刻蚀深度小于所述浅沟隔离槽的深度,去光刻胶;淀积一层薄氧化层;利用刻蚀工艺将槽底部的氧化层去除、留下侧壁氧化层;做干法的各向同性刻蚀,刻蚀后最终达到所述浅沟隔离槽的深度;去除侧壁氧化层,生长线性氧化层,接着,做高密度等离子体氧化层淀积。本发明能有效地解决金属硅化物生长沉淀的过程中沿着浅沟隔离槽边缘向下延伸从而造成器件漏电和隔离变差的问题。

浅槽隔离结构的制备方法、浅槽隔离结构和半导体结构.pdf
本申请实施例提供了一种浅槽隔离结构的制备方法、浅槽隔离结构和半导体结构,该浅槽隔离结构的制备方法包括:提供基底,于基底上形成多个第一沟槽,且第一沟槽的剖面宽度沿垂直方向向下呈增大趋势;于基底的顶部和多个第一沟槽的内侧通过沉积工艺形成连续的第一隔离层,且第一隔离层位于第一沟槽内的部分形成第二沟槽;第二沟槽的剖面宽度沿垂直方向向下保持不变;于第一隔离层的表面通过ISSG工艺形成连续的第二隔离层,且第二隔离层位于第二沟槽内的部分将第二沟槽完全填满。这样,由于第一沟槽的剖面宽度沿垂直方向向下呈增大趋势,可以直接对

一种浅槽隔离结构制备方法.pdf
本发明提供一种浅槽隔离结构制备方法,所述制备方法包括:提供一中间结构,于所述中间结构上表面形成掩膜层;于所述掩膜层上表面形成研磨停止层,所述研磨停止层包括氮氧化硅层;于所述研磨停止层上表面形成具有开口图形的光刻胶层;基于所述开口图形在所述中间结构中形成沟槽,并填充所述沟槽形成隔离层;基于所述研磨停止层采用化学机械研磨工艺平坦化所述隔离层;刻蚀去除所述研磨停止层及所述掩膜层,制备得到所述浅槽隔离结构。本发明提供的浅槽隔离结构制备方法能够解决现有浅槽隔离结构制备工艺中执行化学机械研磨工艺会产生蝶形缺陷,造成器

一种Nor Flash浅槽隔离填充方法.pdf
本申请公开了一种NorFlash浅槽隔离填充方法,属于半导体器件及制造领域。该方法中,在介质填充工艺中插入SiCoNi蚀刻工艺,实现将浅沟槽隔离结构淀积过程中存在的孔洞消除,再进行全填充至需求厚度;且SiCoNi蚀刻工艺类似各向同性刻蚀,因此SiCoNi蚀刻工艺之后沟槽轮廓仍然是“V”型,适应了该工序效果。

一种解决凹坑残留的浅槽隔离工艺制备方法.pdf
本发明公开了一种解决凹坑残留的浅槽隔离工艺制备方法,在0.18pumCMOS工艺平台中,浅槽隔离形成的工艺过程为:首先完成氮化硅硬掩膜刻蚀,并以氮化硅作为硬掩膜完成硅片的干法刻蚀形成浅沟槽。然后采用化学气相沉积在浅沟槽中填充二氧化硅,并采用化学机械研磨去掉多余的二氧化硅,再通过磷酸全剥去除氮化硅,形成完整的浅槽隔离。本发明在湿法清洗工艺中引入硬掩膜回刻技术后,增加了二氧化硅介质的填充宽度,可在后续的湿法全剥工艺中抵消横向刻蚀作用;通过优化多步湿法腐蚀和清洗工艺解决浅槽隔离工艺制作过程中出现的凹坑残留问题,
