
低应力IGBT沟槽型栅极的成长方法.pdf

雨星****萌娃






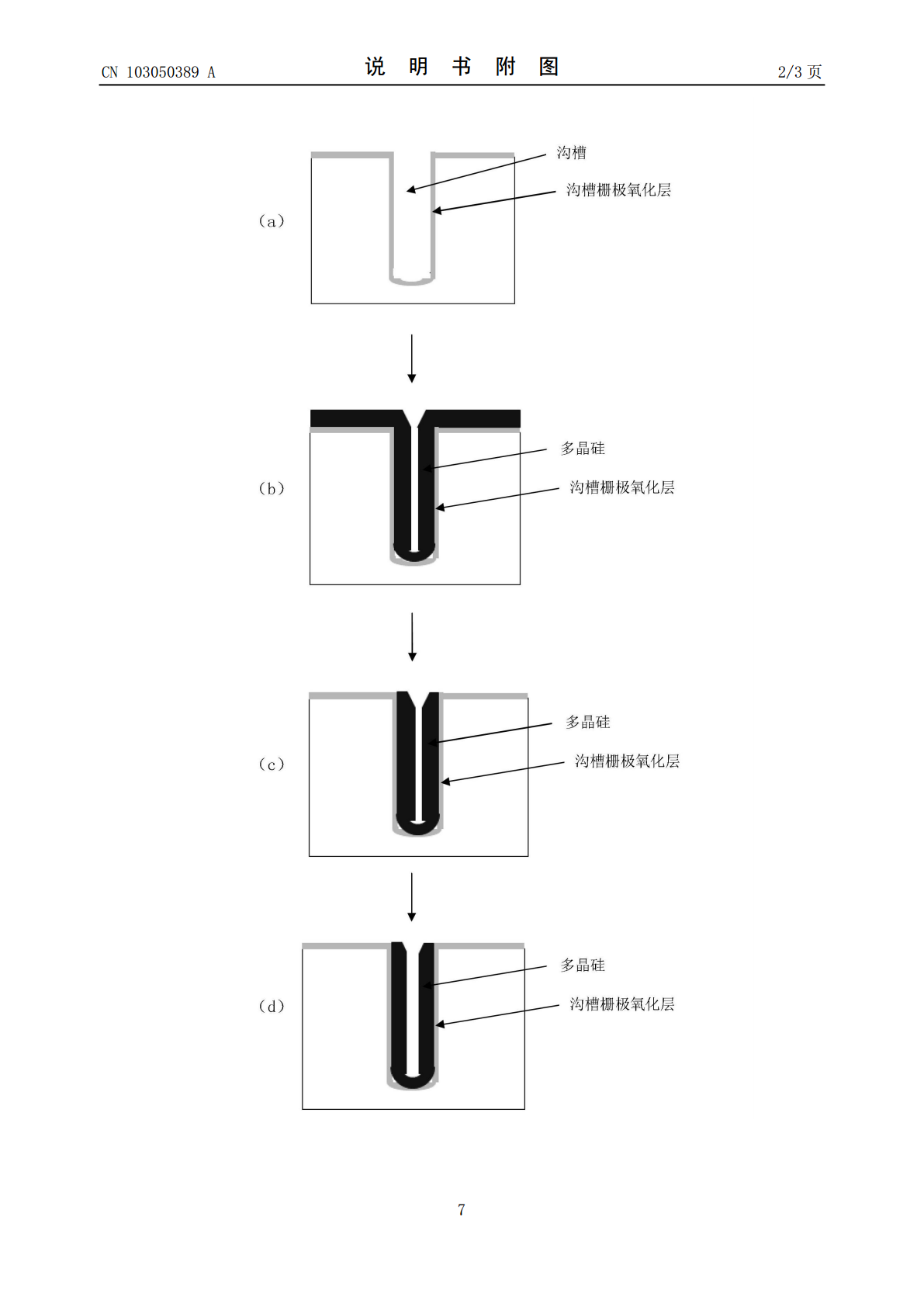

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

低应力IGBT沟槽型栅极的成长方法.pdf
本发明公开了一种低应力IGBT沟槽型栅极的成长方法,该方法在成长完栅极氧化层后,进行以下工艺步骤:1)在栅极氧化层上沉积一层多晶硅,并确保沉积后,沟槽内留有缝隙;2)多晶体回刻,形成上方开口的沟槽填充形貌;3)高温退火;4)多晶硅补沉积,形成无缝填充的沟槽作为栅极。其中,步骤1)至2)或步骤1)至3)可以重复多次进行。该方法通过多次多晶硅成膜和高温退火,使多晶硅的大部分应力得以释放,避免了后续高温工艺引入的应力累积,从而降低了硅片的面内应力,改善了硅片的翘曲度,保证了后续工艺流程中硅片的正常传送。

成长低应力绝缘栅双极型晶体管沟槽型栅极的方法.pdf
本发明公开了一种成长低应力绝缘栅双极型晶体管沟槽型栅极的方法,在沟槽内和沟槽两侧的上端面成长一层IGBT沟槽栅极氧化层;在多晶硅炉管上增加一路氧气管路,在沟槽内沉积多晶硅进行多晶硅成膜,并将需要成膜的多晶硅分多个步骤在一次程式中完成,在每个多晶硅成膜步骤完成后,通入稀薄的氧气,且关闭反应气体,成长一层很薄的氧化层作为应力缓冲层,然后多次重复上述过程,即形成漏氧式多晶硅,并用其填充沟槽。本发明能有效降低硅片应力,且不会影响多晶硅作为栅极的电学性能。

低输入电容的沟槽型IGBT器件及制备方法.pdf
本发明涉及一种低输入电容的沟槽型IGBT器件及制备方法。其对任一元胞,均包括两个呈长条状的元胞沟槽,在沿元胞沟槽的长度方向上,在元胞沟槽内设置若干槽内发射极导电多晶硅,所述槽内发射极导电多晶硅从元胞沟槽的槽口向元胞沟槽的底部方向延伸,且槽内发射极导电多晶硅通过多晶硅间介质层所在区域的栅极导电多晶硅绝缘隔离;在元胞沟槽间相互邻近的外侧壁上设置第一导电类型源区,所述第一导电类型源区沿元胞沟槽的长度方向分布,槽内发射极导电多晶硅在元胞沟槽内的底部位于第一导电类型源区的底部的下方。本发明在不影响米勒电容下,降低了

沟槽型IGBT器件的制作方法、沟槽型IGBT器件.pdf
本申请公开了一种沟槽型IGBT器件的制作方法,涉及半导体制造领域。该沟槽型IGBT器件的制作方法包括在IGBT终端区对应的衬底中形成场限环;在IGBT终端区对应的衬底中形成场氧;在终端区对应的衬底中形成沟槽场板,沟槽场板与IGBT有源区之间为场限环;在衬底表面形成介质层;在衬底的正面制作接触孔及正面金属层;解决了目前小元胞尺寸沟槽型IGBT器件的制作过程中接触孔和沟槽栅容易出现对准偏差的问题;达到了优化接触孔和沟槽栅的对准效果,提升小元胞尺寸沟槽型IGBT器件的性能的效果。

沟槽栅IGBT制作方法及沟槽栅IGBT.pdf
本发明提供一种沟槽栅IGBT制作方法及沟槽栅IGBT,其中,方法包括在衬底上形成掺杂区;在衬底和掺杂区形成沟槽;在掺杂区表面和沟槽内表面生长氧化层;在氧化层表面淀积二氧化硅层或低K介质层,其中,沟槽底部的二氧化硅层或低K介质层位于衬底范围内;将沟槽侧壁及掺杂区表面氧化层上的二氧化硅层或者低K介质层刻蚀掉,保留沟槽底部的二氧化硅层或者低K介质层,以使沟槽底部的第一覆盖层比沟槽侧壁的第二覆盖层厚;在沟槽中填充多晶硅,形成栅电极。由于沟槽底部的第一覆盖层比沟槽侧壁的第二覆盖层厚,因此可以减小沟槽栅IGBT的栅集
