
一种超结功率器件及其制作方法.pdf

Ja****23






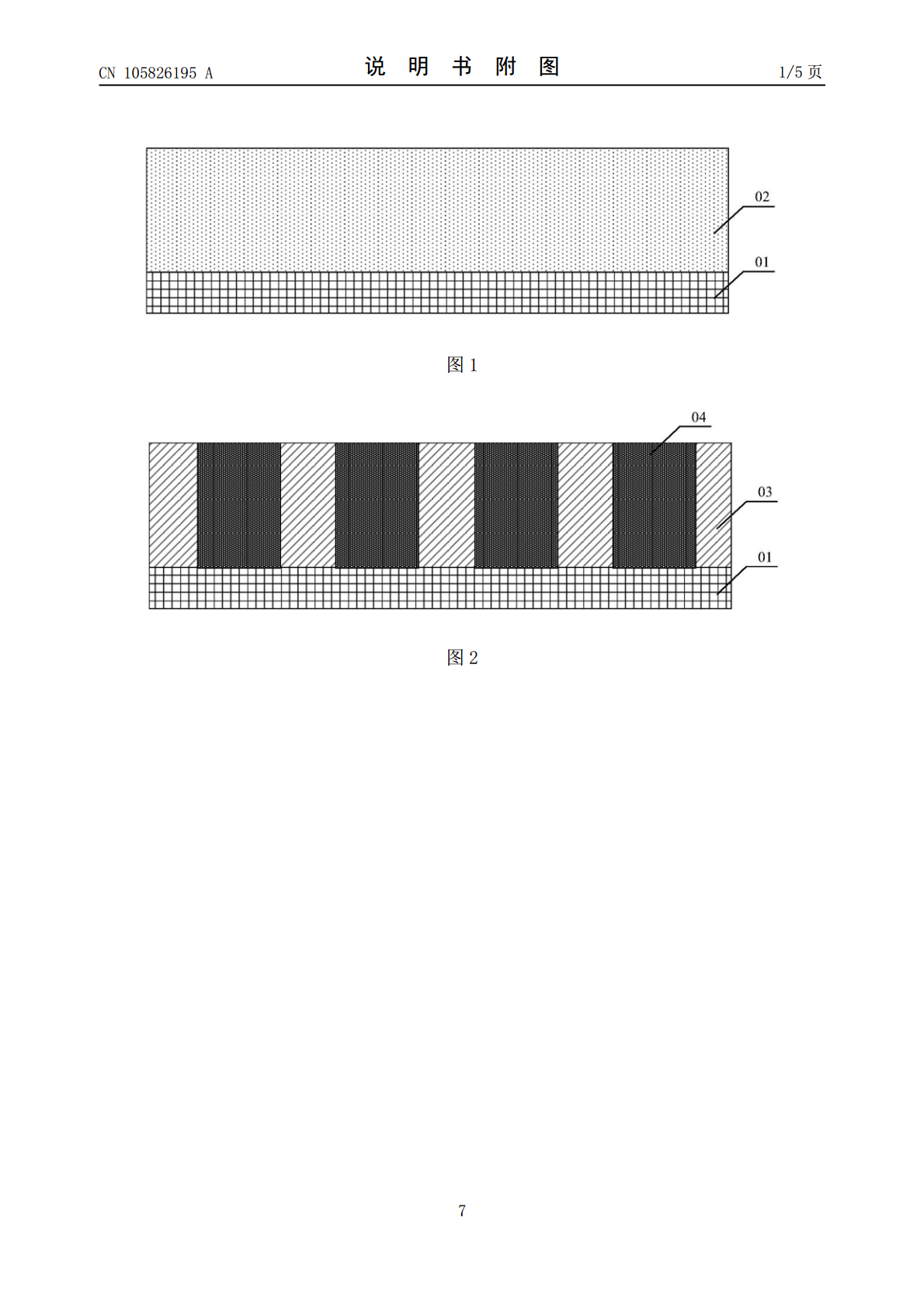



亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种超结功率器件及其制作方法.pdf
本发明公开了一种超结功率器件及其制作方法,其中制作方法包括:在衬底上形成外延层,并对所述外延层进行刻蚀形成沟槽;在所述外延层上方及所述沟槽内形成氧化层和多晶硅;在所述沟槽内填充介质材料形成介质层,去除所述外延层上方的氧化层、多晶硅以及沟槽内的介质层,保留所述沟槽内的氧化层、多晶硅和介质层,使得沟槽内保留的介质层与氧化层和多晶硅高度相同。采用对外延层进行刻蚀形成沟槽的方式,并在沟槽内形成氧化层和多晶硅,然后在沟槽中填充介质材料,形成P型区域,与现有制作方法相比,本发明不需要重复进行外延生长工艺来制作外延层,

一种沟槽型半超结功率器件及其制作方法.pdf
本发明公开了一种沟槽型半超结功率器件及其制作方法,其中制作方法包括:在衬底上形成双外延层,并进行刻蚀形成沟槽;在双外延层上方以及沟槽内形成P型硅;去除双外延层上方的全部P型硅以及沟槽内的部分P型硅;在双外延层以及沟槽内保留的P型硅上方形成氧化层,并在沟槽内填充多晶硅;去除双外延层上方的氧化层和多晶硅,对多晶硅进行N型离子注入,形成源区。采用双层外延片,一次沟槽刻蚀在沟槽下部形成P柱区域,利用氧化层作为隔离,在沟槽上部填充多晶硅形成沟道,工艺简单,降低了器件制造成本。双外延层以及保留的P型硅上方形成的氧化层

一种超结IGBT器件及其制作方法.pdf
本发明提供一种超结IGBT器件及其制作方法,涉及半导体器件技术领域,包括:集电结构,所述集电结构的上表面形成有超结结构,所述集电结构的下表面覆盖有集电极,所述超结结构包括若干个交替排列的N型柱和P型柱;N型载流子存储层,形成于所述超结结构的上表面;元胞单元,形成于所述N型载流子存储层的上方,所述元胞单元的上表面覆有发射极,所述元胞单元内形成有多个沟槽栅,各所述沟槽栅沿朝向所述超结结构的方向延伸并贯穿所述N型载流子存储层,各所述沟槽栅的底部形成与所述超结结构的所述P型柱相连的的P型重掺杂保护区。有益效果是设

超结功率器件及其制备方法.pdf
本发明提供一种超结功率器件及其制备方法,在制备超结功率器件时,可在形成第一导电类型外延层之后通过添加超结掩膜版、在形成第二导电类型阱区之前或之后直接通过阱区掩膜版,以及在形成接触结构之前或之后直接通过接触掩膜版,即可在第一导电类型外延层内注入第二导电类型杂质,以依次形成第二导电类型浮岛及第二导电类型柱,该制备工艺无需进行多次外延工艺,且无需进行深沟道刻蚀,因此制备工艺简单、成本低,且成品率及可靠性较高。本发明的超结功率器件同时具有第二导电类型浮岛及第二导电类型柱,在断路状态,可提高功率器件的击穿电压,降低

超结器件及其制作方法和电子器件.pdf
本申请的实施例提出了一种超结器件及其制作方法和电子器件。超结器件包括衬底以及设置在衬底一侧的外延层、至少两个多晶硅、浮空区、第一栅氧结构和第二栅氧结构。其中,衬底和外延层均为第一导电类型;多晶硅位于外延层,多晶硅为第二导电类型;浮空区位于外延层内且位于其中两个多晶硅之间,浮空区为第二导电类型;第一栅氧结构位于浮空区远离衬底的一侧,且第一栅氧结构与浮空区间隔设置,第二栅氧结构位于外延层远离衬底的一侧。根据本申请实施例中的超结器件,通过设置第一栅氧结构和浮空区能够增加栅漏两级之间的相对面积,使得栅漏电容变大,
