
沟槽型双层栅MOSFET的制作方法.pdf

光誉****君哥





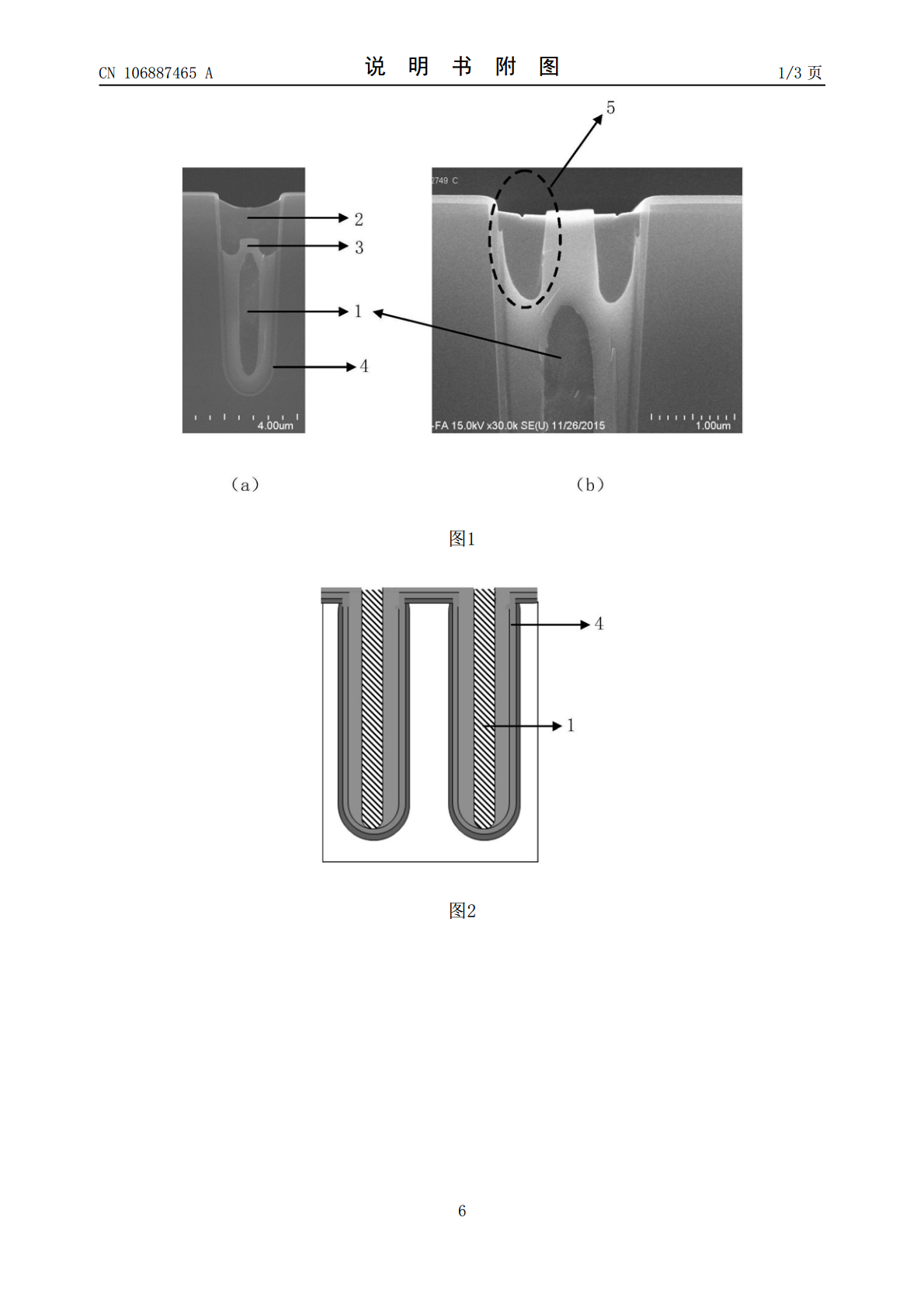
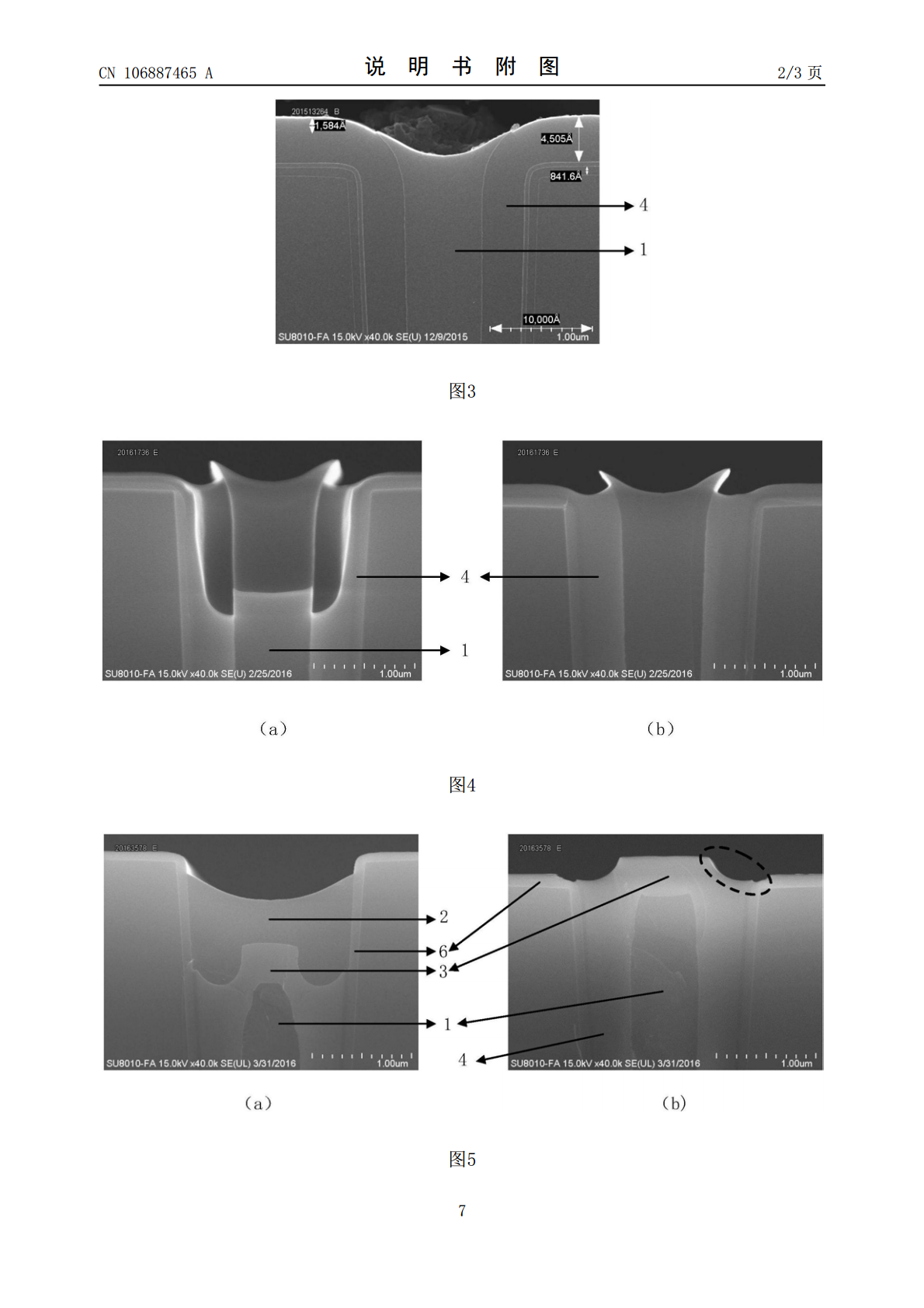

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

沟槽型双层栅MOSFET的制作方法.pdf
本发明公开了一种沟槽型双层栅MOSFET的制作方法,步骤包括:1)刻蚀沟槽,生长ONO结构的沟槽层接膜;2)生长源极多晶硅,反刻蚀至沟槽上表面;3)用光刻胶保护源极多晶硅引出端,反刻蚀密集区的源极多晶硅;4)依次去除沟槽层接膜中的部分外层氧化硅膜、光刻胶、沟槽层接膜中的剩余外层氧化硅膜;5)生长多晶硅间的氧化层;6)去除沟槽层接膜中的氮化硅膜和内层氧化硅膜;7)依次生长栅极氧化层、栅极多晶硅,并反刻蚀栅极多晶硅,完成器件的制作。本发明通过优化沟槽层接膜去除工艺和减少源极多晶硅的氧化量,改善了源极多晶硅引出

沟槽型双层栅MOSFET的制造方法.pdf
本发明公开了一种沟槽型双层栅MOSFET的制造方法,包括步骤:形成多个沟槽,沟槽包括多个栅沟槽以及至少一个源引出沟槽;形成底部介质层和源极多晶硅;采用HDPCVD淀积加回刻工艺形成多晶硅间氧化层;形成栅介质层;进行多晶硅淀积形成第二多晶硅层;对第二多晶硅层进行回刻,由回刻后填充于栅沟槽中的第二多晶硅层组成多晶硅栅,源引出沟槽的侧面也保留有剩余的第二多晶硅层;进行金属下介质层生长,生长厚度大于目标厚度,且金属下介质层的生长厚度满足将源引出沟槽中的间隙区完全填充;进行湿法刻蚀使金属下介质层的厚度减薄到目标厚

屏蔽栅沟槽型MOSFET的制造方法.pdf
本发明公开了一种屏蔽栅沟槽型MOSFET的制造方法,包括如下步骤:步骤一、提供表面形成有硅外延层的硅衬底并进行光刻刻蚀形成沟槽;步骤二、形成底部氧化层;步骤三、形成第一层多晶硅将沟槽完全填充;步骤四、进行热退火,利用热退火使第一层多晶硅再结晶并消除第一层多晶硅的缝隙;步骤五、对第一层多晶硅进行回刻并形成由保留于沟槽底部的第一层多晶硅组成多晶硅屏蔽栅。本发明能提高多晶硅屏蔽栅的表面形貌,进而提高多晶硅屏蔽栅的表面深度的均匀性,提高多晶硅屏蔽栅的屏蔽效果。

沟槽型功率MOSFET设计与栅电荷研究.docx
沟槽型功率MOSFET设计与栅电荷研究摘要:本篇论文主要介绍了沟槽型功率MOSFET(Metal-Oxide-SemiconductorField-EffectTransistor)的设计及应用,同时也研究了栅电荷对沟槽型功率MOSFET的影响。在实验中采用了物理模拟软件进行电路仿真和实验验证,结果显示沟槽型功率MOSFET设计能够实现良好的电性能,并且在相应的工作环境下,栅电荷对MOSFET的性能具有一定的影响。关键词:功率MOSFET;沟槽型;栅电荷;电性能;故障率1.前言随着电子科技的不断发展和应用

一种分裂栅型沟槽MOSFET的制备方法.pdf
本发明提供一种分裂栅型沟槽MOSFET的制备方法,包括步骤:1)提供一衬底,在所述衬底表面生长一外延层;2)刻蚀所述外延层,形成具有第一深度的沟槽,在所述沟槽表面淀积氮化物层,之后腐蚀掉沟槽底部的氮化物层,保留侧壁的氮化物层;3)继续刻蚀所述沟槽底部的外延层材料至第二深度,并热生长氧化物层附着在未被氮化物层覆盖的沟槽侧壁及底部;4)在所述沟槽下部填充第一导电材料,去除侧壁上的氮化物层,在所述第一导电材料表面制作一层隔离层;5)生长栅氧化层,覆盖于沟槽上部裸露的侧壁上,并在沟槽上部填充满第二导电材料,形成上
