
一种碳化硅器件结终端制作方法.pdf

Ch****75






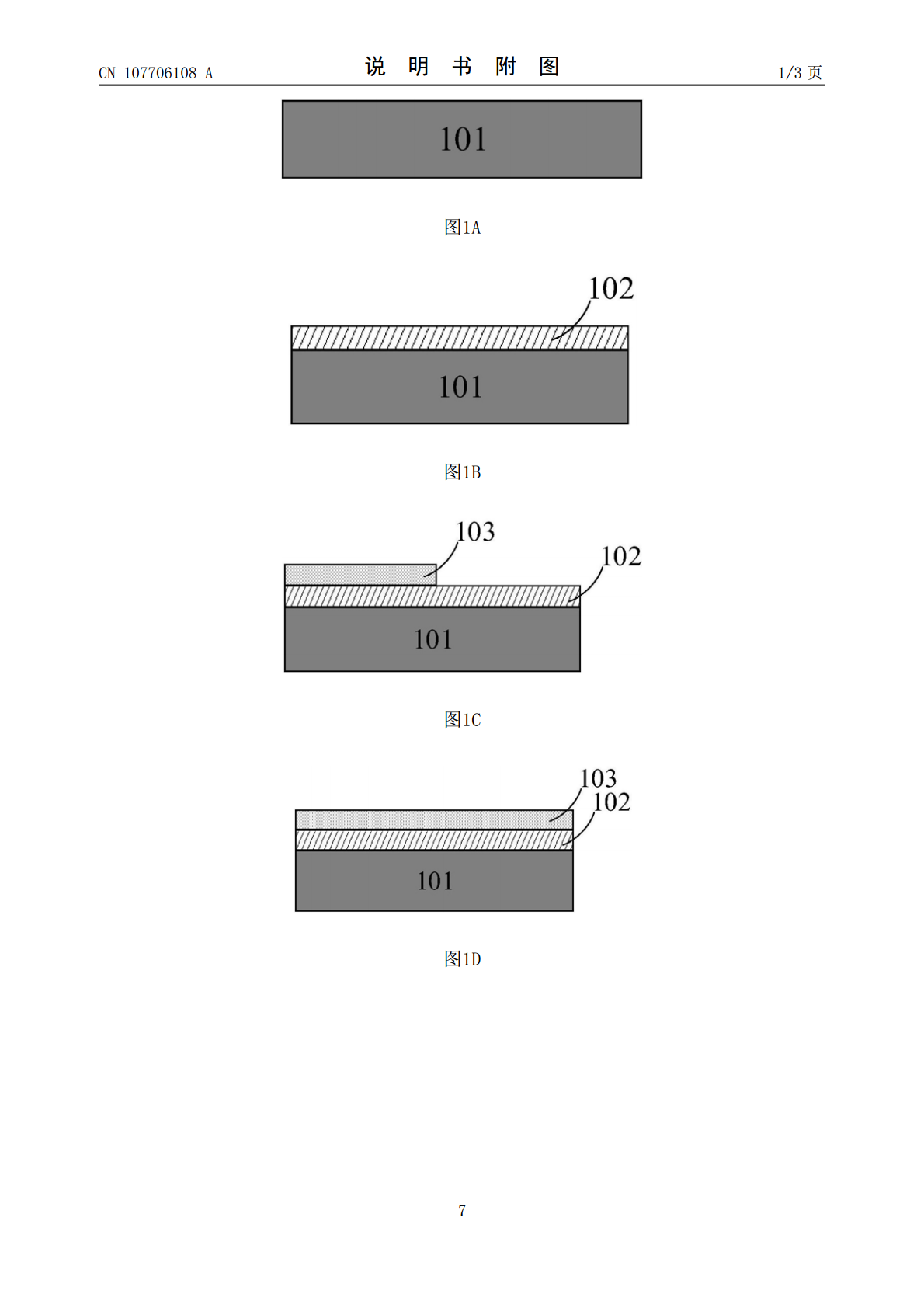
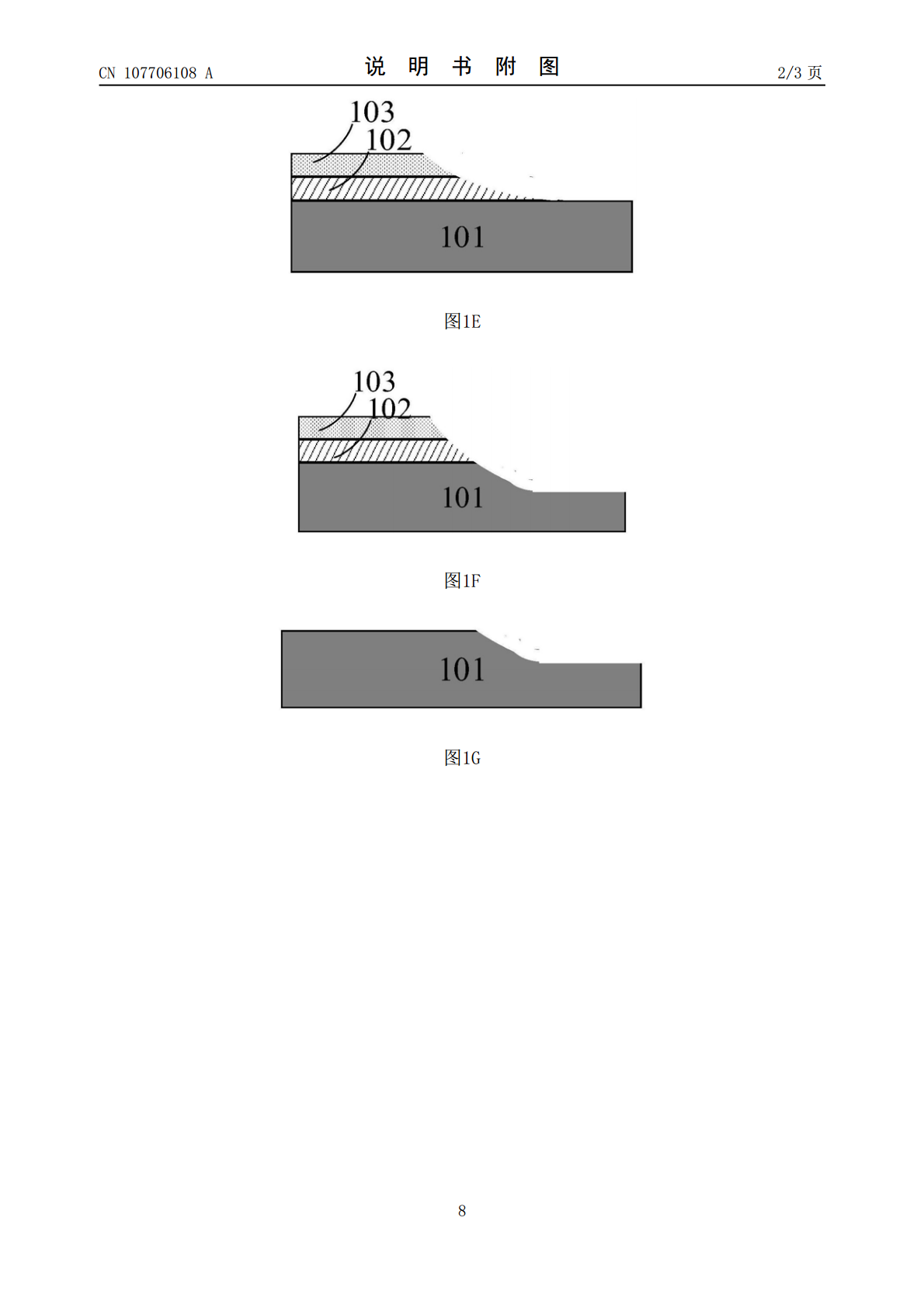

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种碳化硅器件结终端制作方法.pdf
本发明提供一种碳化硅器件结终端制作方法,其中包括:步骤一、提供SiC衬底,并沉积氧化物介质层,用于作为第一干法刻蚀的硬掩膜层;步骤二、在氧化物介质层上旋涂光刻胶,并形成刻蚀图形;步骤三、对氧化物介质层进行第一干法刻蚀并调控工艺参数,将刻蚀图形转移到氧化物介质层并形成第一刻蚀斜坡台面;步骤四、将第一干法刻蚀后的氧化物介质层作为第二干法刻蚀的硬掩膜层,对SiC衬底进行第二干法刻蚀并控制工艺参数,将刻蚀图形转移到SiC衬底并形成第二刻蚀斜坡台面;步骤五、进行湿法刻蚀,去除残留的氧化物介质层以及光刻胶残留层,形成

一种碳化硅器件结终端结构的制备方法及结终端结构.pdf
本发明提供一种碳化硅器件结终端结构的制备方法及结终端结构,包括:在碳化硅衬底层上形成外延层,并在所述外延层上沉积介质层;对所述介质层进行多次光刻和多次刻蚀处理,形成具有多种厚度的掩膜台阶;通过所述具有多种厚度的掩膜台阶向所述外延层进行离子注入,形成具有多种离子深度的结终端结构。通过具有多种厚度的掩膜台阶向外延层进行离子注入,形成具有多种离子深度的结终端结构,可以避免离子注入对碳化硅表面损伤,消除表面不可控的低浓度注入区域,提高了器件终端结构的可靠性和稳定性。

一种碳化硅器件的栅槽制作方法.pdf
本发明涉及半导体制造工艺,特别涉及一种碳化硅UMOS器件的栅槽制作方法。本发明的碳化硅器件的栅槽制作方法,主要是:根据栅槽区域窗口对碳化硅外延片上的介质层进行刻蚀,在刻蚀中保留碳化硅上表面部分介质层,然后采用腐蚀工艺对该部分介质层进行腐蚀,使介质层与碳化硅外延片的接触区域形成圆滑的弧形,从而使碳化硅外延片在刻蚀后能形成侧壁陡直、无微沟槽且底脚圆滑的碳化硅栅槽结构。本发明的有益效果为,得到了侧壁陡直、无微沟槽且底脚圆滑的碳化硅栅槽结构,减小了槽栅底部的电场集中效应,提高了器件击穿性能和可靠性。本发明尤其适用

一种功率器件结终端新技术.docx
一种功率器件结终端新技术随着电子技术的飞速发展,功率器件在各种电力电子设备中越来越受到重视。在众多的功率器件种类中,包括MOSFET、IGBT和SiCMOSFET等。其中,MOSFET作为一种高电压、低电流功率器件,在低压直流应用中得到了广泛的应用。近年来,MOSFET的发展已经进入了一个高端、高功率的阶段。结终端是MOSFET的重要组成部分,具有非常重要的作用。本文主要讨论一种针对结终端的新技术,以期促进MOSFET的更迅速、更稳定、更安全地发展。一、结终端的基本结构与作用MOSFET的结终端由N型材料

碳化硅器件非合金欧姆接触的制作方法及碳化硅器件.pdf
本发明提供了一种碳化硅器件非合金欧姆接触的制作方法及碳化硅器件,属于半导体器件制备领域,包括:对碳化硅圆片进行清洗;在碳化硅圆片表面淀积一层介质;光刻定义P型掺杂区域;对需要P型掺杂的区域进行离子注入,并去除光刻胶;光刻定义N型掺杂区域;对需要N型掺杂的区域进行离子注入,并去除光刻胶;去除碳化硅圆片表面介质,对碳化硅圆片进行高温退火;光刻定义欧姆接触区域;金属沉积以钛打底的多层金属;金属剥离,去除多余金属,保留金属电极部分,完成非合金欧姆接触电极的制作。本发明提供的制作方法,能够解决现有技术中存在的欧姆接
