
金属栅的制造方法.pdf

邻家****曼玉









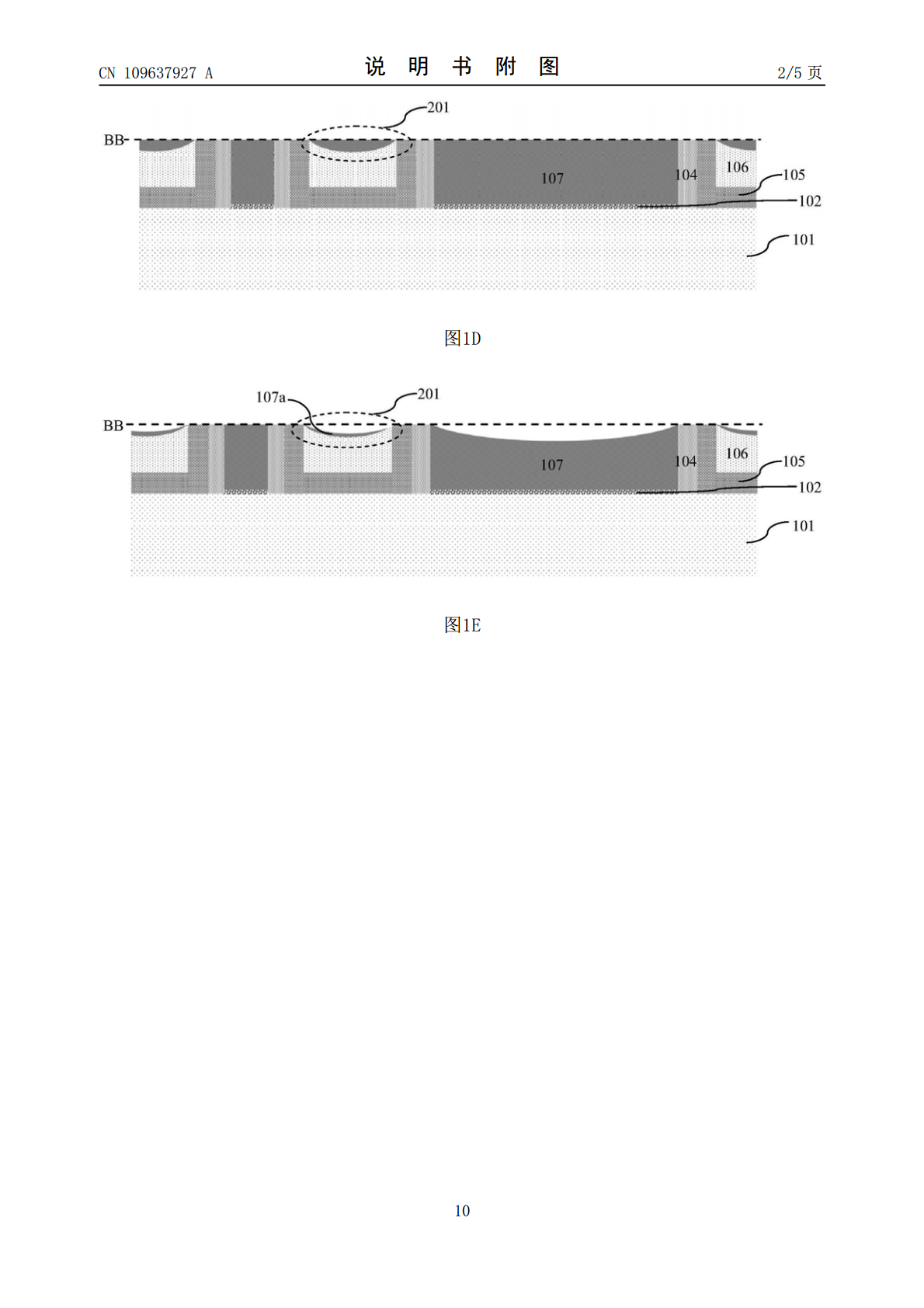
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

金属栅的制造方法.pdf
本发明公开了一种金属栅的制造方法,包括步骤:步骤一、提供形成有伪栅极结构、氮化硅侧墙和接触刻蚀停止层的半导体衬底;步骤二、形成层间膜;步骤三、进行第一次化学机械研磨工艺对层间膜进行平坦化,在层间膜的表面会形成碟状凹陷结构;步骤四、进行第二次回刻工艺对氮化硅进行回刻并将多晶硅栅两侧的氮化硅的表面低于碟状凹陷结构;步骤五、去除多晶硅栅;步骤六、进行金属栅对应的金属材料层的填充;步骤七、进行第二次化学机械研磨工艺对金属材料层进行平坦化,第二次化学机械研磨工艺将层间膜表面的金属材料层都去除并使金属材料层仅填充于多

三维NAND中的金属钨栅的制造方法.pdf
本发明公开了一种三维NAND中的金属钨栅的制造方法,其特征在于:方法包括:提供衬底;在衬底上,沉积介质阻挡层;在介质阻挡层上,沉积种子层;在种子层上,沉积金属钨;对金属钨进行干法刻蚀;以及对干法刻蚀之后的金属钨进行湿法刻蚀。本发明使用先干法刻蚀,再湿法刻蚀的技术对钨进行刻蚀,其中,干法刻蚀能够使得刻蚀之后凹槽中的金属钨的宽度变得更为一致,湿法刻蚀能够获得更好的刻蚀之后的金属栅的微观轮廓。

沟槽栅的制造方法.pdf
本发明公开了一种沟槽栅的制造方法,包括:步骤一、在半导体衬底表面形成沟槽。步骤二、形成第一氧化层,第一氧化层形成后需要使沟槽的顶部保持为开口状态。步骤三、沉积第二介质层,第二介质层形成后需要使沟槽的顶部开口封闭并在沟槽内部形成一个被第二介质层所包围的空腔。步骤四、对所述第二介质层进行第一次回刻将空腔外暴露的第二介质层去除且保证空腔顶部封口处的第二介质层保留。步骤五、以空腔周侧的第二介质层为掩膜对第一氧化层进行从顶部到底部的第二次刻蚀以形成栅极底部氧化层。步骤六、去除第二介质层。步骤七、进行栅氧化层的生长。

沟槽栅的制造方法.pdf
本发明公开了一种沟槽栅的制造方法,包括步骤:步骤一、在半导体衬底表面形成沟槽;步骤二、形成第一氧化层;步骤三、根据沟槽的深宽比选用涂布层并形成将沟槽完全填充的涂布层;步骤四、采用干法刻蚀工艺对涂布层进行全面回刻;步骤五、以保留于沟槽底部的涂布层为掩膜进行第一氧化层的湿法刻蚀形成栅极底部氧化层;步骤六、去除涂布层;步骤七、进行栅氧化层的生长。本发明能采用较低成本实现BTO,从而能降低工艺成本;能在更小深宽比的沟槽中形成良好的BTO,从而能适用于各种深宽比的沟槽的BTO形成,从而具有较大的使用范围。

沟槽栅的制造方法.pdf
本发明公开了一种沟槽栅的制造方法,包括:步骤一、在半导体衬底表面形成沟槽。步骤二、形成第一氧化层,第一氧化层形成后需要使沟槽的顶部保持为开口状态并在沟槽内包围处第二沟槽。步骤三、沉积第二介质层,第二介质层形成后需要使沟槽的顶部开口保持或封闭。步骤四、进行第一次化学机械研磨工艺使第二沟槽外第二介质层都去除,保留的所述第二介质层覆盖位于在所述第二沟槽的侧面和底部表面。步骤五、以保留的第二介质层为掩膜对第一氧化层进行从顶部到底部的第二次刻蚀以形成栅极底部氧化层。步骤六、去除第二介质层。步骤七、进行栅氧化层的生长
