
具有多层膜片的半导体换能器装置以及制造具有多层膜片的半导体换能器装置的方法.pdf

猫巷****忠娟








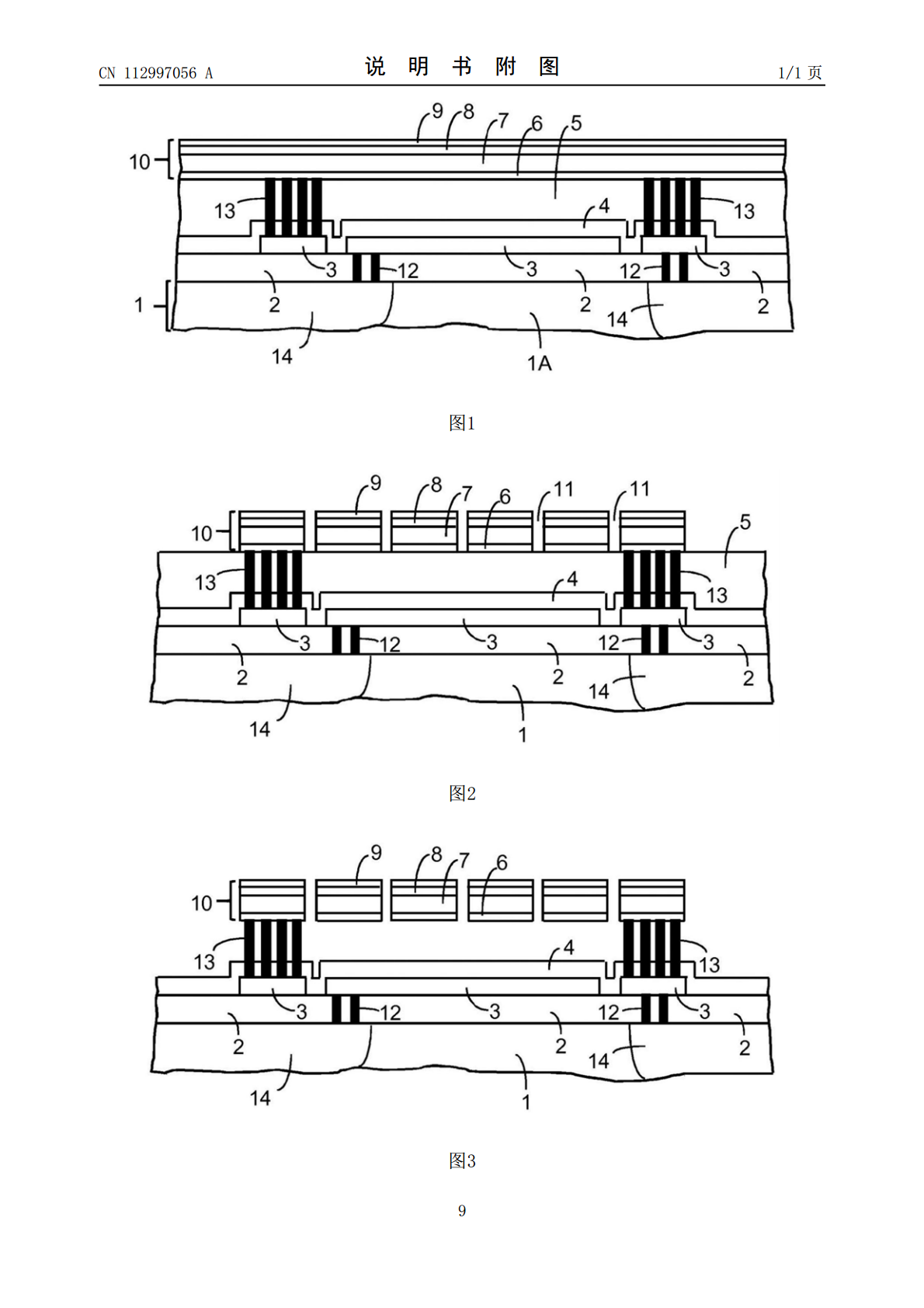
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

具有多层膜片的半导体换能器装置以及制造具有多层膜片的半导体换能器装置的方法.pdf
半导体换能器装置包括悬置在半导体本体(1)上方的膜片(10)。所述膜片(10)的第一层(9)包括耐蚀刻剂的材料,所述蚀刻剂包括氟或氟化合物,并且所述第一层覆盖包括钛和/或TiN的第二层(8)。因此所述第一层(9)充当保护层并且防止在使用HF蒸汽来蚀刻牺牲层(5)以释放所述膜片(10)期间的例如氟化钛的残留物的产生。

生产线圈装置的方法、线圈装置、具有线圈装置的测量换能器、具有测量换能器的仪器.pdf
本发明涉及:一种生产测量换能器(100)或仪器(200)的振荡传感器(9)或振荡激励器(10)的线圈装置(1)的方法(300)、一种线圈装置、一种测量换能器、以及一种仪器,该测量换能器(100)或仪器(200)用于测量流经测量换能器或仪器的至少一个测量管(110)的介质的密度或质量流量,其中,在第一方法步骤(301)中,利用金属微粒糊将线圈装置的电连接线(7)的第一端部(7.1)包围在线圈装置的电路板的凹部(6)中,其中,在第二方法步骤(302)中,干燥金属微粒糊,其中,干燥过程引起金属微粒糊的硬化,以便

荧光膜片及半导体发光装置.pdf
本发明提供了一种荧光膜片及半导体发光装置,其中荧光膜,包括硅胶和荧光粉,硅胶和荧光粉的质量比为1∶(3~4),且硅胶的折射率小于1.45。其使用折射率小于1.45的硅胶对荧光膜片进行制备,且制备中荧光粉与硅胶的质量比在(3~4)∶1,确保能够制备得到低色温/色区目标点距离坐标原点很远的色温的半导体发光装置。在制备过程中,不会出现荧光粉和硅胶混合后流动性很差、无法正常成膜的现象,可以达到能够正常使用的荧光膜片的外观标准,即表面光滑平整无空洞的膜片,且荧光膜片不会过脆导致切割过程中出现开裂等问题。

具有无源磁电换能器的半导体设备.pdf
本申请提供了具有无源磁电换能器的半导体设备。本发明涉及一种半导体设备,包括:第一类型的第一扩散区域(110),具有嵌入其中的、与所述第一类型不同的第二类型的第二和第三扩散区域(115),所述第二和所述第三扩散区域比所述第一区域掺杂得更多,所述第二和第三扩散区域各自连接至相应的触点(130、135),电介质层(120),至少覆盖所述第二和第三扩散区域的边缘以及所述第二和第三扩散区域之间的区域,压电层(140a),设置在所述电介质层(120)上,设置在所述电介质层(120)上方,设置成与所述电介质层(120)

光学膜片的制造装置及光学膜片的制造方法.pdf
本发明涉及一种光学膜片的制造装置,其包括:供料部、第一滚轮、第二滚轮及至少一紫外线光源;该供料部具有一出料管且沿一预定方向延伸;该第一滚轮与该第二滚轮的中心轴位于同一水平面上且均垂直于该预定方向,该第一滚轮与该第二滚轮均位于该出料管下方,该第一滚轮及该第二滚轮均包括齿轮状主体及环绕该齿轮状主体外侧的模仁,该第二滚轮与该第一滚轮隔开一预定距离以形成一成型通道;该第一滚轮及该第二滚轮用于共同挤压流入该成型通道的该紫外线可固化树脂;该至少一紫外线光源位于齿轮状主体内。本发明还涉及一种光学膜片的制造方法。
