
半导体芯片及其制备方法和半导体器件.pdf

曦晨****22








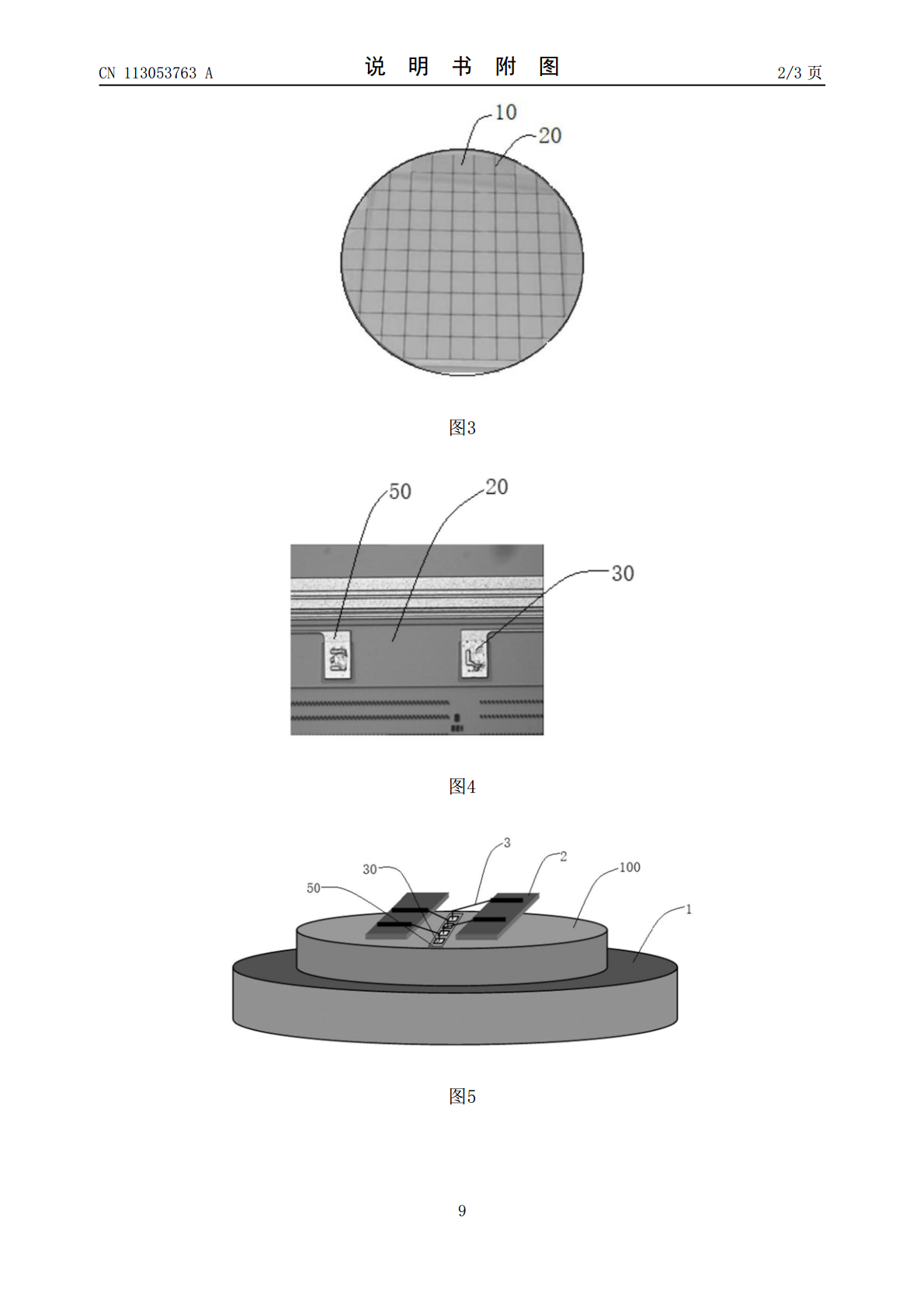

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

半导体芯片及其制备方法和半导体器件.pdf
本发明提供了半导体芯片及其制备方法和半导体器件,该方法包括:提供晶圆,所述晶圆上具有多个间隔分布的芯片,相邻的所述芯片之间设有划片道,所述划片道中设有至少一个用于晶圆允收测试的待测器件;对所述晶圆进行所述晶圆允收测试;在经过所述晶圆允收测试的所述晶圆上形成保护膜层。该方法中,先进行WAT测试然后再形成保护膜层,避免了相关技术中保护膜层残留对测试准确度和稳定性的影响,大大提高了制造效率和良品率,且对测试探针的磨损显著降低,测试成本有效降低。

半导体器件和制备半导体器件的方法.pdf
本发明公开了一种半导体器件和制备半导体器件的方法。该半导体器件包括:第一硅层(110;210);第一介质层(120;220),位于该第一硅层(110;210)上面,该第一介质层(120;220)包含窗口(121;221),该第一介质层(120;220)的窗口(121;221)底部的横向尺寸不超过20nm;III-V族半导体层(130;230),位于该第一介质层(120;220)上面以及该第一介质层(120;220)的窗口(121;221)内,并在该第一介质层(120;220)的窗口(121;221)内与该

半导体器件的制备方法和半导体器件.pdf
本申请公开了一种半导体器件的制备方法和半导体器件,包括:提供一衬底,衬底上形成有外延层,外延层上形成有ESD结构和第一氧化层,外延层中形成有DTI结构;在ESD结构、第一氧化层和DTI结构的表面形成第二氧化层;去除ESD结构、第一氧化层和DTI结构上方的第二氧化层,剩余的第二氧化层在ESD结构的周侧形成侧壁;在ESD结构和第一氧化层的上方依次形成第一层间介质和第二层间介质;在第一层间介质、第二层间介质和DTI结构中形成接触通孔,在接触通孔上形成金属引线,接触通孔的底端与DTI结构连接。本申请通过在ESD结

半导体器件的制备方法和半导体器件.pdf
本发明实施例公开了一种半导体器件的制备方法和半导体器件。方法包括:提供具有多个有源区的衬底,有源区包括源漏极区,位线接触区,字线段和字线绝缘结构;在源漏极区上形成保护层,且保护层覆盖字线绝缘结构并具有在位线接触区上形成的接触通道,接触通道连通到位线接触区;形成缓冲材料层,覆盖保护层以及接触通道的侧壁;刻蚀缓冲材料层,保留缓冲材料层位于接触通道的侧壁的部分,以形成缓冲层,缓冲层再定义接触通道的宽度;在保护层上及接触通道内形成位线材料层,位线材料层还覆盖缓冲层;图案化位线材料层,以在所述接触通道之上形成高于保

半导体器件及其制备方法.pdf
本发明涉及一种半导体器件及其制备方法,在形成第一接触塞和第二接触塞时,使得第一接触塞与第一介质层之间以及第二接触塞与第一介质层之间形成台阶,进而后续形成第一金属层时,第一金属层也形成有台阶;然后直接沉积第二介质层和第二金属层,然后光刻一次,对第二金属层和第二介质层进行刻蚀,在第一金属层的台阶处停留,第二接触塞上的第一金属层暴露出残留的第二介质层;然后在第二接触塞上暴露出的第一金属层上形成刻蚀保护层,再刻蚀残留的第二介质层和第一层接触塞位置之外的第一金属层。相较于传统的两次光刻,本申请仅进行了一次光刻,减少
