
图案化掩膜层的形成方法.pdf

小长****6淑









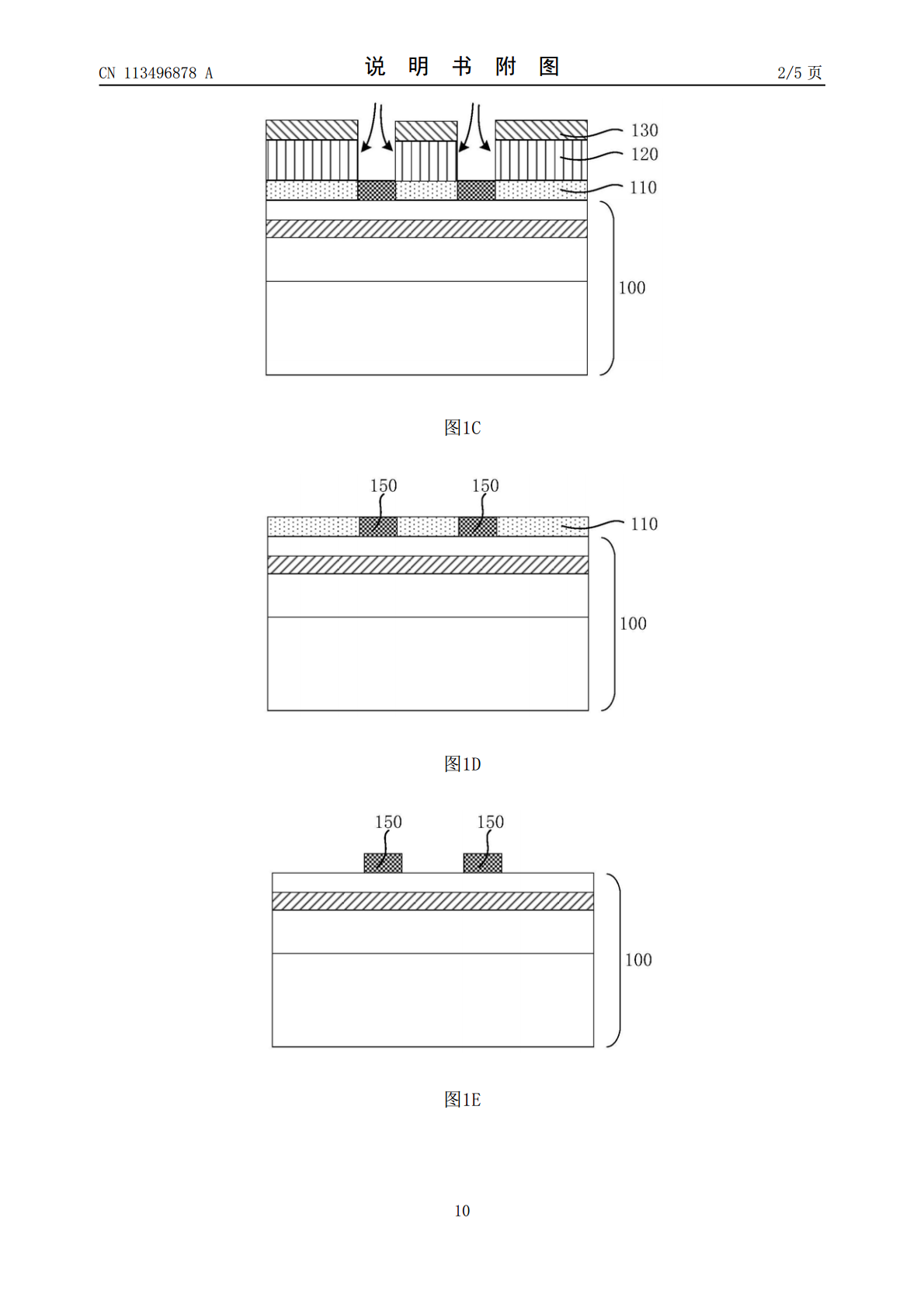
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

图案化掩膜层的形成方法.pdf
本申请公开了一种图案化掩膜层的形成方法,包括:提供基底结构,在所述基底结构上依次形成掩膜材料层,填充层,抗反射层以及光掩膜层;图案化所述光掩膜层,并将所述光掩膜层的图案转移至所述抗反射层以及填充层,形成暴露所述掩膜材料层的开口;沿所述开口对暴露出的掩膜材料层进行离子注入,使离子注入区域的掩膜材料层形成掩膜层,并去除所述光掩膜层;采用干法非等离子体刻蚀工艺去除所述抗反射层;采用湿法刻蚀工艺去除所述填充层;去除所述掩膜材料层。所述方法避免在所述掩膜材料层以及掩膜层表面产生抗反射层以及填充层的残留,以形成无缺陷

图案化掩膜版、其制备方法及使用其进行激光剥离的方法.pdf
本发明属于电子器件制备工艺领域,并公开了一种图案化掩膜版的制备方法,包括以下步骤:1)在透明基板的第一表面上沉积一层吸光材料层并图案化;2)在透明基板的第二表面上旋涂聚合物材料层;3)用激光照射透明基板的第一表面,该透明基板上被吸光材料覆盖的区域,激光能量未达到聚合物材料烧蚀阈值,聚合物得以保留;而透明基板上未被吸光材料覆盖的区域的聚合物会被激光烧蚀,聚合物材料层被烧蚀后实现图案化,并且图案的形状与透明基板的第一表面沉积的吸光材料的形状一致,从而形成所述图案化掩膜版。本发明可以实现对激光剥离后的界面粘附强

形成下层膜的组合物、图案形成方法及形成图案的下层膜形成用共聚物.pdf
本发明提供一种形成下层膜的组合物,该形成下层膜的组合物的材料对有机溶剂的溶解度较高,可通过在大气下且相对低温的加热处理而形成难以破裂的下层膜,在形成有下层膜的情况下对于有机溶剂的涂布膜残留率较高。本发明是一种形成下层膜的组合物及图案形成方法,该形成下层膜的组合物包含共聚物及有机溶剂,共聚物具有聚合部a及聚合部b,聚合部a具有糖衍生物部,糖衍生物部为五碳糖衍生物部及六碳糖衍生物部中的至少一者,聚合部b不具有糖衍生物部,该形成下层膜的组合物为用于图案形成的下层膜形成用。

密合膜形成材料、图案形成方法、及密合膜的形成方法.pdf
本发明涉及密合膜形成材料、图案形成方法、及密合膜的形成方法。本发明的课题是目的为提供一种密合膜形成材料,是在半导体装置制造步骤中的利用多层抗蚀剂法所为的微细图案化处理中,能给予具有与抗蚀剂上层膜的高密合性,具有抑制微细图案的崩塌的效果,且能形成良好的图案形状的密合膜的密合膜形成材料;并提供使用了该材料的图案形成方法、及上述密合膜的形成方法。本发明的解决手段是一种密合膜形成材料,是形成于含硅中间膜与抗蚀剂上层膜之间的密合膜的密合膜形成材料,其特征在于,含有:(A)具有下述通式(1)及下述通式(2)表示的结构

硬掩膜层结构及低K介质层刻蚀方法.pdf
本发明提供一种硬掩膜层结构及低K介质层刻蚀方法,通过使用氮化亚铜(Cu3N)硬掩膜层,避免现有低K介质刻蚀技术中无机TixFy残留物的形成,且氮化亚铜(Cu3N)硬掩膜层易于移除,从而抑制了后续铜电镀工艺中的孔洞缺陷的形成,改善了器件电迁移和和可靠性,提高了产品良率;进一步的,通过刻蚀后的氮气处理工艺在低K介质层的刻蚀内壁上形成阻挡层,缓和了低K介质层和氮化亚铜(Cu3N)硬掩膜层的湿法腐蚀选择比差异,避免低K介质层在湿法腐蚀移除氮化亚铜(Cu3N)硬掩膜层时受损,有效增大低K介质层的刻蚀后的工艺窗口。
